Контроль полупроводниковых слитков.
В связи с анизотропией свойств полупроводниковых монокристаллов, слитки перед их резкой должны быть сориентированы относительно определенной кристаллографической плоскости с точностью порядка 10, а для некоторых типов интегральных микросхем - с точностью 0,50. Определение кристаллографической ориентации монокристалла перед операцией резки слитка на пластины проводят оптическим и рентгеновским методами.
Оптический метод ориентации слитка.
После химического травления торцевой поверхности слитка на ней образуются ямки травления, форма которых определяется кристаллографической ориентацией поверхности. На плоскости (111) ямки травления имеют вид тетрагональных пирамид с треугольным основанием, на плоскости (110) - вид пирамид с ромбическим основанием. Отражаясь от граней ямок травления, световые лучи создают на матовом стеклянном экране характерные световые фигуры. При отклонении плоскости торца слитка от кристаллографической плоскости с заданными значениями индексов Миллера симметрия ямок травления и, соответственно, световых фигур нарушается. На Рис. 1 приведена схема ориентации слитка световым методом.
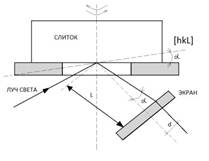
Рис. 1. Схема ориентации монокристалла оптическим методом.
Отклонение плоскости шлифа от кристаллографической плоскости определяют, вращая слиток вокруг его оси до совмещения центра фигуры отражения с центром экрана. Точность ориентации оптическим методом зависит от качества селективного травления и составляет для кремния 3 угловых минуты, а для германия - 15 угловых минут.
Рентгеновский метод ориентации слитка.
Метод основан на использовании известного уравнения Брегга-Вульфа для дифракции рентгеновских лучей:
2dSinQ = nl, (1)
где d - межплоскостное расстояние, Q - угол между падающим и отраженным пучком рентгеновских лучей, l - длина волны рентгеновского излучения, n - порядок отражения.
На Рис. 2 приведена схема ориентации слитка рентгеновским методом.
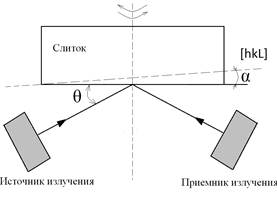
Рис. 2. Схема ориентации монокристалла рентгеновским методом.
Торцевую поверхность слитка обрабатывают так, чтобы она была перпендикулярна оси слитка. Слиток закрепляют на предметном столике, и на поверхность слитка направляют пучок рентгеновских лучей под углом, равным углу рассеяния Q на искомой кристаллографической плоскости. В одной плоскости с осью слитка и осью рентгеновского пучка помешают приемник отраженного рентгеновского излучения. Наклоном слитка и вращением его вокруг оси добиваются максимальной интенсивности отраженного рентгеновского излучения. Найденное отклонение слитка относительно исходной оси и будет отклонением плоскости его поверхности от требуемой кристаллографической ориентации.
 2014-02-09
2014-02-09 2500
2500








