Бесспорно, для дальнейшего развития электроники, т.е. увеличения производительности за счет уменьшения размеров чипов, ключевым моментом является совершенствование методов литографии.
Это значит, что толщина линий, наносимых светом на поверхности фоторезиста в момент формирования “рисунка” микросхемы, должна стремиться к уменьшению. Этого можно достичь уменьшением длины волны, ведь чем меньше длина волны, тем более мелкие детали рельефа она позволяет «нарисовать».
Первоначально засветка производилась инфракрасным излучением с длиной волны чуть более 1 микрона – и ширина дорожек была примерно такой же. Затем стандартными стали длины волн 435 и 365 нм. При помощи источника излучения с длиной волны 365 нм вычерчивались линии толщиной до 0,35 микрон, что почти соответствует длине волны.
Затем благодаря переходу на источники, действующие в спектре глубокого УФ-излучения (DUV*литография “Deep UltraViolet”) с длиной волны 248 нм, полупроводниковая промышленность перешла на 0,18_микронную литографию. Достижение топологических размеров в 100 нм и меньше потребует уменьшения длины волны излучения, возможно, за счет применения принципиально новых источников.
В настоящее время интенсивно развивается EUV*литография (Extreme Ultra Violet)-литография в спектре жесткого ультрафиолета, обеспечивающая толщину линий проводников в 70 нм, что примерно в тысячу раз меньше толщины человеческого волоса.
EUV_литография является обычной литографией, но с использованием излучения с длиной волны 11 - 14 нм, отражательной оптикой и фотошаблонами. Оптическая система содержит набор зеркал между источником света и маской.
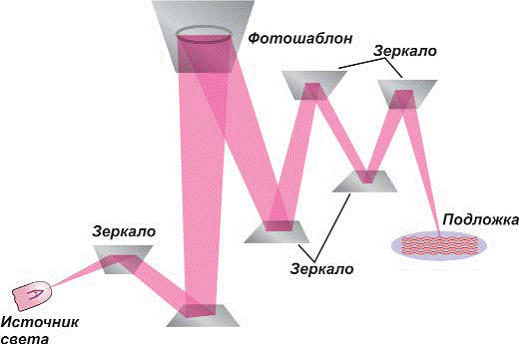
Рис 106. Схема оптической литографии
Чтобы дать читателю представление о преимуществах EUV_литографии, приведем несколько наглядных примеров:
· EUV_технология приводит к появлению микропроцессоров в 30 раз быстрее существующих. Процессор в 10 ГГц, например, будет настолько быстрым, что, например, за время, пока человек успевает моргнуть глазом (около 1/5 секунды), он сможет произвести порядка 2 млрд. вычислений.
· EUV_литография предназначена для печати на кремниевой подложке элементов размером 0,07 мкм (70 нм) и менее. Это все равно, что рисовать изображение размером с двухрублевую монету на поверхности Земли с космического корабля, а затем поверх него печатать другую картинку, четко совмещая их между собой. На одном кристалле соли (с ребром 0,25 мм) раз-местилось бы около 3600 таких 70_нанометровых элементов.
· Элементы, нанесенные с помощью EUV_ и DUV_литографии, примерно так же отличаются друг от друга, как две одинаковые линии, проведенные на бумаге шариковой ручкой (EUV) и маркером (DUV).Переход к EUV_ литографии позволил пересечь 100 нм рубеж, оставаясь в рамках традиционной фотолитографии. Однако сложная зеркальная оптика и технология изготовления фотошаблонов делает такой подход исключительно дорогим, оставляя место для разработки литографических процессов, основанных на иных физических принципах.
Тема 12: «Технологический процесс изготовления планарного транзистора».
Укрупненные схемы технологических процессов изготовления полупроводниковых (монолитных) приведена ниже.

Рис. 1. Укрупненная схема технологического процесса изготовления полупроводниковых (монолитных) ИС.
Опишем технологический процесс производства интегральной микросхемы генератора напряжения.
На первоначальном этапе происходит формирование слитков кремния и резка этих слитков алмазными дисками с внутренней режущей кромкой на пластины – базовые кристаллы, на которых будут сформированы в последствии элементы микросхем. Поверхность кристалла тщательно шлифуют для устранения поверхностных повреждений, полученных в результате резки. Производят полировку, причем разными материалами – алмазной суспензии, порошкообразными материалами. Затем производят очистку с целью удаления поверхностного слоя, в которых находятся поверхностные механические напряжения. Для этого над поверхностью пластины пропускают HCl при высокой температуре и обмывают кристалл деионизованной водой, растворами моющих порошков, проточной воде и, затем, сушат пластину до полного высыхания.
На следующем этапе производят окисление поверхности кристалла с целью образования двуокиси кремния с определенной толщиной.

Это делается для того, чтобы при проведении
легирования, легированным оказался не весь кристалл, а только определенный участок.
Нанесения слоя фоторезиста

Соответственным образом поверх слоя двуокиси кремния наносят слой фоторезиста, контактным (или другим способом) производят процесс фотолитографии. При этом используется фотошаблон.
Открытые участки проявляют, задубливают и ликвидируют, и таким образом получают участок двуокиси кремния для последующего травления.
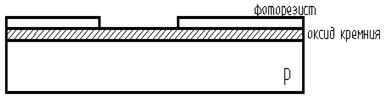
Образовавшиеся окна травят, в результате область подложки становится открытой для последующего легирования и образования скрытого n+ слоя. Таким образом, подложка становится полностью готовой для проведения операции легирования.

Для получения высоколегированного слоя n+ типа, про 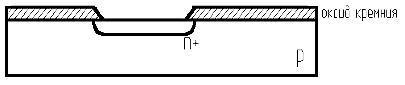 изводится высокотермическая диффузия сурьмой до предела ее растворимости. Таким образом, формируется скрытый n+ слой. Производится разгонка сурьмы в n+ кармане.
изводится высокотермическая диффузия сурьмой до предела ее растворимости. Таким образом, формируется скрытый n+ слой. Производится разгонка сурьмы в n+ кармане.
Слой фоторезиста ликвидируют. Поверхность оксида кремния тщательным образом очищают, омывают в проточной деионизованной воде и сушат центрифугированием.
Слой двуокиси кремния стравливают в плавиковой кислоте, образуется открытая поверхность подложки с тремя участками высоколегированного слоя. Поверхность подложки тщательно очищают химическими методами и омывают в проточной деионизованной воде.
После проведения этих операций, подложка становится готовой к проведению эпитаксиального наращивания кремния n-типа проводимости. Таким образом получают т.н. коллекторный слой, который присутствует в структурах активных элементов, и в этом же слое формируются резисторы среднего номинала (5кОм, 10 кОм), также этот слой присутствует в структуре МДП-конденсатора.

Далее производят разделительную диффузию с целью отделения одних элементов от других. Для этого повторяют ранее описанные процессы: нанесение слоя двуокиси кремния, нанесение фоторезиста, совмещение с фотошаблоном (см. приложение), экспонирование, проявление, удаление засвеченных участков фоторезиста, травления слоя двуокиси кремния в окне фоторезиста. После этого производят разделительную диффузию путем легирования бора в эпитаксиальный слой на поверхности подложки.

Для каждого элемента таким образом образовался свой эпитаксиальный слой. Далее производят диффузию фосфора в эпитаксиальный слой с целью создания базовой области. Для этого повторяют ранее описанные процессы: нанесение слоя двуокиси кремния, нанесение фоторезиста, совмещение с фотошаблоном, экспонирование, проявление, удаление засвеченных участков фоторезиста, травления слоя двуокиси кремния в окне фоторезиста. Затем производится легирование фосфором (см. приложение). Базовая область используется как база у активных элементов и в качестве резистивного слоя у резисторов.

Далее создаются области, которые у активных элементов используются как эмиттерная область, у резисторов она может отсутствовать. Перед этим производится совокупность ранее описанных процессов: нанесение слоя двуокиси кремния, нанесение фоторезиста, совмещение с фотошаблоном, экспонирование, проявление, удаление засвеченных участков фоторезиста, травления слоя двуокиси кремния в окне фоторезиста. Затем производится легирование сурьмы (см. приложение) и ликвидация фоторезиста и слоя двуокиси кремния с последующей тщательной очисткой поверхности.

После этого кристалл готов к нанесению на его поверхность внешней изоляции и нанесения алюминиевых выводов на базовую, коллекторную имиттерную области кристалла. Для этого производят тщательную очистку поверхности кристалла и осаждают нитрид кремния. Затем производят нанесение фоторезиста, совмещение с фотошаблоном, экспонирование, проявление, удаление засвеченных участков фоторезиста, травления слоя нитрида кремния в окне фоторезиста и удаление фоторезиста со вcей поверхности нитрида кремния.

Затем на всю поверхность кристалла наносят сплав алюминия и кремния методом катодного распыления. Далее производят операцию фотолитографии и травление алюминия. Таким образом производится электрическое соединение элементов схемы в соответствии со схемой электрической принципиальной.

Вся поверхность кристалла подлежит тщательной очистке и сушке центрифугированием. Затем на поверхность кристалла наносится слой двуокиси кремния методом окисления моносилана. Производится изготовление окон в изоляционном слое для соединения токоведущих дорожек микросхемы с внешними выводами.



Скрайбирование — раскол пластины на чипы.
 2015-04-01
2015-04-01 1103
1103
