В современном мире не обойтись без использования сложных технических устройств. К тому же все этапы металлографии требуют использование соответствующего оборудования, которое может обеспечить успех лабораторного исследования.
От качества оборудования для металлографического исследования зависит очень многое, например, на этапе пробоподготовки повторяемость свойств материалов от пробы к пробе.
Компания ООО «РВС» предлагает Вам широкий выбор современного оборудования, с помощью которого осуществляется металлография на обоих этапах исследования.
• Отрезные станки;
• Прессы для запрессовки;
• Оборудование для холодной заливки;
• Шлифовально-полировальные станки;
• Сушильные шкафы;
• Микроскопы в комплексе с системами анализа изображений;
• Твердомеры и Микротвердомеры;
• Печи, ванны, закалочные баки для термообработки.
8. Анализ структуры с помощью РЭМ
Растровый электронный микроскоп (РЭМ, англ. Scanning Electron Microscope, SEM) — прибор класса электронный микроскоп, предназначенный для получения изображения поверхности объекта с высоким (до 0,4 нанометра) пространственным разрешением, также информации о составе, строении и некоторых других свойствах приповерхностных слоёв. Основан на принципе взаимодействия электронного пучка с исследуемым объектом.
Современный РЭМ позволяет работать в широком диапазоне увеличений приблизительно от 3-10 крат (то есть эквивалентно увеличению сильной ручной линзы) до 1 000 000 крат, что приблизительно в 500 раз превышает предел увеличения лучших оптических микроскопов.
Сегодня возможности растровой электронной микроскопии используются практически во всех областях науки и промышленности, от биологии до наук о материалах. Существует огромное число выпускаемых рядом фирм разнообразных конструкций и типов РЭМ, оснащенных детекторами различных типов.


 Место РЭМ в микроскопии. Растровый электронный микроскоп (РЭМ) формирует изображение объекта при сканировании его поверхности электронным зондом. Это один из наиболее универсальных приборов для исследования микроструктурных характеристик металла (табл. 1). По темпам развития и количеству моделей РЭМ опережает просвечивающие электронные микроскопы (ПЭМ), так число микрофотографий, полученных на РЭМ приближается к числу фотографий полученных на световом микроскопе и значительно превосходит ПЭМ. По разрешающей способности РЭМ занимает промежуточное положение между ПЭМ и СМ (табл. 2). Но не следует рассматривать их как конкурирующие приборы, скорее они дополняют друг друга.
Место РЭМ в микроскопии. Растровый электронный микроскоп (РЭМ) формирует изображение объекта при сканировании его поверхности электронным зондом. Это один из наиболее универсальных приборов для исследования микроструктурных характеристик металла (табл. 1). По темпам развития и количеству моделей РЭМ опережает просвечивающие электронные микроскопы (ПЭМ), так число микрофотографий, полученных на РЭМ приближается к числу фотографий полученных на световом микроскопе и значительно превосходит ПЭМ. По разрешающей способности РЭМ занимает промежуточное положение между ПЭМ и СМ (табл. 2). Но не следует рассматривать их как конкурирующие приборы, скорее они дополняют друг друга.
ИНФОРМАЦИЯ ПОЛУЧАЕМАЯ С ПОМОЩЬЮ РЭМ
| Свойства | Способ формирования контраста |
| Топография поверхности | Вторичные электроны (основной), отраженные электроны, поглощенный ток, катодолюминесценция |
| Химический состав | Рентгеновское излучение (основной), отраженные электроны, поглощенный ток, катодолюминесценция, Оже-электроны |
| Толщина образца | Прошедшие электроны |
| Электрические и магнитные поля в образце | Вольтовый контраст, магнитный контраст (прошедшие электроны, отраженные электроны, поглощенный ток) |
| Электрические свойства полупроводников | Внутренние токи и напряжения |
СРАВНИТЕЛЬНАЯ ХАРАКТЕРИСТИКА МИКРОСКОРОВ РАЗЛИЧНЫХ ТИПОВ
| Микро-скоп | Разреша-ющая способность, нм | Глубина фокуса | Максим. поле зрения | Пригото-вление образцов | Толщина образца | Рабочая среда | Стоимость |
| СМ | 100-200 | Малая | Большое | Простое | Большая | Разнооб-разная | Низкая |
| РЭМ | 1,5-10 | Большая | Большое | Простое | Большая | Обычно вакуум | Высокая |
| ПЭМ | 0,2-1 | Умеренная | Малое | Сложное | Малая | Вакуум | Высокая |
Можно указать следующие преимущества и недостатки растровой электронной микроскопии:
1) Разрешающая способность и глубина фокуса на два порядка превышает значения для СМ. Разрешающая способность ПЭМ при исследовании реплик и РЭМ при непосредственном исследовании образцов практически равны. Подготовка образцов так же проста, что выгодно отличает его от ПЭМ. РЭМ широко применяется в металлографических исследованиях при увеличениях 300-10000, при меньших целесообразно использование СМ. По разрешающей способности РЭМ уступает ПЭМ, к тому же ему недоступна информация об объеме металла (фольги), что разделяет области использования данных приборов.
2) При наличии соответствующих приставок к РЭМ имеется возможность проведения рентгеносректрального и катодолюминисцентного анализов, электронной спектроскопии, изучения магнитных и электрических микрополей, дифракционных эффектов и т.д. Имеется возможность изучения динамических процессов непосредственно в РЭМ (процессы при механическом нагружении металлов, нагреве, охлаждении и т.д.).
3) Применяемый в РЭМ поточечный принцип формирования изображения позволяет использовать микро-ЭВМ для количественного анализа изображения и обработки результатов измерений.
 Эффекты, возникающие при взаимодействии электронного пучка с веществом и используемые для формирования изображения в РЭМ: 1–эл.пучок; 2–образец; 3–отраженные электроны; 4–вторичные эл.; 5–ток погложенных эл.; 6 – катодолюминесценция; 7–рентген. излучение; 8–Оже-электроны; 9–неведенный ток; 10–прошедшие эл. Эффекты, возникающие при взаимодействии электронного пучка с веществом и используемые для формирования изображения в РЭМ: 1–эл.пучок; 2–образец; 3–отраженные электроны; 4–вторичные эл.; 5–ток погложенных эл.; 6 – катодолюминесценция; 7–рентген. излучение; 8–Оже-электроны; 9–неведенный ток; 10–прошедшие эл. |
Конструкция и принцип работы. В конструкции РЭМ можно выделить следующие основные системы: электронно-оптическую, формирующую электронный зонд и обеспечивающую его сканирование по поверхности образца, систему формирующую изображение, вакуумную систему, устройства точной механики. В РЭМ поверхность исследуемого массивного образца облучается стабильным по времени тонко сфокусированным (диаметр до 1,5-5 нм) электронным зондом, развертывающимся в растр. Растр – совокупность близко расположенных параллельных линий, вдоль которых зонд обегает выбранный участок поверхности образца. В результате взаимодействии зонда с веществом образца возникает ряд различных процессов (рассеяние, прохождение и отражение электронов, рентгеновское излучение и т.д (рис.)). Результаты взаимодействия регистрируются соответствующими датчиками. Полученные сигналы, после детектирования и усиления модулируют яркость электронно-лучевой трубки (ЭЛТ), развертка которой синхронизована со смещением электронного зонда. Таким образом между точками растра на поверхности образца и точками растра на ЭЛТ существует взаимно однозначное соответствие, причем яркость точек на ЭЛТ определяется интенсивностью сигнала из соответствующей точки образца. Увеличение РЭМ определяется соотношением амплитуд развертки луча по экрану ЭЛТ и зонда по поверхности образца. Если размер поля зрения на образце равен l, а на ЭЛТ L (постоянная величина), то линейное увеличение будет M = L/l. Таким образом, уменьшение участка сканирования приводит к росту увеличения изображения.
 Распределение эммитированных электронов по энергиям Распределение эммитированных электронов по энергиям |
Энергия электронов зонда может меняться в широких пределах – от 0,2 до 50 кэВ, что позволяет выбрать оптимальные условия получения изображения. В результате воздействия зонда образец эмитирует электроны, распределение которых по энергиям представлено на рис. Область I соответствует электронам, называемыми отраженными. Это электроны, которые, испытав ряд взаимодействий и теряя при этом энергию, изменяют направления движения и покидают образец. Часть их энергии передается электронам образца, что приводит к образованию вторичных электронов со средней энергией порядка нескольких электрон-вольт. Им соответствует область II, имеющая высокий максимум.
Наибольшая разрешающая способность достигается при использовании сигнала вторичных электронов, поскольку область генерации большей их части невелика и мало отличается от размеров электронного зонда. Именно для этого случая приводятся паспортные характеристики приборов.
Размеры области генерации отраженных электронов значительно больше и зависят от длины пробега электрона в материале образца, который быстро растет с увеличением ускоряющего напряжения и уменьшением среднего атомного номера мишени. Поэтому разрешающая способность РЭМ в режиме регистрации отраженных электронов значительно хуже и может меняться в значительных пределах.
В режиме детектирования поглощенных электронов (поглощенного тока) сигналом является разность между током зонда (постоянная величина) и суммой токов отраженных и вторичных электронов. Поэтому в этом случае область генерации совпадает с областью генерации отраженных электронов.
Размеры области генерации рентгеновского излучения зависят от материала образца и ускоряющего напряжения и изменяются от одного до нескольких микрометров даже при минимальном размере зонда.
 Разделение топографического и композиционного контраста Разделение топографического и композиционного контраста |
Детектирование сигналов и формирование контраста изображения. Из информации, получаемой с помощью РЭМ, наиболее часто используемыми являются сведения о локальных изменениях рельефа и химического состава поверхности. Соответственно выделяют топографический и композиционный контраст. Они образуются при использовании сигналов от вторичных и отраженных электронов и поглощенного тока. Обычно в РЭМ используются парные симметрично расположенные относительно зонда детекторы отраженных электронов. Это позволяет различить топографическую и композиционную составляющую контраста. Топографический контраст обусловлен тем, что на детектор попадут только те электроны, область испускания которых находится в зоне прямой видимости детектора, а их количество зависит от угла наклона локального участка поверхности. Причиной возникновения композиционного контраста является увеличение выхода отраженных электронов при увеличении атомной массы мишени. Принцип действия парного детектора показан на рис. Сигналы обуславливающие композиционный контраст, в обоих детекторах эквивалентны, а обуславливающие топографический – обратны. Суммирование сигналов от детекторов (А+В) увеличивает композиционный контраст и уничтожает топографический. А вычитание сигналов (А-В) подавляет композиционный и выявляет топографию поверхности. Современные РЭМ позволяют использую композиционный контраст, разделять фазы, отличающиеся по среднему атомному номеру меньше чем на единицу. Однако при исследовании объектов с сильно развитым рельефом полностью подавить топографическую составляющую контраста не удается.
Наличие топографического контраста при использовании сигнала вторичных электронов обусловлено зависимостью коэффициента эмиссии от угла наклона участка поверхности к электронному зонду. Характерной особенностью является повышенная яркость изображения острых вершин и выступов рельефа (краевой эффект), вызванный увеличением выхода электронов с этих участков. Композиционный контраст в режиме детектирования вторичных электронов относительно мал и используется очень редко.
Детектором поглощенного тока является сам образец. Сигнал поглощенного тока зависит от количества эмитированных вторичных и отраженных электронов, и контраст, создаваемый им, равен с обратным знаком контрасту детектора, который собирал бы все электроны. В нем присутствует и топографическая и композиционная составляющая.
Кроме рассмотренных основных видов контраста, существует еще ряд механизмов его образования, значительно увеличивающих объем информации которую можно получить при помощи РЭМ.
Причиной появления кристаллографического контраста является аномальное поглощение (каналирование) электронов при их движении в направлении, близком к направлению удовлетворяющему закону Вульфа-Брегга. Обычно наблюдается в режиме детектирования отраженных электронов.
Магнитный контраст объясняется влиянием магнитного поля на траекторию движения электронов и, как следствие, искажает их пространственное распределение. Различают магнитный контраст I и II типа в случае если магнитное поле выходит и не выходит за пределы образца. I тип наблюдается в режиме детектирования вторичных электронов, II тип в режиме детектирования отраженных электронов. Используется для изучения доменной структуры металла.
Вольтовый контраст появляется вследствие изменения эффективности регистрации вторичных электронов при изменении потенциала объекта. Применяется для изделий микроэлектроники.
Сигнал тока, индуцированного электронным зондом, может измеряться во внешней цепи. Появляется в полупроводниках вследствие генерации пар электрон–дырка электронами зонда.
Кадодолюминисцентное излучение детектируется световодом, соединенным с фотоумножителем.
9. ПРОСВЕЧИВАЮЩАЯ ЭЛЕКТРОННАЯ МИКРОСКОПИЯ (ПЭМ)
Просвечивающий электронный микроскоп дает возможность "заглянуть" во внутренний мир строения материала изделия, наблюдать очень мелкие частицы включений, несовершенства кристаллического строения - субзерна, дислокации, которые невозможно разглядеть с помощью светового оптического микроскопа.
ПЭМ работает по схеме проходящих электронных лучей в отличие от светового металлографического микроскопа, в котором изображение формируется отраженными световыми лучами. Источник света в электронном микроскопе заменен источником электронов, вместо стеклянной оптики используются электромагнитные линзы (для преломления электронных лучей).
ПЭМ состоит из электронной пушки-устройства для получения пучка быстрых электронов и системы электромагнитных линз. Электронная пушка и система электромагнитных линз размещены в колонне микроскопа, в которой в процессе работы микроскопа поддерживается вакуум 10-2-10-3 Па.
 Рис. 1. Принципиальная схема просвечивающего электронного микроскопа: 1 - источник излучения; 2 - конденсор; 3 - объект; 4 - объектив; 5 - первичное промежуточное изображение; 6 - вторичное промежуточное изображение; 7 - проекционная линза.
Рис. 1. Принципиальная схема просвечивающего электронного микроскопа: 1 - источник излучения; 2 - конденсор; 3 - объект; 4 - объектив; 5 - первичное промежуточное изображение; 6 - вторичное промежуточное изображение; 7 - проекционная линза.
Принципиальная оптическая схема ПЭМа показана на рис. 1. В электронной пушке 1 катод - раскаленная вольфрамовая нить испускает электроны, которые ускоряются на пути к аноду мощным электрическим полем, проходят через отверстие анода. Полученный узкий интенсивный пучок быстро летящих электронов вводится в систему электромагнитных линз электронного микроскопа. После фокусирования двухступенчатой электромагнитной линзой (конденсором) 2 электронные лучи, проходя через объект 3, рассеиваются и далее фокусируются объективной линзой 4, формирующей первичное изображение 5 просвечиваемой электронами части объекта. Объективная линза дает увеличение примерно в 100 раз. Следующая за объективной промежуточная линза перебрасывает промежуточное изображение с небольшим увеличением (обычно до 10 раз) 6 в предметную плоскость проекционной линзы 7, а проекционная линза формирует окончательное сильно увеличенное изображение (проекционная линза дает увеличение до 100 раз). Таким образом, общее увеличение электронного микроскопа может достигать 100 000 раз.
В связи с тем, что обычные микрошлифы для исследования структуры металлов и сплавов с помощью просвечивающего электронного микроскопа непригодны, необходимо приготовлять специальные очень тонкие, прозрачные для электронов, объекты. Такими объектами являются реплики (слепки) с поверхности хорошо отполированных и протравленных микрошлифов (косвенный метод электронномикроскопических исследований металлов и сплавов) или металлические фольги, полученные путем утонения исследуемых массивных образцов (прямой метод электронномикроскопических исследований).
Рис. 2. Схема получения электронномикроскопических препаратов (реплик): а - исходный образец в поперечном
Реплика должна полностью воспроизводить рельеф поверхности микрошлифа. Схема воспроизведения рельефа поверхности микрошлифа репликой показана на рис. 2. Толщина реплики должна быть порядка 0,01 мкм. Реплики могут быть одноступенчатыми (слепки непосредственно с исследуемой поверхности) или двухступенчатыми (сначала получают отпечаток поверхности, на который наносят реплику, копирующую рельеф поверхности первого отпечатка).
Одноступенчатые реплики приготовляют путем распыления вещества (углерода, кварца, титана и других веществ) в вакуумированной испарительной камере (в ВУПе) и осаждения его на поверхность шлифа. Для изготовления углеродных реплик на поверхность шлифа в испарительной камере напыляют уголь с угольных стержней, нагретых пропусканием тока. Пары углерода конденсируются на поверхности шлифа, и образуется тонкая углеродная пленка (реплика). Полученные путем распыления вещества реплики позволяют воспроизводить даже самые мелкие детали рельефа поверхности исследуемого образца.
В качестве реплики для ряда материалов (алюминия и его сплавов, меди и др.) можно использовать оксидную пленку, которая создается на подготовленной поверхности образца путем анодирования в соответствующем растворе. Применяют также лаковые реплики, которые получают нанесением на поверхность шлифа тонкого слоя лака (4%-ного раствора коллодия в амилацетате).
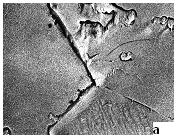

Рис. 3. Изображения стыка трех зерен, полученные с помощью ПЭМ на двухступенчатой реплике (а) и на фольге (б).
При изготовлении двухступенчатой реплики (рис. 3,а) в качестве материала для первой ступени можно использовать, например, отмытую от фотоэмульсии фотографическую или рентгеновскую пленку. Ее размягчают в ацетоне и накладывают на исследуемую поверхность образца под некоторым давлением. После высыхания такой отпечаток осторожно механически снимают с поверхности и на полученный оттиск напыляют в вакууме определенное вещество, например, углерод. Затем подложку (фотопленку) растворяют в ацетоне, а реплику промывают и подвергают исследованию.
Наибольшую информацию о структуре металла дает прямой метод электронномикроскопического исследования, когда объектом исследования служит тонкая металлическая фольга (рис. 3,а).
Фольгу чаще всего приготовляют следующим образом. Из образца, подлежащего изучению, вырезают круглую заготовку диаметром 3 мм и толщиной 0,2-0,3 мм, которую затем утоняют шлифованием до 0,1-0,15 мм. Окончательное утонение пластинки осуществляют химическим или электролитическим (наиболее частый случай) полированием в подходящем реактиве (по химическому составу, температуре). Подготовленную пластинку погружают в электролит в качестве анода. Катодами служат две металлические пластинки, расположенные по обе стороны от образца (фольги). Электрополирование, при оптимальном соотношении тока и напряжения, продолжают до появления в центральной части полируемой пластинки одного или нескольких небольших отверстий (диаметром 0,2-0,8 мм). По краям таких отверстий участки фольги получаются наиболее тонкими и могут быть использованы для просмотра в электронном микроскопе.
При рассмотрении реплик и фольг под электронным микроскопом при больших увеличениях вид микроструктуры значительно изменяется. Поэтому для правильной расшифровки структуры необходимо начинать исследование с небольших увеличений, постепенно переходя к большим.
Для металлофизических исследований обычно используют микроскопы с ускоряющим напряжением 100-200 кВ, позволяющие просвечивать электронными лучами объекты толщиной 0,2-0,4 мкм (предельная толщина зависит от атомной массы материала). С увеличением ускоряющего напряжения возрастает проникающая способность электронов, что дает возможность изучать объекты большей толщины. Широкое применение получили электронные микроскопы УЭМВ-100, ПЭМ-100, ЭМ-200 и др. Известны электронные микроскопы с ускоряющим напряжением 500, 1000, 1500 и даже 3500 кВ. Такие микроскопы позволяют изучать объекты толщиной до нескольких микрометров.
 2018-02-13
2018-02-13 2220
2220
