Термическое вакуумное напыление имеет ряд недостатков и ограничений, главные из которых следующие:
- Напыление плёнок из тугоплавких материалов (W, Mo, SiO2, Al2O3 и др.) требует высоких температур на испарителе, при которых неизбежно "загрязнение" потока материалом испарителя.
- При напылении сплавов различие в скорости испарения отдельных компонентов приводит к изменению состава плёнки по сравнению с исходным составом материала, помещённого в испаритель.
- Инерционность процесса, требующая введения в рабочую камеру заслонки с электромагнитным приводом.
- Неравномерность толщины плёнки, вынуждающая применять устройства перемещения подложек и корректирующие диафрагмы.
Первые три недостатка обусловлены необходимостью высокотемпературного нагрева вещества, а последний - высоким вакуумом в рабочей камере.
Процесс распыления ионной бомбардировкой является "холодным" процессом, т.к. атомарный поток вещества на подложку создаётся путём бомбардировки поверхности твёрдого образца (мишени) ионами инертного газа и возбуждения поверхности атомов до энергии, превышающей энергию связи с соседними атомами. Необходимый для этого поток ионов создаётся в электрическом газовом разряде, для чего давление газа в рабочей камере должно быть в пределах 0,1×10 Па, т.е. на несколько порядков более высокое, чем в камере установки термовакуумного напыления. Последнее обстоятельство приводит к рассеиванию потока атомов с мишени и повышению равномерности толщины осаждаемых плёнки до ±1%, причём без применения дополнительных устройств.



Катодное распыление предусматривает создание тлеющего разряда в среде нейтрального газа между катодом (3) и анодом (4). Давление в камере – 0,133 - 13 Па (10-1 - 10-3 мм РТ. ст.). Напряжение между электродами - более 103 В. Положительные ионы остаточного газа аргона ускоряются в темновом пространстве и бомбардируют катод, выбивая атомы материала самого катода или расположенного вблизи него. Эти атомы с относительно высокой энергией продолжают прямолинейное движение и осаждаются на поверхность подложки. Используются для осаждения на подложку тугоплавких материалов (тантал, вольфрам, молибден), диэлектриков (кварц, окись алюминия). 

Рис. Принцип катодного распыления: 1- базовая плита; 2 – герметизация колпака; 3 – катод; 4-анод; 5- подложка; 6 – держатель подложки; 7 – подогреватель подложки; 8 – атом металла; 9 – отрицательное тлеющее свечение; 10-ион аргона; 11 – темновое катодное пространство; 12- подвод аргона; 13 – присоединение к вакуумному насосу.
+ Использование катода большого размера позволяет получать равномерное распределение толщины плёнки на всей подложке.
+ Большая энергия катодного распыления предопределяет более высокую адгезию плёнки, чем при термовакуумном испарении. Скорость распыления 1-19 нм/с.
Питание осуществляется постоянным напряжением. Электрод с подложками заземлён и находится под более высоким потенциалом, чем катод - мишень. Переменная нагрузка служит для регулирования тока разряда.

На рис. 24 представлена упрощённая структура разряда и распределение потенциала вдоль разряда, а также типы частиц, участвующих в процессе. Разряд разделён на две зоны: тёмное катодное пространство и светящаяся область. На тёмное катодное пространство приходится основное падение напряжения. Здесь заряженные частицы разгоняются до энергии, достаточной, чтобы ионы, бомбардируя катод-мишень, освобождали поверхностные атомы и электроны (если мишень из проводящего материала), а электроны - на границе тёмного катодного пространства ионизировали молекулы аргона. При ионизации образуется ион аргона, который, ускоряясь, стремится к мишени, и электрон, который, как и "отработанный" ионизирующий электрон, дрейфует к аноду в слабом поле светящейся области. Освобожденный с поверхности мишени атом вещества, преодолевая столкновения с молекулами и ионами аргона, достигает поверхности подложки. При этом непрерывный поток ионов бомбардирует мишень, и непрерывный поток атомов вещества движется к подложке.

На рис. 25а приведена вольт-амперная характеристика разряда.
При подаче постоянного напряжения в несколько киловольт происходит пробой межэлектродного промежутка, быстрое нарастание тока и падение напряжения в разряде (область зажигания разряда I). При увеличении тока разряда за счёт уменьшения сопротивления Rн возрастает площадь катода-мишени, покрытая разрядом. Плотность разрядного тока и напряжение на разряде остаются постоянными и невысокими, а скорость распыления мала (область нормально тлеющего разряда II). В области III вся площадь мишени покрыта разрядом, и увеличение разрядного тока приводит к повышению плотности разрядного тока, напряжения на разряде и скорости распыления. Область Ш, называемая областью аномально тлеющего разряда, используется в качестве рабочей области в процессах катодного распыления. Для предотвращения перехода в область дугового разряда (область IV) предусмотрены интенсивное водяное охлаждение мишени и ограничение источника питания по мощности.




























К ограничениям и недостаткам процесса катодного распыления относятся
- Возможность распыления только проводящих материалов, способных эмитировать электроны, ионизирующие молекулы аргона и поддерживающие горение разряда.
- Малая скорость роста плёнки (единицы нм/с) из-за значительного рассеивания распыляемых атомов материала в объёме рабочей камеры.
Первый недостаток, имеющий характер ограничения, преодолевается в процессах высокочастотного распыления. При замене постоянного напряжения на переменное диэлектрическая мишень становится конденсатором и подвергается бомбардировке ионами в отрицательный полупериод питающего напряжения. Распыление мишени происходит не непрерывно, как при катодном распылении, а дискретно с частотой питающего напряжения (обычно 13,56 Мгц).
При высокой частоте и согласованным с ним расстоянием от мишени до подложек электроны, находящиеся в срединной части высокочастотного разряда, не успевают достигать электродов за время полупериода, они остаются в разряде, совершая колебательные движения и интенсивно ионизируя рабочий газ. Это обстоятельство позволяет снизить давление рабочего газа без снижения разрядного тока, т.к. степень ионизации заметно повышается (второй недостаток катодного распыления).


















 .
. 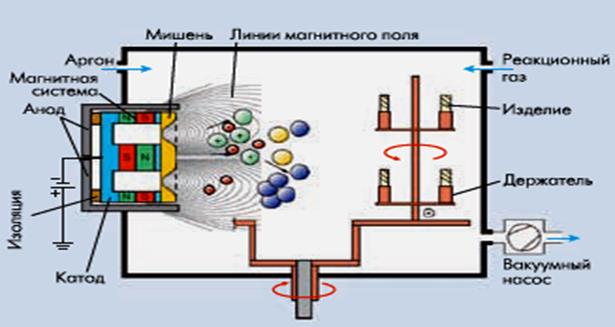
Рис. Магнетронное распыление бомбардировкой пучком ионов из автономного источника. Мишень не является катодом.

Рис. Схемы магнетронного распыления на частоте 13.6 МГц во все объеме рабочей камеры и ионнолучевого распыления.
 Рис. Вакуумная установка напыления плёнок силицида металлов с магнетронной системой (модернизированная) «Электроника ТМ–1202» («Оратория 29П»)
Рис. Вакуумная установка напыления плёнок силицида металлов с магнетронной системой (модернизированная) «Электроника ТМ–1202» («Оратория 29П»)
· Нанесение металлических пленок на кремниевые пластины методом магнетронного распыления и последующим высокотемпературным отжигом или формированием силицида металла в едином вакуумном цикле в производстве БИС и СБИС.

Ионноплазменные методы создания слоев используют плоские электроды. При этом создаются равномерные покрытия на всей поверхности подложки.
Лучевые технологии.
Ионно-лучевое распыление использует сфокусированный пучок частиц высокой энергии. Для создания таких потоков частиц с контролируемой энергией разработаны системы ионных пушек.

Рис. Ионно-лучевое распыление: 1 – напуск рабочего газа; 2 – термоэлектронный катод; 3 – анод; 4 – магнитная система; 5 – ускоряющий электрод; 6 – пучок ионов; 7 – распыляемый материал; 8 – подложкодержатель; 9 – присоединение к вакуумной системе; а – ионная пушка; б – схема напыления.
Низковольтный разряд (40-80 В) возбуждается в среде аргона. Наличие термоэлектронного катода обеспечивает стабильность разряда в широком интервале давлений от 100 до 10-1 Па. Магнитное поле, создаваемое в области цилиндрического анода, изменяет траекторию электронов, увеличивая вероятность столкновения с молекулами газа. Система фокусировки и ускорения позволяет получать практически моноэнергетические пучки ионов с энергией от 100 до 3000 эВ и плотностью тока от 0,1 до 20 мА/см2.
Электронно-лучевое испарение. Ускоренный пучок электронов с помощью отклоняющей системы непосредственно направляется на поверхность испаряемого материала. При столкновении с частицами окружающей среды электроны могут терять свою энергию и изменять направление движения. Число столкновений определяется концентрацией частиц, протяженностью электронного потока и его сечением.

Рис.Схема применения электронно-лучевого нагрева при вакуумном напылении: 1 – прикатодный, формирующий электрод; 2 – термоэлектронный катод; 3 – анод; 4 – поток электронов; 5 – система магнитной фокусировки; 6 – узел поворота электромагнитного пучка на 90°; 7 – водоохлажденный тигель с испаряемым веществом; 8 – поток пара; 9 – заслонка; 10 – подложка на подложкодержателе; 11 – система вакуумирования.
Электронная пушка – устройство для создания, ускорения и фокусировки пучка электронов – состоит из катодного узла и системы фокусировки, обеспечивающей направленность потока. Пушка включает прикатодный фокусирующий электрод, ускоряющий анод и устройство магнитной фокусировки.

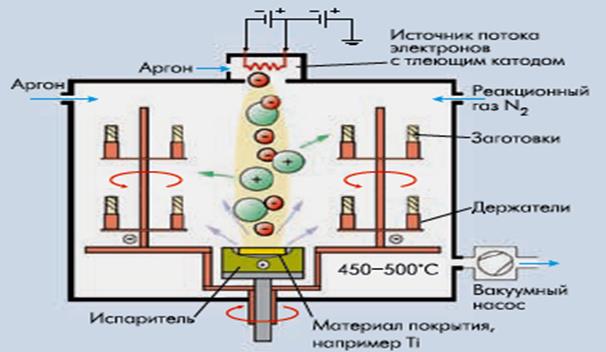



 2017-11-01
2017-11-01 4268
4268