2.16 Резисторы полупроводниковых ИМС 2.16.1 Общие замечания Резисторы широко применяются в цифровых и особенно в линейных интегральных микросхемах. Полупроводниковые рези- сторы формируются в поверхностном объеме кристалла, как пра- вило, одновременно с изготовлением активных элементов микро- схем [1, 3, 4]. Резисторы исполняются в выбранных слоях струк- туры БПТ. Такими слоями могут быть эмиттерный, базовый, кол- лекторный и композиционные, так называемые «зажатые» (pinch) слои базы и коллектора. Технологические исполнения слоев представлены тремя вариантами: – диффузионным; – эпитаксиальным; – ионно-имплантированным. Как отмечалось ранее, конструкция резистора представляет собой полосу в слое, от которой с двух сторон предусмотрены отводы. Резисторы от других элементов схемы в кристалле изо- лируются p-n-переходом или, если слой коллекторный, изоляци- ей, принятой для изоляции коллекторов БПТ. Резисторы могут быть изготовлены на основе эпитаксиальных пленок поликристал- лического кремния, наносимых на диэлектрические основания. 2.16.2 Структуры резисторов полупроводниковых ИМС Наиболее широко применяются полупроводниковые рези- сторы, сформированные на основе коллекторного (1), базового (3) или эмиттерного (4) слоев ЭПСК транзисторной структуры (см. рисунок 2.55). На рисунке 2.55 эпитаксиальный коллекторный слой разделен на «карманы» областями разделительной диффузии Рисунок 2.55 134 (2), на которые, как и на базовый несущий слой для резисторов в эмиттерном слое, подключается обратное смещение относитель- но применяемого резистивного слоя. Для резистивных слоев, изображенных на рисунке 2.55, полагается, что напряжения на их металлизированных выводах положительны относительно вывода от несущих р-слоев (Общ) и не превышают +Еп. Вследствие пространственной протяженности резистивных полос полупроводниковых резисторов, изолированных p-n-пере- ходами, напряжения смещения, и соответственно ширина пере- хода, удельная емкость зависят от пространственных координат. Для интегральных оценок параметров таких резисторов применя- ется усреднение удельной емкости по длине резистора. В цифро- вых переключениях логических элементов из одного состояния в другое напряжение на изолирующих переходах резисторов не ос- тается постоянным и для интегральных оценок также подлежит усреднению по состояниям (во времени). Простейшая конструкция резистора представляет собой уча- сток полупроводникового слоя, на концах которого расположены металлические контакты. Толщина слоя определяется глубиной залегания слоя изоляции. Профиль, изолирующей поверхности резистора, определяется технологией формирования слоя, и к оценке ее геометрии применимы заключения, сделанные в пара- графе 2.13.5 в отношении транзистора. Толщина слоя изоляции между резистивным слоем и несущими слоями составляет доли микрометра. Поэтому средняя удельная емкость изоляции может достигать (400–500) пФ/мм 2, и в схемы замещения резисторов включается емкость на несущее основание Си. Вследствие неравномерности легирования по глубине, диф- фузионные слои характеризуются средним удельным объемным сопротивлением ρ или средним удельным поверхностным сопро- тивлением R□.. Величина R□ не зависит от линейных размеров квадрата, а определяется только свойствами полупроводникового материала и толщиной резистивного слоя. Для ИС, изготовляе- мых по эпитаксиально-планарной технологии, сопротивление R□ в среднем составляет (25…150) Ом для коллекторного слоя, (200…300) Ом для базового слоя и (2,5…10) Ом для эмиттерного слоя. 135 Высокоомные резисторы с изоляцией p-n-переходами фор- мируются на основе базовых слоев, ограниченных по толщине соединенными параллельно эмиттерным и коллекторным слоями. Резистивный слой таких резисторов представляет собой канал р-типа с толщиной, равной ширине нейтральной базовой области, изолированный со всех сторон обратно смещенным p-n-пере- ходом. Структуры высокоомных резисторов субмикронной тол- щины с изоляцией p-n-переходом формируются в ионно-имплан- тированных поверхностных слоях. 2.16.3 Топологические конфигурации резисторов Топологические конфигурации резисторов представляют выделенные в выбранном (коллекторном, базовом или эмит- терном) слое полосы. На рисунке 2.56 приведен пример то- пологической конфи- гурации резистора. Концевым областям полосы придается одна из показанных на рисунках (2.59 — 2.62) графических форм. Электрическая длина резистивной поло- сы зависит от наличия и формы введенных в топологию изгибов. Сопротивление изогнутого топологического участка нелинейно зависит от соотношения размеров участков изгиба. Для исключе- ния учета нелинейных зависимостей применяются ограничения на соотношение размеров изогнутого участка. На рисунке 2.57 изобра- жены две модификации угол- ковых изгибов. В модифика- ции, изображенной на рисунке 2.57, а, три квадрата (1–3) уголкового изгиба соответст- вуют коэффициенту формы изгиба Кфизг = 2,55. Пяти квадратам уголкового изгиба, Рисунок 2.56 Рисунок 2.57 а б 136 изображенного на рисунке 2.57, б, соответствует коэффициент формы изгиба Кфизг = 4. Для изображенных форм следующий смежный уголок может быть размещен (для сохранения коэффи- циента формы изгиба) не ближе внешней границы изгиба (или с отступом от нее)
2.17 Конденсаторы биполярных ИМС 2.17.1 Общие сведения Конденсаторы биполярных ИМС преимущественно выпол- няются на основе р-n-переходов (см. рис. 2.63) и сочетания структур «металл — окисел — полупроводник» (МОП) с p-n-пе- реход (см. рис. 2.64). Основные оценочные параметры конденса- торов (технологический разброс δ%, температурный коэффици- ент ТКЕ, напряжение пробоя Uпр, добротность Q) приведены в таблице 2.5. Таблица 2.5 — Оценочные значения параметров конденсаторов Элемент структуры Со пФ/мм 2 δ%, ТКЕ %/°С Uпр Q Переход БЭ 1000 ±20 –0,2 5–7 5–15 Переход КБ 100 ±20 –0,2 20–50 30–100 Моп-структура 100 ±20 0,02 20–30 50–150 2.17.2 Конденсаторы на основе р-n-перехода В качестве рабочего р-n-перехода для исполнения конденса- торов ИМС применяются переходы из структур БПТ: эмиттерно- базовый, коллекторно-базовый, коллектор-основание. Учитывая, что в схемных применениях основание имеет соединение с об- щим электрическим узлом, рабочий р-n-переход коллектор- основание применяется исключительно в интегрирующих и бло- Рисунок 2.63 Рисунок 2.64 142 кировочных цепях ИМС и в качестве изолирующего для конден- саторов на основе переходов коллектор-база, эмиттер-база. Распространенный вариант структуры конденсатора на ос- нове коллекторно-базового перехода с изоляцией от несущего основания р-n-переходом — коллектор-основание изображен на рисунке 2.63 Электрическая схема замещения конденсатора изо- бражена на рисунке 2.64. Элементы схемы замещения определя- ются подобно тому, как это исполнялось для транзисторов и дио- дов. Так, удельные емкости рабочего и изолирующего переходов определяются для усредненных по режиму применения напряже- ний на переходах. Площадь обкладок конденсатора и изолирую- щего перехода определяется с учетом донной и боковой поверх- ностей. Конденсаторы на основе p-n-переходов чувствительны к по- лярности постоянного смещения на рабочем и изолирующем пе- реходах. Поэтому, согласно схеме замещения, коллекторная об- ласть (клемма 2 на рисунке 2.64) должна быть подключена к ис- точнику более высокого положительного потенциала, чем базо- вая область (клемма 1) и подложка П. Переменная составляющая напряжений между названными клеммами должна быть меньше постоянного смещения. «Пара- зитная» емкость изолирующего перехода нагружает клемму 2, ухудшая частотные (и переходные) свойства схемных примене- ний рассматриваемого элемента. По рисунку 2.63 видно, что площадь изолирующего перехода превосходит площадь рабочего перехода. Поэтому снизить отношение (Сраб/Сиз)=(Ссb/Ccp) можно только уменьшением удельной емкости слоя изоляции в сравнении с удельной емкостью рабочего перехода. Этого можно достигнуть снижением степени легирования подложки относи- тельно базового слоя, увеличением обратного смещения на изо- лирующем переходе по отношению к смещению рабочего пере- хода емкости. Существенного уменьшения отношения Сраб/Сиз (до четырех и более раз) можно достигнуть в структурах с ди- электрической изоляцией коллекторных «карманов». При этом изоляция относительно подложки при соответствующем выборе толщины диэлектрика становится не чувствительной к полярно- сти приложенного напряжения, а удельная емкость изоляции оп- 143 ределяется не свойствами полупроводника, а свойствами диэлек- трика изоляции. 2.17.3 Конденсаторы со структурой МОП Структура и топология МОП-конденсатора показана на ри- сунке 2.65. Здесь над эмиттерным n + -слоем выращен слой тонко- го (0,08–0,12 мкм) окисла. При исполнении металлической раз- водки на этот слой наносится верхняя алюминиевая обкладка конденсатора. Нижней обклад- кой служит эмиттерый n + -слой. Удельная емкость МОП-кон- денсатора определяется ди- электрической постоянной ди- электрика SiO2 и обычно состав- ляет около (250–350) пФ/мм 2. Важным преимуществом МОП-конденсаторов является то, что они не полярны. Одна- ко МОП-конденсатор, как и конденсатор на основе p-n- перехода, имеет нелинейную вольт-фарадную характеристику С(U). Зависимость емкости от напряжения на конденсаторе, по- казанная на рисунке. 2.66, обусловлена тем, что емкость МОП- конденсатора представляет собой последовательное соединение двух емкостей: емкости диэлектрика и емкости обедненного слоя, кото- рый может образоваться в припо- верхностной области полупровод- ника. В конденсаторе, показанном на рисунке 2.65, при нулевом и по- ложительном напряжениях на ме- таллической обкладке приповерхно- стная область подложки обогащает- ся электронами (обедненный слой Рисунок 2.65 Рисунок 2.66 144 отсутствует). Соответственно емкость конденсатора определяется диэлектриком и имеет максимальное значение. При отрицательных напряжениях поверхностный слой по- лупроводника обедняется носителями заряда. Толщина этого слоя растет с повышением отрицательного напряжения, и ем- кость конденсатора соответственно уменьшается. Это приводит к уменьшению результирующей емкости МОП-конденсатора (кри- вая 1 на рис. 2.66). При достаточно большом отрицательном на- пряжении вблизи поверхности образуется инверсионный дыроч- ный слой, т.е. проводящий канал. Тогда емкость обедненного слоя оказывается «отключенной» от емкости диэлектрика и ре- зультирующая емкость МОП-конденсатора снова приближается к начальному значению (кривая 2). Для ослабления влияния обедненного слоя необходимо, чтобы емкость этого слоя была большой по сравнению с емко- стью диэлектрика. Такое требование удовлетворяется при боль- шой концентрации примесей в полупроводнике. Поэтому в каче- стве полупроводниковой «обкладки» МОП-конденсатора исполь- зуется n + -слой. Благодаря малому сопротивлению этого слоя обеспечивается и повышение добротности конденсатора. Пара- зитная емкость МОП-конденсаторов для схем замещения учиты- вается как полярная емкость (Сиз) между n-карманом и р-под- ложкой. Коэффициент Cиз/С в данном случае составляет около (0,1–0,2). Важной особенностью МОП-конденсаторов является зави- симость их емкости от частоты. Такая зависимость обусловлена влиянием быстрых поверхностных состояний на границе полу- проводник—диэлектрик. Перезаряд этих состояний является инерционным процессом и происходит с постоянной времени по- рядка 0,1 мкс. Поэтому с ростом частоты емкость МОП- конденсатора уменьшается и достигает установившегося значе- ния лишь при частотах более нескольких мегагерц.
1.Кремниевая подложка Si (p-типа)

2.Окисление кремниевой пластины p-типа

3.Фотолитография для вскрытия окон под диффузию примеси р-типа и формирования областей размещения n-канальных транзисторов

4.Ионное внедрение бора во вскрытые области, окисление и одновременная разгонка бора

5.Фотолитография для вскрытия окон под области n-канальных транзисторов, диффузионных шин и охранных колец

6.Формирование подзатворного окисла кремния

7.Нанесение пленки поликристаллического кремния и фотолитография по поликристаллическому кремнию для формирования кремниевых затворов и шин

8.Фотолитография для вскрытия окон под легирование областей стоков, истоков р-канальных транзисторов, р-шин и р- охранных колец и проведение загонки бора ионным легированием, затем фотолитография для вскрытия окон под легирование областей стоков, истоков n-канальных транзисторов, n-шин и n-охранных колец и проведение загонки фосфора ионным легированием

9.Окисление и одновременная разгонка примесей в ионно-легированных слоях
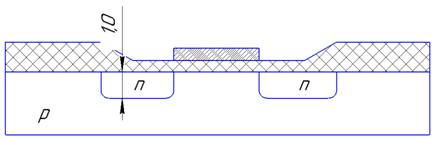
10.Нанесение фосфоросиликатного стекла (межслойная изоляция)
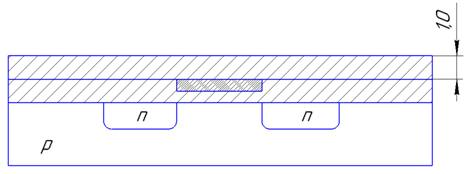
11.Вскрытие окон под контакты методом фотолитографии
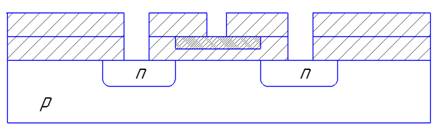
12.Напыление алюминия и фотолитография для формирования металлических проводящих дорожек, перемычек на затворы и контактных площадок
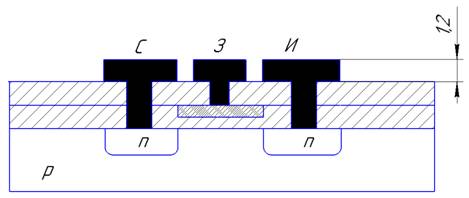
Топология

 2018-02-13
2018-02-13 397
397