Уменьшить толщину окисла под нитридом кремния (Si3N4).
Цель: (локальная).Уменьшить поступление кислорода в область под нитрид.
Уменьшить давление кислорода.
Закрыть боковую область пассивной области нитрида при окислении (сложная технологическая операция, используется в дорогих изделиях).
Указанные меры приведут к минимальным изменениям размеров активных элементов. Типичная величина изменения – десятые, сотые доли мк. Изменения включаются в состав соответствующих параметров моделей.
13. Травление Si3N4 и SiO2.
Цель: Подготовить поверхность для последующих технологических операций. Si3N4 и SiO2 удаляются.
Результат (рис. 2.3):
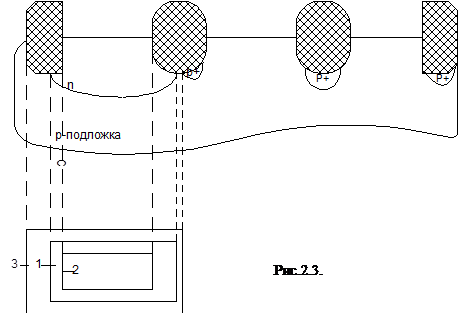 |
14. Окисление.
Цель: Создать промежуточный слой для последующего легирования. Толщина окисла 0.1-0.2мкм, t»950°, время - несколько минут.
 2014-02-09
2014-02-09 266
266






