Зарождение дислокационной петли в напряженной пленке аналогично зарождению новой фазы (например, появлению зародыша твердой фазы в переохлажденной жидкости) и требует затраты какого-то количества энергии. Энергия дислокационной петли радиуса R согласно Мэтьюзу [9] равна
 (10)
(10)
Выигрыш за счет уменьшения напряжений при образовании такой петли внутри напряженной пленки равен
 (11)
(11)
Видно, что дополнительная энергия появившейся дислокационной петли пропорциональна радиусу, а уменьшение энергии напряжений при этом – квадрату радиуса дислокационной петли. Соответственно, алгебраическая сумма этих энергий в зависимости от R должна иметь максимум, как показано на рисунке 1.1. Этот максимум является тем энергетическим барьером, преодоление которого возможно при флуктуационном достижении дислокационной петлей критического радиуса R (рис. 1.1).

Рис. 1.1 Пример расчёта для определения критического радиуса дислокационной петли и энергии её образования для Ge0,3Si0,7/Si(001).
|
|
|
На рисунке 1.1 изображены зависимости Ws и Wl, а также их суммы Ws + Wl, от радиуса дислокационной петли для доли Ge в пленке, равной 0,3. Видно, что расчётный энергетический барьер образования такой петли Wc составляет около 250 эВ. Более точные расчеты с учетом типа дислокации, энергии ступени, образующейся на поверхности пленки при прохождении дислокационной полупетли через ее объем, учет различных значений параметра ядра дислокации β [10,11] дают несколько меньшие значения Wc, которые, тем не менее, близки или превышают 100 эВ для концентрации Ge ≤ 0,3 в твердом растворе GeSi. На основе таких расчетов был сделан вывод о невозможности гомогенного зарождения ДН в псевдоморфных пленках GexSi1-x с х до 0,5 [10]. Тем не менее ДН в таких гетероструктурах возникают.
Хоутон в своей работе работе [12] подошел к зарождению ДН с иных позиций. Он исследовал движение и зарождение дислокаций в напряженных пленках GexSi1-x /Si(001) следующим образом. Выращивались пленки GexSi1-x, при температурах роста 350 – 500 °С до толщин, превышающих hc. Затем, после кратковременного изохронного отжига пленок при более высоких температурах, с помощью селективного травления на их поверхности выявлялись следы ДН, которые и наблюдались в микроскопе с приставкой Номарского. Количество наблюдаемых следов принималось равным количеству возникших ДН, а их длина вдоль поверхности, деленная на время отжига, соответствовала удвоенной скорости разбегания прорастающих ветвей.
Меняя температуру отжига, Хоутон смог оценить скорости зарождения ДН в большом интервале температур. Далее, построив измеренные зависимости скорости зарождения в осях ln(dN/dt) – 1/T, по наклону кривых Хоутон определил энергию активации зарождения Wn. Она оказалась равной 2,5±0,5 эВ и не зависит от доли Ge (в пределах до концентрации х = 0,23) и величины эффективного напряжения τэфф.
|
|
|
Таким образом, согласно модели гомогенного зарождения энергетический барьер для зарождения ДН зависит от рассогласования параметров решеток пленки и подложки и пропорционален ε, где ε ~ f. В то же время, экспериментальные данные показывают, что энергия активации зарождения ДН является величиной, не зависящей от х и близкой к 2,5 эВ. Это противоречие Хоутон предлагает преодолеть, предположив существование некоторой структурной конструкции из минимально возможного количества атомов, представляющей дислокационный зародыш, определенный для каждого типа дислокации в конкретном материале. Однако в настоящее время отсутствует четкое понимание устройства такой конструкции, а также ее местоположения в релаксирующей пленке. В представленной работе сделана попытка изучения источников дислокаций, а также их расположения в пленке.
РЕЗЮМЕ
На основе вышеизложенного материала можно сделать следующие выводы:
1. В эпитаксиальных гетеросистемах с умеренно большим рассогласованием подложки и плёнки, плёнка на начальном этапе растёт псевдоморфно, но при достижении некоторой критической толщины происходит релаксация напряжений, которая приводит к появлению ПД, как следствию введения ДН.
2. Для создания различных приборных ГС необходимо получение полностью релаксированных плёнок, обладающих высоким структурным совершенством: низкой плотностью прорастающих дислокаций (менее 106 см-2), и по возможности малой шероховатостью поверхности.
3. В настоящее время отсутствует четкое понимание устройства и местоположения в релаксирующей пленке структурной конструкции состоящей из атомов, делающей возможным зарождение дислокационных петель.
Одним из важнейших параметров плёнок, выращиваемых для приборных ГС, является плотность ПД. Поэтому вопрос о месте их зарождения в плёнке и возможности управления процессом зарождения является ключевым. Нам необходимо выбирать такие режимы роста, чтобы выращенные плёнки при небольшой степени релаксации имели достаточно высокую плотность ПД. Это позволит выявить источники зарождения дислокационных петель в объёме плёнки.
1.2 Молекулярно-лучевая эпитаксия гетероструктур CaF2/Si
В слоях CaF2, выращенных на Si, механизмы роста и дефектообразования существенно отличаются от известных в гетеросистемах типа полупроводник-полупроводник. Главными отличиями являются отсутствие наблюдения прорастающих дислокаций [15-18]. При этом часто наблюдается разупорядоченная область на гетерогранице CaF2/Si [19] и особенно на границе раздела (ГР) CaF2/GaAs [20]. Кроме того, по данным просвечивающей микроскопии, в пленках CaF2 практически полностью отсутствуют напряжения [21].
Понятно, что отсутствие прорастающих дислокаций, наличие разупорядоченной области на ГР и релаксация напряжений связаны между собой и обусловлены особыми механизмами формирования связей между CaF2 и Si на гетерогранице.
1.2.1 Молекулярно-лучевая эпитаксия CaF2
Осаждение пленок CaF2 на Si подложки проводилось многочисленными исследовательскими группами [22-26]. Интерес к гетеросистеме CaF2/Si объясняется, прежде всего тем, что, как следует из табл. 1.1, система CaF2/Si имеет достаточно малое различие в параметрах решеток.
Таблица 1.1
| Полупроводник | Параметр решетки, А | Фторид |
| Si | 5.43 | |
| GaP | 5.45 | |
| 5.46 | CaF2 | |
| GaAs | 5.65 | |
| Ge | 5.66 |
Фториды ЩЗМ привлекательны для технологии МЛЭ тем, что они имеют малое давление насыщенных паров при комнатной температуре, а при испарении не диссоциируют на ионы фтора и элементы второй группы.
|
|
|
На начальном этапе исследований для сублимации CaF2 использовались различные конструкции молекулярных источников: в работах [22,25] – танталовые лодочки, в [27,23,24] – тигли из пиролитического нитрида бора (ПНБ), в [28,27,23,24] – тигли из графита. В [26] применялся электронно-лучевой испаритель (ЭЛИ) для осаждения пленок фторидов. Хорошие результаты достигаются при использовании тиглей из графита. В пленках CaF2, полученных из тиглей ПНБ, обнаружен бор [25]. При сублимировании CaF2 с помощью ЭЛИ отсутствуют загрязнения, вносимые материалом тиглей, но возникает нестехиометричность состава, обусловленная диссоциацией фторидов на ионы под действием электронного пучка [25]. Наиболее оптимальными режимами считают температуры сублимации 1100 – 14000С, при которых скорости роста составляют 0.4 – 1.0 мкм/час.
1.2.2 Влияние технологических режимов на дефектообразование в CaF2
На структуру и свойства пленок фторидов, выращенных на поверхности полупроводников, в основном влияют два параметра: температура подложки Ts и скорость осаждения Vs. В [27] при осаждении CaF2 на различные полупроводники при комнатной температуре всегда получались поликристаллические пленки. При этом структура пленки не зависела от начальной или конечной стадии обработки поверхности полупроводника. Различия в химической обработке или в режимах отжига кремниевых пластин в условиях СВВ не приводили к изменению картины электронной дифракции от плёнки: на экране всегда наблюдались концентрические резко очерченные кольца, свойственные поликристаллической структуре. При увеличении температуры подложки Ts, возможен эпитаксиальный рост пленок фторидов. В [22] осаждали пленки CaF2 на кремниевые подложки различной ориентации при различных температурах Ts. Дефектность пленок определялась методом каналирования ионами He с энергией 2 Мэв. Для характеристики структурного совершенства кристалла обычно вводят величину cмин, которая может изменяться от 100% в полностью неупорядоченных материалах до минимального значения cмин в совершенных кристаллах.
|
|
|
В реальных объемных монокристаллах CaF2 высокого качества величина cмин обычно равна 0.05-0.07 (5-7%). На рис. 1.2(а,б) приведены зависимости параметров каналирования от Ts для пленок CaF2, выращенных на Si(111) и Si(100) (рис.1.2 (а) и (б) соответственно).
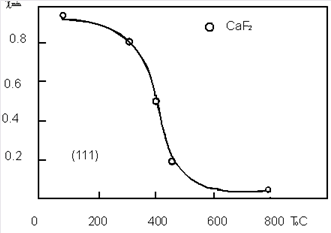
Рис.1.2(а) Зависимость параметра каналирования в пленках CaF2 на подложках Si(111) [22].
дефектообразование полупроводниковый пластический релаксация
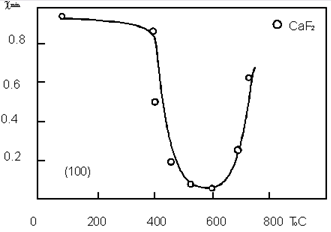
Рис.1.2(б) Зависимость параметра каналирования в пленках CaF2 на подложках Si(100) [22].
На подложках Si (111) монокристаллические слои CaF2 растут в широком интервале температур Ts = 500-800 0C при хорошем качестве слоев (cмин = 0.05) (рис. 1.2(а)).
На Si(100) совершенные пленки CaF2 (cмин =0.06) растут в более узком диапазоне Ts = 500-6000C. На Si(100) для пленок CaF2, величина cмин имеет существенно отличный от Si(100) характер зависимости от Ts. (Рис. 1.2(б)).
На Si(111) пленки CaF2 гладкие и зеркальные. Повышение температуры роста слоев CaF2 от Ts =5000C до Ts > 7000C приводит к образованию морфологических дефектов.
Данные рентгеноструктурного анализа показывают, что на Si(111) пленки CaF2 имеют ориентацию (111). Однако с помощью методики каналирования обнаружено, что пленка состоит из двух типов структур: А и В. Области типа А имеют ту же ориентацию, что и кремниевая подложка, а В – это области пленки CaF2, развернутые на 1800 относительно направления <111>.
Доля областей А и В существенно зависит от температуры роста Ts. Слои CaF2/Si, выращенные при температуре 6000С, состоят в основном из областей В типа.
Темнопольные изображения этих пленок, полученные с помощью просвечивающего электронного микроскопа (ПЭМ), подтверждают эти выводы [10]. Таким образом, на кремнии с ориентацией подложки (111) пленки CaF2 при оптимальных условиях растут В-типа. При увеличения рассогласования параметров решеток фторида кальция и кремниевой подложки или отличии температуры роста от оптимальной увеличивается доля включений типа А.
Изучение структуры пленок фторидов, выращенных на поверхности Si(100) методом рентгеноструктурного анализа, показало: слои СаF2 растут с ориентацией подложки (100) [22].
Наибольшая плотность дефектов наблюдается вблизи границы раздела CaF2 – Si для обеих ориентаций подложки [22].
Данные по росту CaF2 приведены в табл. 1.2.
Таблица 1.2
| Фторид | Ориентация подложки | Ориентация пленки | T роста, оС | Рассогласование, %, (300К) | Тип структуры | cмìин |
| СaF2 | (111) | (111) | 600-800 | +0.61 | В | 0.05 |
| CaF2 | (100) | (100) | 500-600 | +0.61 | - | 0.06 |
1.2.3 Влияние ориентации подложки на морфологию СaF2
Из таблицы 1.2 следует, что лучшие результаты по эпитаксии фторидов на Si могут быть получены при использовании CaF2. Многие авторы [23,29] ставили своей целью выявление причин более качественного роста пленок CaF2 на кремниевых подложках Si (111) в отличие от Si(100).
В [29] эпитаксиальные слои CaF2 толщиной 400 нм выращивались на Si(111) и Si(100) при температурах подложки Ts = 700 и 5500C соответственно. Пленки получались монокристаллическими: параметр каналирования для них не превышал cмин = 0.05. На рис. 1.3(а) и 1.3(б) представлены микрофотографии полученные РЭМ поверхности структур CaF2/Si(111) и CaF2/Si(100) соответственно.
На рис. 1.3(а) видно, что поверхность пленки CaF2 гладкая, и на ней имеются двумерные образования треугольной формы. Такой тип структуры, как правило, образуется при двумерном механизме роста.

Рис.1.3(а) Микрофотография поверхности структуры CaF2/Si(111) [29].
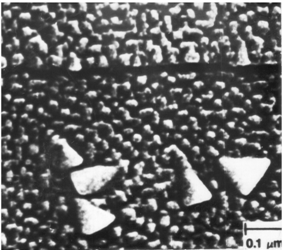
Рис.1.3(б) Микрофотография поверхности структуры CaF2/Si(100) [29].
Авторы [29] считают, что в их случае реализуется двумерный механизм роста пленки CaF2, так как от начала образования первого монослоя до окончания роста пленки ДБЭ не регистрирует трехмерных механизмов роста.
Поверхность CaF2/Si(100) имеет ярко выраженную островковую структуру (рис. 1.3(б)). В этом случае тяжи на дифракционной картине отсутствовали, а размытые рефлексы иллюстрировали наличие шероховатой поверхности пленки. Таким образом, при эпитаксии CaF2 на Si(100) в отличие от CaF2/Si(111) наблюдается наличие шероховатой поверхности пленки. Подводя итог, можно сделать вывод: пленки CaF2 растут более совершенными и в более широком диапазоне температур Ts на подложках кремния с ориентацией (111), чем на кремнии с ориентацией (100). Этот факт объясняется различием в величине свободной поверхностной энергии Es для (111) и (100) поверхностей. Экспериментальные данные [30] и теоретические расчеты [31] показали, что для CaF2(111) величина Es ~ 450-500 эрг/см2, в то время как для CaF2(100) она в 1.5-2 раза выше. Более высокое значение Es может быть из-за дипольного момента, возникающего перпендикулярно поверхности CaF2(100). На рис. 1.4 представлено расположение атомных слоев в направлении {111}. В этом случае отсутствует дипольный момент. В то же время при ориентации поверхности CaF2(100) дипольный момент в направлении {100} присутствует всегда (Рис.1.5). За счет энергии электрического поля возникает дополнительное увеличение Es на поверхности CaF2(100) [29]. Таким образом, при эпитаксии CaF2/Si(111) в отличие от CaF2/Si(100) становится выгодным не двумерно - слоевой, а трехмерный механизм роста.

Рис. 1.4 Структура атомных слоев CaF2 в направлении <100> [29].

Рис.1.5 Структура атомных слоев CaF2 в направлении <111> [29].
1.2.4 Влияние отжигов на морфологию и структуру пленок CaF2
В [32] при анализе методом каналирования пленок CaF2, выращенных при различных температурах на Si(100) обнаружено, что качественные слои CaF2, (cмин = 0.05) растут в очень узком интервале температур Ts = 590-6100C Отклонение всего лишь на 250C от оптимальной Ts резко увеличивало число дефектов. Вероятно, это следствие конкуренции процесса химического взаимодействия между CaF2 и поверхностью кремния при высоких температурах, и процесса островкового роста из-за недостаточной подвижности молекул при низких ростовых температурах [22]. В [32] исследовалось влияние высокотемпературного быстрого отжига в атмосфере аргона на морфологию, структуру и электрофизические свойства слоев CaF2. Пленки CaF2 толщиной 500 нм выращивались при скоростях роста 40-80 А/мин из графитового тигля. Температура роста варьировалась от 300 до 6250С. Отжиг ex situ проводился при температуре 11000С в течение 20-30 секунд в атмосфере аргона для предотвращения окисления и разрушения эпитаксиального слоя. На рис. 1.6(а) приведена зависимость параметра каналирования cмин от ростовой температуры Ts для не отожженных пленок CaF2/Si(100) (кривая 1) и пленок, отожженных в атмосфере аргона (кривая 2). Видно, что быстрый отжиг значительно улучшает качество пленок, снижая cмин от 20-25% до 5-7%. В [33] наряду с быстрым отжигом ex situ (вне ростовой камеры) эксперименты по медленному отжигу пленок CaF2 проводились в ростовой камере (in situ). Температура роста составляла Ts = 5850С, которая после выращивания пленки увеличивалась до необходимой температуры отжига, при которой структура выдерживалась в течение 60 минут. Оптимальная температура отжига Ts, как это следует из рис. 1.6(б), составляет около 7000С.
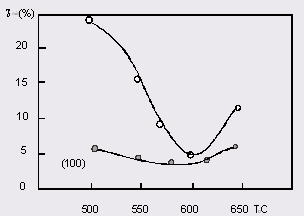
Рис. 1.6 (а). Зависимость cмин от Тs для структуры CaF2/Si(100). 1 - до отжига, 2 - после отжига ex situ [32].

Рис. 1.6 (б). Зависимость cмин от Тs для структуры CaF2/Si(100) после отжига in situ [32].
При отжиге in situ пленки CaF2 становятся более совершенными. Возможность отжига позволяет снизить требования к точности установления температуры подложки Si в процессе эпитаксии.
Морфология поверхности пленок CaF2 исследовалась с помощью РЭМ. Неотожженная пленка CaF2 имела грубую морфологию с поверхностными дефектами размером от 100 до 500 нм. После быстрого отжига ex situ пленки CaF2 становились более высокого качества по сравнению с пленками, отожженными in situ или неотожженными.
На поверхности пленок иногда видны линии, возникающие после быстрого отжига ex situ, которые появляются, по мнению авторов [33] за счет большого различия в коэффициентах термического расширения (КТP) фторида кальция и кремния, поскольку постоянная решетки Si при нагреве от комнатной температуры до 11000С изменяется на 0.4%, в то время как у CaF2 на 2.7%.
Измерения C-V характеристик на структурах Al/CaF2 /Si(100) [33] показали, что оба вида отжига не влияют на величину плотности поверхностных состояний, которая равна Nss = 5×1011 см-2×эВ-1. Отжиг ex situ приводит к увеличению напряженности поля пробоя до Епр = 2×10 6 В×см-1, в то время как отжиг in situ не приводит к увеличению Епр, значение которого обычно равно Епр = (2-5)×105 В/ см.
Важной проблемой сегодня является установление механизма начальной стадии роста гетероэпитаксиальных структур CaF2/Si. В то время как при гетероэпитаксии полупроводниковых гетероструктур обычно наблюдается псевдоморфный рост полупроводниковой пленки, в случае гетероэпитаксии CaF2 на Si(111) механизм начальной стадии остается неясным/
РЕЗЮМЕ
На основании приведенных материалов можно сделать следующие выводы:
1. На Si(111) пленки CaF2 при оптимальных температурных режимах растут монокристаллическими в двойниковой позиции по отношению к подложке (эпитаксия В-типа) с хорошей гладкой поверхностью. Структурное совершенство пленок CaF2 сильно зависит от материалов тиглей и чистоты используемого шихтового фторида кальция.
2. При отклонении ростовых условий от оптимальных или увеличении рассогласования постоянных решеток подложки Si и пленоки CaF2 в них возникают микродвойники - области, развернутые на 180о относительно матричной области пленки (А-типа). Наибольшая плотность дефектов наблюдается вблизи границы раздела CaF2 – Si для обеих ориентаций подложки.
Плёнки диэлектриков, выращиваемые для приборных структур, должны обладать такими параметрами как высокая электрическая прочность, хорошая морфология поверхности, а также, в ряде случаев, малая толщина для обеспечения туннельной прозрачности диэлектрика. Исходя из этого, ростовые процессы следует производить на подложках Si(111). Поскольку при данной ориентации подложки возможно выращивание монокристаллических плёнок CaF2, обладающих высоким структурным совершенством. При этом рост может осуществляться в более широком диапазоне температур по сравнению с ориентацией подложки (100).
 2020-08-05
2020-08-05 109
109








