Современные биполярные транзисторы изготавливаются на основе монокристаллического кремния по диффузионной технологии с использованием планарного процесса. Базовая ячейка транзистора n-p-n типа представлена на рис. 25.
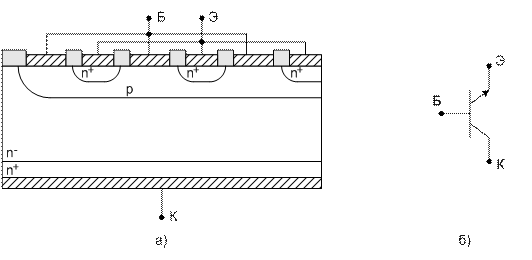
Рис. 25. Поперечное сечение базовой ячейки биполярного транзистора (а), и его условное обозначение (б)
Такую структуру имеет большинство современных типов силовых биполярных транзисторов. Для p-n-p транзисторов будут справедливы практически все выводы, полученные при анализе процессов в рассматриваемой базовой ячейке. Для создания структуры ячейки в качестве исходного материала или подложки используется низкоомный n+-слой, на обратной стороне которого создается омический контакт коллектора. На подложке эпитаксиально выращивается высокоомный коллекторный n--слой, в котором методом диффузии формируется слой p-базы. Таким образом, в структуре образуется асимметричный коллекторный p-n- переход. Далее на поверхности p-базы проводят планарный процесс. Он заключается в создании пленки диоксида кремния и проведении через специально вытравленные окна имплантации донорной примеси для формирования эмиттерных n+-областей. После этого на верхней поверхности кристалла создают металлизированные слои для выводов базы и эмиттера, разделенные изолирующими участками диоксида кремния. Таким образом создается вертикальная структура силового биполярного транзистора. Рассмотрим основные закономерности физических процессов, протекающих в данной ячейке.
Структура биполярного транзистора является системой двух взаимодействующих p-n-переходов. В нашем случае это эмиттерный n+-p-и коллекторный p-n--переходы. В зависимости от полярности напряжений на данных переходах различают четыре режима работы транзистора: насыщение, отсечка, активный нормальный и активный инверсный.
Режим насыщения соответствует открытому состоянию ключа, при этом оба перехода транзистора смещены в прямом направлении.
В режиме отсечки переходы смещены в обратном направлении, а через транзистор проходят сравнительно небольшие точки утечки.
Активный режим работы транзистора в ключевом применении имеет место на фронтах переходного процесса переключения и характеризуется прямым смещением одного из переходов. При прямом смещении эмиттерного перехода активный режим называется нормальным. То есть в этом режиме эмиттер и коллектор транзистора выполняют свойственные им функции инжекции и собирания носителей тока. Не симметрия реальной структуры не располагает к свойству обратимости функций переходов, и, как правило, схемное инверсное включение транзистора на практике применяется крайне редко.
Электрическое поле от приложенного к транзистору внешнего напряжения (положительный потенциал на коллекторе n-p-n-структуры) в режиме отсечки и активно-нормального переключения располагается в области пространственного заряда, расположенного главным образом в его высокоомном n--слое коллектора, называемом также эпитаксиальным (по технологии процесса образования данного слоя). На рис. 26 граница ОПЗ обозначена пунктирной линией. С увеличением внешнего напряжения происходит расширение ОПЗ в глубь эпитаксиального слоя n-.
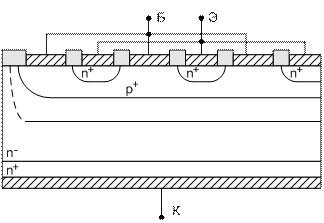
Рис. 26. Область пространственного заряда в структуре
биполярного транзистора
Когда граница ОПЗ, проходя через n--слой, достигает сильнолегированной области коллектора, дальнейшее расширение ОПЗ становится невозможным, начинает расти напряженность электрического поля в n--слое и может наступить лавинный пробой.
Расширение ОПЗ в сторону тонкой базовой области по достижении ее границы до эмиттерного перехода приводит к смыканию ОПЗ в области базы и пробою.
Допустимые рабочие напряжения транзистора (не приводящие к пробою) определяются размерами n--слоя коллектора и его легированием.
Теперь рассмотрим процессы, происходящие при протекании прямого тока через транзистор. Прежде всего интересен так называемый режим больших токов, когда концентрация инжектируемых эмиттером дырок становится сравнимой с равновесной концентрацией электронов в базовой области. При этом используется термин - высокий уровень инжекции, всегда характерный для силовых структур. Особенностью данного режима является возникновение электрического поля в области базового слоя. С одной стороны, это приводит к уменьшению сопротивления базового слоя и, следовательно, к уменьшению коэффициента инжекции, с другой - повышается скорость перемещения носителей через базу, что увеличивает коэффициент переноса. Так как коэффициент передачи тока транзистора от эмиттера к коллектору α является произведением двух упомянутых величин, их противоположное воздействие приводит к появлению точки максимума а при увеличении рабочего тока транзистора с тенденцией заметного уменьшения в области больших токов. Аналогично ведет себя коэффициент передачи тока базы β, имеющий однозначную связь с коэффициентом α ( рис. 27). Таким образом, спад коэффициентов передачи токов определяет предельно допустимый ток биполярного транзистора. Значение β в режиме больших токов составляет для силовых транзисторов всего несколько единиц, что требует значительных затрат мощности управляющего сигнала для поддержания открытого состояния ключа.
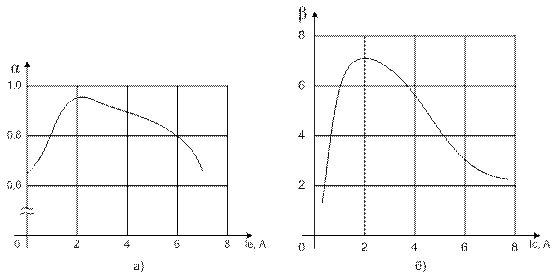
Рис. 27. Зависимость коэффициентов передачи тока биполярного транзистора α (а) и β (б) от тока коллектора
Другой особенностью работы транзистора при высоких уровнях инжекции является неравномерное распределение тока по сечению эмиттера: оттеснение его к периферийным участкам при включении и стягивание его к центральной области при выключении (рис. 28).
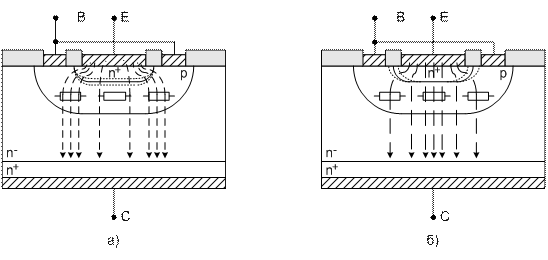
Рис. 28. Эффект локализации (щнурования) тока коллектора при включении (а) и выключении (б) биполярного транзистора
Этот эффект связан с наличием продольного сопротивления области p-базы, в результате чего происходит изменение потенциала базы при протекании управляющего тока. Неравномерное распределение плотности тока является дополнительной причиной снижения коэффициентов передачи в открытом состоянии транзистора. Кроме этого, возможно возникновение термонестабильных горячих точек в структуре прибора, уменьшающих размеры области безопасных режимов транзистора. Для уменьшения влияния эффекта оттеснения следует уменьшить размеры эмиттерного слоя. В современных планарных структурах эмиттер биполярного транзистора делают в виде многополосковой гребенчатой структуры (рис. 29.).

Рис. 29. Гребенчатая металлизация контактов биполярного транзистора
Для ключевых приборов третьего поколения серии SMIII компанией «Motorola» предложена новая структура эмиттера, металлизация которого выполнена в виде полой конфигурации («hollow» emitter) (рис. 30.).
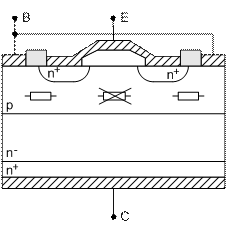
Рис. 30. Структура биполярного транзистора SM III компании «Motorola»
Это позволило разделить эмиттерный слой на две составляющие и соответственно понизить влияние эффектов шнурования тока. Кроме того, продольное сопротивление p-базы, расположенное под полым участком эмиттерной металлизации, не влияет на распределение потенциала базы.
Вольт-амперные характеристики биполярного транзистора (рис. 31), кроме активной области, имеются области насыщения, квазинасыщения и лавинного пробоя.
 Рис. 31. Вольт-амперные характеристики биполярного транзистора ОЭ (а) и ОБ (б): I – область насыщения, II – область квазинасыщения, III – активная область; б) область лавинного пробоя)
Рис. 31. Вольт-амперные характеристики биполярного транзистора ОЭ (а) и ОБ (б): I – область насыщения, II – область квазинасыщения, III – активная область; б) область лавинного пробоя)
В заключение отметим, что динамические характеристики рассматриваемой структуры зависят не только от коэффициентов усиления тока ивремени пролета носителей от эмиттера к коллектору, но и от емкостей переходов транзистора. Основной вклад в инерционность изменения тока на
ряду с процессами накопления и рассасывания носителей вносит перезаряд барьерной емкости коллекторного перехода СКБ. Данная емкость связана в основном с обедненной областью коллекторного перехода и поэтому зависит от напряжения база-коллектор. С ростом напряжения емкость СКБ уменьшается.
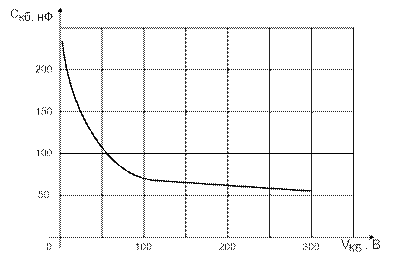
Рис. 33. Зависимость барьерной емкости коллекторного перехода
 2015-07-03
2015-07-03 4754
4754