Тема 5.1 Электрофизические свойства полупроводников
В зависимости от величины удельного электрического сопротивления р все материалы можно разделить на проводники электрического тока (р = 10-6... 10-4 Ом см), полупроводники (р = 10-3... 10-10 Ом см) и диэлектрики (р = 1011... 1015 Ом см). Полупроводниковые материалы, среди которых наиболее широко применяют германий, кремний и арсенид галлия, имеют твердую кристаллическую структуру с решеткой типа алмаза или графита. К полупроводникам относят также селен, теллур, некоторые сульфиды, окислы и карбиды.
В отличие от проводников у полупроводников и диэлектриков удельное сопротивление при нагревании уменьшается; сопротивление полупроводников при температуре вблизи абсолютного нуля приближается к сопротивлению диэлектриков, в то время как сопротивление проводников при этих же условиях становится очень малым (явление сверхпроводимости). Добавление примеси в полупроводник приводит в отличие от проводников к уменьшению его удельного сопротивления. Воздействие внешнего электрического поля, облучение светом или ионизированными частицами также значительно изменяет удельное сопротивление полу- проводников, что не типично для проводников.
В основе принципа действия полупроводниковых приборов лежат электрические свойства электронно-дырочного, или р—п-перехода, образованного на границе двух областей полу- проводника различного типа проводимости.
Рассмотрим некоторый объем монокристаллической идеальной (без нарушения структуры) решетки кремния, которая заменена элементарной геометрической фигурой и представлена на рис. 7.1, а в виде плоскостной решетки.
В процессе формирования кристаллической решетки атомы кремния, расположенные в узлах решетки, связаны между собой посредством четырех валентных электронов. двойные линии между узлами решетки условно изображают парно-валентную или ковалентную связь между каждой парой электронов, одновременно принадлежащих двум атомам. При этом энергия, которой обладает электрон в связанном состоянии, строго определена.
Совокупность энергетических уровней валентных электронов идеальной монокристаллической структуры образует на энергетической диаграмме (рис. 7.1, 6) валентную зону. При температуре абсолютного нуля все валентные электроны в идеальном кристалле участвуют в межатомных связях и заполняют все энергетические уровни в валентной зоне, а зона проводимости остается свободной.
Между валентной зоной и зоной проводимости находится запрещенная зона шириной
ΔЕ = Ес — Еν, где Ес — энергия электрона нижней границы зоны проводимости; Еν — энергия электрона верхней границы валентной зоны. Для кремния ΔЕ = 1,12 эВ. для перевода электрона из валентной зоны в зону проводимости ему необходимо сообщить дополнительную энергию, превышающую энергию запрещенной зоны.
Например, при температуре выше абсолютного нуля часть электронов разрывает ковалентные связи и переходит в зону проводимости, освобождая энергетические уровни в валентной зоне. Вакантный энергетический уровень в валентной зоне называют дыркой проводимости и приписывают ей положительный заряд, равный по величине заряду электрона.
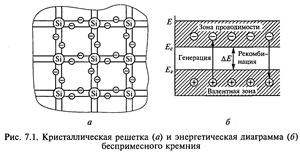 Процесс образования пары «электрон проводимости—дырка проводимости» называют генерацией пары носителей
Процесс образования пары «электрон проводимости—дырка проводимости» называют генерацией пары носителей
(см. рис. 7.1, 6).
Электроны в зоне проводимости и дырки в валентной зоне под действием тепловой энергии совершают хаотическое тепловое движение в течение некоторого времени, называемого временем жизни носителей зарядов. По истечении этого времени происходит процесс захвата электронов валентной зоны дырками зоны проводимости, называемый рекомбинацией.
При наличии источника внешнего напряжения, приложенного к кристаллической структуре, движение электронов и дырок в ней приобретает некоторую направленность, т. е. кристалл может проводить электрический ток. Проводимость кристалла тем выше, чем интенсивнее протекает процесс генерации пар «электрон—дырка», и определяется движением носителей заряда обоих видов. Беспримесные полупроводники называют полупроводниками с собственной проводимостью. Собственная проводимость их невелика и не может быть использована для создания полупроводниковых приборов.
Электронная (п-типа) и дырочная (р-типа) проводимости обусловлены движением в полупроводнике только электронов. При электронной проводимости находящиеся на энергетических уровнях зоны проводимости электроны движутся в направлении, противоположном направлению электрического поля. Введение наряду с отрицательным электроном фиктивного положительного заряда «дырка» обусловлено различием в них подвижности. Подвижность электрона намного больше подвижности дырки, которая, как и положительный электрический заряд, движется по направлению электрического поля.
На практике получили распространение примесные полупроводники, которые получают путем добавления в кристалл полупроводника атомов элементов III или У группы таблицы Менделеева. Проводимость примесных полупроводников гораздо выше, чем собственная проводимость.
Две смежные области монокристаллического полупроводника, одна из которых имеет электронную, а другая — дырочную проводимость, образуют электронно-дырочньий или р—п-переход. Он является основой большинства полупроводниковых приборов. Переходы р—п-типа бывают точечньтми и плоскостньтми. Точечные р—п-переходы применяют лишь в маломощных высокочастотных диодах и приборах сверхвысокочастотного диапазона. Плоскостные р—п-переходы являются основой современных диодов, транзисторов и тиристоров.
Рассмотрим процессы в плоскостном р—п-переходе, считая, что на границе раздела слоев р- и п-типов отсутствуют искажения кристаллической структуры, включения других химических элементов и внешнее электрическое поле.
Концентрации не основных носителей — дырок в п-области и электронов в р-области — намного меньше концентрации основных носителей. Вследствие этого на границе раздела областей различного типа проводимости возникает перепад (градиент) концентрации дырок и электронов, что вызывает диффузионное перемещение электронов из п-области в р-область и дырок в противоположном направлении (рис. 7.4, а).

Из-за диффузии в приконтактном слое п-области концентрация электронов становится меньше равновесной, а концентрация дырок — больше равновесной. Поэтому в приконтактном слое п-области возникает положительный объемный заряд. Аналогично в приконтактном слое р-области возникает отрицательный объемный заряд.
Область полупроводника, охватывающая приконтактные слои, обедненные основными носителями заряда, называют областью объемного заряда р—п-перехода. Образование на р—п-переходе пространственно разделенных положительного и отрицательного зарядов приводит к возникновению электрического поля, вектор напряженности Е0 которого направлен от положительного заряда к отрицательному (рис. 7.4, а) и препятствует дальнейшей диффузии зарядов. В ранновесном состоянии, когда внешнее воздействие на р—п-переход отсутствует, электронный и дырочный токи через переход равны нулю. Распределение электрического поля определяет потенциал на р—п-переходе, который обычно называют контактной разностью потенциалов р—п-перехода, или потенциальным барьером перехода высотой щ (рис. 7.4, 6).
Область объемного заряда р—п-перехода в равновесном состоянии обеднена основными носителями. Сопротивление этой области (запирающего слоя) намного больше сопротивлений электронейтральных слоев р- и п-областей полупроводника. Поэтому если приложить внешнее напряжение к полупроводнику с р—п-переходом, можно считать, что оно практически все будет приложено к области объемного заряда перехода.
Для включения р—п-перехода во внешнюю цепь его снабжают двумя внешними выводами. При подключении источника положительным полюсом к п-области, а отрицательным — к р-области полупроводника получается отрицательное смещение перехода. Приложенное к переходу напряжение (I в этом случае называют обратным напряжением (рис. 7.4, в).
Полярности обратного напряжения UR и контактной разности потенциалов φ совпадают. Поэтому потенциальный барьер возрастает и становится равным φ = φк + UR (рис. 7.4, г). Результирующее электрическое поле Е в переходе будет больше поля Ео, существовавшего на переходе в равновесном состоянии и совпадает с ним по направлению. Запирающий слой увеличивается. При этом быстро уменьшается до нуля диффузионный ток основных носителей зарядов (электронов из п-области и дырок из р-области).
Однако неосновные носители зарядов — дырки из п-области, попадающие благодаря тепловому движению в область объемного заряда перехода, переносятся электрическим полем перехода в р-область. Аналогично электроны из р-области, попадающие в область объемного заряда перехода, переносятся в п-область. Эти не основные носители и обусловливают протекание через переход обратного тока IR. Поскольку концентрация неосновных носителей в р- и п-областях незначительна, обратный ток через переход при его отрицательном смещении очень мал. Уже при отрицательных смещениях UR = 0,05... 0,075 В обратный ток достигает значения тока насыщения.
дальнейшее увеличение обратного напряжения практически не влияет на обратный ток, обусловленный лишь движением неосновных носителей заряда. Однако при значительных обратных напряжениях происходит пробой р—п-перехода и ток, протекающий через него, резко возрастает. Это обусловлено тем, что переносимые через переход под действием электрического поля неосновные носители заряда приобретают энергию, достаточную для ударной ионизации атомов полупроводника. В структуре начинается лавинообразное размножение носителей заряда, что приводит к резкому увеличению обратного тока через переход при практически неизменном обратном напряжении, называемом напряжением пробоя. Такой пробой называют лавинным.
Различают тепловой и электрический лавинный пробой. При электрическом пробое вентильные свойства р—п-перехода полностью восстанавливаются при уменьшении приложенного к нему напряжения.
В то же время под воздействием большого обратного напряжения переход, имеющий малую теплоемкость, сильно нагревается. В результате этого усиливается процесс генерации электронно-дырочньих пар, приводящий к дальнейшему увеличению тока и температуры перехода и, как следствие, к необратимому разрушению р—п-перехода. Такой пробой называют тепловым.
При положительном смещении перехода внешний источник подключают положительным полюсом к р-области, а отрицательным — к п-области полупроводника (рис. 7.4, д). Приложенное напряжение UF в таком случае называют прямым напряжением, а его полярность противоположна полярности контактной разности потенциалов р (рис. 7.4, е). Потенциальный барьер уменьшается и становится равным φ = φк — UF. Результирующее электрическое поле Е в области объемного заряда становится меньше поля Ео, образовавшегося в области перехода в равновесном состоянии. диффузионные токи электронов и дырок через переход возрастают из-за уменьшения практически до нуля потенциального барьера на переходе. Через переход начинает протекать прямой ток.
 При положительном смещении полупроводника электроны из п-области под действием диффузии непрерывно поступают в р-область, где они являются неосновными носителями. дырки из р-области таюке непрерывно поступают в п-область. Процесс внесения неосновных носителей заряда в ту или иную область полупроводника называют инжек цией. Зависимость тока через электронно-дырочный переход от приложенного к нему напряжения называют вольт-амперной характеристикой (ВАХ) перехода, график которой представлен на рис. 7.5.
При положительном смещении полупроводника электроны из п-области под действием диффузии непрерывно поступают в р-область, где они являются неосновными носителями. дырки из р-области таюке непрерывно поступают в п-область. Процесс внесения неосновных носителей заряда в ту или иную область полупроводника называют инжек цией. Зависимость тока через электронно-дырочный переход от приложенного к нему напряжения называют вольт-амперной характеристикой (ВАХ) перехода, график которой представлен на рис. 7.5.
Из графика следует, что при положительном смещении, когда ток через переход экспоненциально растет с ростом напряжения, переход обладает высокой проводимостью. При отрицательном смещении, когда обратный ток быстро достигает значения тока насыщения, переход обладает очень низкой проводимостью. При напряжении внешнего источника, равном нулю, ток, протекающий через переход, также равен нулю. Вследствие резко выраженной нелинейности ВАХ р—п-переходы широко используют в качестве ключевых элементов в вентилях различного типа, т. е. в полупроводниковых приборах, имеющих практически два состояния — проводящее (вентиль открыт) и непроводящее (вентиль закрыт).
Литература:
1. Жаворонков М.А., Кузин А.В. Электротехника и электроника. Москва,
АСАДЕМ!А, 2005.
2. Касаткин А.С., Немцов М.В. Электротехника. Москва, Высшая школа, 2003
3. Петленко Б.И. Электротехника и электроника. Москва,
АСАДЕМ!А, 2004.
4. Шихин А.Я. Электротехника. Москва, Высшая школа, 2001
5. Берикашвили В.Ш., Черепанов А.К. Электронная техника. Москва,
АСАДЕМ!А, 2005.
6. Трофимова Т.И., Курс физики. Москва, Высшая школа, 2003
 2014-01-25
2014-01-25 1134
1134
