1. Если структура изолирована диэлектрическими областями (щелевая или изопланарная изоляция) (рис. 10.6)
Минимальное расстояние между диэлектрическими областями, ограничивающими глубокий коллектор, равно
 мкм.
мкм.
Найдем ширину окна коллектора для фотолитографии:

2.Если нет канавок, т.е. если глубокий коллектор не ограничен диэлектриком
При расчете минимальных размеров коллекторной области, также как и эмиттерной области, необходимо учесть, что контактное окно к коллектору не должно выходить из области коллектора, т.е. необходимо учесть ошибку совмещения.
Размер окна для подлегирования приконтактной области коллектора на фотошаблоне совпадает с размером окна для диффузии примеси в эмиттер. Размер окна для создания области глубокого коллектора равен технологической норме, N.
 мкм.
мкм.
Берем четыре ошибки совмещения, считая, что совмещение при создании контактных окон осуществляется не с коллекторным слоем, а с ранее созданной меткой, по которой совмещались все слои.
Номинальный размер глубокого коллектора:
 Здесь
Здесь  =2 мкм – глубина коллектора.
=2 мкм – глубина коллектора.
Максимальный размер:

Минимальный размер:

При этих цифрах  получится меньше расчетного (6,66 мкм), в этом случае считать
получится меньше расчетного (6,66 мкм), в этом случае считать  надо от
надо от  (как эмиттер), а не от N.
(как эмиттер), а не от N.
Размер окна для диффузии примеси в коллектор на фотошаблоне:

Если размер на фотошаблоне получится меньше технологической нормы, берем W КШ= N, и пересчитываем, соответственно, размер коллектора в структуре.
Расчет разделительных областей
На фотошаблоне ширина разделительной области берется равной N.
Номинальная ширина разделительной области в структуре с изоляцией р-п- переходом:

а максимальная:

Размер окна фотошаблоне:

В случае щелевой изоляции ширина канавки на фотошаблоне берется равной N. Суммарное увеличение размера канавки примем равным ± 30 %.
 мкм.
мкм.
 мкм.
мкм.
В случае изопланарной изоляции ширина канавки на фотошаблоне берется равной N, размер канавки, получившейся в результате травления, не должен быть меньшим, чем две глубины канавки. Тогда размер изолирующей области в структуре получится равным двум глубинам изолирующего слоя ± 30 %.
 мкм.
мкм.
 мкм.
мкм.
 мкм.
мкм.
Ошибка совмещения в данном случае будет равна примерно толщине эпитаксиального слоя 2,5 мкм. Ширина SiO2 между базой и глубоким коллектором:
 мкм..
мкм..
Расчет расстояний до разделительной области
1. Если структура изолирована обратно смещенным p-n-переходом
При расчете суммарного размера структуры нужно учитывать, что ОПЗ коллекторного перехода и ОПЗ изолирующего перехода не должны перекрываться и не должны заходить в область глубокого коллектора. Чтобы это обеспечить, нужно оставить между ОПЗ коллекторного перехода и областью глубокого коллектора запас в две ошибки совмещения, 2D. От ОПЗ изолирующего перехода до ОПЗ коллекторного перехода и до глубокого коллектора достаточно оставить по одной ошибке совмещения, поскольку все области совмещаются, вероятно, по метке, созданной при формировании изолирующей области.
Таким образом, минимальное расстояние между краями разделительных областей:

 ,
,  - зависят от режимов работы транзистора.
- зависят от режимов работы транзистора.
Расчет расстояния между базой и разделительной областью
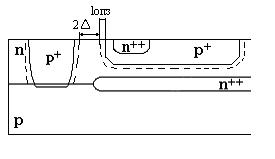
|
| Рис. 10.9. Расстояние между разделительной областью и базой |
При расчете расстояния между базой и разделительной областью необходимо учесть размеры ОПЗ p-n -переходов и обеспечить необходимый запас расстояния между ними. При расчете физических параметров транзистора было получено, например: для перехода разделительная область – эпитаксиальный слой  =0,35 мкм; для перехода база – эпитаксиальный слой
=0,35 мкм; для перехода база – эпитаксиальный слой  =0,34 мкм.
=0,34 мкм.
Минимальный размер расстояния между базой и разделительной областью (РО):

Номинальный размер расстояния РО с учетом случайных погрешностей и погрешности боковой диффузии:

Здесь  =2,5 мкм – глубина разделительной области.
=2,5 мкм – глубина разделительной области.
 зависит от того, что ближе к РО – ПБ или АБ, возьмем, как на рисунке, активную базу, тогда:
зависит от того, что ближе к РО – ПБ или АБ, возьмем, как на рисунке, активную базу, тогда:
 мкм
мкм
Размер на фотошаблоне:

 2014-02-09
2014-02-09 744
744








