Технологии ионного распыления в микроэлектронике используют для очистки поверхности подложек при нанесении слоев металлических, диэлектрических и полупроводниковых материалов, а также для нанесения тонких пленок на подложки методом ионного распыления мишеней. В данных технологиях поверхность подложек не контактирует непосредственно с плазмой, при этом плазменный разряд используется только как источник ионов. Процессы ионно-лучевого распыления реализуются на основе автономных источников ионов различных конструкций. Схема одной из конструкций источников ионов показана на Рис. 1.

Рис. 1. Схема многолучевого источника ионов.
На Рис. 1 обозначено: 1 – термокатод, 2 – ввод рабочего газа, 3 – экран катода, 4 – цилиндрический анод, 5 – соленоид, 6 – плазма, 7 – отражательно-эмиссионный электрод, 8, 9 – ускоряющий и зпмедляющий электроды, 10 – ионный пучок, Up – напряжение разряда, Uу – напряжение ускоряющего электрода, Uз – напряжение замедляющего электрода.
В источниках ионов такого типа разряд формируется в скрещенных электрическом и магнитном полях. Это обеспечивает осцилляцию электронов, испускаемых термокатодом, и в итоге высокую эффективность ионизации рабочего газа. Ионный пучок вытягивается из области плазмы через отверстия в отражательном электроде потенциалом, приложенным к ускоряющему электроду. Ускоряющий электрод совместно с замедляющим и отражательным электродами фокусируют ионные пучки, обеспечивая примерно однородный по сечению суммарный поток ионов из источника. Назначение замедляющего электрода – обеспечить требуемую энергию ионов на выходе из источника.
|
|
|
Эффективность вытягивания ионов из области плазмы и фокусировки ионных пучков сильно зависит от геометрии электродов и приложенных к ним напряжений. В качестве иллюстрации на Рис. 2 для двухсеточного источника ионов приведены конфигурации различные ионных пучков на выходе из источника при различных значениях напряжения, приложенного к ускоряющему электроду.
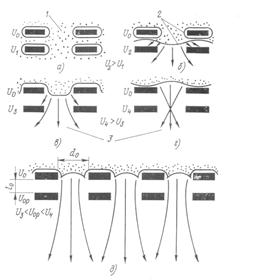
Рис. 2. Схема формирования ионных пучков в двухсеточном источнике ионов.
На Рис. 2 а показан вариант, когда на электродах приложенный потенциал равен нулю. В этом случае обе сетки находятся под потенциалом плазмы, и экстракции ионов на происходит. На Рис. 2 – г показаны конфигурации границы плазмы при последовательном увеличении отрицательного потенциала на ускоряющую сетку. Одновременно с перемещением границы плазмы, как показано на рисунке, происходит фокусировка ионных пучков. Случай Рис. 2 г соответствует перефокусировке ионных пучков, что сопровождается уменьшением плотности ионного тока. Для оптимального соотношения потенциалов на электродах в результате формируется система слабо расходящихся ионных пучков, при этом бомбардировка ионами электродов сводится к минимуму.
|
|
|
При использовании достаточно интенсивных ионных при энергии ионов менее 1 кэВ пучков вследствие действия объемного заряда ионный пучок начинает расфокусироваться. Для устранения данного эффекта применяют метод электронной нейтрализации объемного заряда, как показано на Рис. 3.
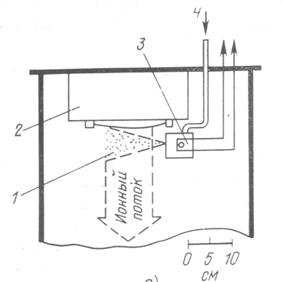
Рис. 3. Схема нейтрализации объемного заряда ионного пучка.
На рис. 3 обозначено: 1 – плазменный поток, 2 – источник ионов, 3 - полый катод, 4 – напуск газа. Назначение полого катода – сформировать поток электронов, нейтрализующий действие объемного заряда ионного пучка.
Скорость распыления различных материалов ионным пучком зависит от распыляемого материала, энергии ионов, плотности ионного тока, угла падения ионов на поверхность материала. В Таблице 1 в качестве примера приведены значения скорости распыления различных материалов ионами аргона с плотностью тока 1 мА/см2, энергии ионов 500 эВ при нормальном падении ионов на поверхность материала.
Таблица 1.
Скорости распыления материалов ионами аргона.
| Материал | Скорость распыления, нм/мин | Материал | Скорость распыления, нм/мин. | |
| Золото | Гранат (GaGd) | |||
| Арсенид галлия | Нержавеющая сталь | |||
| Медь | Молибден | |||
| Пермаллой | Кремний (100) | |||
| SiO2, кристалл | Стекло | |||
| Алюминий | Тантал | |||
| SiO2, пленка | Оксид алюминия |
Достоинством ионных источников со скрещенными магнитным и электрическим полями в области формирования плазмы является возможность независимого управления плотностью ионного тока и энергией ионов. Такие источники ионов позволяют получать ионные пучки диаметром до 300 мм и степенью однородности ионного тока по сечению пучка до 95%. На Рис. 4 преведены различные варианты использования таких источников ионов для напыления тонких пленок на подложки.

Рис. 4. Варианты использования источников ионов для осаждения
тонких пленок.
На рис. 4 обозначено: 1 – источник ионов, 2 – подложка, 3 – мишень, 4 – электронно-лучевой испаритель.
Вариант Рис. 4 а позволяет проводить прямое осаждение пленок непосредственно из ионного пучка, например, используя в качестве рабочего газа летучие соединения кремния. Однако такой процесс можно проводить только при малых значениях энергии ионов, так как с увеличением энергии начинается самораспыление пленок.
Осаждение пленок по схеме Рис. 4 б позволяет получать эпитаксиальные пленки CdTe при температуре подложки 140 0С, пленки HgCdTe при температуре 20 0С, а также эпитаксиальные пленки кремния. При этом, изменяя энергию ионов в источнике ионов, можно в широких пределах изменять микроструктуру эпитаксиальных пленок и их состав. При напуске в систему кислорода или азота до небольших давлений, не снижающих длину свободного пробега ионов, могут быть получены высококачественные пленки оксида или нитрида кремния.
Распыление мишени с одновременной ионной бомбардировкой подложки по схеме Рис. 4 в позволяет в широких пределах изменять состав растущей эпитаксиальной пленки. По такой технологии получают пленки Gd-Cо – гранатов с высокими магнитными свойствами, пленки Si3N4, AlN, HfN, ZrN, TiO и оксидов меди CuO, Cu2O, Cu5O4.
Осаждение пленок из электронно-лучевого испарителя с одновременной бомбардировкой поверхности пленки ионами по схеме Рис. 4 г позволяет изменять структуру пленок за счет ионного перемешивания, генерации дефектов и атомов отдачи.
 2014-02-09
2014-02-09 3054
3054








