Структура МОП - транзистора существенно трехмерная и размерных эффектов много. Отметим наиболее важные:
Зависимость порогового напряжения от длины канала. Для создания инверсного слоя в транзисторе с длинным каналом на затвор надо подать напряжении Uп, а в подложке образуется пространственный заряд q × Na × d × W × L, где d – ширина ОПЗ в подложке. В транзисторе с коротким каналом значительную часть пространства под затвором уже занимает ОПЗ, образованная p – n - переходами истока и стока (рис 1.8). Для создания инверсного слоя потенциал затвора должен сформировать заряд в подложке меньшей величины q × Na × d × W × (L-D), где D – поправка на уменьшение эффективной длины затвора. Пороговое напряжение при этом уменьшается. Величина поправки зависит от емкости окисла, толщины легированных слоев истока и стока, концентрации примеси в подложке.
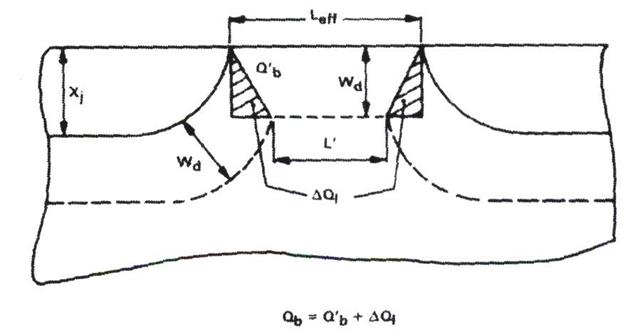
Рис. 1.8. Распределение зарядов в подложке короткоканального транзистора
Изменение порогового напряжения
DUп = – DQL/Cок×Sз, (1.20)
где DQL – изменение заряда в подложке за счет влияния истока и стока, Sз – площадь затвора.
Зависимость порогового напряжения от ширины канала. В поперечном сечении МОП - транзистора толщина подзатворного окисла увеличивается до толщины изолирующего окисла (рис. 1.9). Периферийное поле затвора индуцирует в подложке дополнительный заряд DQW. Для дополнительного заряда требуется дополнительное напряжение на затворе. Изменение порогового напряжения составляет
DUп = – DQW/Cок×Sз. (1.21.)
Эффекты узкого и короткого каналов действуют в противоположных направлениях и могут компенсировать друг друга для транзисторов с размерами, близкими к квадрату (W» L).
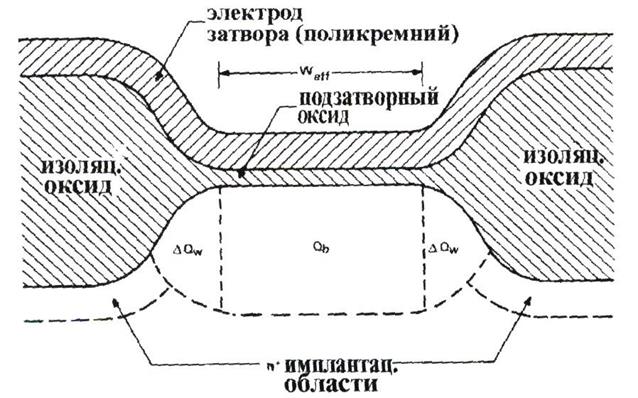
Рис. 1.9. Распределение зарядов в поперечном сечении
МОП - транзистора
Ток в подложке, ограниченный пространственным зарядом. При анализе влияния размерных эффектов на пороговое напряжение предполагалось, что напряжение на стоке Uс мало (< 0,1 В). С увеличением Uс в субмикронных приборах ОПЗ стока смыкается с ОПЗ истока. Электрическое поле стока проникает в ОПЗ истока и снижает потенциальный барьер для электронов. В результате происходит увеличение инжекции электронов из истока в канал и рост подпорогового тока. Соответственно, происходит уменьшение порогового напряжения с ростом напряжения на стоке. Изменение порогового напряжения линейно зависит от напряжения на стоке
DUп = - d×Uс, (1.22)
где d – статический коэффициент обратной связи. Для субмикронных транзисторов ток, ограниченный пространственным зарядом, сильнее влияет на выходное сопротивление транзисторов, чем эффект уменьшения эффективной длины затвора см. формулу 1.16.
Ток утечки затвор - сток при высоком напряжении на стоке. Уменьшение толщины подзатворного диэлектрика необходимо при уменьшении длины затвора. При этом напряженность электрического поля под затвором на границе области стока возрастает настолько, что становится возможным туннелирование электронов из затвора в сток. Кроме того, легированная область стока обедняется электронами и обогащается дырками. Дырки также инжектируются в подзатворный диэлектрик и дают вклад в ток затвора. Туннельные свойства носителей таковы, что ток электронов многократно превышает ток дырок. Однако дырки остаются в окисле и создают в нем объемный положительный заряд. Этот заряд нестабильный, а времена нарастания заряда в окисле и его релаксации многократно превышают времена электрических процессов в схеме. Иными словами, параметры транзисторов меняются во времени, а работоспособность схемы при этом может нарушаться. Борьба с этими эффектами осуществляется путем введения в структуру дополнительных легированных областей с целью снижения напряженности поля под затвором вблизи стока.
Туннельный ток утечки сток - подложка. Для транзисторов с длиной канала менее 0,5 мкм применяют специальные профили легирования подложки с целью уменьшения влияния эффектов короткого канала. В стоковом p – n - переходе создается электрическое поле высокой напряженности. Перепад потенциала в 1¸2 В происходит на расстоянии 10¸20 нм. При этих условиях возникает туннельная составляющая тока утечки. Оценки показывают, что предельная плотность туннельного тока 1 нА/мкм достигается при напряженности электрического поля в переходе сток - подложка 2×106 В/см2.
Квантование энергии носителей в инверсном слое. В МОП - транзисторах с толщиной подзатворного диэлектрика в несколько нанометров электрическое поле локализует носители в инверсном слое толщиной также в несколько нанометров. По законам квантовой механики пространственное квантование элементарных частиц ведет к появлению квантования по энергии, причем самый низкий энергетический уровень для электронов не совпадает с дном зоны проводимости. Симметричная картина реализуется для дырок. Таким образом, квантовые эффекты влияют на поверхностную плотность заряда в инверсном слое (рис. 1.10). Эти эффекты препятствуют приближению электронов к границе окисел - кремний. Эффективная толщина окисла при электрических измерениях становится больше физической толщины
 , (1.23)
, (1.23)
где Тэф и Тфиз – эффективная и физическая толщины окисла, eок, eSi – диэлектрические проницаемости окисла и кремния, DZ – смещение пика концентрации носителей. Величина DZ» 1 нм сравнима с толщиной подзатворного диэлектрика (2¸5 нм) для МОП - транзистора предельных размеров (Lз» 20¸100 нм).
Соответственно уменьшаются удельная емкость затвора и расчетная крутизна транзистора. Пороговое напряжение при этом возрастает, а ток стока уменьшается.
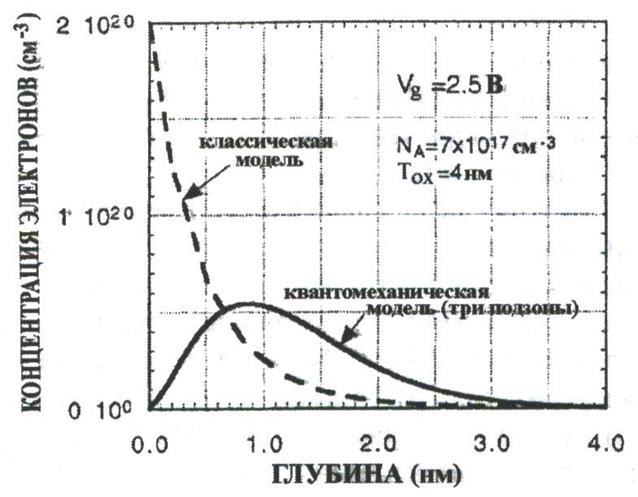
Рис. 1.10. Распределение концентрации электронов в инверсном слое для классической (кривая 1) и квантовой (кривая 2) моделей
1.7. Физические ограничения размеров МОП - транзисторов
Размер волны де Бройля для свободного электрона в зоне проводимости – 5 нм. Толщина подзатворного диэлектрика – SiO2 не может быть менее 1 нм как по технологическим причинам (это два молекулярных слоя), так и по причине туннельных токов через диэлектрик. Сейчас технологический предел оценивается в 1,5 нм. Минимальная длина затвора определяется двумя эффектами: усилением транзистора и туннельным током сток - подложка. При высокой концентрации легирующей примеси в подложке туннельный ток будет сравним с током канала; при низкой концентрации – ОПЗ истока и стока перекрываются, напряжение сток-исток открывает p – n - переход истока и через подложку течет ток, ограниченный пространственным зарядом. Усиление транзистора при этом падает. При длине затвора 10 нм и прямом смещении изолирующего перехода исток - подложка еще можно получить усиление в МОП - транзисторе. Практический предел – 15¸20 нм.
Емкость затвора минимального транзистора (10 нм ∙ 10 нм) составит всего 2×10-18 Ф. При рабочем напряжении 0,8 В и пороговом напряжении 0,2 В в канале находится не более шести электронов.
Ток в транзисторе будет меняться дискретно и статистически, так как заряд электрона дискретный. Высокий уровень дробовых шумов, связанных с дискретностью заряда, не позволит использовать максимальное быстродействие МОП - транзистора, определяемое емкостью затвора и крутизной ВАХ.
Статистическим распределением легирующей примеси в подложке под затвором определяется и воспроизводимость порогового напряжения. Для того же минимального транзистора в ОПЗ подложки под затвором будет в среднем пять легирующих атомов. Разброс порогового напряжения будет сравним с напряжением питания.
С уменьшением размеров и токов приборов повышается их чувствительность к космическим частицам и продуктам радиоактивного распада в материалах конструкции БИС. Схемными и конструктивными средствами избежать сбоев нельзя.
Контактные потенциалы в структуре не масштабируются, поэтому напряжение питания нельзя уменьшить менее 0,5 В.
Скорость распространения сигналов в проводниках ограничена скоростью света. В тонких проводниках микросхем ограничение R-L-C параметрами линии связи снижает эту скорость еще в несколько раз.
 2020-04-12
2020-04-12 479
479








