Для изучения зарождения и распространения дислокаций несоответствия в гетероструктурах GeSi/Si в установке молекулярной эпитаксии "Катунь" были выращены гетероструктуры с псевдоморфными напряжёнными плёнками твёрдого раствора GeSi c заданным составом, на подложке Si (001).
Для введения дислокаций несоответствия в плёнку GeSi образцы гетероструктур отжигались в атмосфере Ar и H2. Перед отжигом гетероструктуры были разрезаны на несколько частей, для каждой из которых анализировалась степень релаксации до и после отжига.
Состав слоёв и степень релаксации механических напряжений после отжига определялись из рентгеновских кривых качания, записанных для отражений (113) и (224), а так же вычислялась по результатам непосредственного наблюдения следов скольжения дислокаций в АСМ и по картинам просвечивающей электронной микроскопии.
2.2.1 Исследуемые образцы
Эпитаксиальные слои твёрдого раствора GexSi1-x выращивались на подложках Si(001) в установке молекулярно лучевой эпитаксии "Катунь". Скорости роста составляли 0.01 – 0.3 нм/с для Si и 0.006-0.04 нм/с для Ge в зависимости от состава выращиваемой плёнки.
Для проведения эксперимента были выращены структуры E9 и F9. Рост эпитаксиальных структур серии Е9 начинался с выращивания 50 нм Si буферного слоя при температуре подложки (Тп) 700 °С. После этого, при Тп = 350 °С производился рост 50 нм низкотемпературного буферного слоя Si. Затем выращивалась плёнка GexSi1-x с содержанием Ge = 0.32. После выращивания плёнка закрывались 5 нм слоем кремния.
Для гетероструктур серии F9 состав и порядок выращивания слоев аналогичен, отличие состоит в пониженном содержании Ge в слое GexSi1-x – доля германия составляет 0.22, а так же в отсутствии прикрывающего слоя Si.
Основные параметры выращенных гетероструктур представлены в таблице 2.1
Таблица 2.1 Состав гетероструктур
| № образца | HT буфер Т = 700°C | LT буфер Т = 350 °C | GexSi1-x слой | Содержание Ge в слое GexSi1-x | Cap-Si слой |
| E9 | 500 Ǻ | 500 Ǻ | 2000 Ǻ 300 °C | 0.32 | 50 Ǻ |
| F9 | 500 Ǻ | 500 Ǻ | 1000 Ǻ 350 °C | 0.22 | нет |
После проведения роста для каждой из гетероструктур была измерена степень релаксации плёнки GeSi, эпитаксиально выращенной на ее поверхности. Степень релаксации измерялась по кривым качания рентгеновской дифракции (рис. 2.2, 2.3) и уточнялась путём наблюдения следов скольжения дислокаций в АСМ (рис. 2.4, 2.5).

Рис. 2.2 Кривые качания рентгеновской дифракции полученные для гетероструктуры Е9. Степень релаксации плёнки: 0%.

Рис. 2.3 Кривые качания рентгеновской дифракции полученные для гетероструктуры F9. Степень релаксации плёнки: 0%.
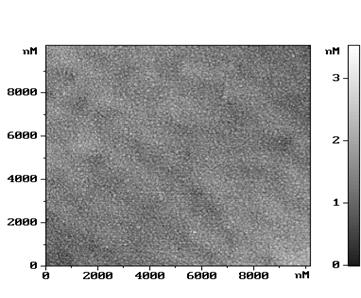
Рис. 2.4 фотография поверхности образца Е9 полученная с помощью АСМ

Рис. 2.5. фотография поверхности образца F9 полученная с помощью АСМ
На рисунках 2.2 и 2.3 приведены кривые качания рентгеновской дифракции полученные для гетероструктур Е9 и F9. Видно, что между главными пиками, образованными подложкой и пленкой, наблюдаются осцилляции промежуточных максимумов, что свидетельствует о высокой степени совершенства выращенной плёнки.
На рисунках 2.4 и 2.5 представлены фотографии поверхностей гетероструктур Е9 и F9, полученные с помощью АСМ до отжига. Поверхности гетероструктур достаточно гладкие: высота микрорельефа не превышает 15 Ǻ, структура поверхности имеет высокую степень совершенства, следов скольжения дислокаций не наблюдается, чужеродные частицы на поверхности отсутствуют.
По данным рентгеновской дифракции и АСМ для обоих гетероструктур получены нулевые значения релаксации, таким образом, можно говорить, что была выращена псевдоморфная плёнка GeSi.
Релаксация пленок
Отжиг образцов серии Е9 проводился при температуре 350 °С, одинаковой для всех образцов этой серии. Отжиг проводился в атмосфере Ar и H2, время отжига варьировалось от 10 мин. до 1,5 часов для разных образцов.
После отжига степень релаксации определялась по кривым качания рентгеновской дифракции. Поскольку для данного метода погрешность измерения релаксации составляет (< 1 %), то при малой степени релаксации для образцов Е9/1 и Е9/5 она уточнялась путём наблюдения следов скольжения дислокаций в АСМ.
Основные параметры отжига образцов серии Е9 сведены в таблицу 2.2
Таблица 2.2 Параметры отжига образцов серии Е9
| Образец | E9/1 | E9/2 | E9/3 | E9/4 | E9/5 | E9/6 |
| Температура Отжига, °С | 350 | |||||
| Атмосфера отжига | Ar | Ar | Ar | Ar | Ar | H2 |
| Время отжига, мин | 10 | 30 | 20 | 90 | 10 | 30 |
| Степень Релаксации *, % | 1 | 9 | 3 | 12 | 1 | 2 |
* – по данным рентгеновской дифракции
Видно, что степень релаксации механических напряжений с увеличением времени отжига увеличивается, однако для образца Е9/6, отожженного в водороде полученное значение релаксации в 4,5 раза ниже, чем для образца Е9/2 отожжённого в аргоне такое же время. На рисунке 2.6 представлен график зависимость степени релаксации от времени отжига.

Рис. 2.6 Зависимость степени релаксации от времени отжига. Т=350 °С
Более очевидно влияние поверхности проявляется на электронно-микроскопических снимках образца E9/1, отожжённого 10 мин в Ar. Отчётливо видны дислокации несоответствия, оканчивающиеся выходящими на поверхность сегментами – пронизывающими дислокациями (рис. 2.7). Обращает на себя внимание тот факт, что значительная часть дислокационных групп имеет форму креста. Можно считать, что в этих случаях на пересечении взаимно-перпендикулярных дислокаций находится дислокационный источник. На картине ПЭМ видно, что, как правило, изображения отрезков дислокаций многкратно накладываются друг на друга так, что видны только выходящие на поверхность сегменты. Следовательно, дислокационные источники, испускали дислокационные петли многократно, одну за другой. На фрагменте гетероэпитаксиальной плёнки, представленной на рис. 2.7, на каждый источник приходится в среднем, 4 дислокации несоответствия, каждая из которых ограничена 2 пронизывающими дислокациями. После отжига 10 минут плотность пронизывающих дислокаций в плёнках GeSi составляла 1.1*108 см-2, а степень пластической релаксации этого образца – 1%. Увеличение длительности отжига до 30 и 90 минут приводит к образованию сплошной дислокационной сетки, что не позволяет выявить места генерации ДН.
Как видно из таблицы 2, при увеличении длительности отжига от 10 до 90 минут степень релаксации плёнки, а следовательно, и плотность пронизывающих дислокаций возрастает примерно на порядок величины, что свидетельствует о продолжающемся действии уже существующих центров зарождения, и/или о появлении новых источников во время отжига.
На рисунке 2.9 представлен увеличенный фрагмент электронно-микроскопического изображения поверхности образца Е9/1. Стрелками А и В отмечены два участка поверхности, содержащие источники дислокационных полупетель. На участке А отчётливо видно (см. также схему к рисунку 2.9), что дислокационная полупетля малого размера находится на линии, соединяющей выходящие на поверхность плёнки концы пронизывающих сегментов большой дислокационной полупетли. Следовательно, можно считать, что обе дислокационных полупетли были образованы одним дислокационным источником. Этот позволяет предположить, что зарождение дислокационных полупетель происходит на поверхности плёнки. В этом случае только одна полупетля достигла границы раздела, образовав одну дислокацию несоответствия.
Во втором случае (источник В) наблюдается четыре дислокации несоответствия, распространяющиеся за счёт скольжения пронизывающих сегментов, обозначенных буквами a – d. Расположение их в одинаковой плоскости скольжения и один и тот же наклон в направлении скольжения (один из двух возможных в этом случае наклонов) свидетельствуют о том, что эти дислокационные сегменты, по-видимому, имеют одинаковый вектор Бюргерса, а дислокационный источник является многоразовым.
Еще более четко поверхностное зарождение дислокационных петель видно на Рис.2.8, где представлено ПЭМ изображение поперечного среза образца Е9/1 в плоскости (110). Анализ поперечных срезов позволил установить, что источники ДН локализованы в приповерхностной области эпитаксиальной плёнки. На рис. 2.8 кроме изображения двух фрагментов поперечного среза гетеросистемы GeSi /Si представлены соответствующие им схемы конфигураций дислокационных линий. На этих изображениях отчётливо видны дислокационные полупетли, распространяющиеся с поверхности вглубь плёнки, а также полупетли, уже достигшие границы раздела и сформировавшие отрезки дислокаций несоответствия. На основании полученных результатов можно предполагать, что активную роль в зарождении дислокаций несоответствия в гетероструктурах играет поверхность.
С этой точки зрения понятна малая релаксация образца E9/6. Известно, что водород, в отличие от аргона, не является инертным газом. Поэтому, при отжиге в атмосфере водорода ковалентные связи молекул вещества, находящегося в приповерхностной фазе, насыщаются, тем самым снижается поверхностная энергия гетероструктуры. В связи с этим можно предположить, что зарождению дислокаций с поверхности каким-то образом препятствует измененное водородом состояние поверхности.
Для того чтобы проверить предположение о влиянии поверхности был проведен ряд дополнительных экспериментов с образцами серии F9. Идея эксперимента была следующей: если уменьшить движущие силы, приводящие к введению дислокаций, то влияние поверхности образца на этот процесс станет более явным. Основной движущей силой для введения дислокаций являются механические напряжения несоответствия, которые определяются составом пленки GeSi. Для того чтобы уменьшить величину механических напряжений необходимо уменьшить содержание германия в пленках. Состав образцов серии F9 удовлетворяет этому условию, поскольку содержание германия в плёнке GeSi для этих образцов составляет 0,22 (для образцов серии Е9 - 0,32).
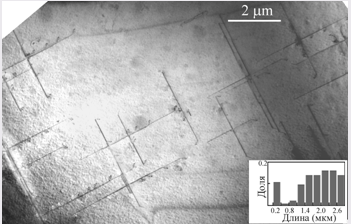
Рис. 2.7 ЭМ снимки поверхности образца Е9/1 после 10 мин отжига Т=350 °С
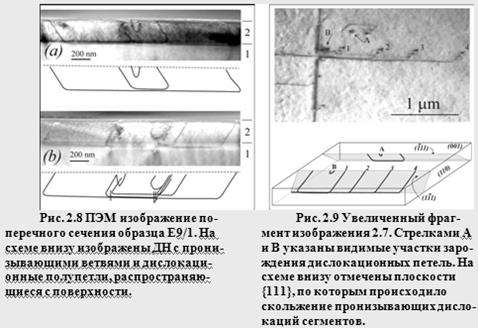
Для серии F9 постоянным для всех образцов было время отжига – 10 мин. Отжиг проводился в атмосфере Ar и H2, температура отжига варьировалось от 500 °С до 700 °С для разных образцов.
После отжига степень релаксации определялась по результатам наблюдения следов скольжения дислокаций в АСМ.
Основные параметры отжига образцов серии F9 сведены в таблицу 2.3
Таблица 2.3 Параметры отжига образцов серии F9
| Образец | F9/1 | F9/2 | F9/3 | F9/4 |
| Температура Отжига, °С | 500 | 600 | 600 | 700 |
| Атмосфера отжига | H2 | H2 | Ar | H2 |
| Время отжига, мин | 10 | |||
| Степень Релаксации*, % | 0 | 0 | 0,2 | 0,02 |
* – по данным АСМ.
Как видно из таблицы, при отжиге образцов в атмосфере водорода релаксации не наблюдалось вплоть до температур 600 °С. Только по достижении 700 °С плёнка GeSi начала релаксировать. Однако и в этих условиях наблюдаемая величина релаксации незначительна и составляет порядка сотых процента. Отжиг в атмосфере Ar при 600 °С даёт величину релаксации плёнки на порядок большую, по сравнению с отжигом в водороде при 700 °С. Тот факт, что отжиг в водороде вплоть до температуры 600 °С не приводит к релаксации образцов серии F9 позволяет сделать вывод, что в данных условиях дислокации вводятся только с поверхности.
Ниже представлены снимки поверхности образцов F9/3 и F9/4, полученные с помощью АСМ. Видны следы скольжения дислокаций, неодинаковая толщина линий, обусловлена разной высотой ступеней, образованных продвижением дислокаций, что свидетельствует об их многократном прохождении вдоль линий скольжения.

Рис. 2.10 Снимки поверхности образца F9/3 после отжига в Ar 10мин. Т = 600 ° С

Рис. 2.11 Снимки поверхности образца F9/4 после отжига в Н2 10мин. Т = 700 ° С
 2020-08-05
2020-08-05 117
117








