Эпитаксия
Это процесс наращивания монокристаллических слоев на полупроводниковую подложку, при котором кристаллическая структура наращиваемого слоя повторяет кристаллографическую ориентацию подложки. Эпитаксия обычно используется для получения тонких рабочих слоев однородного полупроводника на сравнительно толстых подложках, играющих роль несущей конструкции. Эпитаксия позволяет выращивать монокристаллические слои любого типа электропроводности и любого удельного сопротивления на подложке, обладающей также любым типом электропроводности и удельным сопротивлением. Граница между эпитаксиальным слоем и подложкой не получается идеально резкой, поэтому затруднено создание сверхтонких (менее 1 мкм) слоев и многослойных эпитаксиальных структур. Однако она позволила получить достаточно тонкие слои (1...10 мкм), которые невозможно получить другими средствами.
Возможна как газовая, так и жидкостная эпитаксия, при которых наращивание монокристаллического слоя осуществляется из газовой или жидкой фазы, содержащей необходимые компоненты - соединения кремния, бора (акцептор) или фосфора (донор).
2.3. Термическое окисление
Получаемая в этом процессе пленка двуокиси кремния (SiО2) выполняет несколько важных функций: функцию защиты поверхности; функцию маски, через окна которой вводятся необходимые примеси; функцию тонкого диэлектрика под затвором МДП-транзистора. Это стало одной из причин того, что кремний является основным материалом для изготовления полупроводниковых интегральных схем.
Следует заметить, что поверхность кремния всегда покрыта собственной окисной пленкой даже при самых низких температурах, но эта пленка имеет слишком малую толщину (около 5 нм). Поэтому ее нельзя использовать для выполнения перечисленных функций. Пленки SiО2 приходится получать искусственным путем.
Искусственное окисление кремния обычно осуществляется при высокой температуре (1000...1200°С) и называется термическим окислением. Оно может быть проведено в атмосфере кислорода (сухое окисление) и в смеси кислорода с парами воды (влажное окисление) или просто в парах воды. Сухое окисление идет в десятки раз медленнее влажного. Например, для выращивания пленки SiО2 толщиной 0,5 мкм в сухом кислороде при 1000°С требуется около 5 ч, а во влажном – 20 мин. С уменьшением температуры на каждые 100°С время окисления растет в 2...3 раза.
Легирование – операция введения необходимых примесей в монокристаллический полупроводник. Основным способом легирования является диффузия примесных атомов при высокой температуре. Широкое распространение получил и другой способ – ионное легирование (имплантация).
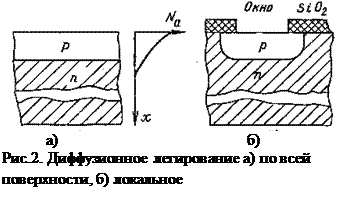 Диффузионное легирование может быть общим (по всей поверхности, рис.2,а) и локальным (на определенных участках через окна в масках, рис.2, б).
Диффузионное легирование может быть общим (по всей поверхности, рис.2,а) и локальным (на определенных участках через окна в масках, рис.2, б).
Диффузию можно проводить однократно и многократно (двойная и трехкратная диффузия). Существует предельная растворимость примеси, которая зависит от температуры. При некоторой температуре концентрация примеси достигает максимального значения, а затем уменьшается. Это значение в кремнии для мышьяка составляет 20·1020 см-3 (1150°С), фосфора 13·1020 см -3 (1150°С), бора 5·1020 см-3 (1200°С) и сурьмы 0,6·1020 см-3 (1300°С). Источниками примеси могут быть их химические соединения в виде жидкости, твердого тела или газа.
Время проведения диффузии пропорционально квадрату необходимой глубины диффузии, поэтому получение глубоких диффузионных слоев требует большого времени: в интегральных схемах глубина рабочих диффузионных слоев обычно 1...4 мкм. Так как зависимость коэффициентов диффузии от температуры сильная (экспоненциальная), то предусматривается очень точная регулировка температуры. Допустимая нестабильность температуры составляет сотые доли процента.
 Ионное легирование осуществляется путем бомбардировки пластины ионами примеси, ускоренными в специальных установках (ускорителях частиц) до значительной энергии. На схеме установки ионного легирования (рис.3) ионы примеси из источника ионов 1 входят в анализатор по массе 2. Необходимость разделения ионов по массе вызвана тем, что вытягиваемый из источника поток ионов неоднороден по составу; в нем присутствуют ионы различных элементов и соединений и многозарядные ионы. Для разделения ионов по отношению массы к заряду применяют различные сепараторы, которые основаны на взаимодействии движущегося иона с магнитными и электрическими полями или с комбинацией этих полей. В большинстве установок сепараторами являются секторные магнитные системы, в которых происходит поворот пучка ионов на угол менее 180° (например, 45°, 60° или 90°).
Ионное легирование осуществляется путем бомбардировки пластины ионами примеси, ускоренными в специальных установках (ускорителях частиц) до значительной энергии. На схеме установки ионного легирования (рис.3) ионы примеси из источника ионов 1 входят в анализатор по массе 2. Необходимость разделения ионов по массе вызвана тем, что вытягиваемый из источника поток ионов неоднороден по составу; в нем присутствуют ионы различных элементов и соединений и многозарядные ионы. Для разделения ионов по отношению массы к заряду применяют различные сепараторы, которые основаны на взаимодействии движущегося иона с магнитными и электрическими полями или с комбинацией этих полей. В большинстве установок сепараторами являются секторные магнитные системы, в которых происходит поворот пучка ионов на угол менее 180° (например, 45°, 60° или 90°).
Ионы с определенным отношением массы к заряду входят в электростатический ускоритель ионов 3, к электродам которого от отдельного высоковольтного источника 9 подводится напряжение, в отдельных установках до 200 кВ и выше. Ускоренные ионы через щель 4 поступают в фокусирующую систему 5, а затем в сканирующую систему 6, которая обеспечивает перемещение сфокусированного пучка ионов по полупроводниковой пластине 8, расположенной в приемной камере 7. В установке обеспечивается необходимый высокий вакуум. Получаемый ток пучка ионов в различных установках составляет от десятков микроампер до нескольких миллиампер. Сканирование пучка в одном поперечном направлении механическое, а в другом электростатическое, площадь сечения пучка 1...2 мм2. Число одновременно закладываемых в камеру пластин с диаметром 75... 150 мм в разных установках составляет 96...24. Следует заметить, что глубина проникновения ионов, зависящая от их энергии, составляет 0,1...0,5 мкм, т.е. очень мала и недостижима при диффузионном легировании. Это позволяет получать резкие профили (большие градиенты) распределения примеси.
Ионное легирование характеризуется универсальностью и гибкостью, позволяет с высокой точностью управлять количеством легирующей примеси (путем регулировки тока пучка ионов) и глубиной внедрения – изменением энергии (напряжения источника). Процесс ионного легирования может осуществляться при низких температурах, вплоть до комнатных, благодаря чему сохраняются исходные электростатические свойства кристаллов. Это большое преимущество метода перед диффузионным легированием. Низкая температура позволяет проводить ионное легирование на любом этапе технологического цикла. Однако недостатком метода (кроме необходимости сканирования пучка) является возникновение обилия радиационных дефектов в облученном полупроводнике, вплоть до образования аморфного слоя. Такие дефекты полностью удается устранить путем кратковременного отжига (в кремнии при 900...1100°С).
 2014-02-17
2014-02-17 1973
1973
