Размеры элементов в ФЛГ процессе принципиально ограничены длиной волны используемого излучения. Для дальнейшего уменьшения элементов ИС необходимо применение электронно-лучевой и рентгеновской литографии.
Применение электронно-лучевой литографии (ЭЛГ) позволяет:
· получать элементы рисунка с размерами менее или равными 0,01 мкм;
· с высокой точностью контролировать дозу электронного пучка, падающего на резист и подложку;
· легко отклонять и модулировать электронный пучок с высокой точностью электрическими и магнитными полями;
· формировать в ряде случаев топологию схемы непосредственно на пластине;
· автоматизировать технологию создания топологического рисунка.
Достоинства и основы метода ЭЛГ. ЭЛГ, благодаря чрезвычайно малой длине волны ускоренных электронов, отличается практически отсутствием дифракции и, как следствие, высокой разрешающей способностью. Длина волны электрона (им) определяется соотношением:

где  — масса и заряд электрона,
— масса и заряд электрона,  — ускоряющее напряжение, В.
— ускоряющее напряжение, В.
При ускоряющих напряжениях от 102 до 104 В  меняется от 0,1 до 0,01 нм. Системы ЭЛГ обладают также высокой глубиной резкости, что снижает требования к плоскостности подложек. Экспонирование выполняется в вакуумных установках, это обеспечивает чистоту. Передача топологии по алгоритму, заложенному в память ЭВМ, позволяет выполнять экспонирование без применения шаблонов.
меняется от 0,1 до 0,01 нм. Системы ЭЛГ обладают также высокой глубиной резкости, что снижает требования к плоскостности подложек. Экспонирование выполняется в вакуумных установках, это обеспечивает чистоту. Передача топологии по алгоритму, заложенному в память ЭВМ, позволяет выполнять экспонирование без применения шаблонов.
Электронное экспонирование основано на нетермическом взаимодействии ускоренных электронов с электронорезистом. Обладая большой энергией, электроны разрывают почти все химические связи на своем пути. Одновременно происходит поперечное сшивание молекул.
Чувствительность электронорезистов определяется дозой заряда, при которой для позитивного резиста облученные участки проявляются на полную глубину слоя, а для негативного – на облученных участках после проявления остается 0,5 исходной толщины. Чувствительность зависит от энергии электронов, типа проявителя, условий проявления, толщины резиста и др. Рассеяние электронов в слое резиста, отражение от подложки, а также влияние электронов, рассеянных от близко экспонируемых участков (эффект близости), увеличивают и искажают экспонируемую область. Размер ее в глубине слоя больше, после проявления стенки окна имеют отрицательный наклон. С увеличением энергии электронов чувствительность возрастает, а разрешение падает из-за увеличения рассеяния. Другой фактор, ограничивающий разрешающую способность, – набухание резистов при проявлении, наблюдаемое в большей степени у негативных резистов.
Электронорезисты – в основном органические материалы с большой молекулярной массой, имеющие высокую прозрачность в видимом и УФ-свете. Позитивные резисты изготавливают на основе полиметилметакрилата (ПММА) и полибутенсульфона (ПБС), негативные – на основе полиглицидилметакрилата (ГМА). В наименовании марки: ЭРП – электронорезист позитивный, ЭРН – электронорезист негативный.
В отличие от нейтрального фотона (оптического и рентгеновского излучений) электрон заряжен, что позволяет с помощью электронной оптики, т. е. электрическими и магнитными полями, ускорять, фокусировать электроны и отклонять полученный электронный луч. Применяют два метода экспонирования: сфокусированным единичным лучом круглого, квадратного или прямоугольного сечения, перемещаемым по заданной программе (сканирующая ЭЛГ), и проецированием изображения шаблона в масштабе 1:1 или от 10: 1 до 30: 1 с помощью широкого пучка электронов на всю подложку или ее участок (проекционная ЭЛГ).
Сканирующая ЭЛГ. Сформированный в вакуумной камере установки (рис. 9.14) электронный луч фокусируется в плоскость подложки со слоем электронорезиста. Сканирование луча по поверхности слоя резиста осуществляется системой управления. Экспонирование слоя резиста производится отдельными участками – кадрами. Сканирование можно проводить двумя способами (рис.9.15). При растровом сканировании луч перемещается по всей поверхности кадра, включаясь и выключаясь в нужных местах в соответствии с запрограммированной топологией. Более производительно векторное сканирование: луч перемещается только в местах, соответствующих элементу топологии, включаясь в момент перехода к следующему элементу.
 |
| Рис. 9.14. Схема вакуумной установки для сканирующей ЭЛГ: 1 – вакуумная камера; 2– электронная пушка; 3–квадратная диафрагма; 4 – линза конденсора; 5 – отклоняющие пластины гашения луча; 6 – отклоняющие обмотки; 7 – проекционная линза; 8 – вакуумная система; 9 – электронный луч; 10– подложка; 11 – вторичные электроны; 12– система перемещений подложки; 13 – прецизионный датчик перемещений; 14 – устройстве ввода информации; 15 – датчик вторичных электронов; 16 – система управлении; 17 – диафрагма |
 |
| Рис. 9.15. Схема растрового (а) и векторного (б) сканировании луча |
Основной недостаток метода – низкая производительность из-за большого времени экспонирования, так как при уменьшении диаметра луча необходимо снижать его ток и увеличивать число строк сканирования. Этот метод приемлем только при формировании изображения незначительного числа топологических элементов, имеющих одинаковые размеры, например при создании изображения контактных окон. В противном случае операция экспонирования кремниевой пластины диаметром 125 мм может протекать в течение нескольких часов
Проекционная ЭЛГ. При проецировании топологии с сохранением масштаба используется шаблон-фотокатод, при проецировании с уменьшением масштаба как шаблон-катод, так и свободная маска из металлической фольги.
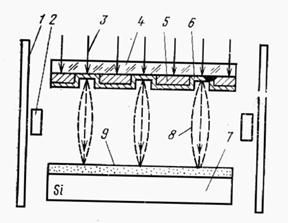 |
| Рис. 9.16. Система проеиционного электронного экспонирования с сохранением масштаба: 1 – отклоняющая система; 2– фокусирующая система; 3 – УФ излучение; 4 – кварцевая основа шаблона – фотокатода; 5–диоксид титана; 6–пленка палладия; 7 – подложка; 8–поток электронов; 9 – слой электронорезиста |
Проекционное экспонирование с сохранением масштаба позволяет одновременно облучать всю поверхность подложки (рис. 9.16). Фотокатод представляет собой полированную кварцевую пластину, на поверхности которой выполнен рисунок в масштабе 1: 1 из слоя непрозрачного для УФ-излучения (хром, диоксид титана). Поверх этого слоя нанесена сплошная пленка материала с высокой фотоэмиссией (палладий, иодид цезия). Фотокатод со стороны кварца облучают ультрафиолетом, с обратной стороны с участков, не покрытых маскирующей пленкой, эмиттируют фотоэлектроны. Далее они ускоряются электрическим полем и с помощью фокусирующей системы проецируют изображение катода на слой электронорезиста. В конструкции установки предусмотрена отклоняющая система, которая позволяет смещать проецируемое изображение в плоскости подложки и тем самым обеспечивать совмещение.
Совмещение производится по изменению рентгеновского излучения на непрозрачных метках-углублениях. Рентгеновское излучение возникает при соударении ускоренных электронов с кремниевой подложкой и проходит через нее. Сигнал рассогласования изображения шаблона и подложки регистрируется датчиками.
Срок службы фотокатодов больше, чем фотошаблонов. Производительность процесса сравнима с производительностью фотолитографии.
К недостаткам относятся сложности совмещения и изготовления прецизионных фотокатодов.
Проекционное экспонирование с уменьшением масштаба выполняется на полях в несколько миллиметров. Источником электронов может являться термокатод электронной пушки или фотокатод-шаблон. В системах с термокатодами (рис. 9.17) используются шаблоны из металлической фольги. Уменьшенное изображение шаблона проецируется на подложку. Затем перемещается столик, и так до полного экспонирования всего слоя электронорезиста.
 |
| Рис. 9.17. Система проекционного электронного экспонирования с уменьшением масштаба: 1 – источник электронов; 2 – отклоняющая система; 3– линза конденсатора; 4 – теневой шаблон из фольги; 5 – проекционная линза; 6 – подложка со слоем электронорезиста; 7– подложкодержатель; 8–датчик отражения электронов; 9–система обработки сигнала; 10 – вакуумная камера |
Совмещение выполняется в режиме сканирования острофокусированного луча, как и при сканирующей ЭЛГ. Экспонирование с уменьшением масштаба позволяет получать размер элемента до 0,25 мкм. Производительность процесса выше, чем при сканирующем экспонировании (менее 1 с на одно поле).
Формирование элементов топологии заданных размеров с малым отклонением от номинальных значений (менее ±10%) требует нескольких перемещений электронного луча, при этом промежутки между двумя соседними положениями луча равны половине ширины луча. Доза экспонирования одного участка пластины воздействует на процесс экспонирования соседних областей, что приводит к размытию профиля распределения энергии экспонирования. Это явление в ЭЛГ получило название эффекта близости.
Суть этого эффекта: при проникновении электронного луча в резист и расположенную под ним подложку электроны подвергаются упругому и неупругому рассеянию. Неупругие столкновения электронов с атомами резиста и подложки приводят к потере энергии, упругие столкновения вызывают изменение направления движения электронов. Следовательно, падающие на пластину электроны рассеиваются по мере их проникновения в подложку, покрытую резистом, до тех пор, пока не потеряют свою энергию или не покинут пластину в результате столкновений, приводящих к обратному рассеянию.
Электроны обратнорассеянные из подложки, передают резисту энергию излучения на расстоянии в несколько микрометров от центра экспонирующего луча. Поскольку резист суммирует вклады энергии от всех окружающих областей, доза экспонирования, полученная одним штрихом, воздействует на процесс экспонирования соседних штрихов.
На рис. 9.18 показано действие этого эффекта. Линейная топология, представленная на рисунке заштрихованными областями, сформирована сканированием электронного луча вдоль трех линий. При проникновении электронов в резист их рассеяние приводит к размытию профиля распределения энергии экспонирования. Следовательно, изображение, проявленное в резисте, будет иметь размеры, большие по сравнению с размерами, определяемыми падающим электронным лучом.
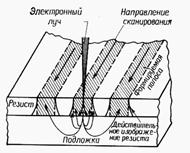 |
| Рис. 9.18. Эффект рассеяния электронов в покрытой резистом подложке |
В экспонирование центральной области элемента большого размера (точка А на рис. 9.19) вносят вклад все электроны, экспонирующие соседние области. Резист в точке В получает, однако, только половину энергии экспонирования точки А, а резист в точке С (в углу элемента) — только 1/4 энергии экспонирования точки А. Изображение на резисте обычно проявляется до тех пор, пока ширина элемента рисунка не станет равной ширине, заложенной в конструкции схемы, т. е. до точки В.
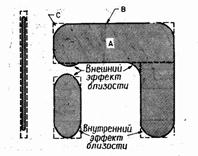 |
| Рис. 9.19. Внешние и внутренние эффекты близости при экспонировании электронным. лучом,: вызванные рассеиванием электронов |
Заштрихованная область на рисунке представляет собой проявленное изображение элемента схемы. Из-за эффектов близости углы элемента не проявляются до положений, определенных конструкцией элемента. Такое явление называют внутренним эффектом близости. Воздействие этого эффекта приводит к тому, что элементы различного размера воспроизводятся по-разному. Элементы, обладающие большой длиной и малой шириной, после проявления имеют размеры, меньшие, чем это определено конструкцией схемы, так как доза экспонирования и условия проявления оптимизированы для получения требуемого положения края элемента в точке В. Кроме того, при экспонировании резиста проявляются эффекты, связанные с тем, что обратнорассеянные электроны проходят большие расстояния, так что элементы топологии, расположенные относительно близко друг к другу, подвергаются воздействию экспонирующего облучения соседних областей. Это так называемые внешние эффекты близости (рис. 9.20).
Для введения поправки на действие эффектов близости топологический рисунок может быть разбит на меньшие элементы. Доза экспонирования малых элементов подбирается такой, что бы средняя доза экспонирования каждого топологического рисунка соответствовала величине, определенной при конструировании схемы. Недостатком этого метода является то, что эта операция может уменьшить производительность злектронно-лу чевого оборудования вследствие увеличения машинного времени, необходимого для разбиения топологического рисунка на субэлементы и формирования их на резисте.
 | 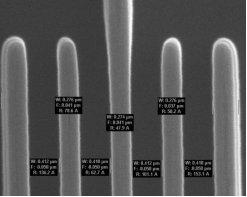 |
| Рис. 9.20. Внешние и внутренние эффекты близости |
Явление рассеяния ограничивает минимальную воспроизводимую ширину линий. Поскольку обратнорассеянные электроны могут проходить большие расстояния перед повторным внедрением в пленку резиста, их некоторое количество внесет вклад в экспонирование областей резиста, расположенных в окрестности сформированного изображения. Другими словами, суммарная поглощенная резистом энергия зависит от близости соседних экспонируемых областей.
Итак, недостатками электронно-лучевой литографии являются:
· малая производительность по сравнению с оптической;
· сложность изготовления шаблонов;
· сложность и высокая стоимость оборудования.
В настоящее время электронное экспонирование применяется при изготовлении фотооригиналов, фото- и рентгеношаблонов; шаблонов для проекционной электронолитографии, а также полупроводниковых сверхбольших ИМ с размерами элементов менее 1 мкм.
 2014-02-09
2014-02-09 4697
4697