1. Характеристики в активной области идут с большим наклоном, чем в схеме с общей базой. Больший наклон объясняется тем, что при постоянном токе базы и напряжении на коллекторе происходит увеличение тока эмиттера, а соответственно и тока коллектора.


2. Характеристики в активной области идут более неравномерно, чем в схеме с общей базой. Это связано с сильной зависимостью коэффициента усиления от тока базы.
 >
>  .
.
3. Характеристика передачи тока:  =
=  |
|  .
.

 '' >
'' >  '.
'.
По сравнению с ОБ эта характеристика имеет большую неравномерность. Эти характеристики более чувствительны к изменению коллекторного напряжения.
4. Характеристика обратной связи:  =
= 
 .
.

 ''' >
''' >  '' >
'' >  '.
'.
3.4 Пробой в транзисторе
Пробой в транзисторе отличается от пробоя в обычном полупроводниковом приборе. Это объясняется следующим образом:
1. При увеличении  меняется толщина базы. База может быть полностью поглощена коллекторным переходом – смыкание базы.
меняется толщина базы. База может быть полностью поглощена коллекторным переходом – смыкание базы.
2. В коллекторном переходе могут происходить лавинные пробои, которые могут протекать по-разному.
3. В транзисторе возможен вторичный пробой, приводящий к резкому увеличению тока через транзистор при резком падении напряжения между коллектором и эмиттером.
1. Смыкание переходов.
При достаточно больших  область объёмного заряда коллекторного перехода может достигнуть эмиттерного перехода. Происходит смыкание p-n-перехода. Потенциальный барьер уменьшается, возрастает ток эмиттера и ток коллектора.
область объёмного заряда коллекторного перехода может достигнуть эмиттерного перехода. Происходит смыкание p-n-перехода. Потенциальный барьер уменьшается, возрастает ток эмиттера и ток коллектора.
Чем меньше толщина базы, тем вероятнее пробой. Чем  больше, тем меньше напряжение пробоя. По этой причине транзисторы имеют малый коэффициент
больше, тем меньше напряжение пробоя. По этой причине транзисторы имеют малый коэффициент  .
.
2. Лавинный пробой коллекторного перехода.
Протекание этого пробоя зависит от сопротивления в цепи базы.
Если ток в цепи базы неограничен, например, как в схеме с ОБ, то в таком случае пробой протекает так же, как в обычном диоде.
Если ток в цепи базы ограничен, как в цепи с ОЭ, то образующиеся за счёт лавинного пробоя (размножения) носители заряда будут попадать в область базы. Основные носители (для базы) будут уходить в область базы, неосновные – в область коллектора.

В области базы происходит избыточное накопление основных носителей заряда. Т. к. R большое, то это изменение основных носителей не может быть скомпенсировано через входной источник  . В результате потенциал базы будет увеличиваться. А увеличение потенциала базы приводит к дальнейшему открыванию эмиттерного перехода. Происходит увеличение тока эмиттера и тока коллектора. Через транзистор протечёт большой неуправляемый ток. Вероятность такого пробоя будет тем выше, чем выше сопротивление базы R.
. В результате потенциал базы будет увеличиваться. А увеличение потенциала базы приводит к дальнейшему открыванию эмиттерного перехода. Происходит увеличение тока эмиттера и тока коллектора. Через транзистор протечёт большой неуправляемый ток. Вероятность такого пробоя будет тем выше, чем выше сопротивление базы R.
! Впаивают вначале и выпаивают в последнюю очередь вывод базы.
0 <  <
<  .
.
3. Вторичный пробой.
Под вторичным пробоем понимают внезапный переход транзистора в состояние с большим прямым током и малым падением напряжения. При вторичном пробое ток локализуется в небольшой области. Возникает шнур проводимости. Возникновение такого шнура связано с наличием дефектов транзистора. Шнур приводит к следующим последствиям:
Происходит тепловая генерация носителей заряда в перегретом месте, что приводит к большой плотности тока, а соответственно к большому перегреву этой области. В результате зона объёмного заряда может полностью исчезнуть. Увеличение плотности тока может привести к уменьшению толщины p-n-перехода, → увеличению напряжённости электрического поля, → увеличению лавинного пробоя, → дальнейшему увеличению количества носителей заряда. Происходит резкое падение напряжения на переходе. Эта зависимость видна на выходных характеристиках КЭ:

Разогревается только локальная область, а не весь транзистор. Процесс происходит очень быстро. Эмиттерная область соединяется с коллекторной.
В транзисторе возможен и тепловой пробой за счёт перегрева структуры. В результате кристалл плавится.
3.5 Зависимость коэффициента усиления от режима работы транзистора
 − коэффициент усиления в схеме с ОБ (
− коэффициент усиления в схеме с ОБ ( ≈ 1);
≈ 1);
 − коэффициент усиления в схеме с ОЭ.
− коэффициент усиления в схеме с ОЭ.
Зависимость  от напряжения на коллекторном переходе.
от напряжения на коллекторном переходе.
За счёт уменьшения тока базы происходит увеличение коэффициента  . При приближении к зоне лавинного пробоя концентрация носителей заряда в базе увеличивается за счёт подтока их из коллекторного перехода. В результате ток базы может уменьшаться вплоть до нуля. Коэффициент
. При приближении к зоне лавинного пробоя концентрация носителей заряда в базе увеличивается за счёт подтока их из коллекторного перехода. В результате ток базы может уменьшаться вплоть до нуля. Коэффициент  в области, близкой к лавинному пробою коллекторного перехода, будет стремиться к бесконечности.
в области, близкой к лавинному пробою коллекторного перехода, будет стремиться к бесконечности.

В зоне лавинного пробоя может произойти явление инверсии тока базы. Т. е. ток из базовой цепи поменяет своё направление.

Зависимость  от тока эмиттера:
от тока эмиттера:

В области малых токов наиболее заметно явление рекомбинации носителей заряда при прямом включении. По мере увеличения тока эмиттера роль рекомбинации в p-n-переходе снижается. За счёт этого увеличивается коэффициент  . Кроме того, при увеличении тока через эмиттерный переход увеличивается концентрация в базе неосновных носителей заряда. Возникает дополнительное поле, облегчающее переход носителей из эмиттера в коллектор.
. Кроме того, при увеличении тока через эмиттерный переход увеличивается концентрация в базе неосновных носителей заряда. Возникает дополнительное поле, облегчающее переход носителей из эмиттера в коллектор.
3.6 Малосигнальные параметры транзисторов (система “h-параметров”)
В большинстве случаев транзистор работает в схемах, в которых на большом постоянном напряжении наложены небольшие переменные напряжения. Переменные составляющие малы по сравнению с постоянными составляющими. Транзистор можно рассматривать как линейный четырёхполюсник, имеющий входные и выходные цепи.
 За положительное направление тока принимают направление втекающего тока. Можно составить системы из двух уравнений.
За положительное направление тока принимают направление втекающего тока. Можно составить системы из двух уравнений.
Система “z-параметров”:
 (3.5)
(3.5)
В качестве параметров рассматривают z, имеющие размерность сопротивления.
 (3.6)
(3.6)
В качестве параметров рассматривают y, имеющие размерность проводимости.
“z-параметры”:
Режим холостого хода (ХХ) тяжело “организовать” для выходной цепи, и легко – для входной.
“y-параметры”:
Чтобы найти эти параметры, необходимо обеспечить режим короткого замыкания (КЗ). В соответствующую цепь нужно зашунтировать сопротивление. Сделать это тяжело для входной цепи, и легко – для выходной.
Для биполярных транзисторов используется совмещённая система параметров – система “h-параметров”.
Режим ХХ по входной цепи.
Режим КЗ по выходной цепи.
 (3.7)
(3.7)
где  − входное сопротивление:
− входное сопротивление:  =
=  при
при  = 0 (при КЗ выходной цепи);
= 0 (при КЗ выходной цепи);
 − коэффициент обратной связи по входной цепи, который показывает, как влияет выходная цепь на входную:
− коэффициент обратной связи по входной цепи, который показывает, как влияет выходная цепь на входную:  =
=  при
при  = 0;
= 0;
 =
=  при
при  = 0;
= 0;
 − выходная проводимость при режиме ХХ по входной цепи:
− выходная проводимость при режиме ХХ по входной цепи:  =
=  при
при  = 0.
= 0.
Различают системы “h-параметров” для схем ОБ и ОЭ.
Малосигнальные параметры относятся к дифференциальным параметрам, показывают малое приращение какой-то величины.

 ;
;  .
.

 3.7 Частотные характеристики
3.7 Частотные характеристики
Важной характеристикой является возможность усиливать переменное напряжение заданной частоты. Для транзистора этой зависимостью является:  =
=  или
или  =
= 
Коэффициент передачи тока зависит от структуры и параметров транзистора. На него влияют ёмкость эмиттера, время пролёта носителей через базу, через область объёмного заряда, постоянная времени в цепи коллектора.
1) Влияние ёмкости в цепи эмиттера.
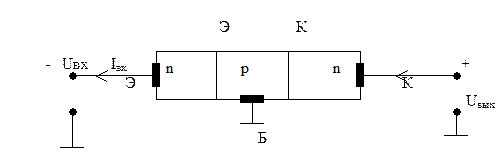
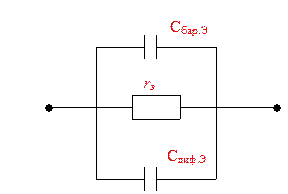
Чем больше ток эмиттера, тем больше задержка.

 =
=  ; (3.8)
; (3.8)
 =
=  , (3.9)
, (3.9)
где  = const.
= const.
Модуль будет показывать изменение величины, а угол (аргумент) – изменение угла вектора данной величины.
 =
=  . (3.10)
. (3.10)
Граничная частота – частота, на которой коэффициент передачи тока эмиттера падает в  раз.
раз.
 − зависит от частоты.
− зависит от частоты.
 =
=  ;
;
 =
=  ; (3.11)
; (3.11)
 =
=  ; (3.12)
; (3.12)
 =
=  ; (3.13)
; (3.13)
 =
=  ;
;
 =
=  .
.
 - предельная частота, на которой может работать транзистор.
- предельная частота, на которой может работать транзистор.  = 1.
= 1.
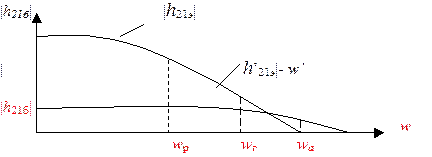 Частотные свойства схемы с ОБ существенно лучше, чем схемы с ОЭ. Это связано с тем, что с увеличением частоты между током эмиттера и током коллектора возникает фазовый сдвиг.
Частотные свойства схемы с ОБ существенно лучше, чем схемы с ОЭ. Это связано с тем, что с увеличением частоты между током эмиттера и током коллектора возникает фазовый сдвиг.
 будет меняться незначительно;
будет меняться незначительно;
 − значительно.
− значительно.
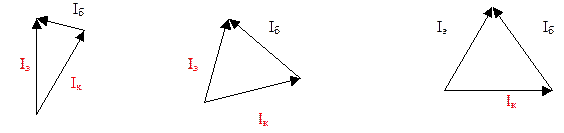
 <
<  <
<  .
.
Наиболее полно частотные свойства транзистора характеризуются максимальной частотой генерации – той частотой, на которой возможна работа транзистора при автоколебаниях.
Коэффициент по мощности больше 1. При дальнейшем увеличении частоты коэффициент усиления меньше 1.
Частота связана с другими параметрами транзистора:
 =
=  , (3.14)
, (3.14)
где  − постоянная цепи коллектора;
− постоянная цепи коллектора;
 − барьерная ёмкость коллекторного перехода;
− барьерная ёмкость коллекторного перехода;
 − граничный коэффициент усиления в схеме ОБ.
− граничный коэффициент усиления в схеме ОБ.
3.8 Работа транзистора на импульс
При работе на импульс транзистор находится в двух устойчивых состояниях:
1) режим отсечки;
2) режим насыщения.
В активной области транзистор находится лишь во время переключения.
Рассмотрим схему с ОБ.
Пусть на эмиттер нашего транзистора мы подаём импульс тока. Вначале положительный, а после выключения – отрицательный.


В момент времени  на эмиттер транзистора подаётся импульс тока. Ток коллектора появляется не сразу, а с некоторой задержкой. Эта задержка объясняется перезарядкой ёмкости эмиттерного перехода, а также временем пролёта носителей через область базы. Начинает формироваться прямой фронт. Происходит накопление носителей в области базы. Концентрация в области базы достигает предельного значения. При этом в цепи устанавливается ток насыщения:
на эмиттер транзистора подаётся импульс тока. Ток коллектора появляется не сразу, а с некоторой задержкой. Эта задержка объясняется перезарядкой ёмкости эмиттерного перехода, а также временем пролёта носителей через область базы. Начинает формироваться прямой фронт. Происходит накопление носителей в области базы. Концентрация в области базы достигает предельного значения. При этом в цепи устанавливается ток насыщения:
 ≈
≈  . (3.15)
. (3.15)
Дальнейшее увеличение количества носителей в базе транзистора приводит к небольшому уменьшению его сопротивления. Чем больше избыточная концентрация неосновных носителей в базе по сравнению с необходимым количеством для насыщения, тем в более насыщенном режиме будет работать транзистор. Это характеризует коэффициент насыщения.
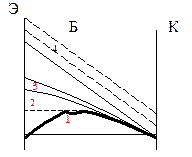 Начиная с 4-го режима, транзистор находится в режиме насыщения.
Начиная с 4-го режима, транзистор находится в режиме насыщения.
В момент времени  на эмиттер транзистора подаётся отрицательный импульс тока. Ток будет вначале в режиме насыщения. Длительность времени
на эмиттер транзистора подаётся отрицательный импульс тока. Ток будет вначале в режиме насыщения. Длительность времени  зависит от накопленных в базе носителей. Скачок тока при переходе от включенного режима определяется падением напряжения на объёмном сопротивлении базы транзистора:
зависит от накопленных в базе носителей. Скачок тока при переходе от включенного режима определяется падением напряжения на объёмном сопротивлении базы транзистора:
 =
=  ; (3.16)
; (3.16)
 ' =
' =  . (3.17)
. (3.17)
После окончания времени рассасывания идёт формирование фронта импульса.

Выходной фронт определяется ёмкостью перехода.
Величины  и
и  можно уменьшить за счёт увеличения соответствующих амплитуд фронта. Время
можно уменьшить за счёт увеличения соответствующих амплитуд фронта. Время  зависит только от степени насыщения транзистора. Контролировать степень насыщения транзистора достаточно сложно.
зависит только от степени насыщения транзистора. Контролировать степень насыщения транзистора достаточно сложно.
Другой способ уменьшения времени рассасывания – создание присадок (создание ловушек). При этом полупроводник легируется золотом.
Включение параллельно к коллекторному переходу диода с малым прямым падением напряжения.

При изготовлении специальных импульсных транзисторов диод Шотки формируется в структуре в процессе производства. Получается транзистор с барьером Шотки.
3.9 Работа на импульс по схеме с ОЭ
 2015-05-12
2015-05-12 692
692








