ВЫПОЛНЕНИЮ ТЕСТОВЫХ ЗАДАНИЙ
Вопросы и задания, содержащиеся в учебном пособии, разработаны в соответствии с рабочей программой дисциплины «Физико-химические основы технологии электронных средств» и опираются на изучаемый лекционный материал и литературу /1-5/. Список которой находится в конце учебного пособия. Вопросы имеют сплошную нумерацию и расположены с последовательностью разделов курса.
Все вопросы задания можно разделить на четыре группы. Структура вопросов и ответов первой группы соответствует известной схеме: каждый сформированный вопрос содержит несколько вариантов ответа, (например, п.1 и п.3 настоящих тестовых заданий). Задача студента – найти правильный вариант, соответствующий постановке вопроса. В следующей группе вопросов (п.2) из всех вариантов ответа надо выбрать все правильные. В еще одном варианте заданий в одном вопросе содержится несколько вопросов (например п.14). В этом случае цифрам (буквам) вопроса следует поставить в соответствие буквы (цифры) ответа.
Последняя группа заданий – это вопросы с рисунками и схемами. Например, в заданиях об устройстве установок (п.17, рис. 4; п. 34, рис.6 и т.д.) необходимо цифры (буквы) на схеме привести в соответствие с буквами (цифрами) ответов. В задании п.13, рис.2 – цифры вопроса – с буквами под рисунками, в п.31, рис.5 – цифры на рисунке – с буквами ответов, в п.123, рис 12 – римские и арабские цифры на схеме – с буквами ответов.
Необходимо стараться отвечать на вопросы самостоятельно, обращаясь к конспекту лекций и рекомендованной литературе.
КОНТРОЛЬНЫЕ ВОПРОСЫ
1. Какие технологические процессы используют в микро- и нанотехнологиях электроники?
а) физические;
б) химические;
в) физико-химические.
2. Какие основные технологические операции при производстве изделий микро- и наноэлектроники вы знаете?
а) диффузия;
б) ионная имплантация;
в) полимеризация;
г) травление;
д) вытяжка;
е) получение тонких плёнок;
ж) литография;
з) вулканизация;
и) эпитаксия.
3. Легирование – это:
а) очистка поверхности;
б) введение примесей;
в) получение тонких пленок;
г) травление.
4. Диффузия – это:
б) движение ускоренных электрическим полем ионов;
в) обусловленное тепловым движением перемещение частиц в направлении убывания их концентрации;
г) движение электронов.
5. В каких веществах при одинаковой температуре скорость диффузии больше?
а) в твердых;
б) в жидких;
в) в газообразных.
6. Какие механизмы диффузии в твердых телах Вы знаете?

Рис. 1
а) обменный;
б) по междоузлиям;
в) по вакансиям.
7. Какой механизм диффузии более быстрый?
а) по вакансиям;
б) по междоузлиям;
в) другое.
8. Первый закон Фика в одномерном случае имеет вид и определяет соответственно:
а) J(x) = -D · ¶N/¶x; скорость диффузии атомов одного вещества в другое при постоянном во времени их потоке и неизменном градиенте концентрации;
б) ¶N / ¶t = D · ¶2N / ¶x2; скорость накопления растворенной примеси в любой плоскости перпендикулярна направлению диффузии;
в) D = D0 exp (-DE / kT); коэффициент диффузии D экспоненциально зависит от температуры; где J(x) – плотность потока атомов; ¶N / ¶x – градиент концентрации диффундирующей примеси; ¶N / ¶t – изменение концентрации во времени; D0 – постоянная; DE – энергия активации диффузии; К – постоянная Больцмана.
9. Второй закон Фика в одномерном случае имеет вид и определяет соответственно:
а) J(x) = -D · ¶N/¶x; скорость диффузии атомов одного вещества в другое при постоянном во времени их потоке и неизменном градиенте концентрации;
б) ¶N / ¶t = D · ¶2N / ¶x2; скорость накопления растворенной примеси в любой плоскости перпендикулярна направлению диффузии;
в) D = D0 exp (-DE / kT); коэффициент диффузии D экспоненциально зависит от температуры; где J(x) – плотность потока атомов; ¶N / ¶x – градиент концентрации диффундирующей примеси; ¶N / ¶t – изменение концентрации во времени; D0 – постоянная; DE – энергия активации диффузии; К – постоянная Больцмана.
10. Уравнение Аррениуса:
а) D = 1/3  l, где
l, где  - средняя скорость беспорядочного движения молекул; l – длина свободного пробега;
- средняя скорость беспорядочного движения молекул; l – длина свободного пробега;
б) D = D0 exp (-DE / kT); коэффициент диффузии D экспоненциально зависит от температуры;
в) ¶N / ¶t = D · ¶2N / ¶x2; скорость накопления растворенной примеси в любой плоскости перпендикулярна направлению диффузии.
11. Что понимают под бесконечным (постоянным) источником примеси?
а) состояние системы, когда поток атомов примеси через поверхность пластины (х=0) отсутствует в любое время;
б) когда количество примеси, уходящей из поверхностного слоя пластины в ее объем, равно количеству примеси, поступающей в поверхностный слой;
в) когда поток атомов примеси Q возрастает с течением времени.
12. Что понимают под конечным (ограниченным) источником?
а) когда поток атомов примеси Q через поверхность пластины все время убывает;
б) состояние системы, когда поток атомов примеси через поверхность пластины (х=0) отсутствует в любое время;
в) когда поток атомов примеси Q возрастает с течением времени.
13. Привести графики распределения концентрации из конечного (1) и бесконечного (2) источников:

а б
Рис. 2
14. Что такое «загонка» (1) и «разгонка» (2)?
а) диффузия из конечного источника;
б) диффузия из бесконечного источника;
в) процесс, при котором ионы примеси «разгоняются» электрическим полем;
г) процесс, граничные условия которого N ( , t) = N0 при t>0.
, t) = N0 при t>0.
15. Укажите начальные и граничные условия (1), решения второго уравнения Фика (2), модели (3) для «загонки» и аналогичные данные (1΄, 2΄, 3΄) для «разгонки».
 а а |  б б |  В В |
 |  д д |  е е |
 г г |
Рис. 3
16. Какова температура проведения диффузии и достаточная точность ее поддержания соответственно при производстве ИМС?
а) 1000-1350 ˚С; ±0,25 ˚С;
б) 400-500 ˚С; ±10 ˚С;
в) 1500-2000 ˚С; ±1 ˚С;
г) 100-200 ˚С; ±1 ˚С.
17. Приведите схемы однозонной (1) и двухзонной (2) установок для диффузии и укажите их основные элементы.
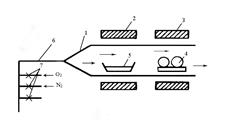
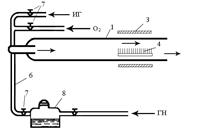
I II
Рис. 4
а) кварцевая труба;
б) высокотемпературная печь;
в) низкотемпературная печь;
г) магистраль;
д) источник примеси;
е) краны;
ж) пластины;
з) источник жидкой примеси.
18. Ионная имплантация – это:
а) стравливание поверхности подложки пучком высокоэнергетических ионов;
б) внедрение ионов примесей в поверхностный слой полупроводниковой пластины;
в) упорядочение структуры подложки пучком ионов низких энергий и малой массы;
г) напыление;
19. При проведении ионной имплантации (И. И.):
а) образуются дефекты кристаллической решетки подложки;
б) «залечиваются» дефекты кристаллической решетки подложки;
в) не образуются дефекты кристаллической решетки подложки;
г) образуются, а потом залечиваются дефекты кристаллической решетки подложки.
20. Требуется ли отжиг пластин после проведения И. И.? Если «да», то при какой температуре
а) «да»; 600-800 ˚С;
б) «нет»;
в) «да»; 200-300 ˚С;
г) «да; 1200-1500 ˚С.
21. При каких энергиях ионов преобладает И.И. (1), а при каких распыление поверхностного слоя (2)?
а) 102 - 103 эВ;
б) 10 - 102 эВ;
в) 103 - 105 эВ;
г) 105 - 107 эВ.
22. Какие механизмы энергетических потерь ионов в твердом теле Вы знаете?
а) ядерные (упругие);
б) ядерные (неупругие);
в) ионные (упругие);
г) электронные (упругие);
д) электронные (неупругие).
23. Какие столкновения вызывают максимальное дефектообразование?
а) ядерные (упругие);
б) ядерные (неупругие);
в) ионные (упругие);
г) электронные (упругие);
д) электронные (неупругие).
24. При каких характеристиках падающих ионов преобладает ядерное (1), а при каких электронное (2) торможение?
а) малые энергии и большие атомные номера;
б) большие энергии и малые атомные номера;
в) большие энергии и большие атомные номера;
г) малые энергии и малые атомные номера.
25. Эффективность И. И. определяется следующими факторами:
а) распределение проекций внедренных ионов на направление ионной имплантации Rx;
б) степень и характер разупорядочения решетки;
в) физические свойства подложки;
г) локализация атомов в кристаллической решетке;
д) электрические свойства слоев после отжига;
е) температура подложки.
26. Rx зависит от следующих параметров:
а) степень и характер разупорядочения решетки; физические свойства подложки; локализация атомов в кристаллической решетке; электрические свойства слоев после отжига; температура подложки.
б) энергия и порядковый номер легирующего вещества;
в) порядковый номер материала подложки;
д) каналирование.
27. Каналирование – это:
а) движение ионов в монокристаллах строго по центру одного из кристаллографических направлений с малыми индексами;
б) преимущественное направление движения ионов в произвольно расположенном кристалле;
в) движение ионов в монокристаллах вдоль одного из открытых направлений в решетке – по кристаллографическим осям или по атомным плоскостям.
28. Что такое критический угол каналирования?
а) максимальный угол, при котором возникает эффект каналирования;
б) максимальный угол, при котором исчезает направляющее действие атомов мишени;
в) угол, при котором канал покидают 50% ионов.
29. Что называется дозой облучения?
а) поток ионов, проходящих через единичную площадку мишени в единицу времени;
б) число ионов примеси, внедренных в единицу объема за единицу времени;
в) концентрация дефектов подложки, вызванных имплантированными ионами в единицу времени.
30. Распределение концентрации внедряемых примесей зависит от:
а) энергии ионов;
б) дозы облучения;
в) взаимной ориентации пучка ионов и монокристаллической мишени;
г) режимов отжига;
д) свойств мишени.
31. Объясните схему образования реального профиля концентрации примесей в твердом теле.
 |  |
Рис. 5
а) профиль для неканалированных ионов;
б) реальное распределение;
в) профиль деканалированных ионов;
г) деканалированные ионы;
д) профиль для монокристалла;
е) остаток каналированного пучка;
ж) профиль для идеально каналированных ионов.
32. Доза аморфизации – это:
а) доза имплантации, при которой концентрация дефектов равна концентрации внедренных ионов;
б) отношение площадей аморфной и кристаллической областей;
в) доза имплантации, при которой образуется сплошной аморфный слой.
33. Какой вид отжига является более удачным решением и наиболее широко распространен?
а) отжиг всей пластины;
б) импульсный электронный отжиг;
в) импульсный ИК-отжиг;
г) импульсный лазерный отжиг.
34. Объясните схему установки ионного легирования, представленную на рис. 6.

Рис. 6
а) источник ионов;
б) фокусирующая линза;
в) вытягивающий электрод;
г) пластины коррекции;
д) пластины электромагнитного сканирования;
е) секционный ускоритель;
ж) диафрагмы;
з) облучаемые пластины;
и) электромагнитный сепаратор;
к) подложкодержатель.
35. Достоинства (1) и недостатки (2) метода И. И. по сравнению с диффузией:
а) возможность точного контроля количества имплантируемой примеси, так как измерение падающего потока ионов выполняется с такой же погрешностью, как и измерение тока;
б) отсутствие зависимости предельной концентрации вводимой примеси от предела растворимости в материале подложки;
в) высокая точность и воспроизводимость параметров имплантации (доза, профиль) по площади обрабатываемой пластины и от процесса к процессу;
г) возможность регулирования профиля легирующей примеси по глубине изменением энергии, тока и положения ионного пучка. При этом градиент концентрации примеси в области p-n-перехода существенно больше, чем у диффузионного профиля;
д) осуществление процесса при относительно низких температурах (870 – 1050 К для отжига), что позволяет сохранять заданный профиль распределения концентрации примесей в структурах и их электрофизические параметры;
е) возможность легирования любыми примесями, которые не растворяются и не могут диффундировать в данном материале;
ж) возможность легирования через тонкие пассивирующие слои (например SiO2, Si3N4), создание скрытых p-n-переходов и изолирующих слоев;
з) большой выбор исходных материалов, меньшие требования к их чистоте, высокая изотопная чистота имплантируемых ионов, сепарированных в магнитном поле;
и) проведение процесса в вакууме, что исключает загрязнение образцов нежелательными примесями;
к) возможность осуществления на одной установке комплекса операций, включая легирование, металлизацию и защиту поверхности;
л) незначительное боковое рассеяние, что позволяет изготовлять быстродействующие приборы с очень малыми размерами;
м) сложность технологических установок;
н) внедрение тяжелых частиц ведет к образованию дефектов, для устранения которых необходим термический отжиг;
о) дополнительные эффекты, появляющиеся в процессе и после ионной имплантации (например каналирование, диффузия на стадии отжига радиационных дефектов), затрудняют контроль профиля.
36. Какими свойствами обладают слои оксида SiO2 и нитрида Si3N4 кремния?
а) маскирующими;
б) полупроводниковыми;
в) диэлектрическими;
г) защитными;
д) экранирующими;
е) термоизолирующими.
37. В конструкциях ИМС слои SiO2 и Si3N4 используют для:
а) изоляции элементов;
б) в качестве диэлектрика в МДП-транзисторах и конденсаторах;
в) в качестве межэлементных соединений;
г) изготовления контактных площадок;
д) защиты кристаллов;
е) создания маски для локальной обработки пластин.
38. Какие требования предъявляются к пленкам SiO2 и Si3N4 при использовании в качестве масок (1), изолятора (2), подзатворного диэлектрика в МДП-ИМС (3)?
а) селективность по отношению к растворам, облучение газам и т.п.
б) отсутствие пор и трещин;
в) равномерность толщины, структуры, свойств;
г) хорошая адгезия;
е) tgδ, ε и их стабильность;
ж) особо высокая чистота и совершенство структуры;
з) полное отсутствие пор, трещин, сколов и т.п.
39. Какие методы получения слоёв SiO2 и Si3N4 применяют в планарной технологии?
а) термическое окисление кремния;
б) прямое азотирование кремния;
в) эпитаксия;
г) пиролиз иланов;
д) анодное окисление в растворах электролита;
е) термовакуумное напыление;
ж) окисление в тлеющем разряде;
з) химические реакции переноса;
и) катодное распыление кремния;
к) УФ-облучение.
40. С помощью каких реакций получают анодный диоксид (1), термический диоксид в сухом (2) и влажном (3) кислороде?
а) Si + O2 = SiO2;
б) Si + 2H2O = SiO2 + 2H2;
в) Si + O2- + p+ = SiO2, где р+ - положительный заряд от внешнего источника;
600-800°C
г) Si(OC2H5)4 → SiO2 + R, где R – С2H5, CH3 и др.
41. При каких температурах проводят термическое окисление кремния?
а) 200 – 400 °C;
б) 600 – 800 °C;
в) 850 – 1300 °C.
42. В чем разница между сухим (1) и влажным (2) окислением кремния?
а) скорость роста плёнки SiO2 выше, свойства лучше;
б) скорость роста плёнки SiO2 выше, свойства хуже;
в) скорость роста плёнки SiO2 ниже, свойства хуже;
г) скорость роста плёнки SiO2 ниже, свойства лучше.
43. Возможно ли сочетание обоих методов? Если «да», то какой процесс проводят первым?
а) «да», влажный;
б) «нет»;
в) «да», сухой.
44. Объясните схему установки термического окисления кремния, представленной на рис.7.
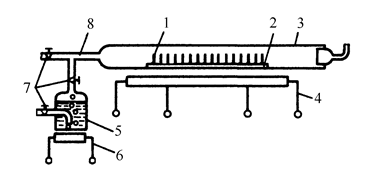
Рис. 7.
а) пластины кремния;
б) кварцевая лодочка;
в) труба из оргстекла;
г) нагреватель;
д) барботер;
е) кварцевая труба;
ж) краны;
з) магистраль;
и) вольфрамовый держатель пластины.
45. Достоинства (1) и недостатки (2) метода термического окисления:
а) технологичность получения;
б) совершенство по структуре;
в) высокое значение Ɛ;
г) сочетание с диффузией;
е) получение только SiO2;
ж) затруднение только при получении прецизионных структур.
46. Что такое силан (1), этоксисилан (2), тетроэтоксисилан (3)?
а) Si(OC2H5)4;
б) SiH4;
в) продукт замещения в SiH4 (или SiCl4) водорода (или хлора) на группу CH3;
г) продукт замещения в SiH4 (или SiCl4) водорода (или хлора) на группу ОC2H5.
47. Реакция пиролиза тетроэтоксисилана следующая:
200-300°C
а) Si(OC2H5)4 → SiO2 + R; где R – CH3;
600-800°C
б) SiH4 → Si↓ + 2H2↑;
600-800°C
в) Si(OC2H5)4 → SiO2 + R; где R – CH5, CH3.
48. В чем заключается сущность вакуумного (I) пиролиза и пиролиза в потоке газа-носителя (II)? В чём их достоинства (1) и недостатки (2)?
а) газ – носитель, проходя через барботер, захватывает пары силана и поступает в камеру;
б) камера откачивается, а пары силана в контролируемый остаточной атмосфере подаются в систему через натекатель;
в) получение наиболее совершенных слоёв;
г) критичность к скорости газа, конструкции держателей пластин и всей системы;
д) зона ламинарного течения силана и газа-носителя меньше зоны постоянной температуры в реакторе;
е) пары силана равномерно распределяются по объёму реактора и дают равномерное охлаждение в зоне с постоянной температурой;
ж) уровень загрязнения снижается до 1015 – 1016 ат/см3;
з) усложнение и удорожание процесса из-за добавления вакуумной системы.
49. Преимущества пиролиза силанов по сравнению с термическим окислением:
а) простота оборудования и доступность материалов;
б) более низкая температура;
в) более высокая температура;
г) универсальность – получение плёнок разных материалов;
д) низкая себестоимость;
е) большая скорость реакции пиролиза;
ж) лучшие электрофизические параметры слоёв.
50. Пути дальнейшего совершенствования методов получения защитных слоёв следующие:
а) освоение материалов, обладающих лучшими по сравнения с SiO2 свойствами;
б) применение более дорогих материалов и оборудования;
в) замена процесса образования слоёв за счёт материала пластины процессами охсаждения;
г) снижение температуры процессов;
д) повышение температуры процессов.
51. Применяется ли метод прямого азотирования для получения слоёв Si3N4? Если «да», то по каким реакциям и при каких условиях?
800°C
а) «да»; 3Si + 2N2 → Si3N4;
б) «нет»;
1000- 1200°C
в) «да»; 3SiН4 + 4NH3 → SiN4 + 12H2;
1300°C
г) «да»; 3Si + 2N2 → SiN4 в присутствии катализатора.
52. Газофазные реакции для получения слоёв Si3N4 следующие:
а) 3SiH4 + 4NH3 → Si3N4 + 12H2;
б) 3SiГ4 + 4NH3 → Si3N4 + 12HГ; где Г – галогены (Cl, Br, I);
в) 3Si(OC2H5)4 + 4NH3 → Si3N4 + 12(C2H5) + 2O2.
53. При каких температурах, протекают реакции п. 209?
а) 800°C;
б) 1000 - 1200°C;
в) 1300 – 1500 °C.
54. Какой структурой (1) и свойствами (2) обладают слои, выращенные по реакциям п. 209 при температурах п. 210?
а) аморфной;
б) монокристаллической;
в) поликристаллической;
г) прозрачны;
д) высокая плотность;
е) хорошая теплопроводность;
ж) хорошая маскирующая способность.
55. Какими преимуществами по сравнению со слоями SiO2 обладают слои Si3N4?
а) высокая плотность;
б) низкая плотность;
в) высокая термостойкость;
г) хорошая тепло- и электропроводность;
д) лучшие маскирующие свойства при бόльших толщинах;
е) лучшие маскирующие и защитные свойства при меньших толщинах (менее 0,2 мкм);
ж) меньшие размеры элементов;
з) более высокая скорость получения при более низких температурах;
и) более высокая электрическая прочность и ε.
56. Используются ли в технологии МДП-ИМС двухслойные структуры SiO2 - Si3N4? Если «да», то как в таких случая называются ИМС?
а) «да»; МОП (металл-оксид-полупроводник);
б) «нет»;
в) «да» МДНП (металл-диоксид-нитрид-полупроводник);
г) «да» МКОП (металл-комбинированный оксид-полупроводник);
д) «да» МНОП (металл-нитрид-оксид-полупроводник).
57. Какие другие диэлектрики применяются в технологии ИМС?
а) Al2О3;
б) TiO2;
в) Fe2O3;
г) Ta2O5;
д) ZrO2;
е) (nAl2O3 · mSiO2);
ж) (nAl2O3 · mSi3N4).
58. Какой процесс называют эпитаксией?
а) рост кристалла из расплава;
б) получение тонких пленок методом ионно-плазменного напыления;
в) ориентированный рост поверхности монокристалла;
г) получение тонких пленок методом магнетронного распыления.
59. Какие основные технологические методы эпитаксии используют применительно к технологии ИМС?
а) газофазные реакции;
б) термовакуумное напыление;
в) вакуумное осаждение;
г) термическое окисление;
д) кристаллизация из жидкой фазы.
60. Есть ли отличия эпитаксиального выращивания от роста кристаллов из раствора или расплава? Если есть, то какие?
а) нет;
б) есть; пленки должны быть монокристаллическими;
в) есть; пленки должны быть поликристаллическими;
г) есть; пленки должны быть аморфными.
61. Чему равна скорость эпитаксии из газовой фазы? Сравните скорости этого процесса с эпитаксией из раствора и чистого расплава.
а) несколько см/сут; рост из газовой фазы быстрее, чем из раствора, но медленнее чем из расплава;
б) несколько см/час; рост из газовой фазы быстрее чем раствора и расплава;
в) несколько мм/сут; рост из газовой фазы медленнее чем из раствора и расплава.
62. Основные этапы выращивания монокристалла:
а) формирование пучка ионов;
б) перенос паров к поверхности подложки (затравки);
в) кристаллизация и рост новых слоев на подложке;
г) рекристаллизация;
д) рассеяние скрытой теплоты кристаллизации и теплоты реакции.
63. Какие процессы называют автоэпитаксиальными (1) и гетероэпитаксиальными (2)?
а)растущая пленка состоит из одного вещества;
б) последующий слой повторяет дефекты предыдущего;
в) последующий слой «залечивает» дефекты предыдущего;
г) пленка состоит из разных веществ;
д) пленка состоит из слоев с разной структурой.
64. Какая эпитаксия называется прямой (1), какая обратной (2)?
а) удельное сопротивление слоя ρs равно удельному сопротивлению подложки ρv;
б) ρs > ρv;
в) ρs < ρv;
г) ρs >> ρv;
д) ρs << ρv.
65. В прямых методах эпитаксии частицы ПП переносятся от источника к подложке без промежуточных реакции путем:
а) испарения из жидкой фазы;
б) под действием ускоряющего напряжения;
в) сублимации;
г) реактивного распыления;
д) магнетронного распыления.
66. В косвенных методах слои ПП выращивают:
а) с помощью реакции окисления;
б) сублимации;
в) разложением паров ПП соединений.
67. Хлоридный метод получения эпитаксиальных слоев основан на:
а) одностадийной реакции SiCl4+2Н2→2Si↓+4HCl↑;
б) двухстадийной реакции
SiCl4+Н2↔SiCl2+2HCl;
2SiCl2↔Si+SiCl4;
в) двухстадийной необратимой реакции
SiCl4+Н2→SiCl2+2HCl;
2SiCl2→Si+SiCl4.
68. Какими способами осуществляется легирование при эпитаксии?
а) из твердой фазы, испаряя пятиокись фосфора Р2О5 , элементарный фосфор, оксид бора В2О5;
б) из раствора, добавляя к жидкому SiCl4 летучие примесные соединения PCl3 или BCl3;
в) введением отдельным газовым потоком фосфина PH3 или диборана B2H6, разбавленным водородом.
69. От каких факторов зависят скорость роста и качество слоев при хлоридном методе?
а) температура;
б) ориентация подложек;
в) величина ускоряющего напряжения;
г) соотношение SiCl4 и Н2;
д) скорость потока водорода;
е) наличие катализатора;
ж) аэродинамические факторы.
70. Чему равна скорость роста слоя в зависимости от температуры?
а) 0,1 мкм/мин при 1100 ˚С;
б) 0,2 мкм/мин при 1200 ˚С;
в) 1 мкм/мин при 800 ˚С;
г) 5 мкм/мин при 1350 ˚С.
71. Объясните схему установки для эпитаксии кремния с горизонтальным реактором:
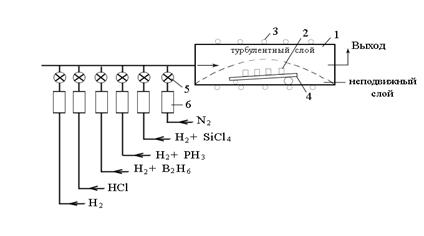
Рис. 8
а) кварцевая труба;
б) кремневые пластины;
в) труба из нержавеющей стали;
г) газовый нагреватель;
д) графитовая лодочка;
е) вентили;
ж) ВЧ-нагреватель;
з) платиновый держатель пластин;
и) ротаметры.
72. Какая температура поддерживается в реакционной камере?
а) 800-1000 ˚С;
б) 1000-1150 ˚С;
в) 1150-1300 ˚С.
73. Каким образом уменьшают влияние аэродинамических факторов?
а) размещают держатель пластин под углом к направлению потока газов;
б) уменьшают скорость потока;
в) применяют вертикальные реакторы;
г) создают встречный поток;
д) уменьшают температуру.
74. Какими методами осуществляется гетероэпитаксия кремния на сапфире (КНС)?
а) хлоридный метод;
б) реактивное распыление;
в) катодное распыление;
г) пиролиз моносилана.
75. Разложение силана на поверхности подложки происходит в соответствии с реакцией:
800 ˚С
а) SiН4 → Si↓+2H2↑;
1100 ˚С
б) SiН4 → Si↓+2H2↑;
700 ˚С
в) Si(ОС2Н3)4 → SiО2+R, где R – С2Н5, СН3 и др.;
1300 ˚С
г) SiН4 ↔ Si+2H2.
76. В чем достоинства (1) и недостатки (2) силанового метода по сравнению с хроридным?
а) более совершенная структура и лучшие свойства;
б) чувствительность к качеству поверхности подложки;
в) чувствительность к присутствию следов окислителя;
г) неэпитаксиальное осаждение частиц кремния.
77. Возможно ли сочетание обоих методов, если «да», то что это дает?
а) «нет»;
б) «да», снижение температуры процесса;
в) «да», повышение температуры процесса;
г) ускорение процесса;
д) уменьшение толщины переходного слоя.
78. В чем заключается метод вакуумного осаждения?
а) в осаждении испаренных элементарных компонентов в сверхвысоком вакууме (10-8-10-9 Па) при температуре подложки 500-700 ˚С;
б) в осаждении испаренных элементарных компонентов в сверхвысоком вакууме (10-8-10-9 Па) при температуре подложки 1000-1300 ˚С;
в) в осаждении испаренных элементарных компонентов в сверхвысоком вакууме (10-8-10-9 Па) в инертной среде при комнатной температуре;
г) обычное термовакуумное напыление в вакууме 10-3-10-4 Па.
79. Каковы достоинства (1) и недостатки (2) вакуумной эпитаксии:
а) высокая чистота реактора и подложки;
б) низкая температура процесса;
в) малая скорость роста;
г) чистые и очень тонкие пленки.
80. Чему равна скорость роста пленок при вакуумной эпитаксии?
а) 1 мкм/час или 1 монослой/с;
б) 10 мкм/час; 10 монослоев/с;
в) 100 мкм/час; 100 монослоев/с.
81. Объясните схему вакуумной эпитаксии:

Рис. 9
а) монокристаллическая подложка;
б) анод;
в) катоды;
г) затворы;
д) аморфная подложка;
е) молекулярные пучки;
ж) источники-нагреватели;
д) ионные пучки.
82. Как осуществляется легирование при вакуумной эпитаксии?
а) добавлением твердой примеси в тигли, являющиеся источниками одного из составных элементов;
б) добавлением газообразной примеси в реактор;
в) испарением примеси из отдельного испарителя.
83. Жидкостная эпитаксия-это:
а) кристаллизация эпитаксиального слоя из раствора;
б) кристаллизация легкоплавкого расплава;
в) кристаллизация тугоплавкого расплава.
84. Каким образом вводятся легирующие примеси при жидкостной эпитаксии?
а) при составлении исходного расплава;
б) из отдельных испарителей;
в) из источников жидких примесей;
г) из газовой фазы.
85. Объясните схему жидкостной эпитаксии:
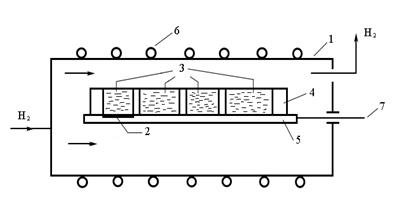
Рис. 10
а) кварцевая труба;
б) источники примесей;
в) подложка;
г) различные расплавы;
д) металлический корпус реактора;
е) нагреватель;
ж) графитовый скользящий держатель расплава;
з) платиновый скользящий держатель расплава;
и) основной графитовый держатель;
к) толкатель.
86. Преимущества эпитаксии в технологии ПП ИМС:
а) возможность получения аморфных слоев;
б) получение монокристаллических слоев с заданной ориентацией кристаллических осей;
в) получение структур с лучшими чем при диффузии характеристиками;
г) лишь одна стадия диффузии при получении четырехслойных структур в ИМС;
д) лишь две стадии диффузии при получении четырехслойных структур в ИМС;
е) сокращение длительности операций;
ж) более низкие по сравнению с диффузией температуры.
87. Что такое травление (1)? Для каких целей этот процесс используется в технологии ИМС (2)?
а) процесс очистки;
б) процесс удаления примесей;
в) процесс удаления приповерхностного слоя пластины;
г) для вытравливания заданного профиля;
д) для селективной обработки с целью выявления структуры;
е) для получения поликристаллического слоя.
88. Как классифицируются методы травления по механизму (1) и применяемым средствам (2)?
а) физические;
б) химические;
в) физико-химические;
г) технологические;
д) жидкостные;
е) тепловые;
ж) сухие;
з) лазерные.
89. На чем основаны физические (1) и химические (2) методы?
а) на механических воздействиях;
б) на облучении ИК-излучением;
в) на распылении поверхности высокоэнергетическими ионами;
г) на термообработке;
д) на протекании поверхностных химических реакций;
е) на реакциях полимеризации.
90. Жидкостное травление-это:
а) очистка поверхности растворителями;
б) растворение поверхности щелочами, кислотами, их смесями и солями.
91. Из каких стадий состоит процесс химического травления?
а) диффузия реагента к поверхности;
б) движение ионов под воздействием электрического поля;
в) адсорбция реагента;
г) десорбция реагента;
д) поверхностной химической реакции;
е) реакции окисления;
ж) десорбции продуктов реакции;
з) диффузия продуктов реакции от поверхности.
92. Какая стадия процесса называется контролирующей?
а) первая;
б) последняя;
в) которую тщательно контролируют;
г) самая медленная, определяющая скорость процесса.
93. Какие травители называют полирующими?
а) которые применяются для полировки;
б) у которых контролирующей стадией является диффузия;
в) щелочи.
94. В полирующих травителях:
а) скорость травления нечувствительна к неоднородностям поверхности;
б) слабо зависит от температуры;
в) сильно зависит от температуры;
г) выступы травятся быстрее впадин;
д) выступы и впадины травятся одинаково;
е) хорошо сглаживаются шероховатости.
95. Согласно химической теории полирующее травление протекает по реакциям:
а) Si + 4HNO3 → SiO2 + 4NO2 + 2H2O;
б) Si + 4HNO3 → SiO2 + 4NO2 + 2H2O;
SiO2 + 4HF → SiF4 + 2H2O;
в) 3Si + 4HNO3 + 18HF → 3H2SiF6 + 4NO + 8H2O.
96. Согласно электрохимической теории полирующее травление протекает по реакциям:
а) Si + 4HNO3 → SiO2 + 4NO2 + 2H2O;
б) Si + 4HNO3 → SiO2 + 4NO2 + 2H2O;
SiO2 + 4HF → SiF4 + 2H2O;
в) 3Si + 4HNO3 + 18HF → 3H2SiF6 + 4NO + 8H2O.
97. Какие травители называются селективными:
а) кислоты;
б) водные растворы щелочей;
в) которые травят не все вещества;
г) у которых контролирующей стадией является химическая реакция.
д) у которых скорость травления различна для разных кристаллографических направлений.
98. Какое травление называют анизотропным:
а) травление поликристаллов;
б) когда скорость травления различна для разных кристаллографических направлений;
в) травление в смеси HNO3 и HF.
99. На каких реакциях основана электрополировка?
а) Si + 4HNO3 → SiO2 + 4NO2 + 2H2O;
SiO2 + 4HF → SiF4 + 2H2O;
б) 3Si + 4HNO3 + 18HF → 3H2SiF6 + 4NO + 8H2O;
в) nSi + 2nHF → (SiF2)n + 2nH+ - 2ne-;
(SiF2)n + 2nH2O → nSiO2 + 2nHF↑ + nH2↑;
SiO2 + 6HF → Н2SiF4 + 2H2O.
100. Какие способы жидкостного травления наиболее распространены в промышленности?
а) ультразвуковое травление;
б) инфразвуковое травление;
в) химико-динамическое травление;
г) анодно-химическое травление;
д) анодно-механическое травление;
е) кавитационное травление;
ж) ионное травление.
101. Какие проблемы жидкостного травления Вы знаете?
а) низкая скорость;
в) потеря адгезии пленок;
г) боковое подтравливание;
д) высокая стоимость;
е) силы поверхностного натяжения;
ж) травление структур субмикронных размеров.
102. Какие существуют методы сухого травления:
а) газовое;
б) ультразвуковое;
в) ультрафиолетовое;
г) ионное;
д) плазмохимическое.
103. Какие травители используют при газовом травлении?
а) газообразные галогены, галогеноводороды (HBr, HCl);
б) смеси водорода или гелия с галогенами, галогеноводородами, сероводородом, гексафторидом серы;
в) соляная кислота.
104. Укажите реакции травления кремния хлористым водородом (1), тетрахлоридом кремния (2), хлором (3), сероводородом (4), гексафторидом серы (5):
1000 ˚С
а) Si (тв) + Cl (газ) → SiCl2↑ (газ);
б) Si (тв) + SiCl4 (газ) ↔ SiCl2↑ (газ);
в) Si (тв) + 2H2S (газ) → SiS2 (тв) + 2H2 (газ);
SiS2 (тв) + Si (тв) → 2SiS (газ)
г) 4Si (тв) + 2SF6 (газ) → SiS2 (тв или жидк) + 3SiF4 (газ);
1150-1250˚С
д) Si (тв) + 4HCl (газ)→ SiCl4↑ (газ) + 2H2 (газ).
105. Как зависит скорость травления кремния от температуры и концентрации HCl в водороде?
а) возрастает при увеличении обоих параметров;
б) убывает при увеличении обоих параметров;
в) возрастает при увеличении температуры и почти не зависит от концентрации.
106. В чем специфика травления в парах сероводорода (1) и гексафторида серы (2)?
а) токсичен;
б) не токсичен;
в) большая скорость;
г) высокая температура процесса;
д) травление сапфира;
е) травление алмаза.
107. Достоинства (1) и недостатки (2) метода газового травления по сравнению с жидкостным:
а) более чистые поверхности;
б) низкая температура;
г) совместимость с термическими операциями;
д) реагенты особой чистоты;
е) возможность травления субмикронных структур.
108. В чем состоит метод ионного травления?
а) во внедрении ионов с энергиями 103 эВ в приповерхностный слой вещества;
б) в удалении поверхностного слоя при его бомбардировке ионами инертных газов высокой энергии;
в) в удалении поверхностного слоя при его бомбардировке ионами О2 с энергией 105эВ.
109. Что такое коэффициент распыления Кр?
а) отношение массы распыленного вещества к массе до облучения;
б) количество распыленных атомов на каждый падающий ион;
в) количество атомов, покидающих поверхность за секунду, под действием пучка ионов с энергией 105эВ.
110. Чему равна скорость ионного травления?
а) Vтр= 
б) Vтр= 6,25 × 1025 
в) Vтр= 6,25 × 1025  cos Q, где t – время; Iи – плотность ионного потока; А – атомный вес материала; ρ – плотность; NA – число Авогадро; Q – угол падения ионов.
cos Q, где t – время; Iи – плотность ионного потока; А – атомный вес материала; ρ – плотность; NA – число Авогадро; Q – угол падения ионов.
111. Какие разновидности ионного травления Вы знаете?
а) ионно-плазменное;
б) ионная имплантация;
в) ионно-лучевое;
г) ионно-магнетронное;
д) ионно-химическое (реактивное);
е) плазмохимическое.
112. На чем основаны методы из п. 268?
1. Травление происходит в плазме газового р-ряда между анодом и катодом при давлении инертного раза 10,3 ×10-2 – 6,67 Па;
2. Травление происходит вне плазмы газового ряда лучом ионов, сформированным с помощью магнитного и электрического полей;
3. Основано на введении в плазму химически активных газов – кислорода и водорода.
113. Чему равна скорость ионно-плазменного травления?
а) для кремния 1 мкм/мин;
б) для кремния 0,5 мкм/мин; для диэлектриков 0,3 мкм/мин;
в) для кремния 0,2 мкм/мин: для диэлектриков 0,1 мкм/мин; для металлов 0,3 мкм/мин.
114. Достоинства (1) и недостатки (2) методов ионного травления:
а) не нужен вакуум;
б) безинерционность;
в) травление локальных участков;
г) травление любых металлов;
д) травление любых металлов (кроме тугоплавких);
е) невысокая температура (100-200 ˚С);
ж) невысокая температура (400-500 ˚С);
з) травление многослойных структур;
и) травление сапфира;
к) высокая разрешающая способность;
л) низкая селективность.
115. На чем основано плазмохимическое травление?
а) основано на введении в плазму химически активных газов – кислорода и водорода;
б) на разрушении поверхностного слоя ионами активных газов (водорода и азота), образовавшихся в плазме газового разряда и вступающих в реакцию с материалом подложки;
в) на разрушении поверхностного слоя ионами активных газов (фтора, хлора, кислорода), образовавшихся в плазме газового разряда и вступающих в реакцию с материалом подложки.
116. Какую плазму используют для травления кремния и его соединений (1), металлов (2), органических материалов (3)?
а) тетрафторида углерода CF4;
б) гексафторид серы SF6;
в) фреон-12 CF2Cl2;
г) CF4 + O2;
д) HCl;
е) О2.
117. От чего зависит скорость плазмохимического травления?
а) от скорости химической реакции;
б) от концентрации активных ионов;
в) от частоты переменного напряжения;
г) от степени высокого вакуума;
д) от температуры;
е) от свойств материала подложки;
ж) от состава плазмы.
118. Объясните схемы конструкций реакторов для плазменного травления: с перфорированным цилиндром (I), планарная (II), для реактивного травления (III) (рис.11):
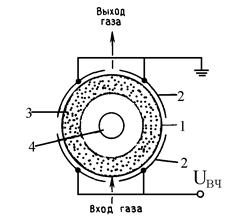 | |
| I | |
 | |
| II | |
 | |
| III |
Рис. 11
а) кварцевая труба;
б) камера;
в) электроды;
г) подложки;
д) нагреватель;
е) плазма;
ж) молекулы инертного газа.
119. Какой процесс называют литографией?
а) вариант сеткографии;
б) создание защитной маски для локальной обработки при формировании структуры ИМС по планарной технологии;
в) создание графического изображения электронным способом;
г) создание графического изображения химическим способом.
120. Какая длина волны соответствует оптической (фотолитографии) (1), рентгеновской (2), электронной (3), ионно-лучевой литографии (4)?
а) 0,05 – 0,1 нм;
б) 0,1 нм;
в) 0,1 – 1 нм;
г) 300 – 400 нм.
121. Что такое резист?
а) резистивная пленка для создания тонкопленочных резисторов;
б) материал, предназначенный для изоляции и защиты структур ИМС;
в) материал, стойкий к агрессивным технологическим воздействиям и способный необратимо изменять свойства под воздействием различных излучений.
122. Что называют шаблоном?
а) плоскопараллельная пластина из прозрачного материала, на который нанесен рисунок в виде прозрачных и непрозрачных для излучений определенной длины волны участков, образующих топологию слоя ИМС, повторенных в пределах активного поля пластин;
б) плоскопараллельная пластина из прозрачного материала, на который нанесено негативное изображение топологии слоя ИМС в масштабе 1:1;
в) плоскопараллельная пластина из органического материала, на который нанесено позитивное изображение топологии слоя ИМС в масштабе 1:1.
123. Объясните общую схему литографии (рис. 12):
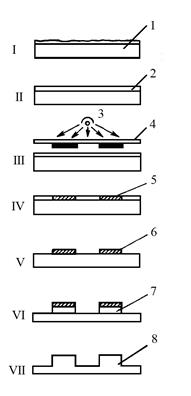
Рис. 12
а) подготовка поверхности пластины;
б) проявление скрытого изображения и задублирование резиста;
в) эксионирование резиста;
г) получение контактной маски;
д) удаление резиста;
е) нанесение и сушка резиста;
ж) перенос изображения контактной маски на пластину;
з) пластина;
и) резист;
к) шаблон;
л) контактная маска;
м) скрытое изображение с контактной маской;
н) излучатель;
о) пластина после снятия контактной маски;
п) полученный профиль травления.
124. Фотолитография бывает:
а) контактная;
б) сканирующая;
в) бесконтактная (на микрозазоре и проекционная);
г) растровая.
125. Что такое фоторезисты?
а) материал, стойкий к агрессивным технологическим воздействиям и способный необратимо изменять свои свойства под действием УФ-излучения;.
б) светочувствительные и после проявления устойчивые к воздействию агрессивных сред органические вещества;
126. Фотошаблоны – это:
п279 для УФ-излучения;
127. В чем заключается сущность контактной фотолитографии?
а) при передаче изображения с фотошаблона на фоторезист между ними находится кварцевая пластина толщиной 10-30 мкм;
б) при передаче изображения с фотошаблона на фоторезист шаблон плотно прилегает к поверхности подложки с нанесенным фоторезистом;
в) электрическое сопротивление контакта между шаблоном и фоторезистом меньше 0,1 Ом.
128. Какие бывают фотошаблоны?
а) эталонные;
б) вторичные;
в) промежуточные;
г) мультиплицированные;
д) рабочие.
129. Рабочие шаблоны бывают:
а) напылённые (до 100 операций контактной печати);
б) эмульсионные (не более 20 операций);
в) усиленные кварцем (до 1000 операций);
г) металлизированные с плёнкой хрома (до 3000 операций).
130. Фотошаблоны реализуют минимальные размеры элементов ИМС:
а) 0,1 – 0,2 мкм;
б) 0,4 – 0,7 мкм;
в) 1 – 2 мкм;
г) 10 мкм.
131. Какие бывают фоторезисты?
а) негативные, у которых при освещении возрастает степень полимеризации и защищённый участок светлый;
б) позитивные, у которых фоторезист при облучении разрушается и при проявлении удаляется с облучённых участков и светлое пятно даёт незащищённый участок;
в) позитивные, у которых фоторезист при облучении разрушается и при проявлении удаляется с облучённых участков и светлое пятно даёт защищённый участок.
132. Какие существуют критерии оценки свойств фоторезисторов и как они определяются?
а) чувствительность S – степень полимеризации в зависимости от длительности облучения: S = 1 / Еt, где Е – освещенность; t – время экспозиции;
б) щелочестойкость К – способность противостоять действию кислот: К = h / x, где h – глубина травления; х – боковое травление;
в) кислотостойкость К: способность противостоять действию щелочей: К = h / x, где h – глубина травления; х – боковое травление;
г) минимальный размер элементов (мкм);
д) разрешающая способность R – число чётко различимых параллельных штрихов, расстояние между которыми равно ширине штриха на 1 мм длины: R =1000 мкм / 2l, где l – ширина штриха, мкм.
133. Какой разрешающей способностью обладают современные фоторезисты? Как этот параметр меняется с увеличением толщины резистора?
а) 100 – 200; возрастает;
б) 1000 – 2000; убывает;
в) 10000; не меняется.
134. Как проводят очистку поверхности кремниевых пластин?
а) промывают в дестилированной воде, облучают УФ-излучением;
б) обрабатывают в парах трихлорэтилена, кипячение в азотной кислоте, в деионизированной воде с УЗ-обработкой и термообработкой;
в) промывают в дестилированной воде, облучают УФ-излучением, термообработка в кислородосодержащей среде.
135. Нанесение фоторезиста осуществляют:
а) напылением;
б) центрифугированием;
в) эпитаксией.
136. Как проводится сушка фоторезиста?
а) выдержка 30 мин при температуре 50˚С в лучах УФ-лампы;
б) сушка 15 мин при температуре 20±5˚С;
в) сушка 15 мин при температуре 20±5˚С, сушка 20 – 60 мин при температуре 100±10˚С в лучах ИК-лампы.
137. Экспонирование фоторезистора – это:
а) проявление изображения;
б) облучение рентгеновским излучением;
в) засветка УФ-излучением.
138. Проявление – это:
а) засветка УФ-излучением;
б) обработка в растворах едкого натра или тринатрийфосфата;
в) обработка трихлорэтиленом, толуолом, хлорбензолом.
139. Что такое задубливание?
а) выдержка в дубильных растворах;
б) окончательная полимеризация оставшегося фоторезиста и улучшение его адгезии к пластине, выдержка 20 мин при температуре 120˚С;
в) окончательная полимеризация оставшегося фоторезиста и улучшения его адгезии к пластине, выдержка 20 мин при температуре 120˚С, кипячение 2 мин в соляной кислоте.
140. Травление оксида кремния осуществляется:
а) Si + 4HNO3 → SiO2 + 4NO2 + 2H2O;
SiO2 + 4HF → SiF4 + 2H2O;
б) п. 273;
в) в водном растворе HF с солями NH4F, KF, NaF.
141. Удаление фоторезиста проводят:
а) локальным отжигом;
б) двух – или трёхразовым кипячением по 5 – 10 мин в концентрированной H2SO4 или «хромовой смеси»;
в) пучком высокоэнергетический ионов;
г) холодным 10 – 15% раствором едкого калия.
142. Недостатки контактной фотолитографии:
а) механическое повреждение фотошаблонов и пластин;
б) невысокая разрешающая способность;
в) сложное оборудование;
г) смещение шаблона относительно пластины.
143. Бесконтактная фотолитография на микрозазоре – это:
а) процесс, при котором между объективом и пластиной, покрытой фоторезистом, имеется микрозазор менее 20 мкм;
б) процесс, при котором между фотошаблоном и резистором существует зазор 10 – 30 мкм, который задаётся плёнкой полиэфира или кварцевыми полосками;
в) процесс, при котором между фотошаблоном и объективом находится регулируемый микрозазор (5 – 10 мкм).
144. Объясните схему фотолитографии на микрозазоре:
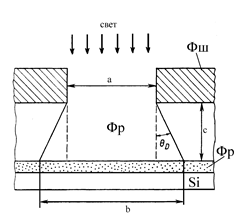
Рис. 13
1 – размер элемента на фотошаблоне;
2 – размер элемента на резисте;
3 – дифракционный угол;
4 – интерференционный угол;
5 – величина зазора;
6 - фотошаблон;
7 – фоторезист;
8 – пластина.
145. Достоинства (1) и недостатки (2) фотолитографии на микрозазоре:
а) отсутствие дефектов, возникающих из-за контакта;
б) простота оборудования;
в) сложность оборудования;
г) уменьшение разрешающей способности;
д) непаралельность шаблона и пластины;
е) эффекты дифракции;
ж) время экспонирования 2 – 5 с;
з) равномерность освещения подложек большой площади;
и) минимальный размер элемента – 1,5 мкм.
146. Как уменьшить ϴD:
а) уменьшить ширину зазора;
б) увеличить ширину зазора;
в) облучение многими источниками под углом к оптической оси;
г) облучение более длинноволновым источником.
147. Бесконтактная проекционная фотолитография заключается в:
а) передаче топологии шаблона на фоторезист сфокусированным объективом единичным оптическим лучом;
б) передаче топологии шаблона на фоторезист сфокусированным объективом единичным УФ-лучом;
в) проектировании изображения фотошаблона на пластину с фоторезистором с помощью объектива с высокой разрешающей способностью.
148. Объясните схему проекционной фотолитографии:
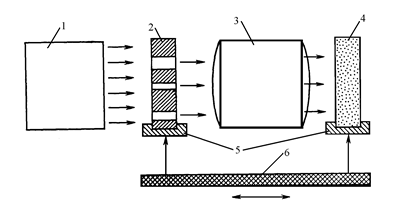
Рис. 14
а) источник света;
б) источник света – УФ-излучение;
в) фотошаблон;
г) пластина с фоторезистом;
д) объектив;
е) держатели;
ж) система совмещения;
з) неподвижное основание;
и) система вертикального перемещения.
149. Достоинства (1) и недостатки (2) проекционной фотолитографии:
а) шаблон используется неограниченно;
б) шаблон используется до 1000 раз;
в) разрешающая способность выше чем на микрозазоре;
г) разрешающая способность ниже чем на микрозазоре;
д) возможности автоматизации процесса;
е) сложность разработки объективов на большие поля изображений;
ж) невысокая производительность;
з) сложное оборудование;
и) повышенные требования к плоскостности пластины и фоторезиста;
к) некритичность к мощности и монохроматичности УФ-источника;
л) перспективность метода.
150. Электронолитография – это:
а) одновременная передача всей топологии шаблона на пластину с электронорезистом;
б) формирование топологических конфигураций с субмикронными размерами на пластине с электронорезистом с помощью электронов;
в) формирование топологических конфигураций с субмикронными размерами на пластине с электронорезистом с помощью сфокусированного пучка электронов, сканирующего всю пластину.
151. Минимальный размер элементов, получаемых с помощью электронолитографии, и его теоретический предел:
а) 10 мкм; 10 нм;
б) 0,1 – 0,2 мкм; 0,1 нм;
в) 0,5 мкм; 0,1 нм.
152. Особенности электронолитографии:
а) высокая энергия электронов;
б) топология в масштабе 1:1;
в) возможность безмасочной технологии;
г) отсутствие необходимости проявления.
153. Какие методы электронолитографии получили наибольшее распространение?
а) сканирующая растровая;
б) сканирующая векторная;
в) с длиной волны 5 – 10 нм;
г) проекционная;
д) проекционная с длиной волны 500 нм.
154. На каких установках реализуются методы п. 310?
а) растровые электронные микроскопы (РЭМ);
б) электронно-лучевые ускорители (ЭЛУ).
155. Достоинства (1) и недостатки (2) сканирующей электронографии:
а) высокая разрешающая способность;
б) высокая точность воспроизведения (±,025мкм);
в) низкая производительность;
г) низкая энергия электронного луча;
д) большое время экспонирования;
е) низкая стоимость оборудования.
156. Проекционная электронолитография – это:
а) одновременная передача всей топологии шаблона на пластину с электронорезистом;
б) формирование топологических конфигураций с субмикронными размерами на пластине с электронорезистом с помощью фокусированного пучка электронов, сканирующего всю пластину;
в) формирование топологических конфигураций с субмикронными размерами на пластине с электронорезистом с помощью фокусированного пучка электронов, сканирующего всю пластину с длиной волны облучения 50 – 100 нм;
г) одновременная передача всей топологии шаблона на пластину с электронорезистом в уменьшенном или истинном (1:1) масштабе.
157. Объясните схему проекционной электронографии в истинном масштабе:
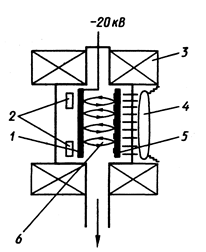
Рис. 15
а) анод;
б) пластина;
в) детекторы рентгеновского излучения;
г) детекторы УФ-излучения;
д) электронная пушка;
е) УФ-лампа;
ж) фотокатод с маской;
з) обмотки магнитов;
и) сверхпроводящие обмотки магнитов;
к) электроны.
158. Что представляет собой фотокатод?
а) кварцевую пластину, на которую нанесена плёнка оксида титана, с нанесённой топологией в масштабе 1:1, поглощающего УФ-лучи. Поверх оксида титана нанесён слой палладия толщиной 4 нм для фотоэмисии электронов;
б) пластина из оргстекла, на которую нанесена плёнка оксида титана, с нанесённой топологией в масштабе 1:1, излучающего электроны. Поверх оксида титана нанесён слой палладия толщиной 4 нм для поглощения УФ-лучей;
в) кварцевую пластину, на которую нанесена плёнка оксида титана, с нанесённой топологией в масштабе 1:1, поглощающего УФ-лучи. Поверх оксида титана напылена плёнка люминофора толщиной 5-10 мкм для фотоэмисии электронов.
159. Какую степень интеграции, минимальный размер элемента и производительность соответственно обеспечивают отечественные установки электронолитографии при производстве БИС?
а) 3; 10 мкм; 100 пластин в час;
б) 5-6; 1 мкм; 5 пластин в час;
в) 4; 5 мкм; 100 пластин в час.
160. Какой процесс называют рентгенолитографией?
а) взаимодействие характеристического рентгеновского излучения с рентгенорезистами, приводящее к увеличению или уменьшению стойкости к проявителям;
б) взаимодействие вторичного рентгеновского излучения с длиной волны 300-400 нм;
в) формирование топологических конфигураций с субмикронными размерами на пластине с рентгенорезистом с помощью сфокусированного пучка рентгеновского излучения, сканирующего всю пластину.
161. Что такое рентгенорезисты?
а) кремнийорганические материалы, которые разрушаются под действием рентгеновских лучей;
б) полимерные материалы, которые разрушаются (позитивные) или сшиваются (негативные) под действием рентгеновских лучей;
в) линейные полимеры, которые сшиваются (негативные) под действием рентгеновских лучей.
162. Какой позитивный резист наиболее часто используют в рентгено- и электронолитографии?
а) полиметилметакрилат (ПММА, оргстекло);
б) полиэтилен (ПЭ);
в) поликарбонат.
163. Какие виды рентгенолитографии Вы знаете?
а) проекционная, аналогично п.300;
б) сканирующая, аналогичная п. 312;
в) проекционная, аналогичная пункту 313.
164. Объясните схему рентгенолитографии:
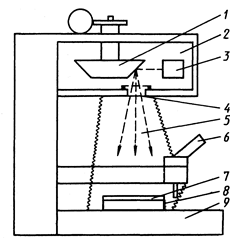
Рис. 16
а) вращающийся анод;
б) вращающийся катод;
в) вакуумная камера;
г) источник рентгеновского излучения;
д) электронная пушка;
е) окно в бериллиевой фольге;
ж) микроскоп;
з) устройство совмещения;
и) прозрачное окно;
|
|
 2015-05-13
2015-05-13 751
751