Технологический процесс операции фотолитографии
Технологический процесс фотолитографии
| № оп.
| Название и содержание операции
| Эскиз операции
| Оборудование, материалы
|
|
| ПОДГОТОВКА ПЛАСТИНЫ
Очистка полупроводниковой пластины. Цикл обработки не более 5 мин.
|  4 – рабочая камера
5 – кремневые пластины
6 –теплоизолирующий слой
4 – рабочая камера
5 – кремневые пластины
6 –теплоизолирующий слой
| 1) Установка для обработки пластины в парах растворителя
2) Растворитель фреон-113
|
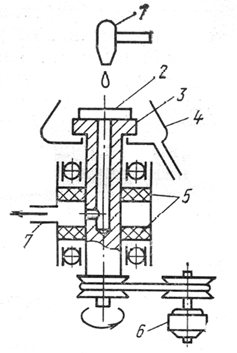  2 2
| НАНЕСЕНИЕ ФОТОРЕЗИСТА
Нанесение слоя фоторезиста с помощью метода центрифугирования или пульверизации.
| Ценрифугирование
1 – дозатор фоторезиста
2 – пластина
Пульверизация
2 – подвижный стол с пластинами
3- подвижная форсунка
| 1) Центрифуга,
2) Полуавтомат ПНФ-1Р (для пульверизации),
3) Раствор фоторезиста
|
 3 3
| СУШКА ФОТОРЕЗИСТА
Удаление остатков раство-рителя и упорядочение структуры фоторезиста с помощью инфракрасной сушки (5-15 мин.) или СВЧ-сушки (неск. сек.)
|
| ИК-сушка:
Источник ИК-излучения
СВЧ-сушка:
печь мощностью 200-400 Вт, рабочая частота 2,45 ГГц
|
 4 4
| СОВМЕЩЕНИЕ С ФОТОШАБЛОНОМ
Совмещение структуры фотошаблона со структурой пластины:
– контрольный модуль фотошаблона перпендикулярен (или параллелен) базовому срезу пластины;
– знаки совмещения в модулях фотошаблона и пластины совпадали.
|
1 – групповой фотошаблон
2 – контрольный модуль
3 – групповая пластина
4 – базовый срез пластины
5, 6 – знаки совмещения в модулях пластины и фотошаблона
| 1) Механизмы перемещения вдоль двух координатных осей и поворота вокруг вертикальной оси,
2) Микроскоп с увеличением до 400X
|
| 5
| ЭКСПОНИРОВАНИЕ
Перенос изображения с фотошаблона на фоторезист путем засветки фоторезиста через фотошаблон.
|
| Источник УФ-излучения (ртутно-кварцевая лампа,λ=0.4мкм)
|
 6 6
| ПРОЯВЛЕНИЕ И ТЕРМООБРАБОТКА ФОТОМАСКИ
1. Избирательное удаление участков фоторезиста – экспонированных (для позитивного фоторезиста) или неэкспонированных (для негативного).
2. Удаление остатков проявителя и усиление кислотостойких свойств фотомаски.
|
3 – струйная форсунка сушки
4 – пневматические форсунки проявления и промывки
5 – платформа с пластинами
| 1) Проявители:
– для позитивного фоторезиста неорганические соединения со щелочными свойствами KOH, NaOH, Na3PO4∙12H2O;
– для негативного фоторезиста органические растворители диоксан, трихлорэтилен, толуол, хлорбензол, ксилол;
2) Центрифуга для струйного проявления и сушки.
|
|
| ТРАВЛЕНИЕ
Удаление ненужных участков покрытия с помощью химического или плазмо-химического травления.
|
| 1) Химический травитель – плавиковая кислота;
2) Реактор установки плазмохимического травления.
|
|
| УДАЛЕНИЕ ФОТОМАСКИ
Удаление остатков фоторезиста химическим или плазмохимическим методом и получение рельефа пластины.
|
| 1) Концентриро-ванная серная кислота, ацетон, диоксан, водно-щелочные растворы;
2) Кислородосо-держащая плазма безэлектродного ВЧ-разряда.
|
 4 – рабочая камера
5 – кремневые пластины
6 –теплоизолирующий слой
4 – рабочая камера
5 – кремневые пластины
6 –теплоизолирующий слой
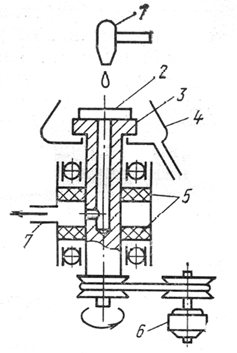
 2
2
 3
3
 4
4
 6
6
 2015-09-06
2015-09-06 822
822







