Эпитаксией называют процесс наращивания слоев с упорядоченной кристаллической структурой путем использования ориентирующего действия подложки (повторения ее структуры). Если подложка и слой состоят из одного вещества, то процесс называют гомоэпитаксией (например, кремний на кремнии), если из различных – гетероэпитаксией (например, кремний на сапфире).
В процессе выращивания эпитаксиальной пленки в нее можно вводить легирующие примеси, создавая полупроводниковые пленки с определенными свойствами (типом проводимости, удельным сопротивлением и т.д.). Например, на поверхности кремния n -типа проводимости можно вырастить слой кремния (толщиной обычно 1…25 мкм) p -типа проводимости. В отличие от диффузии здесь удается получить четкие границы между слоями с различным типов проводимости.
Для получения эпитаксиальных слоев кремния наибольшее распространение получил хлоридный метод. Процесс протекает в реакторе вертикального (рис. 4.50) или горизонтального типа, содержащем кварцевую трубу, установленную в индуктор ВЧ-генератора. Подложки устанавливают на графитовой пирамиде, грани которой имеют наклон 5…70. Каждый из газов подается из баллона по отдельной магистрали, содержащей фильтр, регулятор давления, запорный вентиль, манометр, ротаметр и электромагнитный клапан.
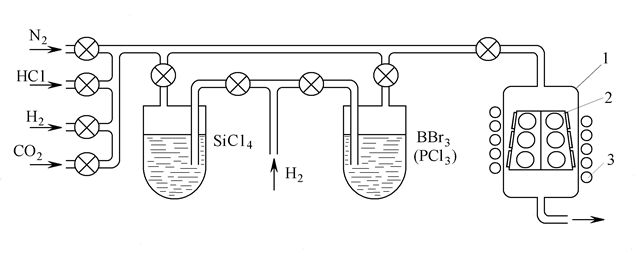
Рис. 4.50. Схема установки эпитаксиального наращивания из парогазовой фазы с вертикальным реактором:
1 – реактор; 2 – держатель пластин; 3 – индуктор
После загрузки пластин и герметизации реактора систему продувают азотом (для удаления воздуха), а затем водородом. Далее следует нагрев до 1200 0С и выдержка в атмосфере водорода, в течение которой происходит восстановление окисных пленок кремния и их удаление с поверхности. Затем камеру заполняют газовой смесью HCl + H2 для травления (на глубину в несколько мкм) нарушенного слоя и остатков SiO2. После очистки систему продувают водородом, после чего, подают SiCl4 и легирующую примесь (BBr 3 или PCl3).
В результате реакции
SiCl4(пар) + 2 H2(газ)  Si(тв.) + 4 HCl(газ)
Si(тв.) + 4 HCl(газ)
тетрахлорид кремния разлагается и на кремниевыу подложку осаждается кремний, который принимает структуру лежащего под ним слоя. При подаче CO2 на поверхности эпитаксиальной пленки может быть получена пленка SiO2. После окончания процесса подложку охлаждают потоком чистого водорода.
 2014-02-09
2014-02-09 901
901








