Рис. кільця Ньютона

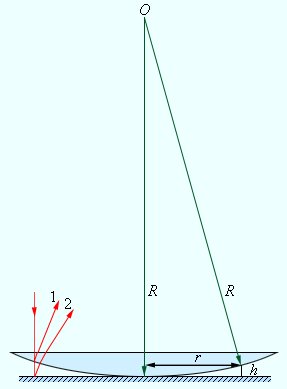
Суть процесса ионного внедрения заключается в формировании пучков ионов с одинаковой массой и зарядом, обладающих необходимой заданной энергией, и внедрении их в подложку или мишень в определенном количестве, называемом дозой. Таким образом, основными характеристиками процесса являются энергия и доза пучка ионов.
Нужная энергия E0 приобретается ионом под действием разности потенциалов U:

где n - кратность ионизации, n = 1, 2, 3; e - заряд электрона. (Например, 31P+ означает, что внедряется однократно ионизованный (+) ион фосфора с атомной массой 31;  - однократно ионизованная молекула фторида бора.)
- однократно ионизованная молекула фторида бора.)
Преимущественное использование ионного легирования перед диффузионным позволяет обеспечить:
- строгое задание количества примеси, определяемого током ионов во время внедрения;
- воспроизводимость и однородность распределения примеси;
- возможность использования в качестве маски при легировании слоев SiO2 и Si3N4;
- внедрение через тонкие слои диэлектриков и резистивных материалов;
- пониженную в сравнении с диффузией температуру.
Вместе с тем процесс ионного внедрения сопровождается рядом явлений, для устранения которых необходимо использование специальных технологических приемов. В результате взаимодействия с ионами в решетку полупроводника вносятся радиационные повреждения, которые при последующих операциях могут искажать профили распределения примеси. Дефекты способствуют также увеличению токов утечки и изменению других характеристик приборов. Устранение дефектов требует постимплантационной высокотемпературной обработки (отжига).
 2014-02-09
2014-02-09 677
677







