Министерство образования и науки Российской Федерации
Государственное образовательное учреждение
Высшего профессионального образования
«ЛИПЕЦКИЙ ГОСУДАРСТВЕННЫЙ ПЕДАГОГИЧЕСКИЙ УНИВЕРСИТЕТ»
Факультет физико-математических и компьютерных наук
Кафедра физики
Специальность 050203.65 – «Физика и информатика»
Курсовая работа
по дисциплине (Физика)
на тему:
Гетероструктуры полупроводников
Выполнил:
студент 4 курса
группы ФИ-4
Корнев Денис
Липецк 2012
Содержание.
1. Определение гетероперехода.
2. Энергетическая диаграмма идеального гетероперехода.
3. Требования к материалам, образующим гетероструктуры.
4. Применение гетероструктур в наноэлектронике.
5. Приложение.
6. Использованная литература.
ОПРЕДЕЛЕНИЕ ГЕТЕРОПЕРЕХОДА
Полупроводниковые гетероструктуры лежат в основе конструкций современных транзисторов, приборов квантовой электроники, СВЧ - техники, электронной техники для систем связи, телекоммуникаций, вычислительных систем и светотехники.
Основным элементом гетероструктур различного типа является гетеропереход.
Под гетеропереходом понимается контакт двух различных по химическому составу полупроводников, при котором кристаллическая решетка одного материала без нарушения периодичности переходит в решетку другого материала.
Различают изотипные и анизотипные гетеропереходы. Если гетеропереход образован двумя полупроводниками одного типа проводимости, то говорят об изотипном гетеропереходе. Анизотипные гетеропереходы образуются полупроводниками с разным типом проводимости.
Существует три модели гетероперехода:
- идеальный гетеропереход;
- неидеальный гетеропереход;
- гетеропереход с промежуточным слоем.
В идеальном гетеропереходе, в отличие от неидеального, на границе раздела материалов отсутствуют локальные энергетические состояния для электронов. Гетеропереход с промежуточным слоем формируется через слой конечной толщины и локальные энергетические состояния могут существовать как в самом промежуточном слое, так и на границах его раздела.
ЭНЕРГЕТИЧЕСКАЯ ДИАГРАММА ИДЕАЛЬНОГО ГЕТЕРОПЕРЕХОДА
Для построения энергетической диаграммы часто применяют простое «правило электронного сродства» (в англоязычной литературе – правило Андерсона), согласно которому разрыв зоны проводимости равен разности электронного сродства двух материалов. Но следует иметь в виду, что данный подход далеко не всегда справедлив, так как в разрыв зон зависят еще и от деталей формирования связей на гетерогранице и деформационного потенциала.
Для построения энергетической диаграммы идеального гетероперехода должны быть известны следующие характеристики полупроводников:
- ширина запрещенной зоны ( ,
,  ). При построении считаем, что
). При построении считаем, что  ;
;
- термодинамическая работа выхода ( ,
,  )– расстояние от уровня Ферми полупроводника до уровня вакуума. Следует учитывать, что термодинамическая работа выхода зависит от положения уровня Ферми, то есть от уровня легирования материала;
)– расстояние от уровня Ферми полупроводника до уровня вакуума. Следует учитывать, что термодинамическая работа выхода зависит от положения уровня Ферми, то есть от уровня легирования материала;
- сродство к электрону ( ,
,  ) – расстояние от дна зоны проводимости до уровня вакуума.
) – расстояние от дна зоны проводимости до уровня вакуума.
При построении диаграммы считаем, что
- ширина запрещенной зоны и внешняя работа выхода неизменны до плоскости контакта, на которой они скачком изменяют свою величину;
- в приконтактном слое каждого из полупроводников происходит изменение потенциальной энергии электрона. Полное изменение потенциальной энергии равно разности работ выхода, что обеспечивает неизменное положение уровня Ферми вдоль гетероперехода.
До «приведения в контакт» двух полупроводников потенциальная энергия электронов в них разная из - за разной термодинамической работы выхода. При «соприкосновении» двух полупроводников, как и в случае обычного p-n-перехода, электроны начнут «переходить» из полупроводника с меньшей работой выхода в полупроводник с большей. Это будет происходить до тех пор, пока диффузионный ток не будет скомпенсирован дрейфовым током носителей заряда под воздействием поля, созданным избыточными носителями. При этом возникнет контактная разность потенциалов

и образуется область пространственного заряда шириной d (Рисунок 1).

Рисунок 1. Энергетические диаграммы полупроводников (а) и диаграмма идеального гетероперехода (б).
При таком построении видно, что из -за различия электронного сродства в контактирующих полупроводниках дно зоны проводимости первого полупроводника выходит на плоскость контакта в точке, не совпадающей в общем случае с точкой выхода на эту плоскость дна зоны проводимости второго полупроводника – формируется разрыв зоны проводимости  . Он равен
. Он равен


Аналогично формируется и разрыв валентной зоны. Он равен:

Следует заметить, что разрывы зон могут быть как положительными так и отрицательными. Можно выделить следующие разновидности гетеропереходов:
1) охватывающий переход возникает, когда разрыв зоны проводимости  и разрыв валентной зоны
и разрыв валентной зоны  положительны. Такой случай реализуется, например, в гетеропереходе GaAs-AlGaAs. В литературе данный тип гетероперехода называют гетеропереходом I типа, или стандартным;
положительны. Такой случай реализуется, например, в гетеропереходе GaAs-AlGaAs. В литературе данный тип гетероперехода называют гетеропереходом I типа, или стандартным;
2) в случае же, когда разрыв один из разрывов зон положителен, а другой отрицателен говорят о переходе II типа, или ступенчатом. Данный случай реализуется в гетеропереходе  .
.
3) также возможен вариант, когда запрещенные зоны вообще не перекрываются по энергии. Данный гетеропереход называет гетеропереходом III типа или разрывным гетеропереходом. Классический пример – гетеропереход InAs-GaSb. Экспериментально измеренные параметры основных типов гетеропереходов изображены на рисунке 2.
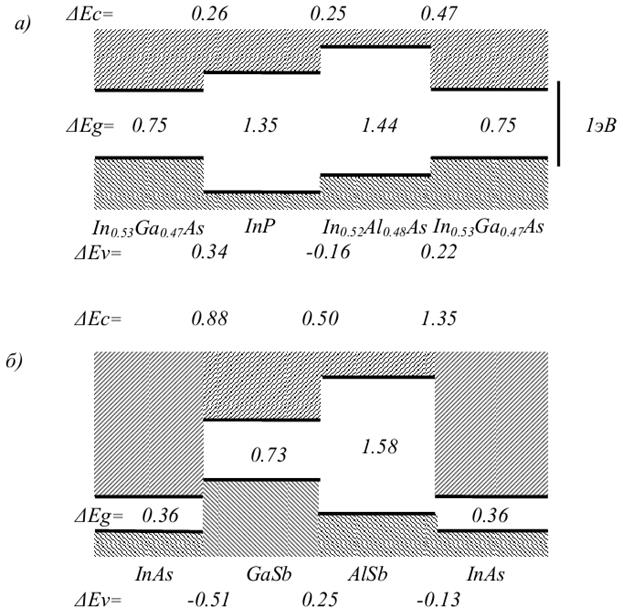
Рисунок 2. Экспериментально определенные разрывы валентной зоны и зоны проводимости двух наиболее близких по параметрам решетки гетеропар:а)  и б) InAs-GaSb-AlSb.
и б) InAs-GaSb-AlSb.
В справочниках обычно приведены величины эффективных масс плотности состояний для электронов  и дырок
и дырок  . Тогда
. Тогда  и
и  вычисляются по формулам
вычисляются по формулам
 ,
, 
Если приведены поперечная  и продольная
и продольная  составляющая эффективных масс, число эквивалентных эллипсоидов M, то плотность состояний в этом случае рассчитывается по формуле
составляющая эффективных масс, число эквивалентных эллипсоидов M, то плотность состояний в этом случае рассчитывается по формуле

В полупроводниках p-типа необходимо также учесть вклад двух подзон от легких и тяжелых дырок:

Далее по формулам вычисляем положение уровня Ферми и контактную разность потенциалов:
 .
.
Для вычисления распределения потенциала в области пространственного заряда требуется решить совместно уравнение Пуассона и уравнение плотности тока, при условии, чтобы в равновесии диффузионный ток через переход уравновешивался дрейфовым током.
В приближении Шоттки в случае равномерного легирования полупроводников для анизотипного гетероперехода получается линейная зависимость поля и параболическая зависимость потенциала:
в области 


В области 


А размер области пространственного заряда получаются равными:


где  ,
,  – контактные разности потенциалов, приходящиеся на n и p области,которые для идеального гетероперехода равны:
– контактные разности потенциалов, приходящиеся на n и p области,которые для идеального гетероперехода равны:
 ,
, 
Полная длина ОПЗ:

Распределение поля и потенциала показано на рисунке 3.

Рисунок 3. Распределение поля и потенциала в резком анизотипном гетеропереходе.
Следует также принимать во внимание, что материалы гетеропары могут иметь минимумы зоны проводимости в разных точках зоны Брюллиена. К примеру, минимум зоны проводимости GaAs находится в точке Г, в то время как наименьший минимум в AlAs близок к точке X. Таким образом, природа низшего минимума зоны проводимости меняется при изменении доли Al в твердом растворе 
 (рисунок 4). Низший минимум
(рисунок 4). Низший минимум  изменяется от прямого расположения (минимум в Г) зон до непрямой зонной структуры (минимум в Х) при содержании
изменяется от прямого расположения (минимум в Г) зон до непрямой зонной структуры (минимум в Х) при содержании  . Обычно твердый раствор
. Обычно твердый раствор  получают с долей Al, меньше 0.4, чтобы получить прямое расположение зон.
получают с долей Al, меньше 0.4, чтобы получить прямое расположение зон.
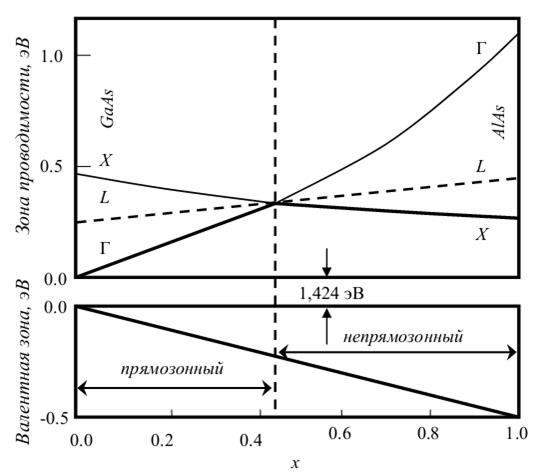
Рисунок 4. Расположение валентной зоны и зоны проводимости в
 .
.
Покажем простой способ построения энергетической диаграммы на конкретном примере. Пусть требуется построить энергетическую диаграмму  . Используя справочные данные (см. Таблица 1), находим ширину запрещенной зоны и электронное сродство для материалов гетеропары. При этом учитываем, что при х =0.3 минимум зоны проводимости твердого раствора
. Используя справочные данные (см. Таблица 1), находим ширину запрещенной зоны и электронное сродство для материалов гетеропары. При этом учитываем, что при х =0.3 минимум зоны проводимости твердого раствора  лежит в точке Г (см. рисунок 4). Для GaAs получаем
лежит в точке Г (см. рисунок 4). Для GaAs получаем  и
и  χ1=4.07 эВ, а для
χ1=4.07 эВ, а для  –
–  и
и  .
.
Построение зонной диаграммы разобьем на несколько этапов. Сначала отдельно нарисуем зонные диаграммы для GaAs и  в отсутствие контакта. Относительно энергии электрона в вакууме их следует располагать, используя определение электронного сродства.
в отсутствие контакта. Относительно энергии электрона в вакууме их следует располагать, используя определение электронного сродства.
Сразу можно вычислить разрыв зон проводимости. Разрыв зоны проводимости:

и разрыв валентной зоны:

В данном случае  ,
,  , таким образом, этот гетеропереход относится к гетеропереходу I типа - дно зоны проводимости
, таким образом, этот гетеропереход относится к гетеропереходу I типа - дно зоны проводимости  лежит выше дна зоны проводимости GaAs, а потолок валентной зоны
лежит выше дна зоны проводимости GaAs, а потолок валентной зоны  лежит ниже потолка валентной зоны GaAs (рисунок 5, а).
лежит ниже потолка валентной зоны GaAs (рисунок 5, а).
Далее нарисуем уровни Ферми в двух полупроводниках в соответствии с уровнем легирования (рисунок 5, б). В данном примере считаем полупроводники невырожденными и просто располагаем уровень ферми в GaAs ближе к потолку валентной зоны, а в  – ближе к дну зоны проводимости. Проводим ряд вспомогательных линий, которые помогутправильно построить диаграмму: это уровни
– ближе к дну зоны проводимости. Проводим ряд вспомогательных линий, которые помогутправильно построить диаграмму: это уровни  ,
,  , являющиеся продолжением
, являющиеся продолжением  ,
,  GaAs в
GaAs в  (рисунок 5, б).
(рисунок 5, б).
Соединим плавной пунктирной линией уровни  ,
,  и
и  ,
,  в GaAs (рисунок 5, в). На последнем этапе нарисуем разрывы зон (рисунок 5, г).
в GaAs (рисунок 5, в). На последнем этапе нарисуем разрывы зон (рисунок 5, г).
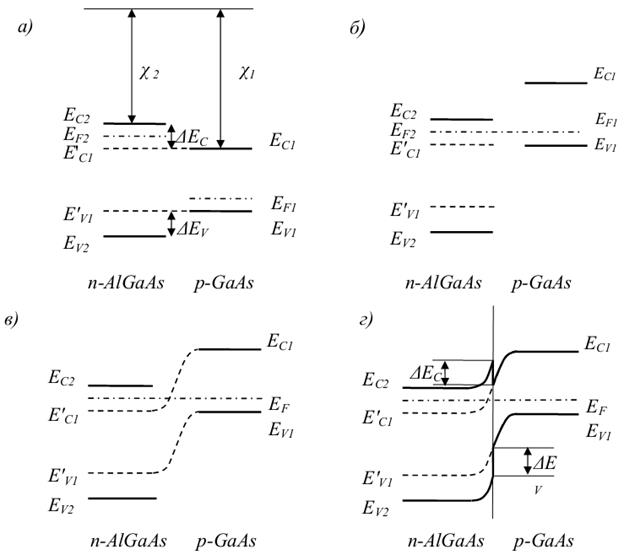
Рисунок 5. Пример построения энергетической диаграммы гетероперехода
p-GaAs-n-AlGaAs.
 2015-09-06
2015-09-06 5047
5047







