Таблица 2.1 Перечень, последовательность и номинальные параметры слоёв микросхем.
| № п.п. | Наименование слоя | Номер фотошаблона | Номинальные параметры | Примечание |
| Исходный кристалл | – | КЭФ=4,5 (100) КЭФ=20 (100) | 
| |
| Первичный термический окисел | – | d=0,40÷0,50 мкм | 
| |
| Карман р -типа | Na=1·10  см¯³
d=5÷8 мкм см¯³
d=5÷8 мкм
| Выполняют фотолитографию «кармана» и двухстадийную диффузию «кармана» на необходимую глубину.
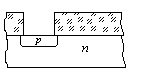
| ||
Диффузионные р  -слои (исток, сток, охранная область) -слои (исток, сток, охранная область)
| rs=10÷25 Ом/ d=0,40÷0,50 мкм | Выполняют фотолитографию и диффузию.
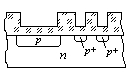
| ||
Диффузионные n  -слои (исток, сток, охранная область) -слои (исток, сток, охранная область)
| gs=10÷25 Ом/ d=1,4÷1,6 мкм | 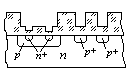
| ||
| Тонкий оксид | d=0,09 ±0,01 мкм | Проводят фотолитографию.
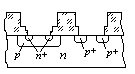 Выращивают тонкий слой окисла.
Выращивают тонкий слой окисла.
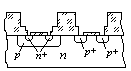
| ||
| Поликристаллический кремний | d=0,3÷0,6 мкм | Наращивают специальную маску из поликристаллического кремния Si*.
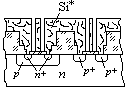
| ||
| Подлегирование областей истока – стока р -канального транзистора | Na=1·10  см¯³
d=0,4 мкм см¯³
d=0,4 мкм
| 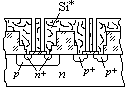
| ||
| Подлегирование областей истока – стока n -канального транзистора | Nд ≈1·10  см¯³
d =0,4 мкм см¯³
d =0,4 мкм
| 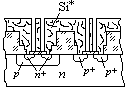
| ||
| Межслойный диэлектрик | – | d≈0,5 мкм | ||
| Контактные окна | 4×4 мкм | Проводят фотолитографию – вскрытие окон под контакты. | ||
| Металлизация алюминием | d=1,2÷0,2 мкм | Создание внутрисхемных соединений путём металлизации алюминием.
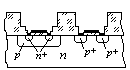
| ||
| Диэлектрический защитный слой | d=0,5 ±0,2 мкм | Пассивация – нанесение защитного покрытия, в котором фотолитографией вскрывают окна под периферийные контактные площадки. |
 2015-09-06
2015-09-06 400
400







