Цель работы – изучение устройства, принципа действия и характеристик полевых транзисторов, изучение схем усилительных каскадов на основе полевых транзисторов.
3.1. Теоретические сведения
Полевые транзисторы представляют собой полупроводниковые приборы, в которых изменение силы тока, протекающего вдоль тонкой проводящей области (канала) полупроводникового кристалла, осуществляется за счёт изменения электрического сопротивления этой области в результате действия на неё поперечно направленного электрического поля, создаваемого с помощью управляющего (затворного) электрода (ЭЗ).
Полевые транзисторы могут иметь каналы с дырочной проводимостью (каналы p -типа) и каналы с электронной проводимостью (каналы n -типа). Ток в канале создаётся в результате перемещения основных свободных носителей электрического заряда. Поэтому они также называются униполярными транзисторами.
Внешние выводы транзистора, через которые проходит управляемый ток канала, называются истоком (И) и стоком (С). Движение основных носителей электрического заряда вдоль канала происходит от истока к стоку. Внешний вывод транзистора, соединённый с управляющим электродом, называется затвором (З).
Кроме того, полевые транзисторы могут иметь внешний вывод подложку (П), соединенный с несущей частью полупроводникового кристалла.
По принципу действия полевые транзисторы бывают следующих видов:
- с управляющим p–n -переходом (рис.1,а);
- с управляющим переходом Шотки;
- с изолированным затвором.
В полевых транзисторах с изолированным затвором канал может быть встроенным (т.е. созданным при изготовлении транзистора) или индуцированным (т.е. наводящимся под воздействием управляющего напряжения). Поэтому различают два типа полевых транзисторов с изолированным затвором: МДП-транзисторы со встроенным каналом и МДП-транзисторы с индуцированным каналом (рис.1, б,в).






















|
|
|
|
|
|

а б в
Рис. 1
Характерным для всех полевых транзисторов является очень малый ток в цепи затвора в статическом режиме работы, т.к. ЭЗ либо изолирован от канала слоем диэлектрика, либо между ним и каналом имеется p – n -переход (или переход Шотки), на который в рабочем режиме работы транзистора подаётся напряжение обратной полярности. Поэтому полевой транзистор при низких частотах входного сигнала обладает большим значением входного сопротивления ( Ом). В этом заключается существенное отличие полевых транзисторов от биполярных, во входной цепи которых в активном режиме работы протекает значительный ток (особенно при включении биполярного транзистора по схеме с общей базой). Отсюда следует, что полевой транзистор – это электронный прибор, управляемый напряжением (электрическим полем).
Ом). В этом заключается существенное отличие полевых транзисторов от биполярных, во входной цепи которых в активном режиме работы протекает значительный ток (особенно при включении биполярного транзистора по схеме с общей базой). Отсюда следует, что полевой транзистор – это электронный прибор, управляемый напряжением (электрическим полем).
В микроэлектронике наибольшее применение находят транзисторы с изолированным затвором. Транзисторы с управляющим переходом Шотки на основе арсенида галлия используется для создания быстродействующих цифровых интегральных микросхем и в электронных устройствах СВЧ. Транзисторы с управляющим p – n -переходом на основе кремния являются относительно низкочастотными приборами.
 Полевые транзисторы с управляющим p – n -переходом. Кристалл полупроводника в простейшем варианте конструкции транзистора (рис.2) состоит из p + - и n- областей. К внешней поверхности р + - области прилегает электрод затвора (ЭЗ), канал образован n -областью кристалла. Внешние выводы И и С электрически связаны с каналом через электроды ЭИ и ЭС.
Полевые транзисторы с управляющим p – n -переходом. Кристалл полупроводника в простейшем варианте конструкции транзистора (рис.2) состоит из p + - и n- областей. К внешней поверхности р + - области прилегает электрод затвора (ЭЗ), канал образован n -областью кристалла. Внешние выводы И и С электрически связаны с каналом через электроды ЭИ и ЭС.
 | |||
 | |||
















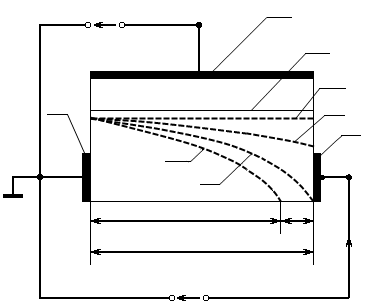
Рис. 2
Между р + - и n -областями существует p – n- переход. Линия, изображающая границу p–n- перехода со стороны р + -области, обозначена буквой α, а линия, изображающая границу p–n- перехода со стороны n- канала, буквой β (индексы 0,1,2,3 при букве β соответствуют различным режимам работы транзистора).
В рабочем режиме на p–n -переход подаётся управляющее напряжение U зи обратной полярности (U зи < 0). При возрастании абсолютного значения этого напряжения увеличение толщины p–n- перехода происходит за счёт его расширения в основном в сторону менее легированной n -области (канала). При этом сопротивление канала возрастает из-за уменьшения площади поперечного сечения его рабочей области, т.к. через область объёма канала, занятой p–n -переходом, ток практически не протекает. Это обусловлено тем, что p–n -переход обладает высоким значением электрического удельного сопротивления, а вероятность проникновения электронов рабочей области канала в область p–n -перехода близка к нулю из-за возрастания потенциального барьера p–n -перехода под действием приложенного к нему напряжения обратной полярности (U зи).
При одновременном действии напряжений U зи и U си обратное напряжение на p–n -переходе создаётся их совместным действием. Около ЭИ численное значение обратного напряжения на p–n -переходе равно значению | U зи |. Т.к. потенциал ЭС выше потенциала ЭИ на значение U си > 0, то численное значение обратного напряжения на p–n -переходе постепенно возрастает в направлении от ЭИ до ЭС начиная с уровня |U зи | до уровня |U зи | + | U си |. Поэтому при U си = 0 сужение толщины канала по всей ее длине происходит одинаково и нижняя граница p–n -перехода представляет собой горизонтальную плоскость, обозначенную на рис.2 в виде линии β0. При U си > 0 линия, изображающая нижнюю границу p–n -перехода искривляется так, что толщина канала около ЭИ оказывается большей, чем около ЭС. При этом для значений U си, равных  ,
,  ,
,  (
( <
<  < <
< <  ), нижняя граница p–n -перехода принимает положения, обозначенные на рис.2 соответственно линиями β1, β2, β3.
), нижняя граница p–n -перехода принимает положения, обозначенные на рис.2 соответственно линиями β1, β2, β3.
Из сказанного следует, что ток стока I c в статическом режиме является функцией двух переменных (U зи и U си). Поэтому основными статическими вольт-амперными характеристиками (ВАХ) являются:
- семейство выходных (стоковых) характеристик, состоящее из множества функций Ic(Uси) с параметром Uзи (рис.3);
-  семейство передаточных (стокозатворных) характеристик, состоящее из множества функций переменной Ic(Uзи) с параметром Uси (рис. 4).
семейство передаточных (стокозатворных) характеристик, состоящее из множества функций переменной Ic(Uзи) с параметром Uси (рис. 4).












|








Рис. 3 Рис.4
При малых значениях напряжения U си зависимости I с(U си) близки к линейной функции. По мере увеличения напряжения U си крутизна этих графиков постепенно уменьшается и при превышении некоторого уровня  (напряжение насыщения), зависящего от значения U зи, кривые графиков становятся почти горизонтальными линиями.
(напряжение насыщения), зависящего от значения U зи, кривые графиков становятся почти горизонтальными линиями.
Уменьшение крутизны графиков по мере увеличения U си обусловлено уменьшением толщины канала вблизи ЭС под действием напряжения U си. При достижении этим напряжением некоторого значения  толщина канала около ЭС уменьшается до нуля (происходит перекрытие правого конца канала). Нижняя граница области p–n- перехода в этом режиме работы транзистора на рис.2 обозначена линией β2. При U си >
толщина канала около ЭС уменьшается до нуля (происходит перекрытие правого конца канала). Нижняя граница области p–n- перехода в этом режиме работы транзистора на рис.2 обозначена линией β2. При U си >  нижняя граница области p–n- перехода изменяется так, что протяжённость области перекрытия канала достигает некоторого значения ∆L. Такому режиму соответствует нижняя граница p–n- перехода, обозначенная линией β3. Дальнейшее увеличение U си приводит к возрастанию ∆L, и некоторому уменьшению длины неперекрытой части канала L к. Это явление называют эффектом модуляции длины канала. При этом к области перекрытия канала длинной ∆L приложено напряжение ∆U = U си –
нижняя граница области p–n- перехода изменяется так, что протяжённость области перекрытия канала достигает некоторого значения ∆L. Такому режиму соответствует нижняя граница p–n- перехода, обозначенная линией β3. Дальнейшее увеличение U си приводит к возрастанию ∆L, и некоторому уменьшению длины неперекрытой части канала L к. Это явление называют эффектом модуляции длины канала. При этом к области перекрытия канала длинной ∆L приложено напряжение ∆U = U си –  , обеспечивающее прохождение тока I c через эту область. Поэтому в режиме, когда U си >
, обеспечивающее прохождение тока I c через эту область. Поэтому в режиме, когда U си >  , увеличение U си приводит к незначительному нарастанию тока I c.
, увеличение U си приводит к незначительному нарастанию тока I c.
Напряжение насыщения  определяется в соответствии с равенством:
определяется в соответствии с равенством:
|  | = |
| = |  | – |
| – |  |,
|,
где  напряжение отсечки (значение напряжения U зи < 0, при котором происходит перекрытие канала по всей её длине), когда ток I c становится близким к нулю.
напряжение отсечки (значение напряжения U зи < 0, при котором происходит перекрытие канала по всей её длине), когда ток I c становится близким к нулю.
Ток стока при напряжении U зи = 0 и напряжении U си  |
|  | называется начальным током стока транзистора (
| называется начальным током стока транзистора ( ).
).
При достаточно больших значениях напряжения U си возникает пробой области p–n- перехода вблизи стока, что сопровождается резким возрастанием тока I c. Чем больше U зи, тем меньше напряжение U си, при котором начинается пробой, т.к. обратное напряжение на p–n- переходе вблизи правого (стокового) конца канала равно сумме | U си | + | U зи |.
В режиме насыщения тока I c, когда U си >  передаточная характеристика достаточно хорошо аппроксимируется выражением
передаточная характеристика достаточно хорошо аппроксимируется выражением
 ;
;
где α – параметр аппроксимации; α = 1,5...2,5.
В варианте планарной структуры кристалла полевых транзисторов с управляющим p–n- переходом (рис.5) между концами канала n -типа и электродами ЭИ и ЭС созданы n + -области с высокой концентрацией донорной примеси. Это позволяет уменьшить сопротивления между электродами ЭИ и ЭС и n -каналом. Электроды ЭИ, ЭЗ, ЭС расположены на одной грани кристалла полупроводника. Поверхность этой грани покрыта защитной оксидной пленкой (SiO2).


















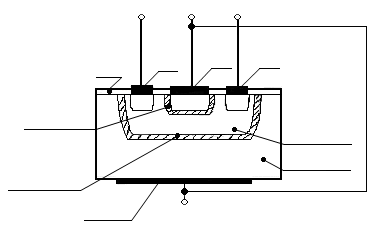
Рис. 5
При создании этой структуры в кристалле кремния p -типа (подложке) сначала путём диффузии через верхнюю грань кристалла вводится донорная примесь (при этом образуется n -область), а затем в эту область через окна (незащищённые слоем SiO2 участки поверхности кристалла) вводятся атомы примесей для образования p +- и n + - областей кристалла. Канал n -типа создан между верхним и нижним p–n- переходами кристалла.
Полевые транзисторы с изолированным затвором. В этих транзисторах ЭЗ изолирован от полупроводникового кристалла тонким слоем диэлектрика, т.е. они имеют структуру типа «металл – диэлектрик – полупроводник». Поэтому они называются также транзисторами МДП-типа. В случае, когда в качестве диэлектрика используется оксид кремния (SiO2), их называют МОП-транзисторами (структура «металл – оксид – полупроводник»).
Принцип действия МДП-транзистора основан на использовании физического явления, называемого эффектом поля. Это явление заключается в том, что под действием напряжения, приложенного между ЭЗ и подложкой, происходит изменение электропроводимости прилегающего к диэлектрику тонкого слоя полупроводника (канала).
МОП-структура (рис.6) представляет собой своеобразный конденсатор с металлическим и полупроводниковым электродами (обкладками). Если к ним приложить напряжение, то на них накапливаются электрические заряды.



|







|
|
|





| |
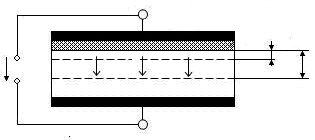
 Рис. 6
Рис. 6
В металлах число свободных электронов велико (сравнимо с числом атомов), поэтому заряд металлической обкладки «конденсатора» сосредоточивается в его тончайшем поверхностном слое со стороны диэлектрика. Заряд полупроводниковой обкладки конденсатора из-за относительно малой концентрации свободных носителей заряда в ней распределяется в поверхностном слое значительно большей толщины, чем в металлической обкладке.
Если в случае полупроводника p -типа между металлическим электродом и полупроводниковой подложкой приложить положительное напряжение (U мп > 0), то под действием создаваемого им электрического поля дырки будут оттесняться от прилегающей к диэлектрику поверхности подложки, а свободные электроны будут притягиваться к этой поверхности. В результате в поверхностном слое полупроводника некоторой толщины l ос нарушается ее электрическая нейтральность и этот слой приобретает отрицательный заряд, обусловленный распределенными по объему подложки в пределах данного слоя неподвижными отрицательными ионами акцепторной примеси полупроводника и более тонким приповерхностным слоем притянутых к поверхности полупроводника электронов. Этот суммарный отрицательный заряд поверхностного слоя представляет собой заряд полупроводниковой обкладки конденсатора типа МДП-структуры. При малых значениях U мп этот поверхностный слой полупроводника находится в режиме обеднения свободными носителями электрического заряда по сравнению с равновесным состоянием кристалла.
Электрическое поле в диэлектрике является однородным, (Е д = const), т.к. в диэлектрике практически нет свободных носителей электрических зарядов. Напряженность электрического поля в полупроводнике (Е п) убывает начиная от наибольшего значения на верхней поверхности кристалла полупроводника до уровня, близкого к нулю, в пределах толщины l ос поверхностного слоя неравновесного распределения индуцированного электрического заряда.
По мере увеличения значения этого напряжения толщина обедненного слоя увеличивается, а концентрация дырок в нем уменьшается.
При превышении значения U мп некоторого порогового значения концентрация дырок в тонком приповерхностном слое полупроводника со стороны диэлектрика становится меньше концентрации электронов, притягивающихся сюда электрическим полем из глубины подложки. Тогда в тонком приповерхностном слое верхней грани подложки происходит режим инверсии типа электропроводности полупроводника (на поверхности индуцируется канал n -типа). Этот инверсный слой имеет толщину l ис в несколько нанометров. При этом l ис << l ос.
МОП-транзистор с индуцированным каналом. Вустройстве МДП-транзистора с индуцированным каналом n -типа (рис.7) структура кристалла транзистора состоит из подложки p -типа, в которой сформированы две низкоомные области n + -типа.
На поверхности диэлектрической оксидной пленки (SiO2) расположен ЭЗ. Внешний вывод транзистора подложка (П) обычно электрически соединяется с выводом И либо внутри корпуса прибора при его изготовлении, либо при внешнем монтаже схемы электронного устройства, создаваемого с использованием данного транзистора.




















Рис. 7
В равновесном состоянии кристалла полупроводника (когда U си = 0, U зи = 0) вдоль поверхностей границ раздела p- области с левой и правой n + - областями возникают слои р–п- переходов. При этом p- область в верхнем приповерхностном слое кристалла разделена от левой и правой n + -областей этими слоями p–n -переходов.
Если при U зи = 0 подать напряжение U си > 0, то на стоковой p–n -переход (находящийся между правой n + -областью и p- областью кристалла) будет подано обратное напряжение, а на истоковый p–n -переход (находящийся между левой n + - областью и p- областью кристалла) будет подано прямое напряжение. В этом режиме работы ток I c равен обратному току стокового p–n -перехода, и его численное значение близко к нулю.
При небольших значениях напряжения U зи > 0 в верхнем приповерхностном слое кристалла между n +- областями возникает режим обеднения свободными носителями электрического заряда. Нижняя граница этой обедненной области и нижние границы истокового и стокового р–п -переходов (являющихся также обедненными свободными носителями электрического заряда областями) на рис.7 показана штриховой линией β. Этот приповерхностный обедненный слой, так же как и р–п -переход, содержит распределенный в объеме заряд отрицательной полярности, обусловленный зарядами ионов атомов акцепторной примеси. Толщина обедненной области стокового р–п -перехода больше толщины истокового перехода, поскольку под действием U си > 0 на стоковом р–п -переходе создается напряжение прямой, а на истоковом – обратной полярности.
При увеличении напряжения U зи до некоторого порогового значения ( ) в тонком приповерхностном слое кристалла под диэлектрической пленкой между n + - областями возникает режим инверсии типа проводимости полупроводника, т.е. (между
) в тонком приповерхностном слое кристалла под диэлектрической пленкой между n + - областями возникает режим инверсии типа проводимости полупроводника, т.е. (между  -областями кристалла индуцируется токопроводящий канал п -типа.
-областями кристалла индуцируется токопроводящий канал п -типа.
По мере дальнейшего увеличения напряжения U зи толщина канала практически не меняется, но происходит увеличение в нем концентрации свободных электронов за счет экстракции все большего их числа из глубины подложки и из n + - областей. При этом сопротивление канала уменьшается, а ток I с увеличивается (рис.8, a).



|
|
|














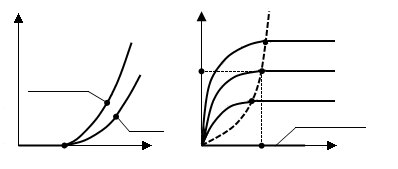
а б
Рис. 8
Уменьшение крутизны графиков семейства статических выходных ВАХ МДП-транзистора с индуцированным каналом п -типа (рис.8, б) по мере увеличения U си происходит вследствие уменьшения концентрации электронов на правом конце канала под действием электрического потенциала электрода ЭС. При превышении напряжения U синекоторого значения  (напряжения насыщения) в конце канала образуется обеднённая свободными носителями электрического заряда область, сопротивление которой по мере дальнейшего увеличения U си возрастает так, что ток I снарастает незначительно.
(напряжения насыщения) в конце канала образуется обеднённая свободными носителями электрического заряда область, сопротивление которой по мере дальнейшего увеличения U си возрастает так, что ток I снарастает незначительно.
МДП-транзистор со встроенным каналом. Структура кристалла МДП-транзистора со встроенным каналом п -типа (рис.9) в тонком приповерхностном слое подложки р -типа под слоем диэлектрика, который может быть создан при изготовлении транзистора в результате локальной диффузии или ионной имплантации донорной примеси в приповерхностный слой подложки р -типа:
|
|









|
|


|











|




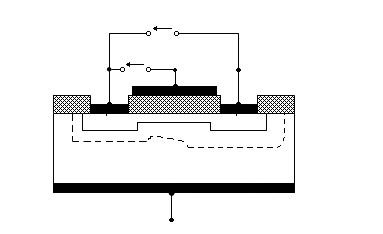
Рис. 9
Встроенный канал может также самопроизвольно образовываться благодаря содержанию в диэлектрической плёнке оксида кремния является то, что она всегда содержит примеси донорного типа (натрий, калий, водород). Поэтому в этой пленке на границе с кремниевой подложкой р -типа образуется тонкий слой положительно заряженных донорных атомов, а отданные ими электроны, переходя в приповерхностный слой кремния, рекомбинируют с дырками. Тогда в поверхностном слое подложки р -типа образуется объемный отрицательный заряд ионов. При этом наряду с обедненным слоем может возникнуть и тонкий приповерхностный инверсионный п -слой (встроенный канал п -типа).
Встроенный канал может возникнуть также в результате изменения характера распределения атомов примесей вблизи поверхности подложки в процессе термического окисления ее поверхности с образованием диэлектрического оксидного слоя SiO2.
Графики семейства проходных вольт-амперных характеристик рассматриваемого транзистора показаны на рис.10, а. Транзистор может проводить ток как при U зи > 0, так и при U зи < 0. В случае U зи > 0 электроны подтягиваются из глубины подложки в область канала, что приводит к режиму обогащения канала свободными носителями электрического заряда и возрастанию тока I с по мере увеличения U зи.
В случае U зи < 0 (режим обеднения канала свободными носителями электрического заряда) электроны из канала оттесняются в глубь подложки и в канале уменьшается концентрация свободных носителей электрического заряда. В этом случае по мере увеличения | U зи | ток I с уменьшается.














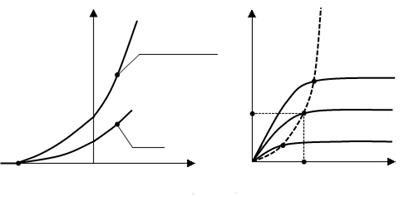
Рис. 10
Графики семейства выходных ВАХ рассматриваемого МДП-транзистора показаны на (рис.10, б). Замедление роста тока стока I c с увеличением напряжения U си, связано с нарастанием продольного падения напряжения в канале. Потенциал точек канала возрастает по мере удаления от ЭИ в сторону ЭС, а разность потенциалов между ЭЗ и подложкой уменьшается от значения U зи около ЭИ до значения (U зи – U си) около ЭС. Соответственно уменьшаются напряженность электрического поля в диэлектрике SiO2 и на верхней поверхности подложки, а следовательно, снижается концентрация электронов в канале. Это приводит к возрастанию продольного сопротивления канала. При увеличении напряжения U си до некоторого  , как и в случае МДП-транзистора с индуцированным каналом, на правом конце канала возникает режим обеднения. Поэтому при дальнейшем увеличении U си ток I c практически не возрастает.
, как и в случае МДП-транзистора с индуцированным каналом, на правом конце канала возникает режим обеднения. Поэтому при дальнейшем увеличении U си ток I c практически не возрастает.
Полевой транзистор с переходом Шотки. Этот вид полевых транзисторов появился в связи с использованием в интегральной схемотехнике арсенида галлия, который позволяет существенно увеличить быстродействие элементов вычислительной и информационной техники. Высокое быстродействие арсенид-галлиевых полупроводниковых приборов объясняется значительно большей подвижностью электронов в этом полупроводнике, чем в кремнии.
Кроме того, арсенид галлия имеет более широкую запрещенную зону, поэтому p–n- переход в этом материале имеет лучшие изолирующие свойства, чем в кремнии.
По принципу действия этот транзистор подобен полевому транзистору с управляющим p–n -переходом, где роль p–n -перехода играет переход металл-полупроводник (переход Шотки). Такой транзистор иногда называют полевым транзисторомс переходом Шотки (рис. 11).
Условное графическое обозначение транзистора такое же, как у транзистора с управляющим p–n -переходом (см. рис.1).
|
|
|
|
|
|
|
|

|
|


|
|
|




При условии, если работа выхода электронов из полупроводника меньше, чем из металла (ЭЗ) электроны поверхностного слоя полупроводника переходят на ЭЗ. В полупроводнике под ЭЗ возникает слой, обеднённый свободными носителями электрического заряда и содержащий объемный заряд неподвижных положительных ионов атомов донорной примеси. Эта область называется переходом металл-полупроводник (переход Шотки). Толщину этого слоя и соответственно толщину канала n -типа можно изменять меняя напряжение U зи. Графики семейства проходных и выходных статических ВАХ транзистора с переходом Шотки аналогичны графикам ВАХ полевых транзисторов с управляющим p–n -переходом.
Дифференциальные параметры и электрические модели полевого транзистора. Если режим работы транзистора характеризуется одновременным действием постоянной ( ,
,  ) и переменной (u си, u зи) составляющими напряжений, то при малых значениях переменных составляющих напряжений (u зи <<
) и переменной (u си, u зи) составляющими напряжений, то при малых значениях переменных составляющих напряжений (u зи <<  , u си <<
, u си <<  ) можно пользоваться линеаризованными статическими ВАХ, получаемыми на основе формулы полного дифференциала функции. Т.к. ток стока является функцией двух переменных I c = I c (U си, U зи), то полный дифференциал тока стока определяется виде соотношения
) можно пользоваться линеаризованными статическими ВАХ, получаемыми на основе формулы полного дифференциала функции. Т.к. ток стока является функцией двух переменных I c = I c (U си, U зи), то полный дифференциал тока стока определяется виде соотношения
 . (1)
. (1)
Входящие в выражение (1) частные производные определяют тангенсы углов наклона графиков линеаризованных ВАХ транзистора. При некоторых заданных значениях постоянных составляющих напряжений U си, U зи они являются следующими дифференциальными параметрами транзистора:
- крутизна передаточной характеристики
 ; (2)
; (2)
- дифференциальное сопротивление цепи исток-сток
 . (3)
. (3)
Уравнение (1) с учетом (2) и (3) принимает вид
 . (4)
. (4)
Полагая в (4) приращения dU си и dU зи такими, что dI c =0, получаем
 , (5)
, (5)
где µ – коэффициент усиления транзистора по напряжению.
Коэффициент усиления µ показывает, насколько U зи сильнее влияет на изменение I c, чем U си.
Статические дифференциальные параметры s,  и µ для некоторого заданного режима работы транзистора, определяемого значениями
и µ для некоторого заданного режима работы транзистора, определяемого значениями  ,
,  , можно определить по статическим передаточным или выходным вольтамперным характеристикам, заменяя в формулах (2), (3) и (4) дифференциалы переменных их малыми конечными приращениями ∆ I c, ∆ U си,∆ U зи.
, можно определить по статическим передаточным или выходным вольтамперным характеристикам, заменяя в формулах (2), (3) и (4) дифференциалы переменных их малыми конечными приращениями ∆ I c, ∆ U си,∆ U зи.
Если в (4) эти приращения рассматривать как переменные составляющие тока i c и напряжений u си и u зи, то (4) принимает вид
 . (6)
. (6)
С учетом (5) равенство (6) представляется в виде
 . (7)
. (7)
Из уравнений (6) и (7) следуют упрощённые варианты электрических моделей транзистора для случаев не очень быстрых малых изменений напряжений (рис.12, а и рис.12, б), где i s = su зи, e µ = – µ u зи.
При достаточно быстрых изменениях напряжений эквивалентные схемы рис.12 должны быть дополнены емкостными параметрами транзистора.
|
|
|
|
|
|
|
|



а б
Рис. 12
Схема варианта реализации электрической модели транзистора с управляющим р–n- переходом для случая достаточно быстрых изменений напряжения (рис.13) содержит дифференциальные параметры (s, r си), межэлектродные емкости (Сзс, Сзи, Сси), емкость p–n- перехода между затвором и каналом (Сзк), сопротивление обратно смещенного p–n -перехода (Rзк), объемное сопротивление канала между p–n -переходом и истоком (Rк) и источник тока  , выражающий усилительные свойства транзистора.
, выражающий усилительные свойства транзистора.
Типичные значения этих параметров у маломощных транзисторов находятся в пределах: s = 0,3…10 мА/В; (С зс, С зи, С си) = 0,2…1,0 пФ; С зк = 2…10 пФ; R зк= 108…109 Ом;  = 104…106 Ом; R к = 50…200 Ом.
= 104…106 Ом; R к = 50…200 Ом.
Быстродействие устройств на основе полевых транзисторов определяется значениями межэлектродных емкостей, постоянной времени транзистора  и зависимостью s от частоты входного сигнала.
и зависимостью s от частоты входного сигнала.
| |||
| |||
|
|
|
|
|
|
|

|
|
|
|
|

 2020-10-10
2020-10-10 124
124









