Изготовление фотошаблонов.
Пол __Мужской_
Тест самоактуализации
Неисправности
Правильно собранная схема не дает треска, щелчков или сильного шума, гула из колонок. Если что-то из этого есть, то надо проверить схему еще раз: может быть, не припаян какой-либо "минусовой" провод. К "минусу" питания должны быть также припаяны оплетки звукового кабеля от источника звука. Можно попробовать изменить положение проводов, укоротить их. Если усилитель не подает признаков жизни даже после поворота ручек резистора, надо проверить наличие питания. Если оно было подключено в обратной полярности, микросхема уже не оживет никогда. В этом случае она, как правило, вздулась или треснула, может быть вылетел кусок, пахнет гарью =). Собранную схему можно запихнуть в колонки или оформить в отдельный корпус.
Ф.И.О. ___Жигилий Дмитрий__
| 1. | 2. | 3. | 4. |
| 5. | 6. | 7. | 8. |
| 9. | 10. | 11. | 12. |
| 13. | 14. | 15. | 16. |
| 17. | 18. | 19. | 20. |
| 21. | 22. | 23. | 24. |
| 25. | 26. | 27. | 28. |
| 29. | 30. | 31. | 32. |
| 33. | 34. | 35. | 36. |
| 37. | 38. | 39. | 40. |
| 41. | 42. | 43. | 44. |
| 45. | 46. | 47. | 48. |
| 49. | 50. | 51. | 52. |
| 53. | 54. | 55. | 56. |
| 57. | 58. | 59. | 60. |
| 61. | 62. | 63. | 64. |
| 65. | 66. | 67. | 68. |
| 69. | 70. | 71. | 72. |
| 73. | 74. | 75. | 76. |
| 77. | 78. | 79. | 80. |
| 81. | 82. | 83. | 84. |
| 85. | 86. | 87. | 88. |
| 89. | 90. | 91. | 92. |
| 93. | 94. | 95. | 96. |
| 97. | 98. | 99. | 100. |
Фотошаблоны широко применяются в технологии интегральных микросхем как на стадии формирования активных элементов в полупроводниковом материале, так и при создании пассивных элементов и межсоединений.
Фотошаблон – стеклянная пластина (подложка) с нанесенным на ее поверхности маскирующим слоем – покрытием, образующим трафарет с прозрачными и непрозрачными для оптического излучения участками. В процессе фотолитографии слой фоторезиста экспонируется в соответствии с рисунком покрытия, имеющегося на фотошаблоне.
Подложку фотошаблона выполняют либо из обычного стекла (при экспонировании светом с длиной волны l более 300 нм), либо из кварцевого стекла (при l менее 300 нм). В качестве материала маскирующего слоя фотошаблона обычно используется хром, оксиды хрома, железа и др., образующие твердые износостойкие покрытия.
К фотошаблонам для производства полупроводниковых структур предъявляется комплекс требований, к которым в первую очередь следует отнести следующие: оптическая плотность маскирующего материала должна быть не менее 2,0; толщина маскирующего материала – не более 100 нм; его отражательная способность не выше 15%; неплоскостность от нескольких мкм до десятков мкм (для разных классов фотошаблонов); микродефектность порядка 0,1 см-2; краевая четкость рисунка не ниже 0,1 мкм для элементов изображения с размером менее 1 мкм.
Конструкция полупроводниковой микросхемы полностью определяется её физической структурой (совокупностью слоёв в кристалле, отличающихся материалом и электрофизическими свойствами) и топологией (формой, размерами, относительным расположением отдельных областей и характером межсоединений по поверхности кристалла). Можно также сказать, что структура – это чертёж поперечного сечения кристалла интегральной микросхемы, а топология – вид в плане.
На рис приведен фрагмент структуры микросхемы, представляющей n-p-n-транзистор и включённый в коллекторную цепь резистор, а на рис. 4,б – топология этого же участка. На рис. 4,а цифрами обозначены: 1 – исходная монокристаллическая пластина – подложка; 2 – открытый слой; 3-эпитаксиальный слой (он же коллекторный); 4 – разделительный слой; 5 – базовый слой; 6 – эмиттерный слой; 7 – изолирующий слой с контактными окнами; 8 – слой металлизации; 9 – защитный слой (обычно SiO2).
Рис. Фрагмент интегральной микросхемы: а – структура; б – топология.
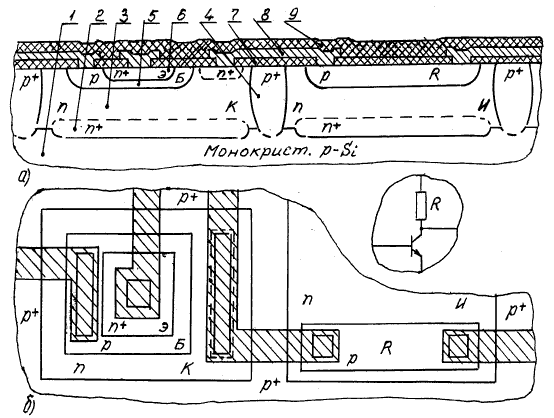
Каждый из слоёв 2…6 представляет собой совокупность отдельных островков (областей), имеющих одинаковые толщины, тип проводимости (электронная n или дырочная p) и характер распределения примеси по толщине. Это достигается одновременным введением примеси через окна защитной маски из SiO2, формируемой предварительно на поверхности пластины-кристалла. В отличие от слоёв 2…6 слои 7, 8 и 9 получают путём формирования сплошной плёнки и последующего избирательного травления с использованием фотошаблона. В результате изолирующий слой 7 (SiO2) содержит контактные окна, слой металлизации 8 (обычно Al) – систему соединительных проводников и периферийные монтажные площадки, а слой 9 – окна над монтажными площадками.
Приведённая структура получила название эпитаксиально-планарной и предполагает взаимную изоляцию смежных элементов за счёт обратносмещенных p-n-переходов на границах изолирующего слоя. Высоколегированный скрытый слой (n+) служит для уменьшения сопротивления коллекторов транзисторов и за счёт этого повышения их быстродействия. Области n+ под коллекторными контактами исключают образование потенциального барьера (барьера Шоттки), обеспечивают, таким образом, омический контакт со слаболегированным коллектором и принадлежат эмиттерному слою.
 2014-02-17
2014-02-17 404
404