Окончательная обработка кремния
Основные способы определения качества кремния
Визуальный осмотр. Отбраковывают части слитка, имеющие неправильную форму, меньший диаметр, плоскости двойникования.
Селективное травление п роводят в хвостовой части кристаллического слитка для выявления дислокаций. Используют травитель Сиртла, состоящий из 49% HF и 5 М хромовой кислоты, смешанной в пропорции 1:1.
Ультразвуковой метод применяется для выявления микротрещин.
Четырехзондовый метод применяется для определения удельного сопротивления кремния (концентрации примесей). При этом контролируются постоянство прижима электродов-зондов и температура монокристалла.
Из установки извлекают кремниевый слиток диаметром 20 - 50 см и длиной до 3 метров. Для получения из него кремниевых пластин заданной ориентации и толщиной в несколько десятых миллиметра производят следующие технологические операции:
- Механическая обработка слитка:
отделение затравочной и хвостовой части слитка;
обдирка боковой поверхности до нужной толщины;
шлифовка одного или нескольких базовых срезов (для облегчения дальнейшей ориентации в технологических установках и для определения кристаллографической ориентации);
резка алмазными пилами слитка на пластины: (100) - точно по плоскости (111) - с разориентацией на несколько градусов.
- Травление. На абразивном материале SiC или Al2O3 удаляются повреждения высотой более 10 мкм. Затем в смеси плавиковой, азотной и уксусной кислот, приготовленной в пропорции 1:4:3, или раствора щелочей натрия производится травление поверхности Si.
- Полирование - получение зеркально гладкой поверхности. Используют смесь полирующей суспензии (коллоидный раствор частиц SiO2 размером 10 нм) с водой.
В окончательном виде кремний представляет собой пластину диаметром 15 - 40 см, толщиной 0.5 - 0.65 мм с одной зеркальной поверхностью.
Получаемая при окислении пленка SiO2 выполняет следующие функции:
защита поверхностей вертикальных участков p-n переходов, выходящих на поверхность;
маски, через окна которой вводится необходимые примеси при легировании;
тонкого диэлектрика под затвором МОП транзистора;
для межслойной изоляции разводки;
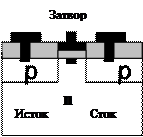
Рис. 4. Схема МОП-транзистора
Методы получения слоев SiO2:

Получаемые слои SiO2 совершенны по равномерности толщины и структуре, а также обладают высокими диэлектрическими свойствами.
Существует две основные разновидности метода термического окисления кремния:
1) высокотемпературное окисление в атмосфере сухого кислорода или водяного пара при атмосферном давлении;
2) окисление в парах воды при высоком давлении и температуре 500¸800°С;
Процесс окисления кремния происходит в три этапа:
1) адсорбция окислителя поверхностью пластины, покрытой оксидом;
2) перенос окислителя через оксидный слой SiO2;
3) реакция окислителя с кремнием на границе Si - SiO2;
Толщина оксидной пленки определяется по формуле:
 , где
, где
k – коэффициент, зависящий от температуры и влажности кислорода;
t – время;
Особенности:
окисление при сухом кислороде в десятки раз медленнее влажного;
с уменьшением температуры на каждые 100° время окисления повышается в 2¸3 раза;
Различают толстые (0,7¸0,8 мкм) и тонкие (0,1¸0,2 мкм) слои.
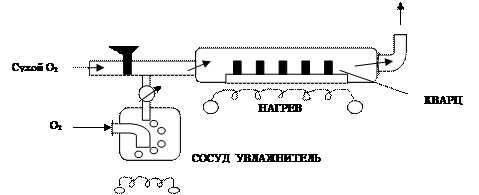
Рис. 5. Однозонная высокотемпературная печь
В промышленности выполняется комбинированное окисление: сначала выращивается тонкий слой SiO2 в сухом кислороде, толстый слой SiO2 во влажном, а затем снова в сухом.
Недостатки метода термического окисления – трудноуправляемые физические явления:
возникновение зарядов в слое оксида;
невысокая стойкость к проникновению водяных паров и ионов щелочных металлов;
малый коэффициент теплопроводности;
Дальнейшим совершенствованием метода является освоение новых материалов. Одним из перспективных материалов является Si3N4.
Преимущества:
материал обладает лучшими маскирующими и защитными свойствами в меньших толщинах из-за более высокой плотности и термостойкости;
высокая скорость нанесения (до 10нм/мин);
электрическая прочность выше чем у SiO2 (107 В/см);
Для получения слоев используются методы:
1) осаждение продуктов при протекании реакции взаимодействия силана кремния (Si3N4) c аммиаком или гидразином (N2H4);
2) нанесение реактивным катодным распылением; высокочастотным реактивным распылением в плазме азота; плазмохимическим осаждением Si в присутствии азота.
 2014-02-24
2014-02-24 1368
1368
