Отжиг после ионного внедрения необходим для восстановления нарушенной радиацией кристаллической решетки полупроводника и перевода ионов в электрически активное состояние, в котором непосредственно после проведения процесса ионной имплантации находится около 10% внедренных ионов. За 10...20 мин при температурах до 700 °С смещенные атомы полупроводника и внедренные ноны приобретают достаточную подвижность и переходят в вакантные узлы решетки. Происходит упорядочение структуры полупроводника и достигается цель легирования: примесь, находящаяся в узлах, выполняет роль доноров или акцепторов. Электрическая активация большинства внедренных примесей начинается при температурах свыше 300°С.
Коэффициент активности прмеси  или
или  .
.
На рис. 8.17 показан профиль полного количества атомов бора 1 (70 кэВ, 1015 см-2) после отжига при 800 °С и распределение концентрации активных атомов 2. Чем выше доза облучения, тем более высокие температуры требуются для полной электрической активации примесей (рис. 8.18).
Отрицательным воздействием высокотемпературной обработки при этом является диффундирование атомов примеси, которое искажает первоначально сформированный профиль распределения внедренных атомов.
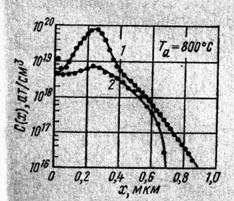 а а |  |
| Рис. 8.17. Распределения внедренных атомов бора 1 и дырок 2 | Рис. 8.18. Дозовая зависимость степени электрической активности фосфора |
Выбор температуры отжига, обеспечивающей полную активацию доноров и акцепторов и устранение остаточных дефектов, с одной стороны, и минимальное протекание диффузии введенных атомов, с другой стороны, является одной из основных проблем технологии ИИ.
По-разному во время отжига ведут себя легкие и тяжелые примесные ионы. Так легким ионам В легче передвигаться по кристаллу, и соответственно для них вероятность занять места в узлах кристаллической решетки больше, чем для тяжелых атомов Ga, In или Tl (рис. 8.19). Поэтому эти три элемента редко применяются для создания легированных областей методом ИИ.
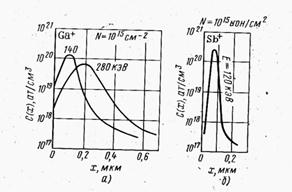 |
| Рис. 8.19. Профили распределения Ga (а) и Sb (б) в кремнии |
Во время отжига протекают одновременно несколько процессов: отжиг радиационных дефектов, диффузия примесей и самодиффузия, ассоциация и диссоциация образованных ранее дефектных комплексов, перевод аморфных участков полупроводника, образовавшихся после ИИ, в монокристаллические. В случае малой дозы имплантированных ионов их электрическая активность возрастает при увеличении температуры отжига (рис. 8.20).
| |||
| Рис. 8.20. Зависимость отношения концентрации атомов бора в узлах кристаллической решетки к дозе имплантации бора от температуры изохорного (30 мин) отжига при энергии ионов бора 150 кэВ и различных дозах D: 1 – D =2∙1015; 2 – D =2,5∙1014; 3 – D =8∙1012 ион∙см-2 |
В области I происходит ликвидация дивакансий. При увеличении дозы облучения происходит падение степени замещения узлов кристаллической решетки внедренными ионами, этот эффект обычно называют отрицательным отжигом. Для области II характерны переход атомов кремния из междоузлии и вытеснение ими примесных ионов из кристаллической решетки. При повышении температуры от 700 до 1000 °С концентрация активных атомов бора вновь увеличивается (область III).
При температуре отжига процессы диффузии несколько меняют профиль распределения (см. рис. 8.21).
 |
| Рис. 8.21. Влияние термообработки на распределение фосфора, внедренного в кремний |
В дефектном слое примесь диффундирует быстрее, что приводит к размытию профиля легирования, поэтому максимум сдвигается к поверхности, где больше дефектов.
Примеры профилей распределения ионов
Теоретический расчет распре деления пробегов внедренных ионов не может учесть всех явлений, сопровождающих имплантацию и отжиг: степень влияния каналирования, миграцию внедренных атомов в процессе имплантации и отжига, влияние радиационных дефектов и др., поэтому реальные профили отличаются от кривой Гаусса.
На рис. 8.22, а показаны профили распределения атомов В. С увеличением энергии ионов В профили приобретают явный асимметричный вид, причем глубинные фронты спадают более круто, чем поверхностные. Это связано с тем, что в начале пробега ноны бора обладают высокой энергией, роль ядерного торможения невелика, ноны рассеиваются на малые углы, траектории их более прямолинейны, они «проскакивают» вглубь кристалла. Асимметрия сильнее выражена при более высоких энергиях. Такой же вид имеют профили распределения атомов В, внедренных в аморфный кремний.
 |
| Рис. 8.22. Профили распределения ионов бора в кремнии: а—при неориентированном внедрении по оси [763]; б—при каналированив вдоль оси [110] |
Профиль бора, внедренного с дозой 1015 см-2 в произвольно ориентированный монокристаллический кремний с энергией 70 кэВ, имеет вытянутый глубинный фронт, связанный с проявлением эффектов каналирования и реканалирования (рис. 8.22,6). Эффект каналирования по направлению [110] приводит к значительному углублению профиля. Кривая имеет два максимума, причем ближайший к поверхности максимум немного смещен вглубь кристалла относительно максимума кривой Гаусса, получаемой для неориентированного внедрения.
Профили внедренных атомов фосфора, показанные на рис. 8.23,а (отжиг 800 °С –20 мин), также отличаются от кривой Гаусса наличием удлиненных хвостовых участков, обусловленных реканалированием. Увеличение дозы облучения приводит к пропорциональному росту концентрации фосфора на всех глубинах. При этом сохраняются «хвосты» распределений и глубина рп -переходов может значительно возрасти. Влияние взаимной ориентации пучка ионов фосфора и кристалла кремния на форму профиля распределения показывает рис. 8.23, б.
Разориентация до 2° значительно уменьшает количество каналированных ионов, тогда как поворот плоскости (110) на 8° относительно направления падения пучка практически устраняет каналирование.
 |
| Рис. 8.23. Профили распределения фосфора в кремнии: а – неориентированное внедрение; б – различные углы разориентации от направления [110] |
 2014-02-09
2014-02-09 1839
1839