Достоинства ионной имплантации:
· быстрый процесс;
· можно проводить при Тк;
· применять для легирования примесями с низкими коэффициентами диффузии или низкими растворимостями в твердой фазе, а также для легирования полупроводников с низкой температурой плавления (InAs) или полупроводников, диффузионное легирование которых требует очень высоких температур (SiC);
· точная дозировка примеси (теоретически – 1%, практически – 5%);
· высокая чистота;
· расширенная возможность локального легирования (широкий круг маскирующих материалов, меньше боковое легирование);
· можно легировать вообще через маску;
· возможность получения управляемого профиля распределения – вплоть до формирования захороненного слоя.
· возможность создания мелких переходов является основным достоинством процесса ИИ. Технически осуществимым является сосредоточение легирующих примесей в слое толщиной 20 нм, это значит, что р—n -переход будет заметен на глубине около 40 атомных слоев. Создание мелких переходов требует исключения эффекта каналировапия, полное устранение которого достигается предварительной аморфизацией кремния.
· имплантация, так же как диффузия, может быть общей и локальной. Важным достоинством ИИ является то, что ионы, двигаясь по прямой линии, внедряются только в глубь пластины, а боковая диффузии (под маску) практически отсутствует. При локальном ИЛ возможен независимый выбор примеси профилей в вертикальном и горизонтальном направлениях. Для широкофокусного пучка профиль распределения внедренных ионов в горизонтальном направлении формируется с помощью маски, при этом размеры легированной области более точно, чем при диффузии, воспроизводят размеры окна (рис. 8.25).
· ИИ, как и диффузию, можно проводить многократно, «встраивая» один слой в другой. Однако сочетание энергий, времен экспозиции и режимов отжига, необходимое для многократной ИИ, оказывается затруднительным, поэтому ИИ получила главное распространение при создании одинарных слоев.
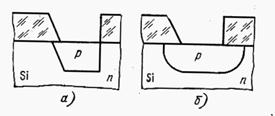 |
| Рис. 8.25. Фронт р-п перехода при ионном (а) и диффузионном (б) локальном легировании |
· в отличие от диффузии при ИЛ свойства получаемых слоев в основном определяются внешними электрическими параметрами процесса. ИЛ легко управлять путем изменения ускоряющего напряжения, плотности ионного пучка, угла наклона пучка, времени облучения пластин, а в случае обработки сфокусированным пучком и скорости его сканирования.
Недостатки и ограничения ионного легирования:- необходимость отжига; сложность воспроизводимого легирования слоев толщиной более 1 мкм; сложность однородного легирования пластин большого диаметра из-за расфокусировки луча при больших отклонениях, сложность оборудования.
Отметим также, что применение ионного легирования не ограничено только легированием.
Применение ионного легирования:
· введение примеси (точная дозировка);
· модификация свойств материала;
· создание захороненного слоя оксида кремния;
· геттерирование примеси.
 2014-02-09
2014-02-09 3001
3001
