для измерения D Е полупроводника
Основой любого полупроводникового диода является р - n - переход. который образуется при контакте двух полупроводников n - и p -типа.
Электронная (n -типа) проводимость образуется при введении в собственный полупроводник донорной примеси. Донорами являются атомы пятой группы таблицы Менделеева (например, доноры для ПП Ge – Р, As, Sb). Уровень энергии, соответствующей донорной примеси (Еd), лежит в запрещенной зоне «ниже» Ес на 0,01 эВ для германия и на 0,05 эВ для кремния (рис. 6.2). Поэтому уже при комнатных температурах все доноры будут ионизированы, т.е. «лишние» электроны атомов донорной примеси перейдут в зону проводимости. Концентрация электронов (ne) в зоне проводимости примерно равна концентрации атомов примеси. Электроны для полупроводника n -типа – основные носители заряда. Ионизированные атомы-доноры становятся положительными ионами.
Положение уровня Ферми (ЕF) определяется температурой (Т) и концентрацией атомов донорной примеси. О качественной зависимости положения ЕF от температуры для полупроводника n -типа можно судить по диаграмме, (рис. 6.2). При 50% ионизации примесных атомов ЕF совпадает с Ed, при 100% ионизации ЕF расположен «ниже» Ed примерно на величину, равную Ес – Ed, т.е. на 0,02 эВ для германия. Это состояние и соответствует примерно комнатным температурам.
При увеличении температуры выше 40–50°С (для Ge) начинается интенсивный переход электронов из валентной зоны в зону проводимости. При этом концентрация электронов в зоне проводимости резко возрастает, но на столько же возрастает и концентрация дырок в валентной зоне. Когда ЕF достигнет середины запрещенной зоны, происходит компенсация типа проводимости – примесный полупроводник становится похожим на собственный: ne = np. Для Ge это происходит при Т = 150°С.
Дырочная проводимость (или проводимость p -типа) образуется при введении в полупроводник акцепторной примеси. Акцепторная примесь – атомы трехвалентных элементов, например для Ge – Al, Zn, Ga. На зонной диаграмме уровень энергии акцепторов (ЕА) находится тоже внутри запрещенной зоны, но вблизи потолка валентной зоны.
Для большинства акцепторов в Ge разность ЕА – ЕV = 0,01 эВ. Вследствие малости этой энергии акцепторы при комнатных температурах будут все ионизированы, что соответствует положению уровня Ферми в легированных полупроводниках вблизи верхней границы валентной зоны в зависимости от температуры.
 Еd – Энергетический уровень ЕA - Энергетический уровень
Еd – Энергетический уровень ЕA - Энергетический уровень
донорной примеси акцситорной примеси
Рис. 6.2. Зонная диаграмма примесного полупроводника
При переходе электронов из валентной зоны на акцепторный уровень (акцепторы при этом превращаются в отрицательные ионы) в валентной зоне образуются дырки, концентрация их примерно равна концентрации акцепторов: np = nA. Дырки являются основными носителями заряда для полупроводника р -типа. При комнатных температурах в зоне проводимости имеется небольшое число электронов, попавших туда из валентной зоны. Электроны для полупроводника р -типа – неосновные носители.
Положение ЕF в полупроводнике р -типа изменяется в зависимости от температуры совершенно так же, как и в полупроводнике n -типа. И все остальные рассуждения, связанные с изменением положения ЕF, аналогичны приведенным выше для n -типа.
Итак, независимо от типа проводимости германиевого полупроводника, при комнатных температурах интервал энергий ЕF – ЕV (для n -типа) или ЕС – ЕF (для р -типа) всего на 0,02 эВ меньше ширины запрещенной зоны полупроводника D Е. Это обстоятельство позволяет использовать стандартные Ge-диоды для определения D Е.
p-n -переход образуется при соединении полупроводников р - и n -типа. Вблизи границы контакта на длине свободного пробега электроны и дырки, встречаясь друг с другом, рекомбинируют. Оставшиеся нескомпенсированными ионы примеси (положительные в n -типе) и отрицательные в p -типе образуют область пространственного заряда (ОПЗ), которая своим электрическим полем препятствует диффузии основных носителей: дырок из р -области, электронов из n -области (условия равновесия).
Состояние динамического равновесия характеризуется тем, что уровень Ферми будет одинаков для p - и n -областей, как это показано на рис. 6.3, а.
В состоянии равновесия электроны в зоне проводимости полупроводников p- и n -типа имеют разную энергию, и чтобы электрону из n -области перейти в p -область, ему необходимо преодолеть потенциальный барьер ЕПБ. Именно высота этого барьера и определяет состояние равновесия.
При прямом включении высота потенциального барьера ЕПБ становится меньше (рис. 6.3, б) (так как поле источника и поле перехода Еп направлены противоположно, результирующее поле уменьшается).
При обратном включении поле источника и поле перехода Еn суммируются и высота потенциального барьера возрастает, (рис. 6.3, в). Обратный ток диода на один-два порядка меньше прямого тока и его легко замерить.
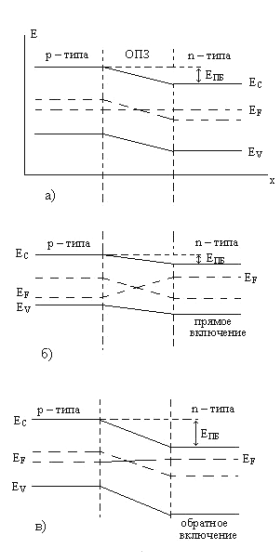
Рис. 6.3. Уровень Ферми в полупроводниках различного типа
Если на торцы p- и n- областей нанести металлизированные слои и к ним припаять выводы для подключения внешнего источника питания, то получается полупроводниковый диод (рис. 6.4), у которого p -область называется анодом, а n -область – катодом.
Внешний источник к диоду можно подключить двумя способами:
1) «Плюс» источника к аноду, а «минус» к катоду – это прямое включение.
2) «Минус» к аноду, а «плюс» к катоду – это обратное включение.
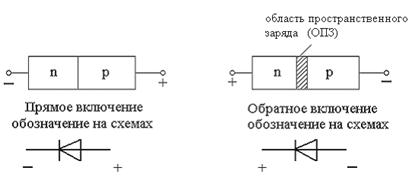
Рис. 6.4. Стандартное изображение диода
Неосновные носители в легированных полупроводниках появляются лишь при переходе электронов из валентной зоны в зону проводимости. Вероятность такого перехода пропорциональна  для р -области; для n -области ~
для р -области; для n -области ~  . Поскольку величины (ЕС – ЕF) и (ЕF – EV) в соответствующих областях мало отличаются от D Е (для германия не более чем на 0,02 эВ), то используя (6.1) можно записать обратный ток диода:
. Поскольку величины (ЕС – ЕF) и (ЕF – EV) в соответствующих областях мало отличаются от D Е (для германия не более чем на 0,02 эВ), то используя (6.1) можно записать обратный ток диода:
 (6.4)
(6.4)
где I 0 – постоянная для данного диода.
Примечание. Выражение (6.4) справедливо для резких р-n -переходов при небольшом запирающем напряжении, когда генерацией носителей заряда в области перехода можно пренебречь.
Описание экспериментальной установки
Экспериментальная установка состоит из воздушного термостата, включенного и электрическую схему (рис. 6.5), исследуемый диод (V5) и термосопротивление (R4) для измерения температуры.
Основными элементами экспериментальной установки являются полупроводниковый диод (VD5 на схеме установки) и терморезистор R4, которые помещены в воздушный термостат и поэтому находятся при одинаковой температуре. Терморезистор весьма заметно изменяет свое электросопротивление при изменении температуры, что позволяет использовать его в качестве термометра, т.е. по величине его электросопротивления определять температуру, при которой он находится.
Установка содержит также понижающий трансформатор и два мостовых выпрямителя на диодах VD1…VD4 и VD6…VD9. Первый выпрямитель обеспечивает обратное напряжение на исследуемом диоде VD5, а второй обеспечивает питание измерительного моста, одним из плеч которого является терморезистор R4. В другое плечо включен переменный резистор R2, с помощью которого устанавливается баланс моста, т.е. состояние, при котором ток в диагонали АВ моста равен нулю.
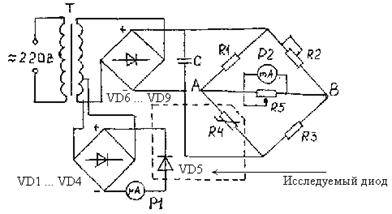
Рис. 6.5. Электрическая схема экспериментальной установки
Микроамперметр P1 измеряет обратный ток диода VD5.
Миллиамперметр P2 предназначен для измерения тока разбаланса моста при изменении температуры термостата.
Порядок выполнения работы
1. Включить установку. При этом на исследуемый диод подается обратное напряжение, равное 2,5 В. Убедиться по прибору Р1, что Iдиода = Iобр не превышает 2 мкА.
2. С помощью потенциометра R2 установить такой ток, чтобы потенциалы точек А и В были равны (см. рис. 6.5). При UA = UB ток через прибор Р2 равен нулю. (При изменении температуры сопротивление R4 изменяется, нарушается равновесие плеч моста и через прибор Р2 будет течь ток, пропорциональный изменению температуры). Формула, по которой определяется температура внутри термостата, имеет вид:
Т = Т 0 + a I, Т – Т 0 = a I (6.5)
где Т 0– температура в лаборатории, К;
a= коэффициент пропорциональности 1,0 град/мкА,;
I – ток через Р2, мкА.
Прибор Р2 отградуирован в единицах температуры, так как D Т = Т – Т 0 = a I.
3. Включить нагрев. Изменяя температуру на 5°, снимать показания тока.
4. Снять зависимость обратного тока германиевого диода от температуры.
5. Результаты измерений внести в табл. 6.1. Выполнить 7–10 измерений.
Таблица 6.1
| № | Т, К | Δ Т, К | 1/ Т, К–1 | Iобр, мкА | ln Iобр |
| … | |||||
6. По результатам измерений построить зависимость ln Iобр = f (1/ T).
7. Вычислить D Е (в эВ) ширину запрещенной зоны германия по формуле (6.4).
Обработка результатов
Формулу (6.4) прологарифмируем. Получим:
 (6.6)
(6.6)
График зависимости  , показан на рис. 6.5.
, показан на рис. 6.5.
Данное выражение сравнить с уравненим прямой y=cx показан на рис. 6.5.
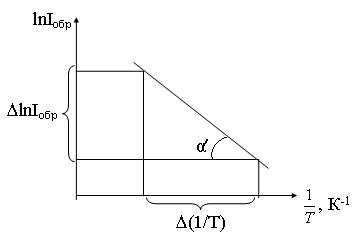
Рис. 6.5. Типичная зависимость ln  от величины,
от величины,
 2015-03-07
2015-03-07 604
604








