Основой полупроводниковых устройств является электронно-дырочный переход (p - n переход). Это переходный слой между двумя областями полупроводника, одна из которых имеет электропроводность p -типа, а другая – n -типа. P - n переход получают в едином кристалле полупроводника путем легирования его донорной и акцепторной примесями. Слева от границы раздела (рис. 6) электронов меньше, чем справа, поэтому они стремятся дифундировать в р -область. Попадая в р -область они рекомбинируют с дырками и их концентрация быстро падает. Аналогично дырки переходят в n -область и тоже рекомбинируют с электронами. В силу этого имеет место ток диффузии
I диф = Ip диф + In диф,(1.6)
направление которого совпадает с направлением диффузии дырок.
Вследствии диффузии основных носителей в их областях остается нескомпенсированный заряд ионизированных атомов примеси. Таким образом, вблизи границы раздела образуется переходный слой из противоположных по знаку зарядов. Они создают электрическое поле, направленное от положительных доноров к отрицательным акцепторам, т.е. от n -области к p -области. Между p и n областями создается разность потенциалов U кн, которая называется контактной. Для германиевых p - n переходов U кн= 0,3 - 0,4 В, для кремниевых – U кн = 0,7 - 0,8 В. Это поле препятствует диффузии основных носителей в соседнюю область, создавая потенциальный барьер. Это, в свою очередь, препятствует выравниванию концентраций носителей по объему кристалла. Поскольку в объеме кристалла имеются неосновные носители (дырки в n -области и электроны в p -области) электрическое поле p - n перехода способствует переходу неосновных носителей в соседнюю область (электронов – в n -область, дырок – в p -область). Таким образом создается ток неосновных носителей, который называется тепловым током
 I o = I o n + I o p .(1.7)
I o = I o n + I o p .(1.7)
Этот ток мал.
За положительное направление тока принимают направление тока диффузии.
Наличие контактной разности потенциалов приводит к снижению тока диффузии, вследствие чего суммарный ток через p-n переход
Ip-n = I дифo - I o = 0.(1.8)
Это приводит к образованию слоя, обедненного подвижными носителями, который обладает малой удельной проводимостью и называется запирающим. Его ширина
 , (1.9)
, (1.9)
|
e – относительная диэлектрическая проницаемость кристалла;
N д» n; N а» p – концентрация ионизированных атомов донорной и акцепторной примесей.
Обычно переход несимметричен. Если N а >> N д, то
 . (1.10)
. (1.10)
|
Обратное смещение p-n перехода
При обратном направлении подаваемого на p-n переход смещения, (рис.7, а) источник подключается так, чтобы поле, создаваемое внешним источником, совпадало по направлению с полем p-n перехода. При этом потенциальный барьер увеличивается и становится равным
U ¢ = U кн + U. (1.11)
Из-за его роста количество носителей заряда, способных преодолеть отталкивающее действие результирующего поля, уменьшается. Соответственно уменьшается и ток диффузии (рис.7).
а б
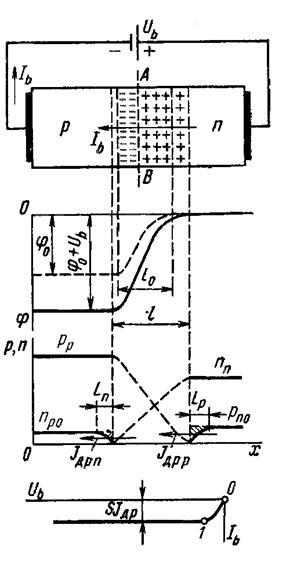

Рис. 7. р- n переход при: а – обратном смещении; б – прямом смещении
Под действием электрического поля, создаваемого источником напряжения U, основные носители заряда будут оттягиваться от приконтактного слоя. Из-за этого ширина запирающего слоя возрастает. Рост внешнего обратного напряжения приведет к сокращению количества подвижных носителей заряда, отчего диффузионный ток будет стремиться к нулю. Снижение I диф происходит по экспоненте:
 ;
;  , (1.12)
, (1.12)
здесь In 0, Ip 0 – диффузионный ток электронов и дырок при U = 0.
Тепловой ток зависит от концентрации неосновных носителей заряда в n - и p областях и не зависит от напряжения, приложенного к переходу. Полный ток через переход равен
 . (1.13)
. (1.13)
Прямое смещение p-n перехода
При прямом направлении смещения (рис.7, б) внешний источник напряжения включается так, что поле, создаваемое им в p-n переходе, направлено навстречу собственному полю перехода. Это приводит к уменьшению потенциального барьера. Облегчается диффузия основных носителей заряда и появляется диффузионный ток. Так как прямое напряжение вызывает встречное движение дырок и электронов, их концентрация в переходной области растет, ширина запрещающего слоя уменьшается.
Зависимость тока диффузии от прямого напряжения имеет вид
 . (1.14)
. (1.14)
Тепловой ток по-прежнему не зависит от напряжения. Полный ток через переход равен
 . (1.15)
. (1.15)
 Вольт-амперная характеристика перехода показана на рис. 8.
Вольт-амперная характеристика перехода показана на рис. 8.
|
При прямом смещении с одной стороны растет ток за счет роста I 0, а с другой из-за нагрева уменьшается проводимость полупроводникового кристалла, отчего ток снижается.
|
 2015-03-27
2015-03-27 1399
1399
