Лабораторная работа №2
Дисциплина: «Моделирование и проектирование микро- и наносистемной техники»
Тема: «Фотолитография»
Выполнил: студент группы 4НАН - 4ДБ - 079
Юнусов У.Д.
Проверил: Жуков А.А.
Москва, 2014 г.
Содержание
Введение………………………………………………………………………………..…….3
1. Теоретическая часть……………………………………………………………….9
2. Экспериментальная часть…………………………………………………...…….8
Заключение……………………………………………………………………………….…..9
Литература……………………………………………………………………………………9
Введение
Актуальность работы связана тем, что в настоящее время центральное место в современной технологии изготовления изделий микроэлектроники занимает фотолитография. Литографический процесс определяет минимальный (критический) размер элементов на полупроводниковом кристалле и степень интеграции микросхемы, а значит её размеры и быстродействие при эксплуатации. Фотолитография характеризуется минимальным размером элементов - 0,2 мкм. Существуют различные технологии литографии, но в серийном производстве ИС в основном используется проекционная фотолитография.
Целью настоящей работы является исследование фотошаблона для проекционной фотолитографии и определение минимального размера его объекта.
Для достижения поставленной цели необходимо было решить следующие задачи:
1. Изучение основ техники безопасности
2. Изучить теоретические основы фотолитографии.
3. Выполнить экспериментальную часть лабораторной работы: измерение минимального размера объекта на фотошаблоне с помощью оптического микроскопа Olympus BX51
Раздел 1. Теоретические основы фотолитографии.
Основы фотолитографии.
Фотолитография (оптическая литография) - процесс избирательного травления поверхностного слоя с использованием защитной фотомаски.
Основными составляющими процесса фотолитографии, определяющими её уровень, являются фоторезист, фотошаблон и конкретная схема реализации технологического процесса, связанная с техническими характеристиками используемого оборудования.
Фотошаблоны.
Фотошаблон – стеклянная пластина (подложка) с нанесенным на ее поверхность маскирующим слоем – покрытием, образующим трафарет с прозрачными и непрозрачными для оптического излучения участками. В процессе фотолитографии слой фоторезиста экспонируется в соответствии с рисунком покрытия, имеющегося на фотошаблоне. Подложку фотошаблона выполняют из стекла. В качестве материала маскирующего (непрозрачного) слоя фотошаблона обычно используются вещества, образующие твердые износостойкие покрытия. Это - серебряная эмульсия, обработанный ионами резист, оксид железа, германий, хром или его оксид, оксид европия и другие.
К фотошаблонам предъявляется комплекс требований, в первую очередь, следующие:
- высокая оптическая плотность маскирующего материала;
- толщина маскирующего материала – не более 100 нм; его отражательная способность - не выше 15%;
- высокая разрешающая способность; - точность воспроизведения всех размеров рисунка;
- неплоскостность (допускается от нескольких мкм до десятков мкм для разных классов фотошаблонов);
- малая микродефектность, стойкость к истиранию.
При плохом контакте пластины и фотошаблона, т.е. при наличии зазора, возникает дифракция, которая и искажает размеры экспонируемой области. К искажению геометрических размеров рисунка могут привести также неправильно подобранные режимы экспонирования и проявления. К дефектам шаблона относятся - неровный край, разрыв рисунка, царапины, проколы, внедрения. Шаблоны необходимо промывать через каждые 15- 20 совмещений в деионизованной воде с последующей сушкой.
Контактный, бесконтактный и проекционный способы фотолитографии.
Различают контактный, бесконтактный и проекционный способы фотолитографии (см. рис. 1.2).
1. При контактном способе фотошаблон и пластина с нанесенным фоторезистом соприкасаются. Пластина устанавливается на вакуумном держателе, который поднимает ее до тех пор, пока пластина и шаблон не придут в соприкосновение друг с другом. Чтобы провести совмещение топологического рисунка фотошаблона с предыдущим, топологическим рисунком, шаблон и пластину разводят на 25 мкм, а пару объективов с сильным увеличением помещают сзади от шаблона для одновременного наблюдения рисунков шаблона и пластины из двух точек. Объективы принадлежат микроскопу с разведенным полем зрения, так что правый глаз видит точку на правой стороне шаблона и пластины, а левый - точку слева. Шаблон и пластину совмещают механическим перемещением и вращением вакуумного держателя (столика) до совпадения топологических рисунков шаблона и пластины. В этом положении пластина приводится в соприкосновение с шаблоном и проводится еще одна проверка на точность совмещения. При экспонировании микроскоп автоматически отводится, и луч ультрафиолетового (УФ) облучения освещает весь шаблон в течение определенного времени экспонирования. Время экспонирования подбирают экспериментально, обычно в пределах 15-20 с.
Интенсивность экспонирования на поверхность пластины, умноженная на время экспонирования, дает энергию экспонирования или дозу облучения, получаемого резистом.
Вследствие тесного контакта между резистом и шаблоном при контактной печати значения разрешения (~ 0.1 мкм) выше, чем при использовании других методов литографии.
Некоторые недостатки этого метода заключаются в следующем. Реальная поверхность пластины не является абсолютно ровной, поэтому между ней и фотошаблоном существуют микро - зазоры, толщина которых по поверхности изменяется случайным образом. Наличие зазора приводит к тому, что размеры и форма элементов искажаются из-за расходимости светового пучка. Поскольку плотный контакт между пластиной и фотошаблоном невозможен, воздушные зазоры приводят к появлению дифракционных эффектов и увеличению размеров изображения.
Этому же способствуют дифракция света на краях элементов, рассеяние света в толще фоторезиста и многократное отражение от контактирующих поверхностей, приводящее к тому, что свет заходит в область геометрической тени. К искажению рисунка слоя приводят механические и температурные деформации пластины, вызывающие смещение рисунков различных топологических слоев.
Проблемы, возникающие при контактной печати, связаны также с изнашиванием фотошаблона при его многократном использовании. Соприкосновение фотошаблона с резистом приводит к возникновению дефектов на нем, и к накоплению дефектов и частиц фоторезиста, прилипающих к фотошаблону при многократном экспонировании. Кремниевая пылинка на пластине может привести к повреждению поверхности шаблона в момент его соприкосновения с пластиной. Поврежденный участок шаблона затем воспроизводится как дефектный топологический рисунок на всех других пластинах, при экспонировании которых использован этот шаблон. Каждая пластина добавляет свои собственные повреждения поверхности шаблона.
Если при изготовлении ИМС не обеспечивается необходимая чистота процесса и окружающей среды, то лишь некоторые элементы схем не будут иметь дефектов. Для обеспечения высокого выхода годных изделий плотность дефектов (число дефектов на 1 см2) должна быть минимальна для каждого процесса литографического переноса.
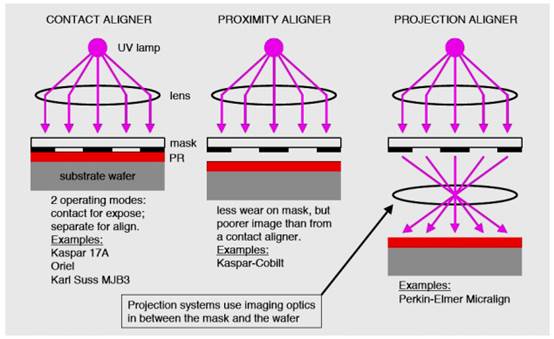
Рис 1.2. Типы проекций.
Слева - контактная печать. При контактной печати пластина кремния, покрытая резистом, находится в непосредственном физическом контакте со стеклянным фотошаблоном.
В центре - бесконтактная печать. Во время экспонирования между кремниевой пластиной и шаблоном поддерживается небольшой зазор шириной 10-25 мкм.
Справа - проекционная печать. Изображение топологического рисунка шаблона проецируется на кремниевую пластинку, на расстоянии нескольких сантиметров от шаблона.
Интерференция проходящего через слой фоторезиста светового потока и его отражения от границы с подложкой, а также рассеяние света, создают нерезкую зону по краю изображения, которая после проявления даёт "ореол", что ухудшает контрастность и изменяет геометрические размеры рисунка. Для ослабления этого эффекта применяют антиотражающие покрытия, например, плёнки оксида хрома, которые осаждают на поверхность пластины перед нанесением фоторезиста.
2. Метод бесконтактного экспонирования схож с методом контактной печати, за исключением того, что во время экспонирования между пластиной и шаблоном поддерживается небольшой зазор шириной 10-25 мкм. Этот зазор уменьшает возможность повреждения поверхности шаблона. Однако дифракция света уменьшает разрешающую способность и ухудшает четкость изображения. При бесконтактной печати величина разрешения составляет 2-4 мкм.
3. При проекционном способе фотолитографии контакта фотошаблона с подложкой нет, что исключает возможные его повреждения. Кроме этого, проекционный метод упрощает процесс совмещения фотошаблона и позволяет осуществить совмещение точнее, чем при использовании контактного метода.
Проекционную фотолитографию можно осуществить одновременной передачей всех элементов топологического слоя на пластину, поэлементным (шаговым) проецированием отдельных фрагментов или модулей на пластину, вычерчиванием рисунка в слое фоторезиста подложки при помощи сфокусированного до определенных размеров светового луча, управляемого от компьютера.
Для достижения высокого разрешения отображается только небольшая часть рисунка шаблона. Это небольшая отображаемая область сканируется или перемещается по поверхности пластины. В сканирующих проекционных устройствах печати шаблон и пластина синхронно перемещаются. С помощью этого метода достигается разрешение около 1,5 мкм для ширины линий и расстояния между ними.
Проекционные устройства печати, в которых изображение на шаблоне перемещается над поверхностью пластины, называют системами с непосредственным перемещением по пластине или фотоштампами. При использовании этих устройств печати шаблон содержит топологию одного кристалла большого размера или нескольких кристаллов малых размеров, которые увеличены в несколько раз (до десяти). Изображение этой топологии или структуры уменьшается и проецируется на поверхность пластины. После экспонирования одного элемента кристалла пластина сдвигается или перемещается на столике с интерферометрическим управлением по осям XY к следующему элементу одного кристалла, и процесс повторяется. С помощью уменьшающих проекционных фотоштампов можно получить разрешение ~1 мкм.
В большинстве современных проекционных систем печати оптические элементы являются достаточно совершенными, и их характеристики точности отображения ограничены дифракционными эффектами, а не аберрацией линз. Эти устройства печати называют системами с дифракционным ограничением.
 2015-05-10
2015-05-10 1837
1837







