Реальный переход имеет участки выходящие на поверхность кристалла. На поверхности в след. поверхностных энергетических уровней, молекулярных и ионных пленок могут образоваться токопроводящие каналы по которым протекает ток утечки.
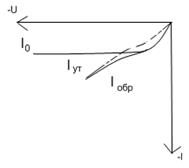
Iут может превысить Iо и Ig. Зависимость от температуры слабая. Для устранения Iут на микросхемах поверхность покрывают оксидной пленкой.
17. «Мы все умрем»(ты сам умрешь!!!)
Различают 3 вида пробоя р-n перехода при достаточно больших обратных напряжениях: туннельный, лавинный и тепловой. Первые два связаны с увеличением электрического поля в переходе, а третий – с увеличением рассеиваемой мощности и соответственно температуры.
В основе туннельного пробоя лежит туннельный эффект, т.е. «просачивание» электронов сквозь тонкий потенциальный барьер. Под высотой барьера понимается ширина запрещенной зоны з, а под его толщиной – расстояние d между противолежащими зонами.
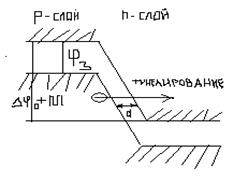
В основе лавинного пробоя лежит «размножение» носителей в сильном электрическом поле, действующем в области перехода. Электрон и дырка, ускоренные полем на длине свободного пробега, могут разорвать одну из ковалентных связей нейтрального атома п/п. В результате рождается новая пара электрон – дырка и процесс повторяется уже с участием новых носителей. Обратный ток при этом возрастает. При достаточно большой напряженности поля, когда исходная пара носителей в среднем порождает более одной новый пары, ионизация приобретает лавинный характер.
Ход ВАХ в области «размножения» вплоть до пробоя описывается полуэмпирической формулой

Где М – коэффициент ударной ионизации
Одной из отличительных особенностей лавинного и туннельного пробоев яв-ся разный знак температурного коэффициента пробивного напряжения. Это объясняется тем, что напряжение туннельного пробоя находится в прямой зависимости от ширины з.з., поэтому уменьшение величины з с ростом температуры вызывает уменьшение Uz. Напряжение лавинного пробоя находится в обратной зависимости от подвижности, поэтому уменьшение величины µ с ростом температуры вызывает увеличение UM.
В основе теплового пробоя лежит саморазогрев перехода при протекании обратного тока. С ростом температуры обратные токи резко возрастают, и соответственно увеличивается мощность, рассеиваемая в переходе; это вызывает дополнительный рост температуры и т.д. Тепловой пробой может начаться лишь тогда, когда обратный ток уже приобрел достаточно большую величину в результате лавинного или туннельного пробоя.
Важной особенностью ВАХ яв-ся обратная зависимость м/у прямым напряжением и тепловым током: чем меньше тепловой ток, тем больше прямое напряжение и наоборот. Еще один факт, что прямое напряжение уменьшается с увеличением площади перехода
18. При воздействии на p-n-переход U высокой частоты проявляются инерц-е св-ва п-да: распр-е носителей при быстрых изменениях тока или напряжения требует опр. времени. Внешнее U изменяет ширину ЗЗ, высоту потенциального барьера, граничную концентрацию носителей (величину объемных q в п-де), следовательно, p-n-переход обладает емкостью. Для p-n-перехода характерны два состояния (прямо- и обратносмещенное), поэтому эту емкость можно условно разделить на две составляющие барьерную и диффузионную. Деление чисто условное, барьерная -обратносмещенный, диффузионная прямосмещенный.Барьерная емкость отражает перераспределение носителей в p-n-переходе, т.е. обусловлена нескомпенсир-м объемным q, сосредоточенным по обе стороны от границы перехода. Роль диэлектрика у барьерной емкости выполняет ЗЗ, практически лишенная носителей. Сбар зависит от площади перехода, от концентрации примеси, от U на переходе 
 где S площадь p-n-п-да; диэлектрическая проницаемость полупроводникового материала; Nd концентрация примеси; U напряжение на переходе.Особенностью барьерной емкости является то, что она изменяется при изменении U на п-де (рис.1); изменение C бар при изменении U может достигать десятикратной величины, то есть эта емкость нелинейна, и при увеличении обратного напряжения барьерная емкость уменьшается, так как возрастает толщина запирающего слоя (площадь p-n-перехода).C бар зависит отN прим: чем
где S площадь p-n-п-да; диэлектрическая проницаемость полупроводникового материала; Nd концентрация примеси; U напряжение на переходе.Особенностью барьерной емкости является то, что она изменяется при изменении U на п-де (рис.1); изменение C бар при изменении U может достигать десятикратной величины, то есть эта емкость нелинейна, и при увеличении обратного напряжения барьерная емкость уменьшается, так как возрастает толщина запирающего слоя (площадь p-n-перехода).C бар зависит отN прим: чем 
Рис. 1
При прямом смещении происходит диф-я, к-я ув-ет заряд p в n-обл-ти и заряд е в р-обл-ти. С диф опр-ся зарядом неосн НЗ (р),накопленных в базе.
Диффузионная емкость отражает перераспределение носителей в базе Cдиф = dQ/dU, где Q – инжектир-й q.


где  время жизни носителей; Lр диф-я длина.
время жизни носителей; Lр диф-я длина.
Значение диффузионной емкости колеблется от сотен до тысяч пФ.
C диф также нелинейна и  с ув Uпр. Образование этой емкости схематично можно представить следующим образом. Эмиттером будем считать p-область, а базой n-область. Носители из эмиттера инжектируются в базу. В базе вблизи перехода происходит скопление дырок объемный положительный заряд, но в это время от источника прямого напряжения в n-область поступают электроны, и в этой облаcти, ближе к внешнему выводу, скапливается отрицательный объемный заряд. Таким образом, в n-области наблюдается образование двух разноименных зарядов "+Qдиф" и "Qдиф".
с ув Uпр. Образование этой емкости схематично можно представить следующим образом. Эмиттером будем считать p-область, а базой n-область. Носители из эмиттера инжектируются в базу. В базе вблизи перехода происходит скопление дырок объемный положительный заряд, но в это время от источника прямого напряжения в n-область поступают электроны, и в этой облаcти, ближе к внешнему выводу, скапливается отрицательный объемный заряд. Таким образом, в n-области наблюдается образование двух разноименных зарядов "+Qдиф" и "Qдиф".
Диффузионная емкость является причиной инерционности полупроводниковых приборов при работе в диапазоне высоких частот и в режиме ключа, так как процесс накопления и особенно рассасывания объемного заряда требует затраты определенного времени.
При Uпр на p-n- п-де (обл1) откл-е реальной характеристики от идеальной связано с R слаболегир-й области базы (rБ'). Часть Uвнеш падает на объемном rБ', поэтому U на p-n-пер ум-ся до величины Upn=U-i rБ'.
 При U обр обратный ток реального перехода больше, чем ток идеального, величина обратного тока зависит от обратного напряжения (обл 2). Причиной этого отличия является тепловая генерация в обл объемного заряда. Вследствие малой концентрации НЗ в p-n-переходе, скорость генерации пар НЗ в этой обл преобладает над скоростью рекомбинации; любая параНЗ, генерируемая в этой области, разделяется полем перехода, а следовательно, к тепловому току добавляется генерационная составляющая.
При U обр обратный ток реального перехода больше, чем ток идеального, величина обратного тока зависит от обратного напряжения (обл 2). Причиной этого отличия является тепловая генерация в обл объемного заряда. Вследствие малой концентрации НЗ в p-n-переходе, скорость генерации пар НЗ в этой обл преобладает над скоростью рекомбинации; любая параНЗ, генерируемая в этой области, разделяется полем перехода, а следовательно, к тепловому току добавляется генерационная составляющая.
 Важным параметром при этом будет время восстановления обратного сопротивления tвос интервал времени от момента переключения до момента, когда обратный ток уменьшается до заданного уровня отсчета; при подаче на диод запирающего импульса ток не может мгновенно уменьшиться до нуля, так как в базе образовался объемный заряд и на его рассасывание требуется определенное время. Этим и объясняется выброс обратного тока в цепи диода.
Важным параметром при этом будет время восстановления обратного сопротивления tвос интервал времени от момента переключения до момента, когда обратный ток уменьшается до заданного уровня отсчета; при подаче на диод запирающего импульса ток не может мгновенно уменьшиться до нуля, так как в базе образовался объемный заряд и на его рассасывание требуется определенное время. Этим и объясняется выброс обратного тока в цепи диода.
распределение заряда в области ОПЗ
 2015-05-30
2015-05-30 1406
1406








