Одним из основных факторов, определяющих энергетические параметры мощного транзистора, является нагрев (перегрев) DТ его активной зоны (канала) в процессе работы. Другая характеристика, определяющая энергетические параметры транзистора – допустимая рабочая температура Т макс активной области. Чем больше разность температур (DТ - Т макс), тем более жесткие требования предъявляются к системе охлаждения транзистора. При заданных разности (DТ - Т макс) и эффективности съема тепла мы получаем ограничение на реализуемую мощность транзистора. Этот ограничивающий фактор может оказаться определяющим, несмотря на то, что по своим электрическим параметрам транзистор может обеспечивать и более высокую выходную мощность.
Таким образом, надо стремиться получить как можно меньшее значение разности температуры перегрева и допустимой рабочей температуры транзистора. Этот параметр (наряду с отдаваемой выходной мощностью) определяется свойствами полупроводниковых структур собственно транзистора и подложки.
По оценкам группы специалистов Института проблем технологии микроэлектроники и особо чистых материалов (ИПТМ) РАН нитрид-галлиевыетранзисторы могут сохранять работоспособность при температуре в активной зоне до 300 °С. Проведено моделирование теплового режима транзисторных структур.
На рисунках 1.22, 1.23 изображены соответственно распределение температуры перегрева в зоне канала и изменение температуры перегрева во времени для структуры GaAs на GaAs и GaN на SiC. Моделировалась меандровая структура (15 элементов, шаг 25 мкм, длина затвора элемента 0,5 мкм, ширина затвора элемента 10 мм, толщина подложки 100 мкм). Выходной СВЧ сигнал представлял собой последовательность импульсов с длительностью 10 нс, импульсной мощностью 1000 Вт и скважностью 100.
Если максимальная температура перегрева в первом случае составляет 800 градусов при допустимой рабочей температуре 125 градусов (снять тепло в такой ситуации практически невозможно), то во втором случае перегрев равен 350 К при рабочей температуре до 300 градусов (то есть охлаждения практически не требуется).

Рис. 1.22. Изменение во времени максимального перегрева DT* для структуры GaAs на GaAs.

Рис. 1.23. Изменение во времени максимального перегрева DT* для структуры GaN на SiC.
На рисунке 1.24 приведено трехмерное распределение температуры перегрева структуры нитрида галлия на карбиде кремния. Транзистор представлял собой периодическую гребенку и з 15-ти каналов шириной 700 мкм, длиной 0,3 мкм с шагом 50 мкм. Кристалл размещался на медном радиаторе 30х30х1 мм3. Выходной сигнал – импульсный с импульсной мощностью 200 Вт, длительностью импульса 5 мкс, скважностью 10.
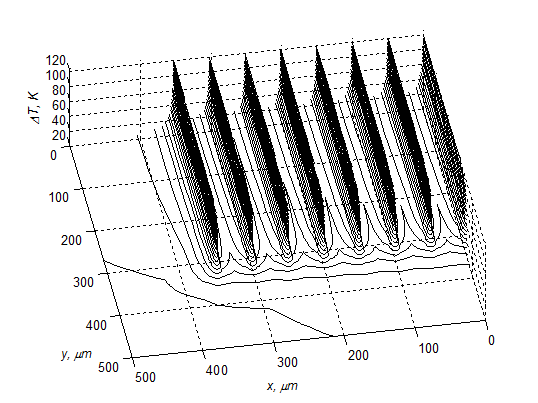
Рис. 1.24. Распределение перегрева DT в зоне "решетки" каналов в двумерном сечении структуры GaN на SiC в момент окончания 100-го импульса (изображена только "четвертинка" структуры). Кристалл 1000´1000´301 mм3 (15 каналов 700´0.3 mм2 через 50 mм). Мощность P=200 Вт. Медный радиатор 30´30´1 мм3.
Как показывает расчет, перегрев в данном случае составляет не более 125 К, что не представляет никакой проблемы для транзисторов на нитриде галлия с подложкой из карбида кремния.
В [10] на основе разработанной нелинейной математической модели проведен анализ СВЧ свойств GaN транзисторов в зависимости от температуры в активной зоне (исток-сток). Нелинейные параметры эквивалентной схемы транзистора (выходное сопротивление rds, активная межэлектродная проводимость gm и емкость затвор-исток Cg) представляются в виде степенных разложений по величине vgs (напряжение затвор-исток) с учетом члена 3-й степени. Было проведено моделирование HEMT транзистора Al0.25 GA0.75N/GAN (1мкм х 150 мкм) и сравнение результатов с опубликованными экспериментальными данными [11]. В [10] показаны результаты хорошего совпадения расчетных и экспериментальных данных.
На Рис. 1.25 приведены результаты моделирования характеристик полевого GaN транзистора с затвором 0,32 мкм х 100 мкм в зависимости от температуры.
Как видно из рисунка, значения выходной мощности, КПД и коэффициента усиления GaN транзистора в интервале температур (100 ¸500) К снижаются монотонно и достаточно плавно. Уменьшение составляет:
- по выходной мощности с 617 мВт до 422 мВт………………14,6 %;
- по КПД c 23,3 % до 16,3 %………………………………………14,3 %;
- по коэффициенту усиления c 18,5 дБ до 16,7 дБ……………15,1 %.
При дальнейшем увеличении температуры (от 500К до 600К) наблюдается более резкое снижение характеристик транзистора. Уменьшение значений выходной мощности КПД и коэффициента усиления в интервале температур (100 ¸600) К составляет:
 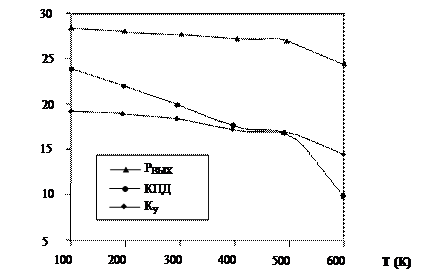 | |||
|
- по выходной мощности с 617 мВт до 204 мВт………………в три раза;
- по КПД c 23,3 % до 10 %…………………………………………в 2,3 раза;
- по коэффициенту усиления c 18,5 дБ до 13,75 дБ………… в три раза.
Результаты Рис. 1.25 получены для рабочей частоты транзистора 2 ГГц.
Следует отметить, что поведение характеристик GaN транзистора от температуры существенно зависит от его конкретной структуры и конструкции.
По проведенным оценкам, [10] в качестве допустимой температуры GaN транзисторов можно ориентироваться на величину ~ 300°С.
В [12] приводятся результаты бесконтактных измерений температуры саморазогрева активной зоны AlGaN/GaN HEMT транзисторов, выращенных на подложках из сапфира и карбида кремния. С этой целью применяется микро Raman спектроскопия, позволяющая строить температурные карты объекта с пространственным разрешением 1 мкм и точностью измерения температуры лучше 10°С. Метод основан на зависимости частоты излучаемых исследуемым объектом фононов от температуры. При этом объект (в данном случае AlGaN/GaN транзистор) просвечивается лазерным лучом, играющим роль возбудителя. Проходя через объект, оптическое излучение модулируется по частоте в соответствии с температурой нагрева и в режиме сканирования лазерного луча, путем последующей обработки, составляется температурная карта. Исследовались два прибора: а) AlGaN/GaN транзистор на сапфире c зазором исток-сток 10 мкм, затвором длиной 4 мкм, расположенным по центру между истоком и стоком; б) AlGaN/GaN транзистор на SiC c зазором исток-сток 4 мкм, затвором длиной 1 мкм, зазором затвор-сток 2 мкм. Ширина затвора обоих транзисторов 200 мкм.
В качестве источника оптического возбуждения использовался газовый лазер с рабочей длиной волны 488 нм и мощностью 3 мВт. При этой мощности побочный подъем температуры транзистора из-за облучения лазером не превышал 10°. Размер лазерного пятна составлял 1 мкм. Управляемое компьютером сканирование осуществлялось с шагом 0,2-2 мкм.
Для повышения точности измерений температуры саморазогрева транзистора при поданном рабочем напряжении (20 В) исключалась побочная температурная составляющая при нулевом напряжении, вызванная рассеянием лазерного излучения на металлических контактах.
Согласно построенным температурным картам, выделяемое транзисторами тепло в результате саморазогрева концентрируется, в основном, в виде линии вдоль границы затвора.
Мощность рассеиваемого тепла составила:
- для транзистора на сапфире 0,65 Вт при максимальной температуре нагрева 180°;
- для транзистора на SiC 1,75 Вт при максимальной температуре нагрева 120°.
Таким образом, AlGaN/GaN транзистор на сапфире, из-за меньшей теплопроводности подложки, рассеивает во внешнее пространство приблизительно в 2,7 раза меньшую тепловую мощность чем AlGaN/GaN транзистор на SiC. При этом температура саморазогрева транзистора на сапфире на 60° (в 1,5 раза) выше по сравнению с транзистором на SiC.
Литература к разделу нитрид-галлиевых усилителей
- Lester F. Eastman, Performance limits of AlGaN/GaN HEMT’s, 24’th Workshop on Compound Semiconductor Devices and Integrated Circuits held in Europe, May 29 – June 02, 2000.
2. L. Shen, S. Heikman, B. Morgan et.all, AlGaN/Gan/AlN/GaN High-Power Microwave HEMT, IEEE Electron device letters, vol. 22, № 10, p.p. 457 –459, Oktober, 2001.
3. V. Tilak, B. Green, Val Kaper et. all, Influence of Barrier Thickness on the High-Power Performance of AlGaN/Gan HEMTS, IEEE Electron device letters, vol. 22, № 11, p.p. 504 –506, November, 2001.
- Bruce M. Green, V. Tilak, Sungae Lee et. all, High-Power Broad-Band AlGaN/Gan HEMT MMICs on SiC Substrates, IEEE Transactions on Microvawe Theory and Techniques, vol. 49, № 12, p.p. 2486 –2493, December, 2001.
5. XXVI Workshop on Compound Semiconductor Devices and Integrated Circuits, held in Europe.(Черноголовка), Сборник материалов, стр. 94, май 2002.
6. Jane J. Xu, Stacia Keller, Gia Parish et all, A 3-10 GHz GaN-Based Flip-Chip Integrated Broad-Band Power Amplifier, IEEE Transactions on Microwave Theory and Techniques, vol. 48, No. 12. 2000.
7. International Workshop on Nitride Semiconductors,22 –25 July 2002, Achen, Germany (Bank of elements), Lecher F. Fostman.
8. Cree pushes GaN transistor power density past 30 W/mm, Compound Semiconductor, January/February, 2004, p. 12.
9. Fujitsu smashes power record for GaN-based HEMT amplifiers, Compound Semiconductor, January/February, 2004, p. 5.
- A. Ahmed, Syed S. Islam, A.F.M. Anvar, A Temperature-Dependent Nonlinear Analisis of Gan/AlGan HEMTs Using Volterra Series, IEEE Transactions on Microvawe Theory and Techniques, vol. 49, № 9, p.p. 1518 –2523, September, 2001.
11. S.C.Binari, J.M.Redrwing, G.Kelner and W.Kruppa, AlGan/Gan HEMTS Grown on SiC Substraits”, Electron Lett., vol.33, no.3, p.p. 242-243, Jun. 1997.
12. M. Kuball, J.M. Hayes, M.J. Uren et. all, Measurement of Temperature in Active High-Power AlGan/GaN HFETs Using Raman Spectroscopy, IEEE Electron device letters, vol. 23, № 1, p.p. 7 –9, Jan., 2002.
 2015-06-26
2015-06-26 1706
1706








