В виду жестких ограничений по габаритам, накладываемых на поперечное сечение приемо-передающего модуля (ППМ) АФАР сантиметрового диапазона, практически нет возможности наращивания выходной мощности ППМ за счет увеличения ширины затвора мощного выходного транзистора или за счет суммирования в выходном каскаде усилителя мощности нескольких транзисторов. В этих условиях единственно возможный путь – увеличение плотности выходной мощности на единицу ширины затвора транзистора. Ниже приводятся опубликованные данные о достигнутой плотности выходной мощности на 1 мм ширины затвора и о полной величине выходной мощности GaN транзисторов.
Публикации по разработкам мощных GaN транзисторов появились в 1999 –2000 годах
В [1] опубликованы данные о получении плотности выходной СВЧ мощности транзистора до 6,5 Вт/мм.
В [2] рассматривается HEMT транзистор на гетеропереходе AlGaN/AlN/GaN. В отличие от обычных HEMT транзисторов в структуру вводится очень тонкий (~ 1нм ¾ Рис. 1.9) промежуточный AlN слой. для улучшения электрических свойств перехода AlGaN/GaN.
 | |||
|
На окончательном этапе изготовления транзистора проводилась пассивация слоем Si3N4 толщиной 100 нм.
На Рис. 1.10 приведены результаты измерений СВЧ характеристик HEMT транзистора на частоте 8 ГГц в непрерывном режиме. (ширина затвора 0,15 мм, длина 0,7 мкм, расстояние затвор-сток 2 мкм).
  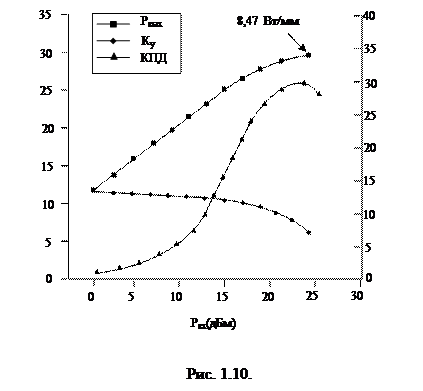 |
Транзистор работал в классе АВ при напряжении сток-исток VDS = 45 В и токе IDS = 160 мА/мм в режиме настройки на максимальную мощность. Была получена плотность выходной мощности 8,47 Вт/мм. Коэффициент усиления и КПД составили соответственно 7,5 дБ и 28%.
В ИПТМ РАН разработана технология СВЧ транзисторов на основе широкозонных эпитаксиальных структур, изготовлены и испытаны первые экспериментальные образцы транзисторов на структурах AlGaN/GaN.
Схематично структура транзистора изображена на рисунке 1.11.
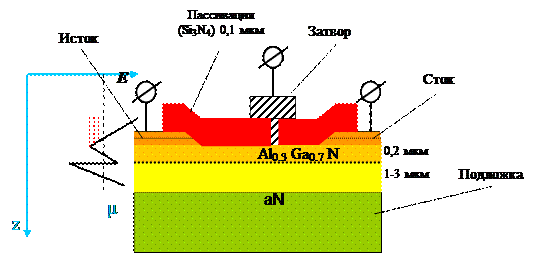

Рис. 1.11. Структура GaN транзистора.
Для изготовления транзисторов использовались эпитаксиальные структуры, выращенные методом MOCVD. На подложке из сапфира (2 дюйма) растился буфер GaN (1 мкм), который заканчивался 20 нм слоем широкозонного материала Al0.3Ga0.7N.
Изготовленные образцы транзисторов на частоте 10 ГГц имели характеристики: Рвых = 100 мВт (плотность мощности 5 Вт/мм), Ку = 11 дБ, КПД = 40%, напряжение на стоке Vds = 40 В.
 |
На рисунке 1.12 приведены вольтамперные характеристики одного из транзисторов до и после пассивации.
|
Результаты показывают, что пассивация транзисторов нитридом кремния (с применением СВЧ-плазменного стимулирования в условиях электронного циклотронного резонанса) позволяет увеличить ток насыщения, крутизну и пробивные напряжения транзисторов.
Выходная мощность, коэффициент усиления и КПД транзисторов (до и после пассивации) были измерены на частоте 10 ГГц. Результаты измерений одного из образцов приведены на рисунках 1.13 и 1.14.
Выходная мощность Усиление

Рис. 1.13.

Рис. 1.14.
Демонстрируется резкое увеличение КПД после проведения пассивации структуры транзистора методом ЭЦР.
В [3] исследовался эффект зависимости тока в HEMT транзисторах AlGaN/GaN от толщины AlGaN перехода. В частности, измерения мощности проводились для AlGaN/GaN транзисторов 2х125х0,3 мкм на SiC подложке. На частоте 8 ГГц для транзистора с толщиной AlGaN перехода 10 нм была получена плотность выходной мощности 1,23 Вт/мм. Для аналогичного транзистора с толщиной AlGaN перехода 20 нм плотность выходной мощности составила 2,65 Вт/мм. Отмечено улучшение характеристик этих приборов на больших сигналах после пассивации.
Наилучшие характеристики получены на частоте 10 ГГц для транзистора с размерами 150 х 0,3 мкм при толщине AlGaN перехода 20 нм (Рис. 1.15).
 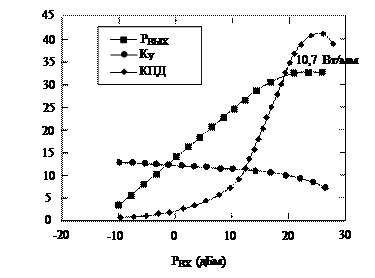 | |||
|
Транзистор испытывался в режиме высокого насыщения (класс В) при напряжении стока 45 В и напряжении на затворе –3,5 В.
Как отмечено на Рис. 1.15, достигнута плотность выходной мощности 10,7 Вт/мм при КПД 40%. Полная выходная мощность транзистора ~ 2,5 Вт.
В [4] впервые описывается разработка монолитных интегральных схем мощных усилителей на основе AlGaN/GaN HEMT транзисторов, изготавливаемых на высокотемпературных SiC подложках. Усилители строились на базе каскодных (Рис. 1.16) ячеек в сочетании с внутренним согласованием цепей по потерям.
 | |||
|
Упрощенно поперечное сечение монолитной интегральной схемы транзистора с использованием семи фото-шаблонов показано на Рис. 1.17.
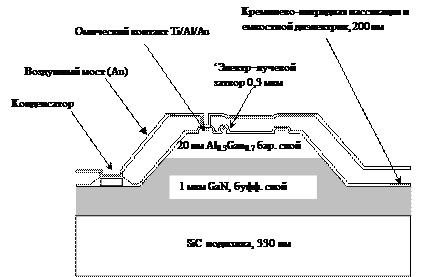 | |||
|
На базе двух каскодных ячеек (Рис. 1.16) с суммарной шириной затвора транзисторов 2 мм был создан монолитный широкополосный усилитель. На Рис. 1.18 представлены результаты измерений характеристик усилителя в режиме насыщения при входной СВЧ мощности 29 дБм и напряжении стока 25 В. В полосе (3 ¸ 8) ГГц выходная мощность усилителя составила (5 ¸ 7,5) Вт при КПД (20 ¸33) %.
Эти результаты приводились также на XXVI европейской конференции по полупроводниковым приборам и интегральным схемам (Россия, Черноголовка, май 2002 г.) – [5].


Описанный HEMT транзистор AlGaN/GaN на SiC с шириной затвора 125 мкм, показал рекордные характеристики для частоты 10 ГГц на время публикации. Плотность мощности 6,9 Вт/мм (Рвых = 0,87 Вт) при полном КПД 52%, коэффициенте усиления 9 дБпри напряжении питания 30 В. Эти данные относятся к режиму оптимизации выходной мощности. При оптимизации режима работы транзистора по полному КПД до 60% плотность мощности уменьшалась до 3,7 Вт/мм.
HEMT транзистор с шириной затвора 1,5 мм (штыревая структура 12 х 125 mm), измеренный в составе шайбы, имел коэффициент усиления 12 дБ, выходную мощность 3,9 Вт (2,6 Вт/мм), КПД 29%.
На рисунке 1.19 представлены характеристики 3 мм транзистора на частоте 7,4 ГГц. При входной мощности свыше 30 дБм (1 мВт) напряжение исток-сток увеличено с 28,4 В до 31 В. Получена выходная мощность 9,1 Вт (3,03 Вт/мм), КПД 29,6%, усиление 7,1 дБ.
 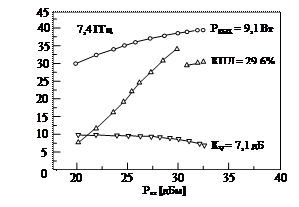 |
Рис. 1.19
Широкополосный усилитель, работающий в полосе 3¸11,5 ГГц [6], спроектирован на базе 2-х МИС, каждая из которых содержит два параллельных HEMT GaN транзистора с шириной затвора 1 мм. Схема усилителя приведена на рисунке 1.20. Транзисторы смонтированы методом перевернутого монтажа. Схема, имеющая размеры 12 х 8 мм2, выполнена на подложке из нитрида алюминия (AlN).
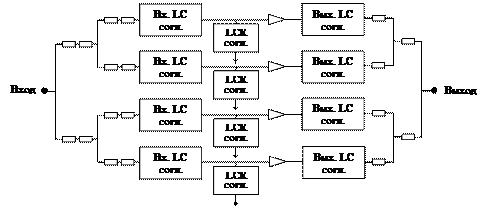 |
Рис. 1.20.
Результаты измерений характеристик усилителя в диапазоне частот 4,5 ¸10 ГГц приведены на рисунке 1.21. На частоте 9,5 ГГц усилитель имел выходную мощность 8 Вт при КПД 20%. С учетом суммарной периферии затвора 4 мм плотность мощности составляет 2 Вт/мм. Напряжение исток-сток равнялось 24 В.
   |
Рис. 1.21
В [7] опубликованы данные о мощности 10 Вт на GaN транзисторе с шириной затвора 1,5 мм с плотностью мощности 11,7 Вт на мм (на малых уровнях мощности).
В компании Cree (США) – [8] получены GaN HEMT транзисторы с рекордными показателями по плотности мощности и КПД: 32 В/мм, 55% на частоте 4 ГГц и 30 В/мм, 50% на частоте 8 ГГц. Такие параметры, по заявлению Cree, достигнуты благодаря прорывам в области GaN эпитаксии, техпроцессов изготовления приборов и схемотехники, позволяющим транзисторам работать при напряжении на стоке до 120 В. Компания продемонстрировала нитрид-галлиевую МИС на SiC подложке двухкаскадного усилителя с выходной мощностью 20 Вт, коэффициентом усиления 14 дБ и КПД 20%.
Гибридный усилитель на базе 12 мм GaN/AlGaN транзистора на SiC подложке имеет выходную мощность 40 Вт (3,39 Вт/мм) и КПД 20%.
Cree ставит задачу освоения с помощью дискретных и монолитных GaN приборов диапазона частот (5 ¸ 35) ГГц для широкополосных коммерческих систем связи, а также для систем радиолокации и связи военного назначения. Частично эти работы финансируются исследовательским лабораторным центром ВВС (Air Force Research Laboratories) и исследовательским отделом ВМФ (Office of Naval Research).
Fujitsu сообщает о разработке в своих лабораториях самого мощного в мире GaN HEMT усилителя с выходной мощностью 174 Вт (при напряжении 63 В) и КПД = 40%. Усилитель может использоваться в базовых станциях мобильной беспроводной связи диапазона 3 ГГц, [9]. Работая в настоящее время над созданием производственного оборудования и контрольно-измерительной аппаратуры для массового выпуска, Fujitsu ожидает появления усилителей на рынке через 1 – 2 года.
В заключение данного раздела следует отметить, что высокая (~5 Вт/мм и более) плотность мощности, получаемая на GaN структурах при малых мощностях, на практике не реализуется при попытке создания на этих структурах транзисторов с выходной мощностью более (3 ¸5) Вт. Причину этого, вероятнее всего, следует искать в падении электрических характеристик GaN транзистора в процессе его разогрева на больших мощностях.
 2015-06-26
2015-06-26 1489
1489








