Рис. 5. Трассирование BGA с разбиением на квадранты.
Шаблоны трассировки BGA.
Оценка числа необходимых для трассировки слоев печатной платы.
Имеется возможность предварительно оценить, какое количество слоев на плате потребуется для разводки цепей, подходящих к BGA-корпусу. Для этого необходимо иметь следующие данные: тип корпуса BGA (пластик или керамика),размер шариков, шаг и шаблон размещения выводов, карту подводимых к ним сигналов, размер переходного отверстия, ширину проводников и допустимые зазоры. Тип подложки микросхемы, размер шариков и шаг выводов, как показано выше, определяют размер контактной площадки. Если вычесть из шага выводов размер контактной площадки, то получится размер свободного для трассировки пространства. Его надо разделить на ширину проводника и зазора таким образом, чтобы посчитать число проводников, которые могут быть проложены между двумя соседними контактными площадками. Прибавьте к полученному значению единицу, и получится число связей, которые могут быть отведены от корпуса через один ряд выводов на верхнем слое. Аналогичная формула используется для оценки числа отводимых связей на первом внутреннем сигнальном слое. Только здесь размеры контактных площадок меняются на размеры переходных отверстий. Здесь также надо добавлять единицу, так как она соответствует крайней в ряду площадке, к которой провод-ник подводится непосредственно.
Имея число трассируемых рядов на слое и карту связей, можно без труда оценить число необходимых сигнальных слоев.
Рассмотрим пример. Используется пластиковый BGA корпус(PBGA) с шагом выводов 1,27 мм и размером шарика 0,75 мм. Согласно Табл. 4. рекомендованный диаметр контактной площадки в этом случае будет 0,55 мм. Округляем его в большую сторону до 0,6 мм. Используем для симметрии переходные отверстия того же размера 0,6 мм с отверстием 0,3 мм, проводники выбираем шириной 0,125 мм, зазор между ними также 0,125 мм. Вычитаем из шага выводов (1,27 мм) диаметр контактных площадок (0,6 мм) и получаем 0,67 мм. Делим это значение на размер проводников и зазоров (0,125мм) и получаем всего два проводника и три зазора. Добавляем 1 к числу проводников (2) и получаем число рядов (3),трассировка которых возможна на одном слое. Так как размер площадки переходного отверстия составляет те же 0,6 мм, то на каждом следующем слое будет разведено также по три ряда выводов. Таким образом, на двух сигнальных слоях мы можем развести шесть рядов выводов. На каждом слое внешний ряд разводится напрямую, а два других проводниками, проложенными между контактными площадками. Если корпус имеет глубину размещения сигнальных выводов в пределах шести рядов, то в нашем случае его можно развести всего на двух сигнальных слоях. Если бы корпус имел 10 рядов сигнальных выводов, то для его трассировки потребовалось бы четыре сигнальных слоя, без учета внутренних слоев питания и заземления.
Использование регулярных шаблонов трассировки при работе с корпусами BGA дает ряд преимуществ. Например, разбиение на квадранты (см. Рис. 5.) позволяет облегчить трассировку посредством упорядочивания групп сигналов, а также возможностью разводки дополнительного ряда выводов при недостаточном числе сигнальных слоев. Если какие-либо из цепей внешнего ряда должны быть перенесены на другой слой, то это необходимо делать на некотором удалении от корпуса. Если использовать переходные отверстия на внешних рядах выводов, то это неизбежно приведет к необходимости добавления дополнительных сигнальных слоев.
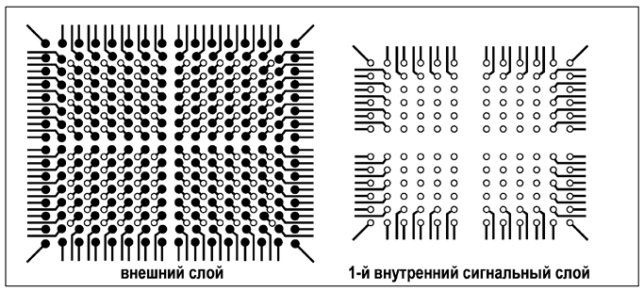
Так как выводы питания и заземления у BGA расположены на внутренних рядах выводов, использование квадрантного разбиения упрощает подвод питания к микросхемам BGA на внутренних слоях в виде широких полос металлизации по направлениям осей квадрантов (см. Рис. 5.). Если внутренний
слой питания или заземления имеет много участков с удаленной медью для обеспечения зазоров между переходными отверстиями, то это приведет к росту его паразитной индуктивности. При разработке слоев питания/заземления со
сплошной заливкой для BGA нужно стараться оставлять ширину меди между двумя соседними переходными отверстиями как можно больше, но не менее 0,25 мм (и уж никак не менее 0,2 мм). Для BGA с шагом менее 1,0 мм это приводит к необходимости удаления со слоев питания/земли площадок переходных отверстий, неподключенных на этих слоях. При этом зазор от границы медной заливки до канала отверстия дол- жен быть не менее 0,2 мм (и уж никак не менее 0,15 мм). Отсюда видно, что в некоторых случаях даже при шаге 0,8 мм,
может случиться так, что потребуется применение технологии micro via.
 2013-12-29
2013-12-29 768
768