Ионным распылением (иногда называют «катодное распыление») материалов называется процесс бомбардировки мишени из распыляемого материала быстрыми ионами, в результате чего с поверхности мишени выбиваются атомы и осаждаются на расположенные вблизи подложки. Ионная бомбардировка сопровождается эмиссией с поверхности вещества различного рода частиц. Это, в первую очередь, атомы вещества, электроны (ионно-электронная эмиссия), частицы, входящие в состав бомбардирующего ионного пучка (обратное рассеяние ионов), и, наконец, фотоны (ионно-люминесценция).
Для описания процесса ионного распыления предлагается несколько моделей, основанных на двух механизмах. Согласно первому механизму распыленные атомы возникают в результате сильного локального разогрева поверхности мишени самим падающим ионом (модель «горячего пятна») либо быстрой вторичной частицей (модель «теплового клина»). Второй механизм состоит в передаче импульса падающего иона атомам решетки материала мишени, которые в свою очередь могут передавать импульс атомам решетки, вызвав тем самым каскад столкновений (модель столкновений).
На рис. 3.1 представлена схема механизма распыления мишени. В случае, когда поверхностный атом получит энергию, достаточную для разрыва связи с ближайшими соседями, и направление этого импульса к поверхности, то атом мишени перейдет в паровую фазу. Ионное распыление начинается в тот момент, когда энергия ионов становится больше некоторого значения пороговой энергии распыления Е пор. Чтобы оторвать атом от поверхности вещества, необходимо затратить энергию (пороговая энергия смещения Е см). Значение Е см лежит в интервале (1,6 – 4,8)·10–8 Дж, что составляет 10–30 эВ. Если для вещества известно Е см, то легко определить пороговую энергию распыления:
 (3.1)
(3.1)
где M 1 – масса иона;
M 2 – масса атома вещества мишени.

Рис. 3.1. Схема механизма распыления мишени
Для ионов Аr+, распыляющих поверхность, значения Е пор колеблются в зависимости от вещества мишени в интервале 7– 40 эВ.
Следует отметить, что при энергии выше определенного значения (назовем ее энергией имплантации ионов) распыление отсутствует из-за относительно глубокого внедрения бомбардирующего иона в мишень. Вся энергия в этом случае расходуется на радиационные искажения решетки мишени.
Основной характеристикой ионного распыления является коэффициент распыления S – число атомов, выбиваемых из мишени одним падающим ионом. Коэффициент распыления не является обычно целым числом и должен рассматриваться как среднестатистическое значение. В соответствии с определением
 , (3.2)
, (3.2)
где N A – число распыленных атомов вещества;
N 0 – число бомбардирующих ионов.
Коэффициент распыления находится в корреляционной зависимости от многих параметров (около двадцати). Основными из них являются:
– энергия ионов Еi;
– заряд и масса ионов Zi и Мi соответственно;
– угол падения ионов α;
– кристаллографическая ориентация материала мишени;
– шероховатость, температура мишени;
– величина импульса иона;
– энергия связи атомов вещества с поверхностью;
– плотность тока ионов на мишени;
– величина дозы облучения мишени;
– вид материала мишени;
– давление газа в вакуумной камере.
Коэффициент распыления согласно теории Зигмунда сложным образом зависит от кинетической энергии ионов (3.4). На рис. 3.2 представлена зависимость величины S от энергии бомбардирующих ионов.
При энергиях, лежащих ниже порогового значения, не происходит сколь-нибудь существенного распыления. При возрастании энергии падающих частиц выше этого уровня величина S растет суперлинейно, потом линейно, проходит широкий максимум в области килоэлектронвольт и начинает медленно спадать при достаточно больших энергиях, в области которых наблюдается не распыление материала мишени, а имплантация (внедрение) ионов в мишень.
Исходя из предположения, что основной вклад в процесс распыления вносит первое столкновение иона с атомом мишени, была предложена простая формула для расчета величины S:
 , (3.3)
, (3.3)
где λ– cредняя длина свободного пробега ( ); (3.4)
); (3.4)
К – коэффициент, характеризующий физическое состояние мишени;
М 1 и М 2 – массы иона и атома мишени соответственно;
Ei – энергия иона;
d – диаметр столкновения иона и атома;
n 0 – концентрация атомов в мишени.
Значение К определяется путем сравнения расчетной кривой с экспери-ментальными данными.
Зигмундом была предложена полуэмпирическая формула для расчета коэффициента распыления:
 , (3.5)
, (3.5)
где E св – энергия связи поверхностных атомов мишени;
Z 1 и Z 2– заряды иона и атома мишени соответственно.
Для технологии ионного распыления интересно знать зависимости коэффициента распыления от различных параметров процесса, т. к. от величины S зависит и скорость нанесения пленок (V H):
 , нм/с, (3.6)
, нм/с, (3.6)
где j – плотность тока падающего ионного потока;
ρ – плотность материала мишени.

Рис. 3.2 Зависимость коэффициента распыления от энергии бомбардирующих ионов
На рис. 3.3 представлена зависимость величины S для некоторых металлов от энергии ионов. Для ионов с энергией 0,5–6 кэВ коэффициент распыления линейно зависит от энергии, т. е. S = кЕ, а для Е > 6 кэВ линейность нарушается.
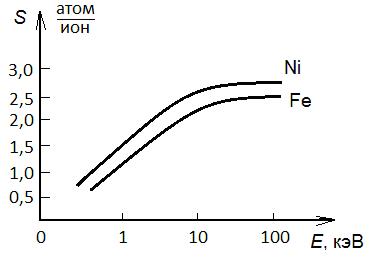
Рис. 3.3 Зависимости коэффициента распыления некоторых металлов от энергии
бомбардирующих ионов
Если распыление мишени производится ионным пучком, то наблюдается сильная зависимость коэффициента распыления от угла падения ионов (рис. 3.4). Для многих материалов зависимость S от угла падения α, может быть записана в виде:
S (α) = S (0)cosα, (3.7)
где S (0)– коэффициент распыления при нормальном падении ионов.

Рис. 3.4. Зависимость коэффициента распыления от угла падения бомбардирующих ионов
Рост S при увеличении угла падения ионов α объясняется тем, что при α ≠ 0 длина пробега и число столкновений иона с атомами в приповерх-ностном слое мишени возрастает в 1 / cos α раз.
Зависимость величины S от температуры мишени может быть довольно сложной. Она зависит от того, как изменяется структура мишени с увеличением температуры. Поскольку на структуру мишени при этом начинает влиять отжиг дефектов, который восстанавливает повреждения решетки, производимые падающим ионом до того, как в это место попадает следующий ион, то температура может снижать величину S. Если же повышение температуры мишени влечет за собой фазовые превращения, как, например, в железе при 906 °С ОЦК решетка переходит в ГЦК, то характер зависимости S от Т может при этом измениться.
Угловое распределение распыленных частиц очень часто имеет первостепенное значение для практических целей получения качественных тонких пленок. В отличие от процесса испарения угловое распределение при катодном распылении не подчиняется строго закону косинуса. Только при распылении аморфных или поликристаллических мишеней распределение выбитых атомов по углам вылета с поверхности близко к косинусоидальному. При распылении монокристаллических мишеней картина несколько иная (рис. 3.5).

Рис. 3.5. Распределение распыленных частиц, выбитых из монокристалла Мо
В распределении выбитых атомов по углам вылета появляются направления, в которых число выбитых атомов больше, чем в других. Установлено, что в направлении наиболее плотной упаковки атомов в кристаллической решетке наблюдается преимущественное распыление атомов. Это можно объяснить следующим образом: вдоль направления плотной упаковки атомов существует возможность фокусировки импульса иона (образование так называемого «фокусона»).
Давление в вакуумной камере складывается из парциальных давлений рабочего и остаточных газов. Присутствие остаточных газов, обычно химически активных (кислород, азот, пары воды, вакуумных масел), снижает коэффициент распыления вследствие образования на поверхности образца пленок химических соединений, особенно оксидов.
Распыляемые атомы мишени, испытывая столкновения с молекулами или атомами рабочего газа, могут возвращаться на мишень. Обратное рассеяние существенно, когда масса распыленного атома меньше массы газовой частицы. Обратная диффузия возрастает с ростом давления рабочего газа. Например, при давлениях более 1–1,2 Па величина S уменьшается.
Плотность ионного тока на мишень не может прямо влиять на коэффициент распыления, но при низких плотностях тока (j < 100 мкА/см2) может наблюдаться снижение S из-за наличия хемосорбированных газов, которые затрудняют распыление.
Состояние поверхности мишени (кристаллографическое и химическое) сильно сказывается на коэффициенте распыления в начале процесса, но при длительном распылении, когда раскрыты внутренние участки объема мишени и нет нерегулярного воздействия остаточных газов, это влияние ослабевает.
Экспериментально установлена зависимость величины S от атомного номера элемента материала мишени. На величину S существенное влияние оказывает также масса распыляющих ионов. Коэффициенты распыления максимальны для ионов инертных газов и минимальны для элементов, расположенных в центральных столбцах периодической системы (Al, Ti, Zr, Hf и редкоземельные элементы). Весьма интересным является тот факт, что коэффициенты распыления изменяются значительно сильнее в зависимости от природы ионов (в сто и более раз), чем в зависимости от природы атомов мишени (в 10 раз). Коэффициент распыления может достигать довольно высоких значений. Так для пары Al–Hg+ он составляет 50 атом/ион.
В технологии очень часто встречаются не только с распылением простых мишеней. Процесс распыления сплавов, а также соединений более сложен, чем распыление мишеней из простых веществ. Кинетическая энергия бомбардирующих ионов неодинаково распределяется между компонентами сложной мишени. В результате происходит преимущественное распыление какого-либо компонента и, следовательно, нарушается стехиометрия состава распыляемой поверхности мишени за счет обеднения ее хорошо распыляемым элементом.
Распыление сплавов и соединений имеет особое значение, т. к. способность переносить сложный по составу материал с мишени на поверхность подложки является основным преимуществом ионных методов нанесения тонких пленок по сравнению с другими методами. Стехиометрия состава пленок сохраняется даже в случае распыления материалов, состоящих из компонентов с сильно различающимися парциальными коэффициентами распыления. Единственное требование для обеспечения заданной стехио-метрии пленок – хорошее охлаждение мишени для исключения диффузии компонентов из объема. Поток распыленного материала с установившейся стехиометрией по составу компонентов формируется следующим образом. Поверхность мишени обедняется ионами с высоким коэффициентом распыления до количества, компенсирующего различие в скоростях распыления различных компонентов. Если диффузия не обеспечивает пополнение из объема поверхности обедненным компонентом, состав будет установившимся, постоянным. Если коэффициенты распыления всех компонентов близки, то установившееся состояние достигается после удаления всего лишь нескольких слоев. Если через SA, KA, CA обозначить соответственно коэффициент распыления, поверхностную концентрацию и объемную концентрацию компонента A, а через SB, KB, CB – компонента В, то установление равновесия поверхностной концентрации можно охарактери-зовать соотношением
 . (3.8)
. (3.8)
Из него следует, что распыление компонентов будет происходить со скоростями, пропорциональными объемным концентрациям их в материале. Таким образом, при распылении многокомпонентных материалов могут быть обеспечены условия для получения пленок требуемого состава.
Как отмечалось, состав распыленных частиц при ионном распылении слагается из атомов и ионов основного вещества, ионов, атомов и молекул примесей и газов, содержащихся в мишени, химических соединений материала мишени, рабочего и остаточного газов. Так, при распылении тантала обнаружено, что основная часть (94 %) распыленных частиц является нейтральными атомами металла и около 1 % составляют положительные ионы Та+, TaN+,TaO+, TaO2+, Ta2O+, Ta2 O2+. Надо отметить, что по сравнению с термическим испарением количество ионизованных частиц чрезвычайно велико.
Энергетический спектр распыленных атомов и ионов металла определяется условиями распыления: природой и энергией первичных ионов, природой распыляемого металла и углом вылета атомов из мишени. Величина анергии распыленных частиц колеблется от 0,5 до 200 эВ со средним значением порядка 5 эВ, что в терминах температуры для частиц соответствует 58 000 °С.
На рис. 3.6 представлены энергетические спектры атомов Ag и Zr, распыляемых ионами криптона с энергией 1200 эВ.

Рис. 3.6. Энергетические спектры атомов Ag и Zr, распыляемых ионами криптона с энергией 1200 эВ
Таким образом, основными особенностями конденсации пленок, наносимых ионным распылением, являются повышенная кинетическая энергия атомов и относительно высокое содержание заряженных частиц и ионов инертного газа в общем потоке. Кинетика конденсации пленки при этом имеет следующие особенности. Вследствие значительной энергии конденсирующихся атомов их подвижность на подложке высокая, что способствует увеличению плотности центров зародышеобразования и уменьшению размеров кристаллов, при этом пленка становится сплошной при меньшей толщине по сравнению с методом термического нанесения. Увеличение плотности центров зародышеобразования происходит также вследствие возникновения радиационных дефектов в поверхностном слое подложки. Осажденные пленки обладают высокой адгезией к подложке, т. к. энергия осаждаемых атомов достаточна для образования хемосорбционных связей.
Для конденсации пленок при ионном распылении характерно также повышенное содержание в их составе атомов примесных остаточных газов. Благодаря ионизации атомы этих газов интенсивно проникают в пленку вещества и замуровываются или адсорбируются в ней.
 2020-07-12
2020-07-12 1517
1517








