Основное отличие реального диэлектрика от идеального заключается в том, что пленка диэлектрика имеет структурные дефекты, которые неравномерно распределены по ее толщине. Из-за различия структурной матрицы диэлектрика и Si на границе их раздела имеются дефекты, которые дают уровни в запрещенной зоне Si – поверхностные состояния (interface states). Ионизация дефектов, находящихся на границах раздела и в глубине диэлектрика, может приводить к изменению поверхностного потенциала ψ s, и, соответственно, электрических свойств МДП-структур и приборов, изготовленных на их основе. На рис. 6.1 схематически изображена микроструктура SiO2 вблизи границы с Si. На схеме показаны отдельные дефекты, электрическая активность которых может оказывать влияние на характеристики МДП-структуры.
Qss – заряд поверхностных состояний (surface state), который концентрируется вблизи границы раздела Si-SiO2. Поскольку максимум этих состояния располагаются вблизи краев запрещенной зоны, время их перезарядки может быть весьма малым (рис. 6.2).

|
| Рис. 6.1 |
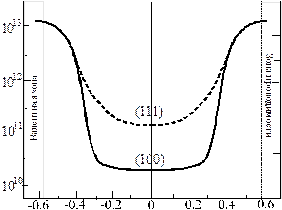
|
| Рис. 6.2 |
Qf – заряд фиксированный вблизи поверхности (обмен зарядами этого типа не может происходить так же быстро, как для Qss).
Qt – заряд, захваченный ловушками в окисле.
Qm – заряд подвижных ионов, который возникает в результате присутствия в диэлектрике посторонних ионов, например Na+.
Величину всех этих зарядов обычно относят к единице площади границы раздела, т.е. измеряют в единицах Кл∙см-2. Вместо зарядов часто используют соответствующие поверхностные плотности, которые обозначают символом Ni с теми же индексами (Ni =Qi/ q – число зарядов на 1 см2). Поскольку энергетические уровни состояний, захватывающих поверхностный заряд Qss, непрерывно распределены в запрещенной зоне полупроводника, полезной характеристикой является энергетическая плотность поверхностных состояний

| (6.1) |
Измеряется в [число зарядов/см2∙эВ].
Фиксированный заряд в окисле Qf (обычно положительный) экранирует электрическое поле затвора.
 2014-02-09
2014-02-09 1075
1075








