Расчет профиля легирования (распределения концентраций примесей по глубине транзисторной структуры) позволяет определить глубины залегания p-n-переходов, толщины слоёв эмиттера, базы и коллектора, электрофизические параметры этих слоёв и в конечном счёте основные параметры транзистора.
Процесс базовой диффузии проводится в две стадии. На первой стадии, называемой процессом загонки легирующей примеси (бора), в полупроводниковую пластину вводится строго определенное количество примеси. Поверхностную концентрацию бора при загонке  выбирают по величине предельной растворимости бора в кремнии при заданной температуре. Загонку проводят при температурах 950 - 1100 оС, при этом
выбирают по величине предельной растворимости бора в кремнии при заданной температуре. Загонку проводят при температурах 950 - 1100 оС, при этом  . На второй стадии процесса диффузии, называемой разгонкой, эта примесь распределяется на нужную глубину и образует профиль распределения примеси. Разгонка в планарной технологии проводится одновременно с окислением. Окисление поверхности проводится для предотвращения обратной диффузии примеси и под фотолитографию для эмиттерной диффузии. Разгонку базовой примеси проводят при температурах 1100 - 1200 оС, в течение времени от одного до двух часов.
. На второй стадии процесса диффузии, называемой разгонкой, эта примесь распределяется на нужную глубину и образует профиль распределения примеси. Разгонка в планарной технологии проводится одновременно с окислением. Окисление поверхности проводится для предотвращения обратной диффузии примеси и под фотолитографию для эмиттерной диффузии. Разгонку базовой примеси проводят при температурах 1100 - 1200 оС, в течение времени от одного до двух часов.
Процесс эмиттерной диффузии проводится в одну стадию. В практике производства кремниевых планарных n-p-n транзисторов диффузия фосфора проводится для создания эмиттерной области при условии достижения предельной растворимости фосфора в кремнии при температурах 900 - 1200 оС. При этом поверхностная концентрация фосфора  равна 1021 см-3.
равна 1021 см-3.
Введём исходные поверхностные концетрации при базовой Nosи эмиттерной Noeдиффузиях. Температурные характеристики процесса зададим в виде вектора T, а временные – в виде вектора t. Для изменения параметров режима следует изменять либо поверхностные концентрации, либо элементы векторов, либо то и другое одновременно.
Задаем режим диффузии в виде векторов температуры и времени.

 - поверхностная концентрация примеси в базе, см-3.
- поверхностная концентрация примеси в базе, см-3.
 - поверхностная концентрация примеси в эмиттере, см-3.
- поверхностная концентрация примеси в эмиттере, см-3.
Рассчитаем коэффициент диффузии атомов бора в базе.
 - предэкспоненциальный коэффициент диффузии для бора,
- предэкспоненциальный коэффициент диффузии для бора,  ;
;
 - энергия активации атомов бора, эВ;
- энергия активации атомов бора, эВ;
 - номера элементов векторов температуры T и времени t;
- номера элементов векторов температуры T и времени t;
 - коэффициент диффузии бора в кремнии
- коэффициент диффузии бора в кремнии  ;
;
 | |
 |
Распределение концентрации атомов бора после выполнения всех семи технологических операций, учтённых в векторах температуры и времени имеет вид:
 |
Сделаем приближённый расчет глубины залегания базы. Глубина залегания базы находится из условия равенства коллектерной и базовой концентраций. Приближение заключается в том, что не учитывается концентрация эмиттерной примеси. Это делается для исключения неоднозначности при определении глубины залегания базы. Если сразу учитывать эмиттерную диффузию, то из-за неверно выбранного начального приближения, вместо глубины залегания базы будет определена глубина залегания эмиттера. Это объясняется тем, что распределение модуля результирующей концентрации имеет два минимума. В дальнейшем глубина залегания базы будет уточняться.
Зададим начальное приближение переменной  , необходимое для численного решения уравнения
, необходимое для численного решения уравнения  .
.
 |
Глубина залегания базы: 
Рассчитаем коэффициент диффузии атомов фосфора эмиттере.
 - предэкспоненциальный коэффициент диффузии для фосфора,
- предэкспоненциальный коэффициент диффузии для фосфора,  ;
;
 - энергия активации атомов фосфора, эВ;
- энергия активации атомов фосфора, эВ;

 - коэффициент диффузии фосфора
- коэффициент диффузии фосфора  ;
;
 |
Распределение концентрации атомов фосфора после выполнения всех технологических операций, учтённых в векторах температуры и времени, начиная с эмиттерной диффузии, имеет вид:
 |
Приближённо определим глубину залегания эмиттерного перехода. Глубина залегания эмиттерного перехода находится из условия равенства эмиттерной и базовой концентраций. Приближение заключается в том, что не учитывается концентрация примеси в эпитаксиальном слое коллектора. Это делается для исключения неоднозначности при определении глубины залегания базы. Если сразу её учитывать то из-за неверно выбранного начального приближения, вместо глубины залегания эмиттера будет определена глубина залегания базы. Это объясняется тем, что распределение модуля результирующей концентрации имеет два минимума. В дальнейшем глубина залегания эмиттера будет уточняться.
Зададим начальное приближение значения  , необходимое для численного решения уравнения
, необходимое для численного решения уравнения  .
.
 |
Глубина залегания эмиттерного перехода: 
Правильность расчёта можно проконтролировать по графику распределения примесей в транзисторной структуре (рис. 2.5).

Рис. 2.5. Распределение примеси в транзисторной структуре.1 – эмиттерная примесь,2 – базовая примесь, 3 – коллекторная примесь.
Распределение суммарной концентрации примесей в транзисторной структуре изображено на рис. 2.6.
 |
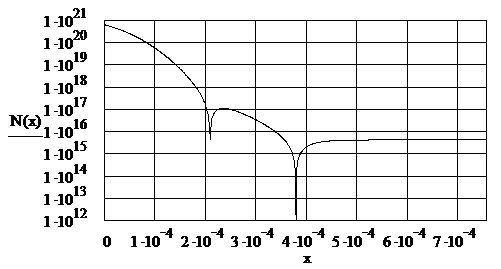
Рис. 2.6. Распределение суммарной концентрации примесей в транзисторной структуре.
Уточним координату металлургической границы эмиттерного перехода. Уточнение происходит в два этапа. Контроль производится по значению результирующей концентрации. В идеале она должна быть равна нулю. Реально достаточно, чтобы она была много меньше концентрации примеси в коллекторе.
 |
В качестве начального приближения возьмём ранее определённое значение координаты эмиттерного перехода. 
 | |
 |
Теперь присвоим  уточнённое значение и повторим расчет.
уточнённое значение и повторим расчет.
 | |
 |
 - концентрация, по которой контролируется достаточность уточнения координаты.
- концентрация, по которой контролируется достаточность уточнения координаты.
Уточним координату металлургической границы коллекторного перехода. Уточнение происходит в два этапа. Контроль производится по значению результирующей концентрации. В идеале она должна быть равна нулю. Реально достаточно, чтобы она была на три порядка меньше концентрации примеси в коллекторе.
В качестве начального приближения возьмём ранее определённое значение координаты коллекторного перехода  .
.
 | |
 |
Теперь присвоим  уточнённое значение и повторим расчет.
уточнённое значение и повторим расчет.
 | |
 |
 - концентрация, по которой контролируется достаточность уточнения координаты.
- концентрация, по которой контролируется достаточность уточнения координаты.
Глубина залегания эмиттерного перехода выбирается в диапазоне 1 - 3 мкм. Глубина залегания коллекторного перехода определяет ширину базы и напряжение пробоя в сферической части коллекторного перехода планарного транзистора. Нижний предел ширины базы ограничен смыканием коллекторного и эмиттерного переходов при максимальных обратных напряжениях на переходах. Верхний предел ширины базы ограничен необходимостью обеспечивать требуемые коэффициент передачи и граничную частоту транзистора.
 2015-05-26
2015-05-26 5872
5872








