Выращивание плёнок GeSi и CaF2 на кремниевых подложках для приборных структур.
Руководитель: в. н. с., к.ф.-м.н. ИФП СО РАН Соколов Л. В.
Кафедра: ППиМЭ
Цель работы:
1 На подложках Si(001) вырастить плёнки твёрдого раствора GeSi с содержанием германия не более 30 % и посредством отжигов в различных атмосферах зафиксировать начальную стадию пластической релаксации плёнки GeSi.
2 Изучить возможности блокировки источников дислокаций несоответствия с целью получения в дальнейшем подложек пригодных для изготовления приборных структур.
3 На подложках Si(111) вырастить плёнки CaF2, обладающих высоким структурным совершенством и электрическими параметрами, делающими возможным применение таких плёнок для изготовления приборных структур.
Результаты и выводы:
1. Зафиксирована начальная стадия пластической релаксации плёнки GeSi.
2. Подтверждено предположение о локализации источников генерации дислокаций несоответствия на поверхности плёнки.
3. Исследована возможность блокировки источников дислокаций посредством отжига в атмосфере водорода.
4. Методами молекулярно-лучевой эпитаксии на подложках Si(111) выращены слои диэлектрика CaF2 с электрическими свойствами, позволяющими использовать их для приборных структур.
Таблица 1 Состав гетероструктур GexSi1-x/Si(001)
| № образца | HT буфер Т = 700°C | LT буфер Т = 350 °C | GexSi1-x слой | Содержание Ge в слое GexSi1-x | Cap-Si слой |
| E9 | 500 Ǻ | 500 Ǻ | 2000 Ǻ 300 °C | 0.32 | 50 Ǻ |
| F9 | 500 Ǻ | 500 Ǻ | 1000 Ǻ 350 °C | 0.22 | нет |

Рис. 1 Фотография поверхности образца Е9 до отжига полученная с помощью АСМ
Таблица 2 Основные параметры отжига образцов серии Е9 (температура отжига 350 °С)
| Образец | E9/1 | E9/2 | E9/3 | E9/4 | E9/5 | E9/6 |
| Атмосфера отжига | Ar | H2 | ||||
| Время отжига, мин | 10 | 30 | 20 | 90 | 10 | 30 |
| Степень Релаксации* % | 1 | 9 | 3 | 12 | 1 | 2 |
* - по данным рентеновской дифракции
Таблица 3 Основные параметры отжига образцов серии F9 (время отжига 10 мин)
| Образец | F9/1 | F9/2 | F9/3 | F9/4 |
| Температура Отжига, °С | 500 | 600 | 600 | 700 |
| Атмосфера отжига | H2 | H2 | Ar | H2 |
| Степень Релаксации, % | 0 | 0 | 0.2 | 0.02 |
*- по данным АСМ

Рис. 2 ЭМ снимки поверхности образца Е9/1 после 10 мин отжига Т = 350 ° С


Рис. 6 Снимки поверхности образца F9/4 после отжига в Н2 10мин. Т = 700 ° С
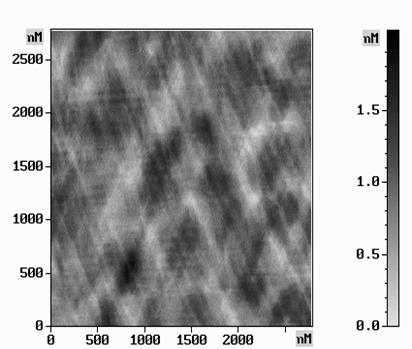
Рис. 7 Фотография поверхности образца 76 (толщина плёнки CaF2 550Å) полученная с помощью АСМ.

Рис. 8 фотография поверхности образца 77 (толщина плёнки CaF2 330Å) полученная с помощью АСМ.
Таблица 4 Состав гетероструктур CaF2/Si(111)
| № образца | Толщина плёнки CaF2, Å | Ориентация подложки | Температура роста, °С | Послеростовой отжиг | Скрорсть роста, нм/с |
| 76 | 550 | (111) | 750 | нет | 0,091 |
| 77 | 330 | (111) | 750 | нет | 0,091 |
| 253 | 290 | (111) | 550 | нет | 0,041 |

Рис. 9 ВАХ МДП конденсаторов Si/CaF2/Al
| Образец | Толщина плёнки CaF2, Å | Удельное сопротивление, Ωּcm | Пробивное напряжение, В/см |
| 253 | 290 | 1011 | 1,5ּ106 |
 2020-08-05
2020-08-05 72
72