Гетероэпитаксия - это процесс наращивания эпитаксиального слоя, повторяющего структуру подложки, но отличающегося от вещества подложки по химическому составу (Si на Ge; Ge на Si; Si на GaAs).
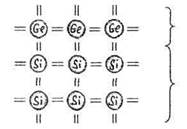
|
Эпитаксиальный слой
Подложка
Эпитаксиальные слои, в отличие от кремниевой пластины из слитка (выращенного из расплава) не содержат кислорода и углерода, которые являются центрами образования различных дефектов.
В ИМС эпитаксиальные слои служат в качестве высокоомных областей транзисторов - приборов, являющихся наиболее важной частью ИМС. Толщина эпитаксиального слоя составляет 3-25 мкм - в зависимости от назначения ИМС.
Эпитаксиальные слои можно наращивать в вакууме, из парогазовой и жидкой фазы. Большинство процессов эпитаксии - осаждение из парогазовой фазы.
Хлоридный метод эпитаксии.
Хлоридный метод основан на восстановлении тетрахлорида кремния SiCl4 водородом при взаимодействии SiCl4 c чистым водородом:

Данная химическая реакция обратима, поэтому необходимо строго выдерживать параметры процесса (температуру, соотношение (H2: SiCl4 ) реагентов), иначе будет наблюдаться обратный процесс - начнет травиться кремний.
Схема установки эпитаксиального осаждения.
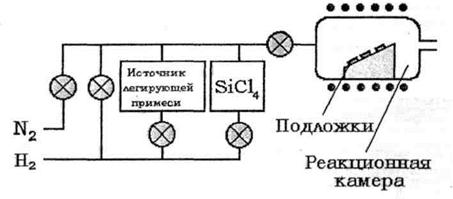
Процесс эпитаксиального осаждения включает этапы:
1. загрузка пластин в реакционную камеру;
2. продувка камеры азотом для вытеснения воздуха;
3. продувка камеры водородом;
4. нагрев пластин до температуры 1200°С,
5. осаждение эпитаксиального слоя, для чего начинают пропускать водород через
жидкий SiCl4. Водород захватывает пары SiCl4 и переносит их в реакционную камеру,
где идет реакция восстановления кремния.
В процессе роста эпитаксиальные слои легируют, т.е. в них вводят донорные или акцепторные примеси для получения определенного типа проводимости (n- или p-) и определенного удельного сопротивления эпитаксиального слоя. Легирование эпитаксиальных слоев происходит одновременно с их ростом путем введения в газовую смесь соединений, содержащих легирующие элементы.
Если необходимо получить эпитаксиальный слой n-типа проводимости, используют легирующие вещества, содержащие фосфор (РС13, РН3 и др.).
Если необходимо получить эпитаксиальный слой p-типа проводимости, используют легирующие вещества, содержащие бор (В2Н6, BBr3 и др.).
Эпитаксия выполняется на установках типа УНЭС, Изотрон, управляемых в основном ЭВМ.
Основной недостаток хлоридного метода - высокая температура процесса, приводящая к проникновению примесей из пластины в растущий эпитаксиальный слой.
Силановый метод эпитаксии.
Силановый метод основан на использовании необратимой реакции термического разложения силана:

Совершенные эпитаксиальные слои получаются при температурах 1000° -1050°С, что на 200° - 150°С ниже, чем в хлоридном методе. Это уменьшает нежелательное проникновение примеси из пластины в эпитаксиальный слой, что позволяет изготавливать эпитаксиальные структуры с более резкими границами переходов.
Скорость роста слоев выше, чем в хлоридном методе.
К недостаткам метода относятся самовоспламеняемость и взрывоопасность силана, поэтому на практике применяют силан в смеси с водородом. При содержании силана менее 5 % смесь не самовоспламеняется.
После проведения процесса эпитаксии контролируют толщину, удельное сопротивление, плотность структурных дефектов эпитаксиального слоя.
Тема: Окисление
Урок
 2014-02-24
2014-02-24 1011
1011








