Типичное распределение примеси или профиль внедренных ионов по глубине мишени при ИИ показан на рис. 8.3.
 | Рис. 8.3. |
В первом приближении (при разориентированном внедрение ионов) распределение внедренных ионов по глубине мишени вблизи максимума этого распределения подчиняется гауссовой функции (нормальному закону), так как столкновение ионов с атомами решетки носит вероятностный характер:
 . (8.1)
. (8.1)
Максимальная концентрация N(Rp) в отличие от термической диффузии соответствует не поверхности подложки, а находится на глубине х=Rp (рис. 8.4) и непосредственно связана с дозой имплантации D:
|
 (8.2)
(8.2) В ряде случаев экспериментальные кривые профиля распределения примеси при ионной имплантации описываются законом распределения, состоящим из двух наложенных гауссовых распределений, каждое из которых имеет свое собственное значение рассеяния D Rp1 и D Rp2.
 |
| Рис. 8.4. Распределение ионов с низкими (а) и высокими (б) значениями энергии ври разориентированном внедрении ионов |
Более точное описание закона распределения требует использования распределения Пирсона с большим числом эмпирических параметров (рис. 8.5). Длина пробега иона определяется по теории Линдхарда, Шарфа и Шиотта (ЛШШ), изложенная, например, в книге Зи.
| |||
| Рис. 8.5. Экспериментальные и расчетные (с использованием модели Пирсона, учитывающей несимметричность реальных примесных слоев) распределения профилей имплантированных атомов бора |
Боковое рассеяние ионов
Очень важными практическими аспектами торможения ионов являются эффекты бокового рассеяния ионов.
На рис. 8.6, а показан толстый маскирующий слой для нонной имплантации (толщина маски  ) с вертикально вскрытым прямоугольным окном. На указанном рисунке координата z, направленная перпендикулярно плоскости рисунка, определяет длину большей стороны окна, координата у характеризует ширину окна, равную 2а, а координата х направлена в глубь образца. Профиль имплантированных ионов описывается формулой
) с вертикально вскрытым прямоугольным окном. На указанном рисунке координата z, направленная перпендикулярно плоскости рисунка, определяет длину большей стороны окна, координата у характеризует ширину окна, равную 2а, а координата х направлена в глубь образца. Профиль имплантированных ионов описывается формулой
 . (8.3)
. (8.3)
где N(х) — плотность распределения по глубине подложки на большом расстоянии от края маски.
(сравните с (3.28)).
 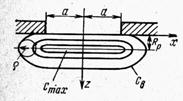 |
| Рис. 8.6. Экспериментальные и расчетные (с использованием модели Пирсона, учитывающей несимметричность реальных примесных слоев) распределения профилей имплантированных атомов бора |
Для 
 что характерно для полуограниченного источника. На рис. 8.6, а
что характерно для полуограниченного источника. На рис. 8.6, а  т. е. края маски находятся на большом расстоянии друг от друга. На рис. 8.6, б приведены линии равной концентрации ионов бора после имплантации ионов с энергией 70 кэВ через щель размером 1 мкм. За счет бокового легирования примесь проникает на значительное расстояние под края маски и влияет на длину канала в МОП-транзисторе с коротким затвором.
т. е. края маски находятся на большом расстоянии друг от друга. На рис. 8.6, б приведены линии равной концентрации ионов бора после имплантации ионов с энергией 70 кэВ через щель размером 1 мкм. За счет бокового легирования примесь проникает на значительное расстояние под края маски и влияет на длину канала в МОП-транзисторе с коротким затвором.
Ионное каналирование
Распределение ионов по закону (8.1) имеет место в случае аморфной мишени, для которой отклонение ионов от траектории абсолютно неупорядоченно. В случае кристаллических мишеней распределение имплантированных ионов зависит от кристаллографической ориентации поверхности мишени. Из-за различия в плотности упаковки атомов вдоль различных кристаллографических направлений возникает эффект каналирования ионов. Когда направление пучка ионов совпадает с кристаллографическим направлением, в котором между атомами полупроводника существуют сравнительно большие промежутки (каналы), часть ионов проникает достаточно глубоко (рис. 8.7, 8.8).
| |||
| Рис. 8.7. Модель эффекта каналирования ионов: а – сильное взаимодействие ионов у поверхности; б – ионы проникают в кристалл, проходя между рядами атомов вдоль каналов |
Так, если ионный пучок падает, как это показано на рис. 8.7, а, то в этом направлении плотность упаковки атомов велика и взаимодействие ионов преимущественно происходит вблизи поверхности мишени. Если пучок падает под несколько отличным от этого направления углом по отношению к кристаллу (рис. 8.7,б), то ионы проникают более глубоко в кристалл, проходя между рядами атомов вдоль «каналов», претерпевая с ними слабые скользящие столкновения.
 |
Рис. 8.8. Схематическое изображение в монокристаллической подложке траектории нона, падающего на мишень в направлении плотной упаковки  . (Траектория ионов имеет два участка: неориентированный и каналируемый.) . (Траектория ионов имеет два участка: неориентированный и каналируемый.) |
Это может привести к негауссовому профилю распределения и даже наличию у него второго максимума. Уменьшить эффект каналирования можно, если ионный пучок немного отклонить от первоначального кристаллографического направления (рис. 8.9, 8.10).
Ориентация кремниевой пластины в наиболее плотно упакованных направлениях позволяет свести к минимуму эффект ионного каналирования, но не исключает его полностью. В тоже время использование эффекта каналирования позволяет проводить ионное легирование на большие глубины. Наибольший угол, при котором исчезает направляющее действие канала, называют критическим углом каналирования. Критический угол зависит от энергии и типа нона, кристаллографического направления мишени. Для Р он составляет 5,9° при Е=50 кэВ, для В – 4,8° при Е=50 кэВ.
Ориентированное внедрение – когда угол между направлением падения ионов и главным кристаллографическим направлением полупроводниковой пластины меньше критического. Движение ионов происходит по каналам.
| |||||
Рис. 8.9. Профили распределения концентрации свободных носителей заряда для различной разориентации пластины от кристаллографического направления  (для ионов 31Р с энергией 300 кэВ и дозе облучения D= 1012ионсм-2) (для ионов 31Р с энергией 300 кэВ и дозе облучения D= 1012ионсм-2) | |||||
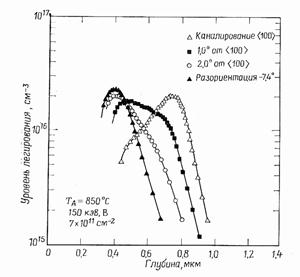 | |||||
Рис. 8.10. Профили распределения концентрации акцепторов для различной разориентации от направления  для ионов бора 11В с энергией 150 кэВ для ионов бора 11В с энергией 150 кэВ | |||||
Глубина проникновения ионов зависит от кристаллографической ориентации и максимальна для направления [100] так как плотность атомов решетки типа алмаза в этом направлении наименьшая. Глубина внедрения меняется в соответствии с рядом [110] > [100] > [111]. Вдоль направления [110] она приблизительно в два раза больше, чем в направлении [111].
В реальных условиях, даже если угол падения отклоняется от оси канала не более чем на критический, чистое каналирование не будет иметь место.
При дозах облучения свыше 1012 см-2 пробег ионов в каналах значительно уменьшается вследствие образования радиационных дефектов. При дозе 1015 см-2 эффект каналирования исчезает.
Распределение ионов при ориентированном внедрении, а также условная схема движения ионов приведены на рис. 8.11. Первый максимум распределения обусловлен отклонением ионов от направления каналирования в результате взаимодействия части из них с поверхностными атомами полупроводника. Распре деление концентрации на этом участке соответствует функции Гаусса. Второй максимум распределения обусловлен идеально каналируемыми нонами. Распределение этих ионов не гауссово. Средняя область кривой распределения обусловлена нонами, которые попали в каналы, но не в идеальные условия. Пройдя некоторый путь, они деканалировали и внедрились в промежутке между двумя максимумами.
С увеличением дозы облучения вероятность рассеяния ионов на поверхности и дальнейшего деканалирования возрастает и поэтому каналирование уменьшается, второй максимум в кривой распределения внедренных ионов понижается, первый увеличивается.
 |
| Рис. 8.11. Условная схема движения (а) и характер распределения ионов (б) при ориентированном внедрении: 1 – отклонения ионов при столкновении с поверхностными атомами пластины; 2 – деканалнрование нонов: 3 – идеально-каналируемые ионы; 4 – гауссово распределение; 5 – негауссово распределение |
При большей дозе облучения и не слишком высокой начальной энергии ионов второй максимум распределения вообще может исчезнуть на фоне деканалированных ионов.
Даже небольшие отклонения от требуемой ориентации ионного пучка относительно выбранного кристаллографического направления приводят к плохой воспроизводимости результатов и к получению нескольких типов профилей распределения примеси. В результате соударения ионов с атомами кристаллической решетки мишени образуется аморфный слой с распределением 1¢ внедренных в кристалл ионов, падающих в острофокусированном пучке и падающих на кристалл ионов под произвольным углом 1 (рис. 8.12).
| Рис. 8.12. Разновидности профилей распределения примесей: 1 – аморфный материал, входящий ионный пучок проникает в мишень под произвольными углами; 2 –слабо ориентированный кристалл, деканалированный ионный пучок; 3 – каналированнын ионный пучок, хорошо ориентированный кристалл; 4 – профиль, полученный при диффузии ионов примеси при отжиге; 5 – эффект каналирования при незначительном отклонении ионного пучка относительно кристаллографической оси |
Способы подавления эффекта каналирования:
1. Легирование через пленку (SiО2, Si3N4) толщиной 3-10 нм;
2. Создание на поверхности аморфизированного слоя (ионное легирование Ne, Ar).
3. На практике внедрение осуществляется при угле падения ионов большем критического.
Практические кривые распределения внедренных ионов имеют характерные особенности и отличаются от расчетных кривых наличием «шлейфа» (рис. 8.13).
 |
| Рис. 8.13. Экспериментальные профили распределения электрвчески активного бора, внелренного при разных анергиях в кремний |
 2014-02-09
2014-02-09 2386
2386