Эпитаксия – процесс наращивания монокристаллических слоев на монокристаллических подложках. Монокристаллические подложки в процессе эпитаксиального наращивания выполняют ориентирующую роль заставки, на которой происходит кристаллизация. Основная особенность – слои и локальные области противоположного типа проводимости или с отличной от полупроводниковой пластины концентрацией примеси представляют собой новые образования над исходной поверхностью. В процессе роста эпитаксиальные слои легируют, т.е. в них вводят донорные или акцепторные примеси. Особенностью также является то, что появляется возможность получения высокоомных слоев полупроводника на низкоомных пластинах.
При жидкофазовой эпитаксии атомы растущего слоя оседают на подложку из расплава или раствора, из которого необходимо вырастить соответствыущий слой. Второй вид эпитаксии – из парогазовой фазы – который и будет использоваться в данной технологии, основан на взаимодействии газа с пластиной. Здесь важными параметрами процесса является температуры газового потока и пластины. Можно использовать тетрахлорид кремния SiCl4 либо силан SiH4.
Хлоридный метод основан на использовании химического взаимодействия паров тетрахлорида кремния с чистым водородом при Т =1200оС:
SiCl4(газ) + 2H2(газ) = Si(тв) + 4HCl(газ)
Наибольшее распространение получил метод восстановления SiCl4 водородом. При этом водород обычно играет роль и газа-носителя, и восстановителя.
Процесс происходит в кварцевом реакторе, который помещен в высокочастотный генератор.
Преимуществом этого метода является возможность достаточно простой очистки исходных реагентов.
Поступающие в камеру газы проходят над поверхностью подложек и удаляются через стеклянную трубку в водоохлаждаемую ловушку. Обогрев осуществляется ВЧ-генератором; перед началом процесса систему заполняют чистым азотом и продувают чистым водородом, который при температуре 1200 градусов по Цельсию вступает в реакцию с остатками оксидных плёнок на поверхности подложки и почти полностью удаляет её. Затем в систему подают смесь водорода и хлора для стравливания поверхности кремния в несколько микрометров.
Следующий этап: в систему подают SiCl4, который вступает в реакцию с водородом, в результате которой на поверхности кремниевой пластины образуется эпитаксиальный слой кремния. Пары HCl удаляются из реактора.
В качестве донорной примеси n-типа используется фосфин (PH3), а для примесей p-типа используется диборан (B2H6).
Идут основная реакция осаждения: SiCl4 +2H2 ↔ Si + 4HCl, (1)
Реакции: SiCl4 +H2 ↔ SiHCl3 + HCl, SiHCl3 +H2 _ Si + 3HCl (2)
и конкурирующая реакция травления: SiCl4 +Si ↔ 2SiCl2. (3)
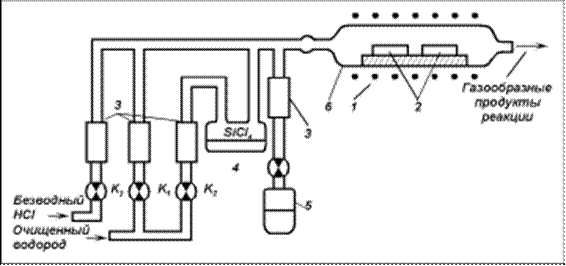
Рис. 18. Схема установки для получения эпитаксиальных пленок Si методом химических реакций: 1 — нагреватель; 2 — подложки; 3 — расходомеры; 4 — испаритель; 5 — источник легирующей примеси; 6 — реакционная камера.

Разность скоростей осаждения и газового травления подложки определяет скорость роста эпитаксиального слоя, характерное значение которой составляет 60–300 мкм/ч. Кроме того, скорость роста и качество получаемых эпитаксиальных пленок зависят от температуры подложки, относительной концентрации SiCl4/H2, скоростей газовых потоков, концентрации примесей, длительности процесса и геометрических характеристик системы.
Основной недостаток – высокие температуры процесса, приводящие к диффузии примесей из пластин в растущий слой, а также автолегированию. Кроме того, обратимость реакции восстановления тетрахлорида требует высокой точности поддержания режима осаждения слоя.
Технология молекулярно-пучковой (ее называют также молекулярно-лучевой) эпитаксии
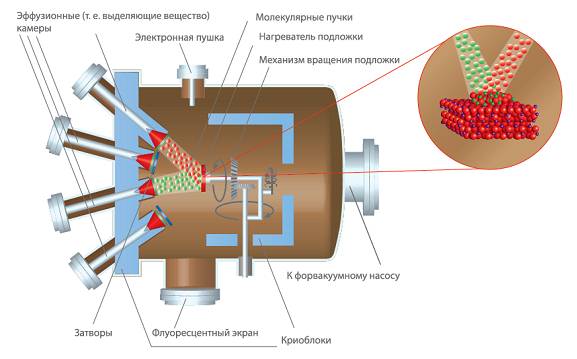
Технология молекулярно-пучковой (ее называют также молекулярно-лучевой) эпитаксии позволяет наносить на поверхность подложки (например, из кремния, сапфира или арсенида галлия) слои различных полупроводниковых и диэлектрических материалов толщиной вплоть до одного атомного слоя. Эти вещества нагреваются в испарительных ячейках установки для эпитаксии. Пучок испарившихся молекул направляется на подложку, где оседает тонким слоем определенного состава. Так, шаг за шагом, можно выращивать многослойную структуру, в которой чередуются материалы с разными свойствами — например, с разным типом проводимости, разной шириной запрещенной зоны. Процесс роста проводится в глубоком вакууме — посторонние молекулы могут привести к искажению свойств создаваемой структуры.
В результате получаются гетероструктуры — новые материалы с необычными свойствами, существование которых было предсказано в начале 60-х годов академиком Леонидом Келдышем. Поскольку с помощью молекулярно-лучевой эпитаксии удается получать сверхтонкие слои толщиной всего в несколько атомов, в материале проявляются квантово-механические эффекты, которые меняют его оптические и электрические свойства.
Технология молекулярно-лучевой эпитаксии — одна из первых революционных технологий, которая позволила управлять структурой вещества на наноуровне, создавая материалы с необычными и полезными свойствами.
Молекулярно-лучевая эпитаксия открывает путь к принципиально новой электронике, сверхбыстрым компьютерам, или, например, солнечным батареям со значительно более высоким КПД, новым оптическим устройствам для телекоммуникаций и другим приложениям.
 2015-04-01
2015-04-01 4298
4298
