Можно выделить следующие важнейшие требования к источнику для имплантации конструкционных материлов:
1) получение высокоинтенсивных пучков ионов (десятки, сотни миллиампер и выше),
2) возможность ионизации атомов твердых тел, в том числе тугоплавких,
3) высокая надежность и простота обслуживания.
Проще обстоит дело с генерацией интенсивных пучков газовых ионов, получаемых, например, при взаимодействии атомов или молекул газа со свободными электронами достаточно высокой энергии. Ионы летучих веществ можно получить аналогичным образом, испаряя соответствующий материал. Возможный путь получения интенсивных пучков нелетучих веществ - распыление поверхности ионами инертных газов с последующей ионизацией выбитых частиц.
В установках для имплантации применяются ионные источники различных типов: Кауфмана, Фримана, Пеннинга, Холла, магнетроны высокочастотные и источники сверхвысокой частоты (СВЧ), дуоплазмотроны, дуговые с прямонакальным катодом, с полым катодом, вакуумно-дуговые. Схемы некоторых источников приведены на рис. 3.2 - 3.5. Отдельно необходимо выделить источники, работающие в импульсном режиме,позволяющие создавать пучки с энергией несколько сотен кэВ и плотностью тока до 500 А/см2 при длительности импульса порядка 50-100 не.

Рис. 3.2 –– Схема ионного источника Кауфмана с аксиальным катодом: 1 –– газ, 2 –– линии магнитного поля, 3 –– анод, 4 –– катод, 5,6 –– экранирующая и ускорительная сетки.
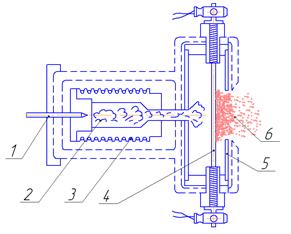
Рис. 3.3 –– Схема разрядной камеры и нагревателя источника Фримана: 1 –– ионный пучок, 2 –– разрядная камера, 3 –– накаливаемый катод, 4 –– магнитное поле, 5 –– нагреватель, 6 –– плазма.
Несмотря на существование большого количества различных типов источников, наибольшее распространение получили плазменные источники, в которых генерация ионов происходит в результате столкновения молекул рабочего вещества, находящегося в газо- или парообразном состоянии, с электронами. Плазменные источники ионов различаются типом и формой разряда, геометрией электродов, температурным диапазоном и зарядовым составом извлекаемого ионного пучка. Для повышения эффективности ионизации используют комбинации магнитных и электрических полей, например, магнетронный разряд, увеличивающие дрейфовый путь электрона в плазме.
Источники Кауфмана обеспечивают генерацию широких пучков с энергией 101 - 103 эВ и плотностью тока 1-5 мА/см2, а также независимый контроль плотности и энергии ионного потока. Источники Кауфмана в меньшей степени подходят для получения химически активных ионов, например кислорода, из-за быстрой деградации нити накала, однако, возможно применение специальных методов ее защиты. Увеличение эффективности отбора ионов из плазмы достигается при использовании источников со щелевидным отверстием, в которых отбор ионов производится поперек оси плазмы. Классическим примером является источник Фримана.При необходимости генерировать ионы тугоплавких элементов, источник Фримана допускает встраивание распыляющего электрода. Разновидностью ионных источников с накаленным катодом являются дуоплазмотроны, которые обеспечивают большую интенсивность ионного пучка. Ток легких ионов, например, водорода может достигать нескольких ампер. При необходимости генерации в дуоплазмотронах тяжелых ионов используют перезарядку первичных легких ионов.
Проблема деградации нити накала решается с переходом к источникам с холодным катодом. Примером являются источники, использующие тлеющий разряд Пеннинга в продольном магнитном поле.

Рис 3.4 – Схема ионного источника Пеннинга: 1 – аксиальное магнитное поле, 2 – катод, 3 – анод, 4 – плазма, 5 – апертура, 6 – источник питания разряда.
В источниках Пеннинга степень ионизации плазмы возрастает благодаря большой длине пути электронов, движущихся по спиральным траекториям вдоль силовых линий магнитного поля. Необходимые для ионизации электроны извлекаются из холодного катода под действием высокого напряжения. Источники Пеннинга с холодным катодом очень просты, надежны и долговечны, обеспечивают создание большого количества многозарядных ионов, но, в отличие от источников Кауфмана, не позволяют независимо контролировать плотность и энергию ионного потока. Степень ионизации в таких источниках ниже, а рабочее давление достигает 102 Па, что делает необходимой дополнительную откачку близи источника.
Проблема деградации катода отсутствует также при использовании источников, в которых ионизация атомов и молекул осуществляется высокочастотным электромагнитным полем. В источниках, основанных на эффекте электронного циклотронного резонанса, генерируется большое число многозарядных ионов. Для получения пучков, состоящих в основном из однозарядных ионов, увеличивают концентрацию электронов в плазме, повышают давление газа и величину магнитного поля. В микроволновых источниках роль нити накала выполняет микроволновой генератор плазмы с частотой колебаний в несколько ГГц. Разброс ионов по энергиям в таких источниках достигает 101 - 102 эВ, то есть превышает разброс в источниках с накаленным катодом. Высокочастотные источники весьма чувствительны к загрязнению конструктивных элементов и наиболее эффективны для получения ионов инертных газов, азота и т. п. К преимуществам высокочастотных источников относятся возможность получения ионов низкой энергии, простота и надежность в работе.
Общим недостатком сеточных источников, в том числе многоаппертурных, является сравнительно быстрая деградация сеток. Применение вместо сеток электрических и магнитных полей, например в источниках Холла увеличивает долговечность источника в целом.

Рис 3.5 –– Схема ионного источника Холла: 1 –– газ, 2 - магнитное поле, 3 –– катод,
4 –– анод.
Источники Холла отличают простота конструкции и управления. К основным недостаткам относятся эрозия катода при использовании химически активных газов, взаимозависимость ионного тока и ускоряющего напряжения. Энергия ионов в источниках Холла обычно не превышает 100 эВ.
Для получения ионов металлов, широко применяется термическое или электронно-лучевое испарение с последующей ионизацией, а также распыление поверхности металлов и извлечение ионов из дуги паров металла.Каждый из перечисленных методов не лишен тех или иных недостатков. Так, испарение эффективно для металлов с высоким давлением паров, использование дуговых источников связано с генерацией микрокапельной фазы. Получение ионных пучков посредством распыления приводит к разбросу ионов по энергиям до 10 - 50 эВ, что существенно выше, чем в источниках с накаленным катодом.
3.1.1 Особенности оборудования для сильноточной ионной имплантации
Основным узлом, обеспечивающим реализацию преимуществ сильноточной низкоэнергетической ионной имплантации, является ионный источник, параметры которого, в основном, определяют степень изменения физико-механических и эксплуатационных характеристик, а также технико-экономические показатели процесса (производительность, надежность, стоимость, простота управления, экологическая чистота и т. д.).
Для обеспечения конкурентоспособности создаваемых на базе сильноточных ионных источников технологических процессов по производительности и уровню достигаемых служебных характеристик изделий, они должны обладать следующими параметрами: плотность ионного тока на мишени несколько миллиампер на квадратный сантиметр, энергия ионов не менее 0,5 кэВ, возможность регулировки энергетических параметров в широком диапазоне. Предпочтительными являются источники, позволяющие за счет собственной мощности нагревать обрабатываемые детали до температур, обеспечивающих эффективное диффузионное перераспределение имплантированной примеси, что исключает применение дополнительных источников нагрева.
Применение сильноточных ионных источников для упрочнения металлов и сплавов имеет свои особенности. Речь идет о контроле за параметрами процесса, определяющими необходимый уровень получаемых физико-механических и эксплуатационных характеристик. Обычно в исследованиях по ионной имплантации одним из основных параметров является доза облучения, требуемая точность определения которой, особенно в микроэлектронике, весьма высока и требует применения специальных устройств типа цилиндра Фарадея. При сильноточной ионной имплантации, использующей пучки ~1мА/см2 и выше, концентрация примеси, достаточная для получения эффекта упрочнения, достигается за время нескольких секунд и дальнейшее облучение вызывает прежде всего увеличение толщины упрочненной зоны за счет процессов диффузионного переноса. В результате оказывается достаточным осуществляемый стандартным амперметром контроль ионного тока на детали. Другим важным параметром при использовании сильноточных ионных пучков является температура обрабатываемой детали, контроль которой не имеет принципиальных отличий и может осуществляться как пирометрическими методами, так и различными контактными датчиками.
Применение сильноточной имплантации низкоэнергетических ионов существенно снижает требования к степени откачки рабочей камеры, так как необходимость ускорения ионов до энергии, не превышающей 1 кэВ, уменьшает вероятность электрического пробоя в ускоряющем межэлектродном зазоре. Одновременно снижаются требования к энергетическому разбросу ионов, выходящих из ионного источника.
К распространенным в сильноточных ионно-лучевых установках источникам ионов относятся источники на базе ускорителей с замкнутым дрейфом электронов. Такие устройства используют ускоряющее напряжение 0,1-2,0 кВ, суммарный ионный ток может достигать нескольких ампер, а средняя энергия ионов порядка 0,7 ускоряющего напряжения UVCK . Разновидностью такого типа источников является ускоритель с анодным слоем, ускоряющее напряжение в котором достигает нескольких киловольт, энергия ионов порядка (0,3-0,5) UVCK, a ионный ток от нескольких сотен миллиампер до единиц ампер.
Упрощенная схема источника приведена на рис. 3.6. Источник обладает достаточной для производственных целей производительностью, прост в обслуживании и имеет большой срок службы, фактически лимитируемый временем «запыления» изоляторов, которые легко подвергаются очистке.
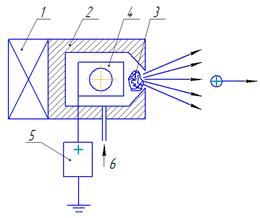
Рис. 3.6 –– Схема ионного источника с замкнутым дрейфом электронов:1 –– магнит; 2 –– магнитопровод - катод; 3 –– разрядное пространство; 4 –– анод; 5 –– блок питания; 6 –– подача газа.
В последнее время в имплантационной металлургии стали достаточно широко применяться источники ионов, разработанные в качестве двигателей для управления космическими объектами и имеющие диаметр до 1,5 м. Такие источники могут генерировать пучки различного размера и формы с однородным распределением плотности ионного тока по сечению. К важным преимуществам этого типа источников относятся простота конструкции, надежность в работе, долговечность и экономное расходование как электроэнергии, так и ионизируемого вещества. Практическое использования ионной имплантации конструкционных материалов требует решения проблемы обработки больших площадей. В таких случаях эффективными оказываются ленточные источники, в которых для формирования необходимой геометрии пучка используются магнитные и электрические поля.
Схема простейшего источника такого типа, имеющего одну вытягивающую апертуру приведена на рис.3.7. Источник обеспечивает ток до 50 мА, плотность ионного тока от 10-2 мА/см2 до 1,5 мА/см2 при ускоряющем напряжении до 150 кВ.
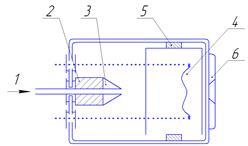
Рис. 3.7 –– Схема сильноточного ионного источника: 1 –– подача газа; 2 –– магнит; 3 –– анод; 4 –– катод; 5 - кольцевой магнит, 6 –– сетки.
 2015-05-20
2015-05-20 6575
6575
