Если к образцу, содержащему p-n-переход, приложить внешнее электрическое поле, то, как и в случае выпрямляющего контакта металл-полупроводник, основная часть напряжения U будет падать в слое объемного заряда, имеющем наибольшее сопротивление.
Пусть поле приложено таким образом, что p-область заряжается отрицательно. Такое включение и вызывает повышение потенциального барьера до величины φ = φ 0+ eU. Приложение внешнего поля в прямом направлении ослабляет внутреннее поле и уменьшает потенциальный барьер до φ = φ 0+ eU. В соответствии с этим изменяется и толщина слоя объемного заряда. Для наиболее распространенного случая (nn << pp), получим согласно (7.27) и (7.28) выражения для толщины барьерного слоя резкого p-n-перехода
 . (7.29)
. (7.29)
Толщина плавного перехода
 . (7.30)
. (7.30)
Таким образом, изменение внешней разности потенциалов приводит к изменению высоты и ширины потенциального барьера (рис. 7.8).











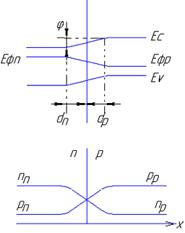

а) б)
Рис. 7.8. Зонная диаграмма и распределение концентрации носителей заряда
во внешнем поле: а – прямое; б – обратное включение
Как видно на рис. 7.8, а, в результате воздействия внешнего поля в прямом направлении происходит перераспределение концентрации носителей заряда так, что концентрация неосновных носителей в области заряда становится больше их равновесной концентрации. Процесс «впрыскивания» избыточных носителей получил название инжекции. Величину концентрации этих носителей Δ p и Δ n можно определить, учитывая концентрации равновесных носителей pn и np
 , (7.31)
, (7.31)
 . (7.32)
. (7.32)
Если напряжение приложено в обратном направлении, приграничные концентрации носителей уменьшаются, по сравнению с равновесными значениями, тоже по экспоненциальному закону (рис. 7.8, б). Такой процесс «вытягивания» носителей заряда называется экстракцией.
Поделив (7.31) на (7.32), получим выражение
 . (7.33)
. (7.33)
Отсюда следует, что в случае резко несимметричного перехода концентрация инжектируемых неосновных носителей гораздо больше в высокоомном слое, чем в низкоомном. Следовательно, в несимметричных переходах инжекция носит односторонний характер. Инжектирующий слой с относительно малым удельным сопротивлением называют эмиттером, а слой с относительно большим сопротивлением, в который инжектируются неосновные для него носители, – базой.
Рассмотрим выпрямляющие свойства p-n-перехода. В равновесном состоянии через переход проходят потоки основных и неосновных носителей, причем эти потоки равны. Поэтому как электронные, так и дырочные токи по обе стороны p-n-перехода равны:
 ,
,  , (7.34)
, (7.34)
где jp, jn – плотность тока основных носителей;
jps, jns – плотность тока неосновных носителей.
Как уже говорилось, токи основных носителей jp, jn называют диффузионными, или инжекционными, поскольку основной носитель, преодолевший металлургическую границу, становится неосновным. Токи неосновных носителей – jps, jns осуществляются в результате экстракции носителей электрическим полем контакта и поэтому называются дрейфовыми.
В случае термодинамического равновесия можно записать, что
 . (7.35)
. (7.35)
Вычисляем jns и jps. Для этого используем выражения для диффузионного тока (см. п.6.2)
 ,
,  (7.36)
(7.36)
и для диффузионной длины носителей L
 ,
,  , (7.37)
, (7.37)
где τ – время жизни носителей.
Поскольку переход является тонким, т.е. dn / dx = np / Ln, dp/dx = pn/Lp, можно записать (7.36) с учетом (7.37) в виде
 ,
,  . (7.38)
. (7.38)
Прямой ток. Приложим к p-n-переходу внешнюю разность потенциалов U, подключив к p-области положительный полюс источника, а к n-области – отрицательный. Как уже говорилось, в этом случае высота потенциального барьера для основных носителей уменьшается, а инжекционные токи jp, jn возрастают в eeU/kt раз. Дрейфовые токи ips, ins от высоты барьера не зависят, и поэтому на их величину внешнее поле не повлияет. С учетом сказанного, выражение (7.35) примет вид
 . (7.39)
. (7.39)
Или с учетом (7.34) и (7.38):
 . (7.40)
. (7.40)
Обратный ток. Приложим теперь к переходу обратное напряжение, подключив n-область перехода к положительному полюсу, а p-область – к отрицательному полюсу. В этом случае потенциальный барьер внутреннего поля возрастает на eU, а обратный ток уменьшается в eeU/kT раз. Для плотности обратного тока можно записать выражение
 . (7.41)
. (7.41)
Выражения (7.40) и (7.41) можно объединить:
 . (7.42)
. (7.42)
или
 . (7.43)
. (7.43)
Последнее выражение представляет собой уравнение вольт-амперной характеристики (ВАХ) p-n-перехода (рис. 7.9, а).
Анализ выражения (7.43) показывает, что при увеличении обратного напряжения экспонента стремится к нулю, а плотность тока к is – плотности тока насыщения.

а) б)
Рис. 7.9. ВАХ p-n-перехода: а – без учета пробоя, 1 – тонкий переход, 2 – толстый
переход; б – пробой перехода; 1 – туннельный, 2 – лавинный, 3 – тепловой пробои
Практически она достигается уже при eU ≈ 4 kT, т.е. при U ≈ 1 В. Поскольку концентрация неосновных носителей невелика, то для германиевых переходов is имеет порядок 10-2 А/м2.
В случае прямого включения p-n-перехода прямой ток возрастает по экспоненте и уже при незначительных напряжениях достигает большой величины. Уравнение ВАХ (7.43) справедливо только для прямого напряжения Uпр ≤ Uот – напряжения отсечки, когда высота потенциального барьера стремится к нулю
 . (7.44)
. (7.44)
При комнатной температуре для большинства полупроводников U о т составляет менее 0,5 В.
В случае прямых напряжений U > U о т , необходимо учитывать ограничивающее сопротивление материала p-n-перехода.
Влияние температуры на свойства p-n-перехода. Согласно закону действующих масс можно записать
 ,
,  , (7.45)
, (7.45)
где  . (7.46)
. (7.46)
Очевидно, что с повышением температуры ni будет быстро увеличиваться, тогда как nn ≈ Nd и pp ≈ Na от температуры практически не зависят. Поэтому при некоторой температуре ni может достичь такого значения, что концентрации основных и неосновных носителей практически сравниваются np ≈ nn, pp ≈ pn. Тогда потенциальный барьер φ 0 (7.20) исчезнет, исчезнут и выпрямляющие свойства p-n-перехода. Из (7.46) видно, что эта температура будет тем выше, чем больше ширина запрещенной зоны полупроводника Eg. Для германиевых переходов Eg =0,62 эВ, предельная рабочая температура ≈75ºС, для кремниевых переходов, где Eg = 1,2 эВ, предельная рабочая температура может достичь 150ºС.
Уравнение вольт-амперной характеристики (7.43) было получено для тонкого перехода без учета процессов генерации и рекомбинации носителей заряда в области p-n-перехода. Для большинства реальных переходов оно не выполняется и вид ВАХ может существенно зависеть от этих процессов (см. рис. 7.9, а, 2). Оказывается, что в реальном переходе, к которому приложено обратное напряжение, преобладает процесс генерации носителей тока. Эти носители разделяются электрическим полем, что приводит к появлению дополнительного обратного тока jген, так что
 , (7.47)
, (7.47)
где d 0 = dp = dn – толщина p-n-перехода;
L 0 = Lp = Ln – диффузионная длина.
В случае прямого включения перехода концентрация основных носителей в переходе возрастает вследствие их инжекции. Поэтому здесь преобладает процесс рекомбинации и ток тоже возрастает на jрек так, что
 . (7.48)
. (7.48)
График 2 на рис. 7.9, а показывает, что в случае учета процессов генерации и рекомбинации возрастают и прямой, и обратный ток, причем при прямом включении ветви для толстого и тонкого переходов уже при малых Uпр практически сливаются. В уравнении ВАХ p-n-перехода (7.43) также не учитывается явление резкого увеличения обратного тока при достижении Uобр = Uпроб – явления пробоя. Напряжение Uпроб называют напряжением пробоя.
В зависимости от характера физических процессов, приводящих к резкому возрастанию обратного тока, различают три основных типа пробоя: лавинный, туннельный и тепловой (см. рис. 7.9, б).
Туннельный пробой возникает в достаточно тонких (d < λ) p-n-переходах. Тогда уже при сравнительно невысоком обратном напряжении, напряженность поля на переходе достигает критической величины Eкр ≈ 107 В/м, для кремния Eкр ≈ 108 В/м.
Такое поле способно вызвать туннелирование электронов сквозь потенциальный барьер p-n-перехода (см. п. 6.4).
Считая, что Eкр = Uпр / d, где d = (2 εε 0 Uпр /2 enn)1/2 – толщина несимметричного p-n-перехода, можно записать
 , (7.49)
, (7.49)
где ρ = 1/(eμnnn) – удельное сопротивление слаболегированной области перехода.
С увеличением величины p-n-перехода вероятность туннельного пробоя уменьшается и возрастает вероятность лавинного пробоя.
Лавинный пробой возникает в p-n-переходах, толщина которых больше длины свободного пробега (d > λ). Здесь при высоких обратных напряжениях электроны могут приобретать такую достаточно высокую кинетическую энергию, что оказываются способными вызвать ударную ионизацию (п. 6.4). В этом случае происходит лавинное увеличение концентрации носителей и тока. Величиной, характеризующей нарастание обратного тока, служит коэффициент умножения γ, выражающий отношение числа носителей, выходящих из p-n-перехода, к числу носителей, входящих в переход n 0: γ=n/n 0. С увеличением толщины p-n-перехода его сопротивление увеличивается и критическое поле в переходе уменьшается. Поэтому зависимость пробивного напряжения от удельного сопротивления (обратного тока) оказывается более слабой, чем для туннельного пробоя (см. рис. 7.9, б).
Резкая зависимость величины обратного тока от обратного смещения в области пробоя используется для стабилизации напряжения. Диоды, предназначенные для работы в таком режиме, называются стабилитронами.
Тепловой пробой. При прохождении тока в p-n-переходе выделяется тепло. Если это тепло не полностью отводится из зоны перехода, то температура перехода будет повышаться, а повышение температуры приводит к увеличению тока. Результатом такого нарастающего процесса будет тепловой пробой перехода (см. рис. 7.9, б). Если туннельный и лавинный пробой обратимы, то тепловой пробой приводит к разрушению материала p-n-перехода.
Диффузионная емкость p-n-перехода возникает в результате инжекции и экстракции неосновных носителей. При приложении внешней разности потенциалов изменяются концентрация носителей вблизи перехода и величина их заряда. Это воспринимается внешней цепью, как емкость Cд, которую называют диффузионной емкостью p-n-перехода.
Расчет показывает, что
 . (7.50)
. (7.50)
Поскольку jp >> jps, jn >> jns, можно записать
 . (7.51)
. (7.51)
Коэффициент выпрямления. Отношение прямого тока к обратному при том же напряжении показывают коэффициентом выпрямления
 . (7.52)
. (7.52)
Так, для комнатной температуры при Uпр = Uобр = 0,5 В, K имеет порядок 109.
Весьма широкой областью применения p-n-переходов являются импульсные схемы радиоэлектронных и электронно-вычислительных средств.
В этих случаях необходимо учитывать высокочастотные и импульсные свойства p-n-перехода. Одним из основных параметров перехода в этих условиях является его быстродействие, характеризуемое длительностью переключения перехода с прямого смещения на обратное и с обратного на прямое. При переключении перехода в нем протекают переходные процессы накопления неосновных носителей при прямом смещении и рассасывания их при обратном. Скорость протекания этих процессов и определяет быстродействие p-n-перехода: она будет тем меньше, чем меньше заряд, то есть емкость перехода.
Для уменьшения Cд и повышения быстродействия p-n-перехода необходимо уменьшить время жизни избыточных неосновных носителей, легируя p-n-переход примесью, создающей активные рекомбинационные центры, например, золотом. Помимо диффузионной емкости p-n-переход еще обладает т.н. барьерной, или зарядовой, емкостью, вызванной объемным зарядом p-n-перехода. Эта емкость связана с высотой и толщиной потенциального барьера. Под действием внешнего поля φ и d изменяют свою величину согласно (7.29) или (7.30). Для плоского p-n-перехода величину барьерной емкости можно вычислить по формуле плоского конденсатора
 . (7.53)
. (7.53)
Барьерная емкость, так же как и диффузионная, негативно влияет на частотные свойства p-n-перехода.
 2015-02-04
2015-02-04 8298
8298








