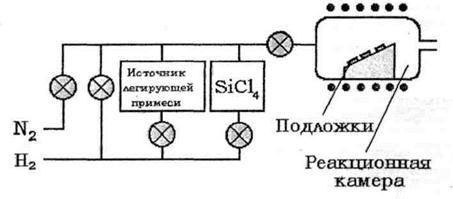
Процесс эпитаксиального осаждения включает этапы:
1. загрузка пластин в реакционную камеру;
2. продувка камеры азотом для вытеснения воздуха;
3. продувка камеры водородом;
4. нагрев пластин до температуры 1200°С,
5. осаждение эпитаксиального слоя, для чего начинают пропускать водород через
жидкий SiCl4. Водород захватывает пары SiCl4 и переносит их в реакционную камеру,
где идет реакция восстановления кремния.
В процессе роста эпитаксиальные слои легируют, т.е. в них вводят донорные или акцепторные примеси для получения определенного типа проводимости (n- или p-) и определенного удельного сопротивления эпитаксиального слоя. Легирование эпитаксиальных слоев происходит одновременно с их ростом путем введения в газовую смесь соединений, содержащих легирующие элементы.
Если необходимо получить эпитаксиальный слой n-типа проводимости, используют легирующие вещества, содержащие фосфор (РС13, РН3 и др.).
Если необходимо получить эпитаксиальный слой p-типа проводимости, используют легирующие вещества, содержащие бор (В2Н6, BBr3 и др.).
Эпитаксия выполняется на установках типа УНЭС, Изотрон, управляемых в основном ЭВМ.
Основной недостаток хлоридного метода - высокая температура процесса, приводящая к проникновению примесей из пластины в растущий эпитаксиальный слой.
 2015-02-14
2015-02-14 553
553








