Слипание происходит, когда концентрация ПД становится настолько большой, что они начинают взаимодействовать друг с другом. Согласно теоретическим представлениям на этой стадии происходит рост дефектов большого размера за счёт поглощения ими малых дефектов. При этом происходит увеличение характерных размеров ПД и сужение их распределения по размерам.
Были проведены облучения кремния дозами Н+ примерно на порядок большими, чем дозы, характерные для Smart-cut процесса [32,33]. После этого в обычный оптический микроскоп наблюдались пластинчатые дефекты с размерами от 1,0 до 6,0 мкм. Распределение этих дефектов по размерам зависело от глубины и энергии иона и было более узким, чем для ПД на стадии роста. Более подробных исследований стадии слипания не проводилось.
Отщепление
Отщепление имеет ту же природу, что и блистеринг. Это подтверждается следующими фактами. Для наблюдения блистеринга и наблюдения отщепления необходима некоторая критическая доза имплантации. Время обоих процессов уменьшается с ростом дозы и одинаковым активационным образом зависит от температуры. Энергия активизации образования блистеров и полного отщепления пластины одинаковы. Однако время отщепления примерно на порядок больше [32,33]. Однако есть и отличие. При блистеринге происходит вскрытие поверхности отдельных микропор, заполненных газом (или отрыв локальных областей поверхности - небольших чешуек). Отщепление же происходит по всей пластине. Чтобы это происходило, необходимо объединение локальных микротрещин до того как образуются блистеры. Это обеспечивается созданием «ребра жёсткости». В Smart-cut технологии ребро жёсткости создаётся путём связывания с опорной пластиной. Обычно это связывание производится через термический окисел. В принципе, возможна и другая комбинация материалов. Чтобы получить качественное ребро жёсткости необходимо обеспечить вдоль всей связанной поверхности отсутствие пустот, посторонних частиц и других загрязнений. Их наличие приводит к «неполному» прилеганию соответствующих поверхностей, то есть отсутствию связывания на соответствующих участках. Последнее ведёт к неполному отщеплению, что сказывается на качестве изготавливаемых структур КНИ.
ОСОБЕННОСТИ ПРОЦЕССА СРАЩИВАНИЯ СТАНДАРТНЫХ ПЛАСТИН КРЕМНИЯ МЕЖДУ СОБОЙ И ПЛАСТИНАМИ ИЗОЛЯТОРОВ (СТЕКЛА) ВО ВЛАЖНЫХ УСЛОВИЯХ (ВКЛЮЧАЯ И МЕТОД МОЛЕКУЛЯРНОГО НАСЛАИВАНИЯ) С ИСПОЛЬЗОВАНИЕМ МЕТОДОВ НАБЛЮДЕНИЯ ВЫДЕЛЕНИЯ ПАРОВ ВОДЫ
Процессы связывания стандартных пластин кремния с различными подложками имеют большое значение в современной полупроводниковой технологии. Существует множество методов связывания монокристаллических подложек. Это в первую очередь термокомпрессионный метод связывания, осуществляемый при высоких температурах с приложением внешнего давления к соприкасающимся очищенным поверхностям подложек. Для создания специальных приборов и устройств используются методы связывания через слои двуокиси кремния, различных оксидов металлов, стеклообразных промежуточных слоев и т.д. Особый интерес представляет метод сращивания стандартных пластин кремния с нанесенными слоями двуокиси кремния посредством химических реакций между гидроксилированными и гидратированными поверхностями пластин
(сращивание во влажных условиях [1-8]). Именно этот процесс получил наиболее широкое распространение на практике. Ниже рассматриваются особенности теории процесса сращивания стандартных пластин кремния во влажных условиях (включая возможность использования химической сборки поверхности методом молекулярного наслаивания [9-15]) по данным выделения паров воды.
Имеются значительные трудности получения структур КНИ посредством технологического роста слоев кремния, например, на сапфире и двуокиси кремния, связанные с несоответствием постоянных решеток, в результате чего получаются некачественные слои кремния. Выше отмечалось, что в последние годы появилась новая технология получения качественных слоев кремния до толщин ~ 10 мкм посредством сращивания двух стандартных пластин и последующего утонения одной из них до требуемой толщины слоя монокристаллического кремния. Процесс сращивания является очень сложным и заключается, по-существу дела, в процессе взаимодействия двух гидратированных и гидроксилированных поверхностей SiO2 [20,21]. Физико-химическая модель сращивания, предложенная в работе [21], влючает три последовательные стадии (рис.2).
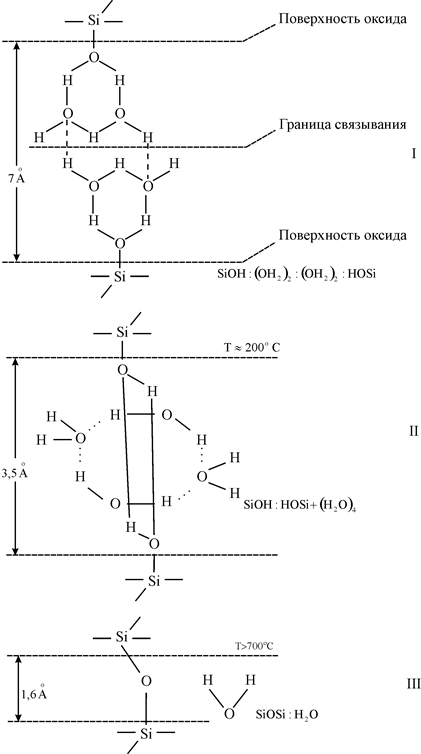
Рис.2 Физико-химическая модель сращивания стандартных пластин кремния.
На первой стадии при соприкосновении двух гидратированных поверхностей образуются водородные связи между кислородом и водородными атомами адсорбированных молекул воды (четыре молекулы воды могут образовать водные кластеры (циклические тетрамеры)). Максимальная энергия связи, свойственная циклическим тетрамерам, составляет величину примерно 10 ккал/моль [21] в расчете на одну молекулу воды, что соответствует 0,43 эВ. Это в три раза больше, чем прочность связи для “гидроксиловой” воды в димере, которая равна примерно 3 ккал/моль. Вследствие этого энергетически выгодно отделение водных кластеров от SiOH групп с образованием новых SiOH - OHSi связей. Так как образующиеся тетрамеры имеют эффективный диаметр около 4 Å, то они не могут диффундировать от поверхности сращивания. Однако, при температурах Т>7000 C кластеры воды распадаются, а молекулы воды диффундируют сквозь сетчатый каркас SiO2.. При этом единичные силанольные связи могут образовать SiOSi связи с выделением молекул воды. В работах [20,21] отмечается, что при комнатной температуре энергия связи двух осушенных гидратированных поверхностей пластин, обусловленная ОН-связями молекул Н2О составляет величину примерно 85 эрг/см2. При температуре выше 3000 С возникают Н-связи за счет ОН-групп поверхности SiO2, а (Н2О)4 распадается и молекулы Н2О диффундируют от места сращивания. При этом предполагается, что имеются две Н-связи на одно место сращивания; при этом получается структура, не имеющая места в воде, но возможная для поверхностных ОН групп. Если взять, как наиболее вероятную, энергию связи в водном димере, то получим для прочности связи величину 2х6,1 ккал/моль, соответствующую поверхностной энергии сращивания 634 эрг/см2 в случае, если все силанольные группы связаны друг с другом. В области очень высоких температур вплоть до 8000 С идет дальнейшее удаление воды и образование связей SiOSi. Технология сращивания включает в свой состав процесс осушки пластин при 500 С перед процессом непосредственного сращивания. Это очень важная стадия, так как она позволяет избежать обильного образования пузырьков воды на поверхности сращивания. Отметим, что образующиеся пузырьки исчезают сами по себе при комнатной температуре за несколько недель или за более короткое время при высоких температурах. В рамках модели работы [21] проведенные эксперименты по предварительной осушке говорят о том, что нагревание пластин перед этапом непосредственного сращивания состоит в десорбции Н2О с гидратированной (гидроксилированной) поверхности с освобождением пространства для развития SiOSi связей при последующих стадиях отжига. Это может оказывать существенное влияние на температурную зависимость прочности связывания пластин кремния.
Резюмируя, еще раз подчеркнем, что модель, предложенная в работах [20,21], состоит из трехстадийного процесса сращивания с участием молекул воды. На стадии I две подложки соединяются через кластеры воды и поверхностная энергия связи составляет величину примерно 100 эрг/см2. На стадии II уже Н-связи силанольных групп связывают пластины, а на поверхности раздела присутствуют водные кластеры со средней плотностью (Н2О)4/13,35.Å2. Максимальная энергия связи на стадии II равна 634 эрг/см2. На стадии III энергия связи достигает величины 2х980 эрг/см2, где 980 эрг/см2 - поверхностная энергия связи кварца. В работах [20,21] были проведены детальные экспериментальные исследования поверхностной энергии связывания в зависимости от времени отжига и температуры. В связи с этим ниже, следуя модели [20,21], посвященную кинетическому анализу поверхностной энергии связи, мы развили модель сращивания, основанную на выделении паров воды. Выпишем основные реакции этой модели
SiOH:(OH2)2:(OH2)2:OHSi 
 SiOH:SiOH+ (H2O)4 (45)
SiOH:SiOH+ (H2O)4 (45)
Структуры, соотвествующие левой и правой частей уравнения (44), соответствуют реакциям между стадиями сращивания I и II. Естественно, что
(Н2О)4 ® (Н2О)3 + Н2О ® (Н2О)2 + Н2О ® 2 Н2О (46)
Кроме того
SiOH:SiOH «SiOSI + H2O (47)
SiOH:SiOH  SiOSi + H2O (48)
SiOSi + H2O (48)
Это протекающие реакции между стадиями сращивания II и III, соответствующие процессу прямого связывания двух окисленных пластин кремния с гидроксильными группами на их поверхности (пластины А и В). При нагревании соединенных двух таких пластин взаимодействие двух противоположных ОН групп приводит к образованию молекул воды и силоксановых связей Si-O-Si.

Рис.3 Прямое связывание двух окисленных пластин кремния с гидроксильными группами на их поверхности (пластины А и В).
В работе [5] показаны сканирующие акустические томографические изображения (СAT) границы раздела связывания. Обе сухие- (А) и влажно-окисленные пластины (С), соединенные в сухих условиях, показывают несовершенную связь, что видно из затемненного пространства. С другой стороны сухие- (В) и влажно-окисленные пластины (D), соединенные во влажных условиях, указывают на более лучшее связывание за исключением пор от царапин и загрязнений. Следует отметить, что чрезвычайно трудно удалить все следы воды в пространстве, окисленном в сухих условиях. Таким образом, для получения качественных КНИ структур поверхности окисленных пластин, синтезируемых с использованием химической сборки поверхности методом молекулярного наслаивания, целесообразно проводить процесс сращивания в условиях влажной атмосферы.
Энергия активации реакции (45) должна быть порядка величины энергии водородной связи, которая равна примерно 50 мэВ. Энергия активации для реакции (48) должна быть заключена в пределах от 1,8 до 2,1 эВ, так как эта реакция подобна поверхностной реакции окисления кремния.
Естественно, что
d[SiOSi]/dt=d[H2O]/dt= k2(no-[SiOSi) = k2(no - [H2O]) (49)
Здесь к1 и к2 - константы скоростей реакций, no - число мест сращивания. Кроме того, согласно (47)
d[H2O]¢/dt = к¢1 [SiOH:SiOH] = k¢1 [H2O]¢ (50)
Решения уравнений (49) и (50), согласно [21], позволяют описать кинетику прочности связывания и кинетику газовыделения
W = (1960 эрг/см2 - WB) [ 1 - exp(-k2t)] + WB (51)
где 2х980 эрг/см2 - энергия связывания пластин кремния за счет SiOSi связей, а
WB = 630 exp(-0,05 эВ/кТ) эрг/см2 (52)
Здесь к - постоянная Больцмана, Т - температура.
Нам удалось показать при этом, что кинетика выделения паров воды во многом может описываться подобно уравнению (51)
[H2O](t) = {[no-no exp(-0,05/kT)] [1-exp(-k2t)]} + no exp(-0,05/kT) (53)
Из выражений (51) и () следует, что зависимости W и [H2O](t) симбатны. Этот вывод теории подтверждается на качественном уровне проведенными нами экспериментами по сращиванию стандартных пластин кремния различных марок. Следует однако отметить, что при выводе выражения (53) мы пренебрегли возможными процессами диссоциации воды на поверхности сращивания. Этот вопрос нуждается в дальнейших экспериментальных и теоретических исследованиях. Подчеркнем, что полученное нами выражение (53) может быть использовано в качестве алгоритма моделирования и оптимизации процесса сращивания пластин кремния. Для этого необходимо определять в ходе экспериментальных исследований величины no и к2, входящие в (53). На основании этих выводов в экспериментах [5] и теории сращивания [16,19,20] приведем модифицированную теорию сращивания, основанную на предположении о возможности наличия различного среднего числа ОН-групп на атоме кремния на поверхности сращиваемых пластин во влажных условиях (включая использование химической сборки поверхности методом молекулярного наслаивания [3,4,9-15,18]). Вначале рассмотрим основы этого метода.
6. Постановка задачи и предполагаемые решения проблемы активирования, гидрофилизации и сращивания поверхностей стандартных протонированных пластин ВО ВЛАЖНЫХ УСЛОВИЯХ Основная идея химической сборки поверхности методом молекулярного наслаивания [12-18], возможно пригодного для прецизионного «синтеза поверхности» пластин с известным составом и ее модифицирования, состоит в последовательном наращивании монослоев структурных единиц заданного химического состава. Технология прямого соединения пластин состоит в сращивании двух окисленных поверхностей пластин кремния, пластин кремния и германия с заданными толщинами окисла SiO2 на каждой из них. Первоначальной задачей является насыщение сращиваемых поверхностей ОН-группами на атомах кремния и германия. Каждый поверхностный атом кремния или германия может присоединять одну или две ОН-группы. Этот “монослой” ОН-групп может быть сформирован в специальном реакторе при обработке поверхности пластин парами воды в инертном газе-носителе (воздух, азот, аргон, гелий и т.д.) при температуре Т£ 2000 С [9-15]. Такого типа термообработка приводит к удалению сорбированной воды (около 2000 С) и образованию гидроксилированной поверхности с функциональными группами вида (ºSi-OH) и (ºGe-OH).
Эти функциональные группы могут активно взаимодействовать, например, с молекулами SiCl4 с образованием кремнийоксохлоридных групп по реакции
 (54)
(54)
Этот процесс следует проводить в обогреваемом реакторе при 2000 С, куда загружаются пластины кремния, прогревать их в потоке тщательно осушенного газа-носителя при 2000 С, а затем через реактор можно продувать, например, азот, насыщенный парами SiCl4. Чтобы обеспечить 100% - ное замещение ОН-групп по реакции (54) ее нужно проводить в условиях максимального удаления от равновесия. Как указывается в [3,4,9-15,18], экспериментально это достигается проведением процесса в не менее чем трехкратном избытке SiCl4 по сравнению с количеством его хемосорбированного по схеме (54) и удалением из зоны реакции газообразного продукта взаимодействия (HСl), способного при накоплении в реакционной зоне разрушать связи ºSi-O-Siº. Следующая операция состоит в продувке сухим азотом пластин для удаления избытка SiCl4, HСl.
Отметим, что число связей с поверхностью, концентрация привитых по реакции (54) функциональных групп (ºSi-O-)2SiCl2 зависит от количества и расположения ОН-групп на исходной поверхности и будут уменьшаться с увеличением температуры.
Теперь можно сформулировать программу и пути ее реализации при синтезе методом молекулярного наслаивания слоя SiO2 заданной толщины. Для этого вполне логично использовать на стадии замещения хлор-ионов пары воды (донора кислорода) и активного хлорзамещающего реагента. При обработке парами воды при Т³ 2000 С на поверхности протекают реакции по схеме
 (55)
(55)
Этот процесс проводят до полного замещения Cl на ОН с последующим удалением избытка физически адсорбированной воды и HСl, то есть получают гидроксилированную поверхность, но ОН-группы уже связаны не с атомами исходной поверхности, а с атомами в составе привитых функциональных групп. Гидроксилированную поверхность вновь обрабатывают парами SiCl4 и образуется второй кремнийоксохлоридный монослой по схеме
 (56)
(56)
Затем продукт реакции (56) может быть подвергнут обработке парами воды и т.д.
Таким образом, многократно и попеременно обрабатывая поверхность кремниевой пластины SiCl4 и парами воды с соблюдением принципов молекулярного наслаивания можно сформировать на поверхности слой SiO2, толщина которого определяется числом циклов молекулярного наслаивания (один цикл в нашем случае включает реакции (54) и (55)) [3,4,9-15,18].
Исходя из вышесказанного можно видеть, что поверхность кремния в общем случае может содержать только 1) функциональные группы (ºSi - OH), или 2) функциональные группы (ºSi - O -)2SiCl2, либо 3) функциональные группы (ºSi - O -)2Si(ОН)2. Таким образом, в процессах термообработки прямого соединения пластин можно выделить шесть случаев поверхностных химических процессов с участием этих групп.
(ºSi-OH) + (HO-Siº) ® (ºSi-O-Siº) + H2O (57)
(ºSi-O-)2SiCl2 + (ºSi-O-)2SiCl2 ® (ºSi-O-)2 -  -(ºSi-O-)2 + SiCl4 (58)
-(ºSi-O-)2 + SiCl4 (58)

(ºSi-O-)2Si(OH)2+(ºSi-O-)2Si(OH)2®(ºSi-O-)2-  -O-
-O-  -(ºSi-O-)2 +Н2O (59)
-(ºSi-O-)2 +Н2O (59)
2 (ºSi-OH) +(ºSi-O-)2Si(OH)2 ® (ºSi-O-)2-  -(ºSi-O-)2 +
-(ºSi-O-)2 +
2 H2O (60)
2 (ºSi-OH) + (ºSi-O-)2SiCl2® 2(ºSi-O-)2-  -(ºSi-O-)2 + 2 HCl (61)
-(ºSi-O-)2 + 2 HCl (61)
(ºSi-O-)2Si(OH)2+(ºSi-O-)2SiCl2®(ºSi-O-)2-  -O-
-O-  -(ºSi-O-)2+2HCl (62)
-(ºSi-O-)2+2HCl (62)
Реакции типа (57)-(62) протекают в условиях нормального давления на поверхность при температурах Т ³ 2000 С. При этом можно предположить, что параметры трехмерной решетки SiO2 вблизи поверхности сращивания могут существенно зависеть от строения функциональных групп на исходных поверхностях соединямых пластин и режимов термообработки. Дальнейшая термообработка под давлением на пластины при температурах Т ³ 7000 С, по-видимому, приводит к возникновению одинаковой аморфной модификации SiO2 во всех указанных случаях. Далее видим, что наличие HCl и SiCl4 (или Cl2) вблизи границы сращивания скорее всего не способствует получению качественных структур кремний на диэлектрике. Поэтому из случаев (57)-(62) способов сращивания можно лишь выделить случаи (57), (59), (60), где летучими продуктами реакций являются пары.
На основании этих выводов экспериментов [12-18] и теории сращивания [19] приведем обобщенную нами феноменологическую теорию сращивания, основанную на предположении о возможности наличия различной плотности ОН-групп на поверхности сращиваемых пластин во влажных условиях (в том числе с возможностью использования химической сборки поверхности методом молекулярного наслаивания [12-18]). Модель, развитая в [19], различает различные стадии процесса сращивания в зависимости от температуры отжига. Первая стадия описывает поведение процесса сращивания при температурах ниже 1100 С. На этой стадии пластины связываются через кластеры воды. На второй стадии до температуры 1500 С, согласно [12-18], силанольные группы реагируют на поверхности раздела по формальной брутто-реакции
Si(1) - (OH)n + (HO)m - Si(2) «Si(1) - O - Si(2) + q H2O + p  (63a)
(63a)
Si(1) - (OH)n + (HO)m - Ge(2) «Si(1) - O - Ge(2) + q H2O + p  (63b)
(63b)
Здесь n и m - средние числа ОН-групп, приходящие на 1 поверхностный атом кремния или германия (0 £ n £ 2; 0 £ m £ 2); Si(1) и Si(2) или Ge(2) относятся к атомам кремния или германия на поверхности двух пластин (1) и (2), соответственно. Индекс s означает вхождение атомов кислорода в каркас SiO2 или GeO2 в местах сращивания. Отметим, что образующиеся молекулы воды диффундируют через каркас SiO2 или GeO2 вдоль поверхности раздела наружу от пластин и перпендикулярно поверхности пластин через слой SiO2 или GeO2, приводя к окислению кремния или германия на границе разделов Si - SiO2 или Ge - GeO2. Реакции (63) обратимы до температуры Т £ 4250 С. От 150 до 8000 С прочность связывания постоянна, если время отжига достаточно велико и ограничено размером контактирующего пространства. Выше 8000 С связывание пластин полностью осуществляется через слой окисла. Эффективная констаета скорости реакции (63) имеет вид
 , (64)
, (64)
то есть  пропорциональна концентрации паров воды в атмосфере. Здесь
пропорциональна концентрации паров воды в атмосфере. Здесь  формуле (64) является «истинной» константой скорости реакции (63). В противоположность этому, при низких давлениях скорость процесса ограничивается диффузией молекул воды от мест сращивания. Константа скорости
формуле (64) является «истинной» константой скорости реакции (63). В противоположность этому, при низких давлениях скорость процесса ограничивается диффузией молекул воды от мест сращивания. Константа скорости  на основании экспериментов по определению энергии связывания методом вставления лезвия в атмосфере паров воды [19,22,23] оказалась заключенной в пределах от 5,9 до 6,1×10-2 с-1 при атмосферном давлении Р0 и равной 4,6×10-2 с-1 при Р = 10 Па и 3,0×10-2 с-1 при Р = 0,2 Па [19], что соответствует сильной зависимости
на основании экспериментов по определению энергии связывания методом вставления лезвия в атмосфере паров воды [19,22,23] оказалась заключенной в пределах от 5,9 до 6,1×10-2 с-1 при атмосферном давлении Р0 и равной 4,6×10-2 с-1 при Р = 10 Па и 3,0×10-2 с-1 при Р = 0,2 Па [19], что соответствует сильной зависимости  от влажности окружающей среды.
от влажности окружающей среды. 
Выпишем возможные практически важные случаи реакции (63), реализуемые при прямом соединении пластин кремния с использованием химической сборки поверхности методом молекулярного наслаивания [8-14]. Для n =1, m = 1 имеем q = 1, p = 0, а
Si(1) - OH + HO - Si(2) «Si(1) - O - Si(2) + H2O (65)
 (66)
(66)
В случае n = 1, m = 2 или n =2, m = 1 имеем q = 3/2, p = 1/2
Si(1) - (OH) + (HO)2 - Si(2) «Si(1) - O - Si(2) + (3/2) H2O + (1/2)  (67)
(67)
 , (68)
, (68)
а в случае n = 2, m = 2 имеем q = 2, p = 1
Si(1) - (OH)2 + (HO)2 - Si(2) «Si(1) - O - Si(2) + 2 H2O + Os (69)
 (70)
(70)

Имеем  и таким образом оптимальным режимом по скорости связывания пластин является режим 3 (реакция 69). Однако в этом случае должно наблюдаться более обильное выделение паров воды по сравнению со случаями 1 и 2 (реакции 65 и 67), что может приводить к образованию на поверхности сращивания больших количеств газонаполненных пор и полостей [8]. Такого же типа выражения, подобные (65)-(70), могут быть записаны и для случая сращивания кремния и германия.
и таким образом оптимальным режимом по скорости связывания пластин является режим 3 (реакция 69). Однако в этом случае должно наблюдаться более обильное выделение паров воды по сравнению со случаями 1 и 2 (реакции 65 и 67), что может приводить к образованию на поверхности сращивания больших количеств газонаполненных пор и полостей [8]. Такого же типа выражения, подобные (65)-(70), могут быть записаны и для случая сращивания кремния и германия. 
В настоящее время в отсутствии чередования послойных процессов молекулярного наслаивания используемый нами процесс прямого сращивания пластин в условиях влажной термообработки вероятнее всего ближе реакционной схеме (65) (по существу это первый этап процесса молекулярного наслаивания - формирования слоя ОН-групп и адсорбция молекул воды на поверхности [6,19,21,22]). В этом случае получаются достаточно качественные структуры кремний на изоляторе, о чем говорят наши экспериментальные данные по электронномикроскопическим исследованиям рельефа границы сращивания. Случаи же, соответствующие реакционным схемам (67), (69) нуждаются в дальнейших экспериментальных исследованиях. Отметим также, что предлагаемый способ получения поверхности с заданным химическим составом, ее активирования и модифицирования при этом в условиях влажной атмосферы (включая использование химической сборки методом молекулярного наслаивания) может частично способствовать сглаживанию неоднородного рельефа поверхности сращиваемых пластин, что приводит к исчезновению пор, полостей и пустот вблизи границы сращивания. Все это и вышеизложенное нами позволяет применить методики низкотемпературного и высокотемпературного связывания и технологию Гёзеля-Тонга [15,18,19] для получения высококачественных структур кремний на изоляторе и структур германий на кремнии, изоляторе, арсениде галлия,  на кремнии и изоляторе и др. и структур кремний на германии.. Изложим ниже основные положения этой технологии на примере изготовления структур на основе кремния.
на кремнии и изоляторе и др. и структур кремний на германии.. Изложим ниже основные положения этой технологии на примере изготовления структур на основе кремния.
7. ТЕХНОЛОГИЯ ГЁЗЕЛЯ-ТОНГА СВЯЗЫВАНИЯ ГИДРОФИЛЬНЫХ ПЛАСТИН ВО ВЛАЖНЫХ УСЛОВИЯХ (ВКЛЮЧАЯ ВОЗМОЖНОСТЬ ИСПОЛЬЗОВАНИЯ ХИМИЧЕСКОЙ СБОРКИ ПОВЕРХНОСТИ МЕТОДОМ МОЛЕКУЛЯРНОГО НАСЛАИВАНИЯ)
Из предыдущего рассмотрения видно, что для достижения связывания без наличия пор необходимы чрезвычайная чистота поверхностей сращивания и очень малое количество частиц между ними в процессе химической и водной очистки. Более того, нужны строгие требования по чистоте к атмосфере, в которой происходит контактирование поверхностей при сращивании. Однако сообщается [20,21], что даже для контактирующих пластин в условиях чистых комнат первого класса около 70 % пластин уже содержат одну или более пор, обязанных частицам пыли <1 мкм в диаметре. Теоретические расчеты показывают [20,21], что частица диаметром около 1 мкм приводит к несвязываемому пространству диаметром около 0,5 см для стандартной пластины кремния диаметром 100 мм и толщиной 525 мкм.
Для того чтобы избежать наличия частиц между пластинами и удовлетворить строгим требованиям атмосферы чистых комнат было предложено простое устройство [20,21] для достижения сращивания без наличия пор. Пластины в нем устанавливаются горизонтально в тефлоновой рамке полированными сторонами друг к другу. При этом пластины содержатся раздельно с помощью прокладки тефлона, омываются потоком деионизованной воды и затем сушатся с помощью центрифугирования. После этого две поверхности приводятся в контакт посредством передвижения тефлоновой прокладки. Содержание пор в пластинах, связанных таким образом, зависит от скорости потока воды в щели между пластинами и от угловой скорости осушителя. При достаточно высоких скоростях воды и высоких значениях угловой скорости осушителя можно достичь высокой степени связывания без наличия пор, присущей сращиванию в атмосфере чистых комнат. Должны отметить, что при высокотемпературном связывании некоторые из пор сжимаются благодаря образованию вакуума между пластинами. Это приводит к более тесному контакту двух поверхностей, что уменьшает пространство несвязывания. Окисление кремния и германия в полости приводит к истощению по кислороду и созданию вакуума в ее объёме. Некоторые поры могут полностью исчезать. Такая ситуация конечно невозможна в случае образовании пор частицами. При отсутствии частиц на поверхности сращивания могут получаться достаточно качественные структуры, что подтверждается данными электронномикроскопических исследований поперечного сечения структуры КНИ (рис.6). Эти же выводы справедливы и для структур германий на кремнии, изоляторе, арсениде галлия,  на кремнии и изоляторе и др.
на кремнии и изоляторе и др.
 2015-04-20
2015-04-20 540
540








