Автор: преподаватель, С. А. Сильвашко, Преподаватель, Оренбургский государственный университет. Тип материала: Учебное пособие
Для создания различных полупроводниковых приборов, применяемых в электронных устройствах, используют кристаллические структуры, состоящие из чередующихся областей полупроводников п - и р -типа. Взависимости от типа полупроводникового прибора, число областей с разными типами проводимости может быть две и более. Основу любого полупроводникового прибора составляют электронно-дырочные переходы.
Электронно-дырочным переходом (или кратко р-п-переходом) называют тонкий слой между двумя областями полупроводникового кристалла, одна из которых имеет электронную, а другая – дырочную электропроводность.
Технологический процесс создания электронно-дырочного перехода может быть различным: сплавление, диффузия одного вещества в другое, эпитаксия (ориентированный рост одного кристалла на поверхности другого) и др. По конструкции электронно-дырочные переходы могут быть симметричными (пп = рр) и несимметричными (пп >> pp или пп << рр, при этом концентрации основных носителей отличаются в 100-1000 раз), резкими и плавными, плоскостными и точечными и др. Однако для всех типов переходов основным свойством является несимметричная электропроводность, при которой в одном направлении кристалл пропускает ток, а в другом – не пропускает.
Устройство полупроводникового кристалла с электронно-дырочным переходом показано на рисунке 1.5. Одна часть этого кристалла легирована (обогащена) донорной примесью и имеет электронную проводимость (п -область). Другая часть легирована акцепторной примесью и имеет дырочную проводимость (р -область). Кроме основных носителей в обеих частях кристалла имеется небольшая концентрация неосновных носителей (соответственно дырок в п -области и электронов в р -области).
Сразу после создания р - п -перехода при отсутствии внешнего электрического поля электроны из п -области стремятся проникнуть в р -область, где концентрация электронов значительно ниже. Аналогично, дырки из р -области перемещаются в п -область. В результате встречного движения противоположных зарядов возникает так называемый диффузионный ток р - п -перехода. Электроны, перешедшие в р -область, рекомбинируют с дырками, в результате чего в р -области вблизи границы раздела двух типов полупроводников появятся отрицательно заряженные неподвижные ионы акцепторной примеси. В свою очередь, уход электронов из п -области приводит к появлению в приконтактной части п -области нескомпенсированных положительно заряженных неподвижных ионов донорной примеси.
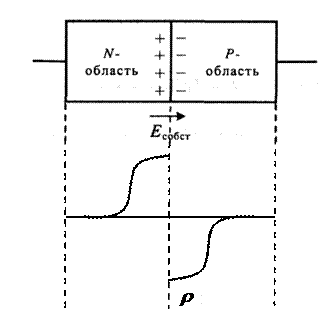
Рисунок 1.5 – Упрощенная структура р-п -перехода
Одновременно с перемещением электронов, из р -области в п -область наблюдается диффузионное перемещение дырок. Этот процесс сопровождается созданием таких же неподвижных положительных и отрицательных ионов вблизи границы раздела двух типов полупроводников в п -области и р -области.
Двойной слой неподвижных электрических зарядов (ионов) создает в области р - п -перехода объемный пространственный заряд, наличие которого приводит к появлению внутреннего электрического поля ( на рисунке 1.5). Вектор этого поля направлен таким образом, что оно препятствует дальнейшему диффузионному движению основных носителей зарядов. Поэтому через короткий промежуток времени на р-п -переходе устанавливается динамическое равновесие, он становится электрически нейтральным, а ток через р-п -переход – равным нулю.
на рисунке 1.5). Вектор этого поля направлен таким образом, что оно препятствует дальнейшему диффузионному движению основных носителей зарядов. Поэтому через короткий промежуток времени на р-п -переходе устанавливается динамическое равновесие, он становится электрически нейтральным, а ток через р-п -переход – равным нулю.
Разность потенциалов, образованную приграничными зарядами, называют контактной разностью потенциалов y к (потенциальным барьером), преодолеть которую носители без «сторонней помощи» не могут. Вместе с тем возникшее в р - п -переходе поле не препятствует движению неосновных носителей через переход, так как для них оно будет ускоряющим. Неосновные носители создают дрейфовый ток р - п -перехода.
Распределение плотности объемного заряда r в р - п -переходе при отсутствии внешнего электрического поля показано на рисунке 1.5.
Р-п -переход представляет собой слой полупроводника с низкой концентрацией подвижных носителей зарядов (обедненный слой). Этот слой имеет повышенное электрическое сопротивление. Поскольку концентрация основных носителей зарядов в областях полупроводника различна, то и ширина обедненного слоя в р- и п- областях также будет различной (в области с меньшей концентрацией основных носителей она будет шире).
Контактная разность потенциалов y к на р-п- переходе зависит от концентрации примесей в областях полупроводника и определяется выражением:
 , (1.1)
, (1.1)
где  – температурный потенциал;
– температурный потенциал;
пi – концентрация носителей зарядов в нелегированном полупроводнике;
k» 1,38 × 10-23 Дж/К – постоянная Больцмана;
Т – абсолютная температура, К;
q» 1,6×10-19 Кл – заряд электрона.
При нормальной температуре (Т = 300 К) j Т» 26 мВ. Контактная разность потенциалов для германия при этом имеет значение 0,2-0,3 В, а для кремния – 0,6-0,7 В.
Высоту потенциального барьера можно изменять приложением внешнего напряжения к р-п- переходу. Если внешнее напряжение создает в р - п -переходе поле, вектор напряженности которого совпадает по направлению с вектором напряженности внутреннего поля (рисунок 1.6, а), то высота потенциального барьера увеличивается, при обратной полярности приложенного напряжения высота потенциального барьера уменьшается (рисунок 1.6, б). Если полярность поля, создаваемого приложенным внешним напряжением, противоположна полярности собственного (внутреннего) поля и внешнее напряжение равно контактной разности потенциалов, то потенциальный барьер исчезает полностью.

а

б
Рисунок 1.6 – Прямое и обратное смещение р-п -перехода
Если приложенное напряжение снижает потенциальный барьер, то оно называется прямым, а если повышает – то обратным.
Обратный ток (i обр) в р - п -переходе вызывается неосновными носителями одной из областей, которые, дрейфуя в электрическом поле области объемного заряда, попадают в область, где они уже являются основными носителями. Так как концентрация основных носителей существенно превышает концентрацию неосновных, то появление незначительного дополнительного количества основных носителей практически не изменит равновесного состояния полупроводника. Таким образом, обратный ток зависит только от количества неосновных носителей, появляющихся на границах области объемного заряда. Его предельное значение (обозначим IТ) называют обратным током насыщения или тепловым током.
Внешнее приложенное напряжение определяет скорость перемещения этих носителей из одной области в другую, но не число носителей, проходящих через переход в единицу времени. Следовательно, обратный ток через р-п- переход является током проводимости и не зависит от высоты потенциального барьера, т. е. он остается постоянным при изменении обратного напряжения на переходе.
При прямом смещении p-п- перехода появляется диффузионный ток, вызванный диффузией основных носителей, преодолевающих потенциальный барьер. Пройдя р-п -переход, эти носители попадают в область полупроводника, для которой они являются неосновными носителями. Концентрация неосновных носителей при этом может существенно возрасти по сравнению с равновесной концентрацией. Такое явление носит название инжекции носителей.
Таким образом, при протекании прямого тока через переход из электронной области в дырочную будет происходить инжекция электронов, а из дырочной области в электронную будет происходить инжекция дырок.
Диффузионный ток зависит от высоты потенциального барьера и по мере его снижения увеличивается экспоненциально:
 , (1.2)
, (1.2)
где U – напряжение на p - n -переходе.
Кроме диффузионного тока прямой ток содержит ток проводимости, протекающий в противоположном направлении, поэтому полный ток при прямом смещении р-п -перехода будет равен разности диффузионного тока и тока проводимости:
 . (1.3)
. (1.3)
Полученное уравнение является аналитическим представлением вольт-амперной характеристики (ВАХ) р-п -перехода. На рисунке 1.7 приведены ВАХ германиевого и кремниевого р-п -переходов.
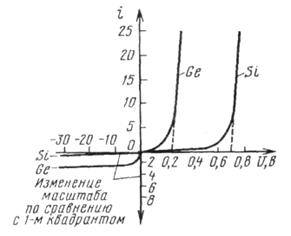
Рисунок 1.7 – Примеры ВАХ электронно-дырочных переходов
Как следует из выражения (1.3), при незначительном обратном напряжении на р-п- переходе (составляющем всего единицы вольт) экспонента стремится к нулю и, следовательно, обратный ток через р-п- переход определяется только тепловым током. Из рисунка 1.7 видно, что обратный ток р-п- перехода на основе кремниевого материала существенно меньше, чем обратный ток р-п- перехода на основе германиевого (например, у кремниевых диодов IT = 1-10 мкА, у германиевых – IT = 100-150 мкА).
Пробой р - п -перехода
Под пробоем р - п -перехода понимают значительное уменьшение его дифференциального обратного сопротивления, сопровождающееся резким возрастанием обратного тока при увеличении приложенного обратного напряжения.
На рисунке 1.8 показана обратная ветвь ВАХ р - п -перехода. На начальном участке обратной ветви ВАХ (участок 0 – 1) при увеличении обратного напряжения, приложенного к переходу, ток растет медленно. Увеличение тока обусловлено, в основном, увеличением количества носителей, принимающих участие в создании тока, возникающих за счет термогенерации в самом р - п -переходе. Кроме того, увеличение тока может быть связано с неидеальностью р - п -перехода. В этом случае за счет наличия дефекта кристаллической решетки возникают токи утечки.

Рисунок 1.8 – Пробой в электронно-дырочном переходе
Участок 1 – 2 называют предпробойным участком. В точке 2 происходит пробой р - п -перехода. Различают два вида пробоя: электрический (участок 2 – 3) и тепловой (участок 3 – 4). Электрический пробой характерен тем, что при практически неизменном падении напряжения на переходе ток резко увеличивается. Для теплового пробоя характерно резкое уменьшение напряжения на переходе при одновременном увеличении обратного тока.
Существует два вида электрического пробоя: лавинный и туннельный. Вид пробоя, в первую очередь, зависит от толщины р - п -перехода, то есть от концентрации примесей в р - и п - областях. Лавинный пробой наблюдается в широких р - п -переходах в слаболегированных полупроводниках. Он происходит при достаточно высокой напряженности электрического поля (0,8 × 105 - 1,2 × 105 В/см2), когда электроны, проходящие через р - п -переход, приобретают энергию, достаточную для ионизации атомов кристаллической решетки. Возникающие при этом вторичные электроны приобретают энергию за счет действия поля и также ионизируют атомы кристаллической решетки в р - п -переходе. Таким образом происходит лавинообразный процесс нарастания носителей, что приводит к резкому увеличению тока.
Туннельный пробой происходит в узких р - п -переходах, когда напряженность поля достигает величины порядка (6-7) × 105 В/см2 и энергетические зоны р - и п -областей смещаются таким образом, что оказывается возможным переход электронов из зоны проводимости п -области в валентную зону р -области и наоборот. Такой переход носит название туннельного, а поскольку электроны для такого перехода практически не затрачивают энергии, то ток через р - п -переход резко растет.
Тепловой пробой возникает за счет нарушения теплового равновесия в области р - п -перехода. За счет возрастания тока iобр мощность, выделяемая в р - п -переходе, увеличивается. Это приводит к увеличению температуры р - п -перехода и, следовательно, к увеличению тока термогенерации. В итоге ток через р - п -переход лавинообразно увеличивается и наступает тепловой пробой.
Процессы, происходящие при электрическом пробое, являются обратимыми, т. е. после уменьшения напряжения U обр ток i обр уменьшается. Тепловой пробой – необратим. В результате теплового пробоя р - п -переход разрушается и полупроводниковый материал приобретает свойства проводника.
Емкость р - п -перехода
Наряду с электропроводностью р - п -переход обладает и определенной емкостью. Образование р - п -перехода связано с возникновением пространственных зарядов, создаваемых неподвижными ионами примесей. Изменение внешнего напряжения меняет ширину перехода, а, следовательно, и величину пространственного заряда в нем. Таким образом, р - п -переход ведет себя подобно своеобразному плоскому конденсатору, обкладками которого служат проводящие слои, а диэлектриком – обедненный носителями слой р - п -перехода.
Емкость р - п -перехода подразделяют на две составляющие: барьерную (Сбар), отражающую перераспределение зарядов в р - п -переходе, и диффузионную (Сдиф), отражающую перераспределение зарядов вблизи р - п -перехода:
 . (1.4)
. (1.4)
При прямом смещении перехода в основном проявляется диффузионная емкость, при обратном – основную роль играет барьерная емкость.
Диффузионная емкость Сдиф, обусловленная прохождением основных носителей заряда, прямо пропорциональна току, протекающему при прямом смещении перехода
 , (1.5)
, (1.5)
где t р – среднее время жизни дырок в п -области;
 – прямой ток через р - п -переход;
– прямой ток через р - п -переход;
Qp – заряд, образуемый дырками, инжектированными в п -область.
При напряжении Uобр» 0,2 В ток I = – Iобр и, следовательно, диффузионная емкость равна нулю. Таким образом, диффузионная емкость существует только при прямом смещении р - п -перехода.
Барьерная емкость Сбар проявляется при обратном смещении р - п -перехода. Ее численное значение обратно пропорционально приложенному напряжению и определяется из выражения:
 , (1.6)
, (1.6)
где S – площадь р - п -перехода;
e а – абсолютная проницаемость полупроводникового материала;
q – заряд электрона;
пп – концентрация основных носителей заряда в п -области;
y к – контактная разность потенциалов;
Uвн – обратное напряжение, приложенное к переходу.
Зависимость барьерной емкости от напряжения (Сбар = f (Uобр)) называется вольт-фарадной характеристикой. Ее примерный вид представлен на рисунке 1.9.
Рисунок 1.9 – Вольт-фарадная характеристика р-п -перехода
 |
Полупроводниковые диоды
Устройство и вольт-амперная характеристика диода
Полупроводниковым диодом называется полупроводниковый прибор с одним выпрямляющим электрическим переходом и двумя выводами, в котором используется то или иное свойство выпрямляющего электрического перехода.
В качестве выпрямляющего электрического перехода в полупроводниковых диодах могут быть использованы:
- электронно-дырочный переход (р-п- переход);
- гетеропереход;
- выпрямляющий переход, образованный в результате контакта между металлом и полупроводником (переход Шоттки).
Особенности устройства р - п -перехода и процессы, протекающие в нем, рассмотрены ранее.
Гетеропереходом называют переходный слой с существующим в нем диффузионным электрическим полем между двумя различными по химическому составу полупроводниками. При этом проводимости двух полупроводников, образующих гетеропереход, могут быть разными или одинаковыми. Кроме этого сам переход может быть выпрямляющим или омическим.
Омическим называется переход, электрическое сопротивление которого не зависит от направления тока через него.
На рисунке 1.10 показаны структуры двух разновидностей гетеропереходов (рисунок 1.10, а, б), а также омического перехода на контакте полупроводников с одним типом электропроводности (рисунок 1.10, в).

а б в
Рисунок 1.10 – Разновидности электрических переходов в полупроводниковых кристаллах
На рисунке 1.11 показаны структуры полупроводниковых диодов с выпрямляющим электрическим переходом в виде р-п- перехода (рисунок 1.11, а) и на контакте Шоттки (рисунок 1.11, б).
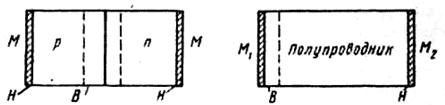
а б
Рисунок 1.11 – Структуры полупроводниковых диодов на основе
р-п -перехода (а) и перехода Шотки (б)
Буквой Н на рисунке 1.11 обозначены невыпрямляющие (омические) переходы, а буквой В – выпрямляющие электрические переходы. Буквой М обозначен металлический слой.
В основе работы большинства полупроводниковых диодов лежат процессы, происходящие в р-п -переходе, причем в реальных диодах, как правило, используются несимметричные р-п -переходы. В таких переходах одна из областей кристалла (область с большей концентрацией основных носителей) бывает достаточно низкоомной (как правило – это р -область), а другая – высокоомной.
На рисунке 1.12 показано распределение основных носителей и области р-п -перехода в кристалле полупроводникового диода.
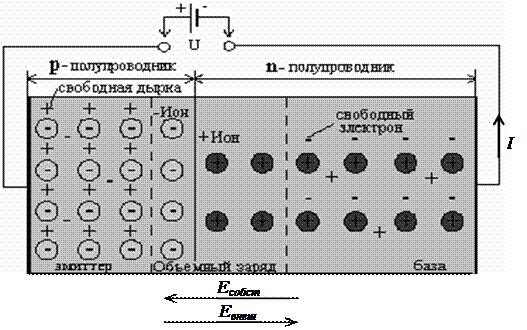
Рисунок 1.12 – Распределение носителей зарядов в кристалле полупроводникового диода
Вывод от р -области диода называют анодом, а от п -области – катодом. Условное графическое обозначение (УГО) диода в общем случае имеет вид, представленный на рисунке 1.13.

Рисунок 1.13 – УГО диода
Если положительный вывод источника напряжения подключен к аноду диода, а отрицательный – к катоду, то приложенное напряжение называется прямым, в противном случае – обратным. Ток через диод при прямом смещении р-п -перехода практически полностью определяется потоком основных носителей низкоомной области. Поэтому ее называют эмиттером. В связи с большей концентрацией носителей в низкоомной области ширина р-п -перехода в ней оказывается меньше, чем в высокоомной. Если различие в концентрации основных носителей велико, то р-п -переход почти целиком расположится в высокоомной области, которая получила название базы.
Вольт-амперная характеристика полупроводникового диода определяется, в общем случае, ВАХ р-п -перехода. На рисунке 1.14 показана ВАХ диода в сравнении с ВАХ обычного (анализируемого ранее) р-п -перехода. Различия в характеристиках связаны с тем, что при анализе свойств р-п -перехода не учитывались особенности структуры кристалла диода, сопротивления полупроводниковых слоев, ширина перехода.
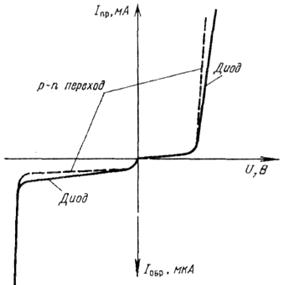 |
Рисунок 1.14 – Общий вид ВАХ диода
Если к диоду приложено прямое напряжение, превышающее по величине контактную разность потенциалов (в частности, для германиевого диода yк = 0,2-0,3 В, для кремниевого – yк = 0,6-0,7 В), то диод открыт и пропускает прямой ток (прямая ветвь ВАХ, рисунок 1.14). При этом его сопротивление незначительно (десятки-сотни Ом) и падение напряжения на диоде составляет десятые доли вольт.
При подаче обратного напряжения по абсолютной величине меньшего Uобр max диод заперт и через него протекает пренебрежительно малый обратный ток Iобр (обратная ветвь ВАХ, рисунок 1.14). Если обратное напряжение превысит значение Uобр max, то наступает пробой р-п -перехода диода (сначала электрический, а при дальнейшем увеличении напряжения – тепловой), при котором обратный ток резко возрастает. В случае возникновения теплового пробоя диод выходит из строя («сгорает»).
В зависимости от способа изготовления р - п -перехода различают точечные, сплавные, сварные и диффузионные диоды. В точечных диодах (рисунок 1.15, а) к предварительно очищенной поверхности кристалла полупроводника электронной проводимости прижимается жесткая заостренная игла из сплава вольфрама с молибденом. После герметизации собранного диода через него пропускают электрические импульсы большой мощности. Под действием этих импульсов приконтактная область полупроводника сильно нагревается, и непосредственно под острием иглы образуется небольшая по размерам (от 5 до 40 мкм) р -область.
 |
Рисунок 1.15 – Способы получения р-п -перехода
В сплавных и сварных диодах (рисунок 1.15, б, в) р - п -переход получают с помощью тонкой проволочки, содержащей атомы акцепторной примеси, при ее вплавлении или сварке с кристаллом полупроводника п -типа.
В диффузионных диодах используют метод диффузии донорных или акцепторных примесей в полупроводниковый кристалл, имеющий противоположный тип электропроводности. Диффундирующие атомы изменяют тип электропроводности небольшой части кристалла, что создает р - п -переход. Для получения малой емкости в рассматриваемом виде диодов после диффузии проводят травление приповерхностных слоев полупроводника, после которого р - п -переход сохраняется на очень малом участке, имеющем вид столика, возвышающегося над остальным кристаллом (рисунок 1.15, г).
Эту полупроводниковую структуру называют мезаструктурой (мезадиффузионные диоды). Другую разновидность диффузионных диодов представляют собой планарные и эпитаксиально-планарные приборы (рисунок 1.15, д), в которых диффузия примеси осуществляется через специальные «окна» в защитной окисной пленке (например, из двуокиси кремния SiO 2). Кроме небольших значений барьерной емкости в диффузионных диодах удается значительно снизить время жизни неравновесных носителей заряда за счет дополнительной диффузии золота.
Цифрами на рисунке 1.15 обозначены: 1 – р - п -переход; 2 – кристалл; 3 – омический контакт.
Для того чтобы количественно характеризовать диоды, используют различные параметры, названия и количество которых зависят от типов диодов. Некоторые из параметров используют при характеристике диодов большинства подклассов.
К ним, в частности, относятся:
Iпр макс – максимально допустимый постоянный прямой ток;
Uпр – постоянное прямое напряжение, соответствующее заданному току;
Uобр макс – максимально допустимое обратное напряжение диода;
Iобр макс – максимально допустимый постоянный обратный ток диода;
rдиф – дифференциальное сопротивление диода (при заданном режиме работы).
В настоящее время существуют диоды, предназначенные для работы в очень широком диапазоне токов и напряжений. Для наиболее мощных диодов Iпр макс составляет килоамперы, а Uобр макс – киловольты.
Классификация полупроводниковых диодов
Полупроводниковые диоды весьма многочисленны, и одним из основных классификационных признаков служит их назначение, которое связано с использованием определенного явления в р - n -переходе.
Первую группу составляют выпрямительные диоды, для которых основным является вентильный эффект (большая величина отношения прямого тока к обратному), но не предъявляется жестких требований к временным и частотным характеристикам.
В настоящее время наибольшее распространение получили кремниевые выпрямительные диоды, которые имеют следующие преимущества:
- примерно на два порядка меньшие (по сравнению с германиевыми) обратные токи при одинаковом напряжении;
- высокое значение допустимого обратного напряжения, которое достигает 1000-1500 В, в то время как у германиевых диодов оно находится в пределах 100-400 В;
- работоспособность кремниевых диодов сохраняется при температурах от –60 до +150 °С, германиевых – от –60 до +85 °С.
Однако в выпрямительных устройствах низких напряжений выгоднее применять германиевые диоды, так как их сопротивление при прямом смещении р - п -перехода в 1,5-2 раза меньше, чем у кремниевых, при одинаковом токе нагрузки, что уменьшает мощность, рассеиваемую внутри диода.
По значению выпрямленного тока выпрямительные диоды делят на диоды малой (Iпр < 0,3 А), средней (0,3 А < Iпр < 10 А) и большой (Iпр > 10 А) мощности.
Вторая группа диодов – высокочастотные и импульсные. В них также используют вентильный эффект, но это маломощные приборы, работающие при высоких частотах (в детекторных, смесительных каскадах) или в быстродействующих импульсных устройствах. Для диодов этих подклассов более важными являются параметры, характеризующие их быстродействие, в частности, емкость диода (обычно десятые доли-единицы пФ), время установления прямого и восстановления обратного сопротивлений (сотые доли-единицы микросекунд), частота без снижения режимов.
Условное графическое обозначение на принципиальных электрических схемах выпрямительных, высокочастотных и импульсных диодов одинаково и соответствует представленному на рисунке 1.13.
Диоды третьей группы – стабилитроны. Они работают в режиме электрического пробоя, который наблюдается при обратном смещении диода. Материалы, используемые в стабилитронах, имеют высокую концентрацию примесей, что приводит к тому, что напряженность электрического поля в их р - п -переходах значительно выше, чем у остальных типов диодов. За счет этого при относительно небольших обратных напряжениях в р - п -переходе возникает электрический пробой. Механизм пробоя может быть туннельным, лавинным или смешанным. Обычно у низковольтных стабилитронов более вероятен туннельный пробой, а у высоковольтных – лавинный. В обоих случаях сильного нагрева р - п -перехода не происходит, поэтому теплового пробоя не наступает.
УГО и обратная ветвь ВАХ стабилитрона, используемая в рабочем режиме, представлены на рисунке 1.16.
 |
Рисунок 1.16 – Обратная ветвь ВАХ стабилитрона
Стабилитроны применяют в нелинейных цепях постоянного тока для стабилизации напряжения. При проектировании стабилизаторов напряжения ток стабилизации стабилитрона при номинальном напряжении на выходе стабилизатора выбирается из условия
 , (1.7)
, (1.7)
где Iст макс и Iст мин, соответственно, максимальный и минимальный токи на рабочем участке ВАХ, взятые из справочника.
Наряду со стабилитронами для целей стабилизации напряжения применяют также стабисторы. Отличие стабилитрона от стабистора заключается в используемой для стабилизации напряжения ветви ВАХ (у стабилитронов используют обратную ветвь, у стабисторов – прямую). Для стабилизации напряжения более 3 B применяют обратносмещенные стабилитроны, а для стабилизации напряжений менее 3 В – прямосмещенные стабисторы.
В диодах четвертой группы используют емкостные свойства р - п -перехода. В связи с тем, что р - п -переход представляет собой область, обедненную носителями зарядов, то его можно рассматривать как своеобразный плоский конденсатор, емкость которого определяется шириной р - п -перехода. Если к диоду приложить обратное напряжение и изменять его величину, то ширина р - п -перехода также будет изменяться, что эквивалентно изменению его емкости. Такое свойство р - п -перехода позволяет использовать полупроводниковый диод в качестве прибора с электрически управляемой емкостью – варикапа. Вольт-фарадная характеристика и УГО варикапа показаны на рисунке 1.17.
Кроме рассмотренных выше диодов в электронных устройствах широко используют диоды Шотки (рисунок 1.18, а), а в специальных случаях – туннельные диоды (рисунок 1.18, б).
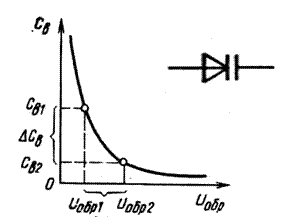
Рисунок 1.17 – УГО и вольт-фарадная характеристика варикапа
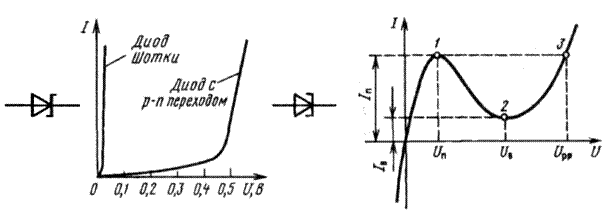
а б
Рисунок 1.18 – УГО и вольт-амперные характеристики диода Шотки (а) и туннельного диода (б)
Основным элементом диодов Шотки является электронный переход металл – полупроводник с нелинейной ВАХ. Свойства таких диодов во многом сходны со свойствами диодов с несимметричными р - п -переходами. Основное отличие диодов Шотки от диодов на основе электронно-дырочного перехода состоит в том, что в них формирование тока осуществляется основными носителями зарядов и не связано с инжекцией неосновных носителей зарядов и их рассасыванием, что обеспечивает значительно лучшие частотные характеристики таких диодов и повышает их быстродействие в импульсных устройствах.
Кроме того, сопротивление барьера Шоттки при прямом напряжении меньше прямого сопротивления р - n -перехода, поэтому прямые ветви ВАХ выпрямительного диода с барьером Шотки и диода с р-п- переходом отличаются. Диоды Шотки широко применяют в качестве элементов цифровых микросхем для улучшения их характеристик.
Туннельный диод – занимает особое место среди полупроводниковых диодов из-за свойственной ему внутренней положительной обратной связи по напряжению и хороших динамических свойств. Его ВАХ (рисунок 1.18, б) имеет участок с отрицательным дифференциальным сопротивлением (участок 1 - 2). Это позволяет использовать туннельный диод в качестве активного элемента в усилителях и автогенераторах СВЧ-диапазона.
Особую группу составляют излучающие диоды и фотодиоды.
Излучающий диод (УГО представлено на рисунке 1.19, а) – полупроводниковый диод, излучающий под действием приложенного напряжения из области р - п -перехода кванты энергии. Излучение испускается через прозрачную стеклянную пластину, размещенную в корпусе диода.

а б
Рисунок 1.19 – УГО излучающего диода (а) и фотодиода (б)
По характеристике излучения излучающие диоды делятся на две группы:
- диоды с излучением в видимой области спектра, получившие название светодиоды;
- диоды с излучением в инфракрасной области спектра, получившие название ИK-диоды.
Принцип действия обоих групп диодов одинаков и базируется на самопроизвольной рекомбинации носителей заряда при прямом токе через выпрямляющий электрический переход. Известно, что рекомбинация носителей заряда сопровождается освобождением кванта энергии. Спектр частот последней определяется типом исходного полупроводникового материала. Основными материалами для изготовления светодиодов служат фосфид галлия, арсенид-фосфид галлия, карбид кремния. Большую часть энергии, выделяемой в этих материалах при рекомбинации носителей заряда, составляет тепловая энергия. На долю энергии видимого излучения в лучшем случае приходится (10-20) %. Поэтому КПД светодиодов невелик.
Светодиоды применяют в качестве световых индикаторов, а ИК-диоды – в качестве источников излучения в оптоэлектронных устройствах (в частности, в пультах дистанционного управления бытовой техники).
Фотодиод (УГО показано на рисунке 1.19, б) – полупроводниковый прибор, принцип действия которого основан на использовании внутреннего фотоэффекта – генерации в полупроводнике под действием квантов света (фотонов) свободных носителей заряда.
Фотодиоды используют для преобразования светового (или инфракрасного) излучения в электрический ток (например, в устройствах дистанционного управления бытовых приборов).
Классификация современных полупроводниковых приборов по их назначению, физическим свойствам, основным электрическим параметрам, конструктивно-технологическим признакам, роду исходного полупроводникового материала находит отражение в системе условных обозначений их типов.
Система обозначений современных полупроводниковых диодов установлена отраслевым стандартом ОСТ 11 336.919-81 и базируется на ряде классификационных признаков.
В основу системы обозначений положен семизначный буквенно-цифровой код, первый элемент которого (буква – для приборов широкого применения, цифра – для приборов, используемых в устройствах специального назначения) обозначает исходный полупроводниковый материал, на основе которого изготовлен прибор. Второй элемент обозначения – буква, определяет подкласс приборов, третий элемент – цифра (или буква для оптопар), определяет основные функциональные возможности прибора. Четвертый элемент – двухзначное число, обозначающее порядковый номер разработки технологического типа прибора, пятый элемент – буква, условно определяет классификацию (разбраковку по параметрам) приборов, изготовленных по единой технологии.
Например:
- КД102А (2Д102А) – кремниевый выпрямительный диод со средним выпрямленным током менее 0,3 А (согласно справочнику – не более 100 мА), номер разработки 2, группа А;
- АЛ103Б (3Л103Б) – арсенид-галлиевый излучающий диод ИК-диапазона, номер разработки 3, группа Б;
- КС156А (2С156А) – кремниевый стабилитрон мощностью не более 0,3 Вт с напряжением стабилизации 5,6 В (номер разработки 56), группа А.
Математическая модель диода
При анализе схем электронных устройств на ЭВМ все элементы схем, в том числе и диоды, заменяются их математическими моделями. Математическая модель диода – это совокупность математических выражений, описывающих токи и напряжения в эквивалентной схеме (схеме замещения) диода. В качестве схемы замещения диода можно использовать электрическую модель Эберса – Молла для одиночного электронно-дырочного перехода, показанную на рисунке 1.20.

Рисунок 1.20 – Схема замещения полупроводникового диода
Постоянное сопротивление Rд включено в схему с целью учета тока утечки. Емкость Сд представляет сумму барьерной и диффузионной емкостей перехода, r – объемное сопротивление тела базы, зависящее от геометрических размеров и степени легирования полупроводника. Управляемый напряжением на переходе ип источник тока Iд моделирует статическую ВАХ диода.
Ток управляемого источника тока подчиняется закону:
 , (1.8)
, (1.8)
где IТ – ток насыщения (обратный ток) р - п -перехода;
А и М – эмпирические коэффициенты;
Числовые значения коэффициентов А и М, как правило, находят экспериментально. С этой целью можно воспользоваться ВАХ диодов, приводимыми в справочной литературе либо снятыми экспериментально. Для каждого типа диода, взависимости от его основных характеристик, технологии изготовления и т. д., эти коэффициенты будут различными.
Предложенная модель хорошо аппроксимирует ВАХ диода, кроме той области, где наступает электрический пробой (рисунок 1.21). Но, как правило, режим пробоя для большинства диодов (кроме стабилитронов) является нерабочим режимом.
 |
Рисунок 1.21 – Аппроксимация ВАХ диода
Электрическая схема замещения диода, представленная на рисунке 1.20, в общем случае является неполной. В электрической модели (а, следовательно, и при составлении математической модели) дискретного диода необходимо также учесть наличие индуктивностей выводов L 1и L 2, емкости корпуса Сп и контактов Ск (рисунок 1.22). Такая модель называется глобальной моделью дискретного диода.

Рисунок 1.22 – Глобальная модель диода
 2015-04-01
2015-04-01 40674
40674
